什么是COB?即板上芯片封装,是一种区别于SMD表贴封装技术的新型封装方式,具体是将LED裸芯片用导电或非导电胶粘附在PCB上,然后进行引线键合实现其电气连接,并用胶把芯片和键合引线包封。
COB封装最早在照明上应用,并且这种应用也成为一种趋势,据了解,COB封装的球泡灯已经占据了LED灯泡40%左右的市场。COB光源除了散热性能好、造价成本低之外,还能进行个性化设计。但在技术上,COB封装仍存在光衰、寿命短、可靠性差等不足之处,如能得到解决,将是未来封装发展的主导方向之一。
COB的封装技术又被归类为免封装或者省封装的模式,但是这种封装方式却并不是省去封装环节,而是省去封装流程,和贴片工艺相比,COB的封装流程要省去几个步骤,在一定程度上节省了时间和工艺,也在一定程度上节约了成本。SMD的生产工艺需要经过固晶、焊线、点胶、烘烤、冲压、分光分色、编带、贴片等环节,而COB的工艺在这个基础上进行简化,首先将IC贴在线路板上然后固晶、焊线、测试、点胶、烘烤,成为成品。
单就生产流程上来看,就省去了几个步骤,业内人士表示,这样一来,就可以节省很大一部分的成本。值得注意的一点是,COB的封装不需要过回流焊,这也成为COB的优势之一。
奥蕾达市场总监杨锐表示常规的封装是将灯珠放在PCB板上进行焊接,灯越来越密的时候,灯脚也会越来越小,那么对于焊接的精密度要求会越高。一个平方有多少颗灯,一个灯有四个脚,那么一个平方就会有许多的焊点,这个时候,对于焊点的要求是很高的,那么唯一的解决办法就是把焊点缩小。
很小的焊锡稳定度很差的,可能随便碰一下,就有可能脱落,这是SMD所无法避免的问题;COB封装省去分光分色,烘干等流程,最关键的区别就是去掉焊锡这个流程,SMD在焊锡的过程中,对于温度的把控极难掌握,温度过高,会对灯造成损坏,过低,则焊锡没有完全融化。很容易造成虚焊、假焊等现象,对于灯珠的稳定性提升是一大挑战。而COB没有这个流程,那么稳定性就会得到很大的提升。
传统LED显示屏的加工工艺比较繁多,尤其是在经过回流焊的过程中,高温状态下SMD灯珠支架和环氧树脂的膨胀系数不一样,极易造成支架和环氧树脂封装壳脱落,出现缝隙,在后期的使用中逐渐出现死灯现象,导致不良率较高。而COB显示屏之所以更稳定,是因为在加工工艺上不存在回流焊贴灯,即使有后期的回流焊贴IC工序,二极管芯片已用环氧树脂胶封装固化保护好了,就避免了焊机内高温焊锡时造成的灯珠支架和环氧树脂间出现缝隙的问题。
-
pcb
+关注
关注
4417文章
23967浏览量
426180 -
COB封装
+关注
关注
4文章
75浏览量
15740
发布评论请先 登录
LED晶膜屏的FPC基材选型与COB封装工艺研究(源头厂家技术白皮书)
CoWoS(Chip-on-Wafer-on-Substrate)先进封装工艺的材料全景图及国产替代进展

云台驱动板拆装工艺与硬件结构拆解分析
豪恩汽电COB封装车载摄像头PCBA通过AEC-Q100认证
人工智能加速先进封装中的热机械仿真

SK海力士HBS存储技术,基于垂直导线扇出VFO封装工艺

保隆科技COB封装摄像头通过AEC-Q认证
COB显示技术加速普及,TCL华星量产入局
联创电子车规级8M COB封装产品荣获AEC-Q100认证
国产划片机崛起:打破COB封装技术垄断的破局之路
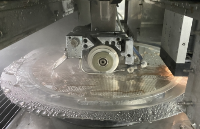
半导体封装工艺流程的主要步骤




 手机cob封装工艺
手机cob封装工艺








评论