湿气如何进入塑封体并影响材料性能
在半导体器件的塑封结构中,主要使用的环氧塑封料和底填胶都是以环氧树脂为基体的复合材料。这些材料中加入了无机填充颗粒、固化剂、催化剂、偶联剂等成分,其中环氧树脂的质量占比约为10%到20%。无机填料通常采用表面经过特殊处理的球形二氧化硅颗粒,这些颗粒能够提高材料的热传导能力、增加机械强度、减少固化过程中的收缩,并改善材料与芯片之间的热匹配性。
从微观结构来看,环氧树脂的分子链之间并不是完全致密的状态,内部存在着比水分子尺寸更大的微小孔隙。同时,分子链上含有羟基、羧基、胺基等容易与水分子结合的极性官能团。在湿热环境下,外界环境中的水分子可以通过材料表面或者填料与树脂之间的界面,逐渐向塑封材料内部扩散。水分子进入后会与这些极性官能团形成氢键吸附,在材料中主要以自由水和结合水两种形式存在。
自由水分布在高分子链之间的孔隙、微裂纹及界面处,具有一定流动性,可在适当温度下迁移或挥发。结合水通过氢键与极性基团牢固结合,难以脱附。水分吸附和滞留会引起湿膨胀、降低界面结合强度,并影响电学性能,最终降低器件长期可靠性。
湿热环境引起的应力问题
塑封料和底填胶吸收水分后会发生湿膨胀,而在温度升高过程中材料又会产生热膨胀。在湿热环境中,芯片、基板、塑封料等不同材料之间的热膨胀系数和湿膨胀系数存在差异,这种不匹配会导致器件出现过大的翘曲变形。由于不同材料的变形受到相互约束,在芯片边缘、键合引线以及塑封料与基板的界面等位置容易产生较高的应力,增加了材料分层和断裂的风险。
对球栅阵列封装器件在吸湿及回流焊过程中的分析表明,吸湿对可靠性的影响甚至大于回流热应力本身。通过有限元分析对三维芯片堆叠塑封结构进行湿热研究,发现边角位置的焊球存在高应力,下层芯片互连焊球的应力高于上层焊球。针对系统级封装模组的湿-热-力耦合模型研究表明,基板厚度变化对内部湿热应力影响较为敏感。
界面分层失效的形成机制
湿气在材料界面聚集会破坏化学键与偶联剂网络,水分子与极性官能团形成竞争性氢键,降低界面结合能力。随着水分子持续吸附,局部断裂强度下降。对于金属界面,湿气可能引发化学反应,促进金属间化合物快速生长,使界面局部厚度增加,形成微裂纹和空洞,进一步弱化界面结合。当界面结合力难以抵抗湿热应力时,出现微裂纹萌生和扩展,最终导致界面分层。湿扩散一方面弱化界面,另一方面吸湿膨胀与热膨胀产生的剪切应力和剥离应力是界面失效的主要驱动力。湿热环境下,界面分层受到断裂强度降低、湿热失配应力及快速升温导致水分蒸发产生的蒸气压共同影响。针对倒装芯片封装结构在回流焊条件下的仿真研究发现,塑封料、硅芯片与粘结剂的交界处应力和能量释放率最大,界面裂纹最容易扩展,且能量释放率与内部湿浓度和热冲击程度正相关。此外,界面富集的水分在回流焊等高温过程中会在界面微孔隙中迅速汽化形成蒸气压,当蒸汽压力与湿热膨胀应力共同作用、超过界面断裂强度时,裂纹沿界面快速扩展,即爆米花效应。蒸气压对含空腔器件影响显著,吸湿器件空腔内蒸气压饱和后与湿热应力共同作用,显著增加界面分层可能性。
焊点的电化学腐蚀与性能劣化
金属焊点本身不吸湿,但湿气扩散至焊点周边的吸湿材料及界面时,会影响焊点受力状态,并可能形成电化学腐蚀环境。当界面分层扩展至焊点区域时,蒸汽压与湿热应力叠加可能加速焊点微裂纹的产生与扩展,甚至导致断裂。通电下,焊点表面水膜和离子杂质形成原电池。阳极金属溶解,阴极析氢,生成氧化物/氢氧化物,破坏焊点完整性。湿热下应力与化学环境协同,提高焊点对湿度、电场、载荷的敏感性。应力集中区成为腐蚀起点,腐蚀降低承载能力,加速裂纹扩展,引发短路或接触不良。通过盐雾试验表明,铜焊盘与锡存在电偶腐蚀,氯离子加速锡溶解。潮湿环境下焊料表面水膜为电解介质,阳极溶解生成亚锡离子,向阴极迁移还原成锡枝晶。湿热越严苛,枝晶生长越快,氯离子显著促进腐蚀,导致可靠性失效。
吸湿引起的电性能退化
塑封器件内部高分子复合材料吸湿会引起整体电学参数变化。湿扩散为局部电场集中和离子迁移提供条件,可能诱发材料电性能退化。塑封料吸湿使界面和吸湿富集区的介电常数升高,并伴随介电损耗增加。介电常数升高改变器件内部电场分布,使界面或缺陷区域产生局部高场点,增加击穿风险。介电损耗增加导致电能转化为热能的比例加大,加剧局部温升,产生额外热管理问题。吸湿导致界面水膜和孔隙中溶解离子在电场下迁移,漏电流增大,并可能诱发电化学腐蚀。长期服役表现为绝缘电阻下降、电场畸变、功能失效。湿扩散、介电变化、离子迁移、腐蚀多因素耦合。研究发现,湿扩散不仅导致塑封料介电常数和耗散因数上升,还降低了临界电场强度,使绝缘层耐压性能减弱。吸湿引起的局部电场畸变增加漏电流与击穿风险,尤其在填料-基体界面处,湿气富集形成电弱化区域,进一步削弱整体绝缘性能。
总结
综上所述,在湿热环境中,塑封半导体器件首先受到湿扩散及湿气在界面上的富集影响,导致局部膨胀、翘曲以及内部应力集中,这类力学效应会削弱界面完整性,并提高界面分层与裂纹扩展的发生概率。与此同时,水分在界面及互连区域的存在会改变局部环境条件,使焊点等关键部位更容易暴露于电化学腐蚀风险之中。当湿气进入互连与焊区后,水膜与溶解离子在电场作用下可能引发离子迁移及绝缘性能退化,表现为漏电流升高和电学性能劣化。此外,吸湿引起的材料电学参数变化也会对局部电场分布产生影响,进一步加剧电性能退化过程。因此,湿热环境下塑封器件的失效并非由单一原因主导,而是湿膨胀应力、界面劣化、焊点腐蚀及电学退化等多种机制并行作用、相互耦合的结果。对于塑封半导体器件的可靠性设计和评估,需要综合考虑这些因素,通过理论分析、实验验证和仿真模拟等手段进行系统评估,以指导可靠性设计工作。
-
材料
+关注
关注
3文章
1582浏览量
28689 -
半导体器件
+关注
关注
12文章
810浏览量
34267
发布评论请先 登录
元器件失效分析方法
半导体失效分析项目介绍
半导体塑封设备
提升功率半导体可靠性:推拉力测试机在封装工艺优化中的应用

湿热环境下的隐患:如何避免聚氨酯灌封胶水解风险? | 铬锐特实业




 塑封半导体器件在湿热环境下的失效风险分析
塑封半导体器件在湿热环境下的失效风险分析


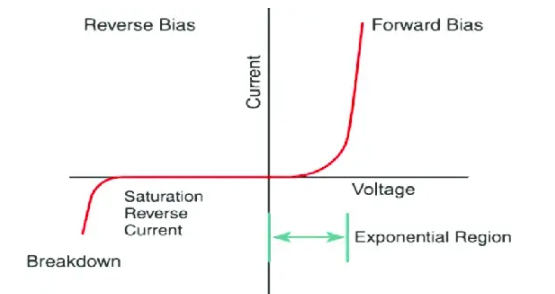





评论