文章来源:Jeff的芯片世界
原文作者:Jeff的芯片世界
侧墙工艺是半导体制造中形成LDD结构的关键,能有效抑制热载流子效应。本文从干法刻蚀原理出发,深度解析侧墙材料从单层SiO₂到ONO三明治结构及双重侧墙的迭代演进,揭示先进制程下保障器件可靠性与性能的核心逻辑。
侧墙工艺是半导体制造中用于形成轻掺杂漏(LDD)结构的关键技术。在器件尺寸不断缩小的过程中,漏极电压升高会导致耗尽区宽度增加,载流子在强电场作用下形成高能热载流子,进而引发热载流子注入效应,这是导致器件和芯片失效的常见诱因。为降低漏极与衬底PN结附近的峰值电场强度,研发人员引入了LDD结构,即在漏极与沟道之间形成一层很薄的轻掺杂区。侧墙工艺的作用正是在LDD离子注入后,制造出掩蔽层以防止后续重掺杂的源漏离子注入影响轻掺杂区域。从器件剖面图可见,LDD结构位于侧墙正下方,侧墙能够有效掩蔽LDD结构,且该工艺不需要掩模版,成本较低、流程简单。
侧墙的形成基于各向异性的干法刻蚀回刻技术。首先淀积厚度为S1的介质层,多晶硅栅的厚度为S2,其侧面介质层总厚度为S1+S2。干法刻蚀方向垂直向下,刻蚀停止于硅表面,刻蚀厚度即为S1,因此多晶硅栅侧面剩余的介质层厚度为S2,最终形成侧墙结构。侧墙的横向侧面宽度略小于S1,该宽度决定了LDD结构的横向尺寸,由淀积的介质层厚度决定。

侧墙刻蚀工艺流程
侧墙刻蚀的典型流程如下:先沉积介质层,随后进行各向异性的干法刻蚀回刻,刻蚀方向垂直向下,停止于硅表面。侧墙的厚度由沉积的介质层厚度决定。针对侧墙刻蚀工艺,主要反应气体包括C4F8、CH3F、CH2F2、CHF3、CF4等,同时需添加稀释气体如O2、Ar和He。对于由二氧化硅和氮化硅组成的ON侧墙,通常使用含氢的碳氟化合物气体(如CH3F、CH2F2、CHF3)进行刻蚀。
在0.8μm及以下的工艺技术中,淀积的隔离侧墙介质层为二氧化硅,常用TEOS(四乙基氧化硅)发生分解反应生成,厚度约2000Å。TEOS的台阶覆盖率良好,随后利用干法刻蚀形成侧墙。
侧墙介质材料的技术迭代
随着特征尺寸不断缩小,侧墙介质层材料经历了多次更新迭代。对于0.8μm及以下工艺,使用单层二氧化硅即可满足要求。当特征尺寸降至0.35μm以下时,单层二氧化硅已无法满足器件电性能需求,需采用二氧化硅和氮化硅(SiO2/Si3N4,ON)双层组合结构。其原因有二:其一,单层刻蚀时没有停止层,易损伤硅衬底,而双层结构中下层可作为刻蚀停止层;其二,深亚微米下栅极与漏极接触填充金属距离很近,二氧化硅隔离效果不足,氮化硅具有更好的电隔离特性。典型工艺为先LPCVD淀积约200Å二氧化硅作为应力缓解层,再淀积约1500Å氮化硅。

当特征尺寸进入0.18μm及以下,双层侧墙结构出现新问题:厚度较大的氮化硅会产生应力,使器件发生应变,导致饱和电流减小、漏电流增大。为此引入三明治结构(SiO2/Si3N4/SiO2,ONO),即先淀积约200Å二氧化硅、再淀积约400Å氮化硅、最后用TEOS生成约1000Å二氧化硅。该结构通过减薄氮化硅并由两层二氧化硅控制应力影响。
当特征尺寸达到90nm及以下时,栅极与漏极间的寄生电容Cgd逐渐增大并影响器件速度。为增大栅极与漏极LDD结构的距离,采用双重侧墙技术:先淀积约50Å二氧化硅和约150Å氮化硅,刻蚀形成第一重侧墙,进行LDD离子注入;随后再淀积ONO三明治结构作为第二重侧墙。第二重侧墙的典型工艺为LPCVD淀积约150Å二氧化硅、约350Å氮化硅、约1000Å二氧化硅,依次刻蚀形成最终结构。
侧墙工艺随晶体管尺寸缩小而不断演进,其介质材料经历了从单层二氧化硅、双层二氧化硅/氮化硅、ONO三明治结构到双重侧墙的演变过程。
-
半导体
+关注
关注
339文章
31194浏览量
266320 -
工艺
+关注
关注
4文章
719浏览量
30388
原文标题:侧墙(Spacer)工艺介绍
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测


半导体制造的难点汇总
半导体制造工艺中的主要设备及材料大盘点
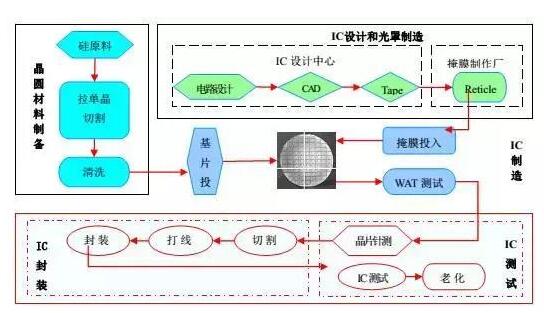
半导体制造工艺教程的详细资料免费下载
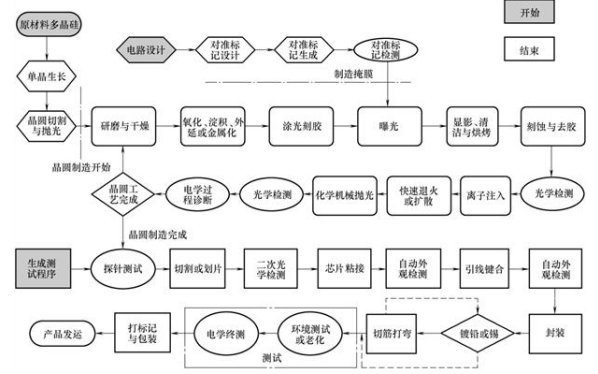
半导体制造教程之工艺晶体的生长资料概述

两种标准的半导体制造工艺介绍
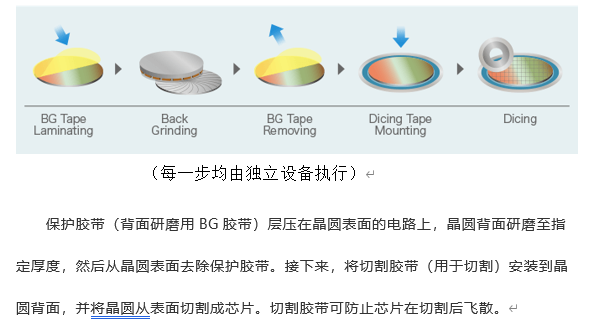
半导体制造中的高温氧化工艺介绍




 半导体制造中的侧墙工艺介绍
半导体制造中的侧墙工艺介绍

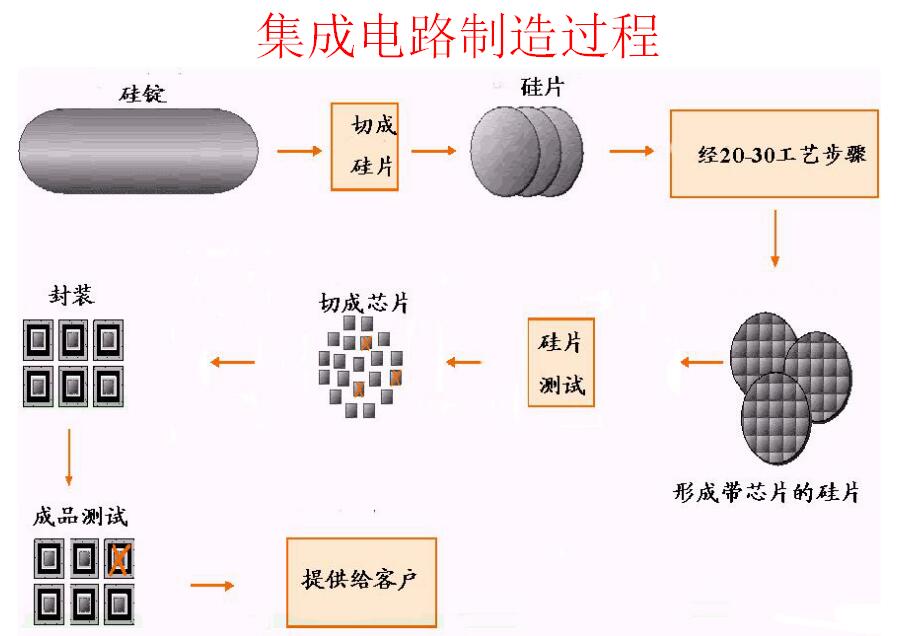




评论