文章来源:学习那些事
原文作者:小陈婆婆
本文介绍了集成电路制造中的硅片双面研磨与表面磨削工艺。
硅片双面研磨与表面磨削作为去除切割损伤层、提升表面平坦度的核心工序,其工艺选择与参数控制直接决定硅片几何精度与后续工序良率。
双面研磨

硅片双面研磨,其技术本质在于通过精密机械运动与化学-机械协同作用去除切割损伤层并提升几何精度。该工艺采用游轮片承载硅片置于上下磨盘之间,依托行星运动轨迹实现硅片与磨盘的相对运动,配合分段加压机制控制研磨压力分布,确保双面加工均匀性。
研磨液由粒度10.0-5.0μm的氧化铝、氧化锆微粉与水基表面活性剂配比而成,通过物理磨削与化学腐蚀的复合作用,可有效去除硅片表面20-50μm的机械应力损伤层及金属离子污染,总加工量通常设定为60-80μm,具体数值根据硅片切割方式及初始损伤情况动态调整。
FO系列磨砂虽能实现较高磨削速率,但易产生较深损伤层,因此更适用于直径200mm以下硅片的加工;而对于大直径硅片,四路驱动双面研磨系统通过精密控制磨盘运动轨迹与压力分布,可实现TTV<2.5μm的高精度加工,同时通过优化研磨液配方降低表面沾污风险。
硅片表面磨削
硅片表面磨削作为先进半导体制造的关键工序,通过金刚石磨头对硅片实施精密磨削,高效去除切割损伤层并提升表面平坦度,其技术演进深刻影响着300mm及以上大直径硅片的制备效率与质量。

该工艺依托正向压力、金刚石磨头粒度(500#~4000#)、磨盘转速及切削液参数的精准调控,实现分级加工——粗磨阶段采用500#~1500#磨头,以≥20.0μm/min的速率快速去除材料,表面损伤层约≤1.4μm,粗糙度Ra≤20.0nm;精磨阶段则选用2000#~4000#磨头,将损伤层压缩至≤0.4μm,粗糙度优化至Ra≤1.0nm,兼具高效率、低成本及低机械应力损伤优势,已逐步替代传统双面研磨成为300mm抛光片制备的主流工艺。
然而,表面磨削易产生“磨削印痕”,其规律性纹理会干扰后续抛光片的纳米形貌特性。为破解此难题,行业探索出双面磨削技术路径:其一为分步单面磨削,,通过手动或自动翻转硅片实现双面加工;其二为同步双面磨削,以卧式系统为代表。

硅片垂直放置且磨头水平布局,配合水静压支撑与砂轮自动角度调整,减少自重变形影响,实现双面同步磨削,磨削速率高达>250μm/min,TTV<1.0μm,表面损伤层<5.0μm,且磨屑不易滞留,避免局部深伤痕。

行星运动双面磨削系统,基于双面研磨原理,通过游轮片夹持硅片在金刚石磨盘间作行星运动,配合纯水基切削液,在80μm/双面加工量下,实现TTV≤1.0μm、粗糙度Ra≤20.0~1.0nm,彻底消除磨削印痕,保障纳米形貌特性,满足先进制程对抛光片的技术要求。
当前技术演进聚焦智能化与环保化升级:算法实时优化磨削参数,结合高精度传感器监测磨削力与温度,实现闭环控制;水基无毒切削液的开发降低废水处理成本,纳米级复合磨料提升磨削效率与表面质量;复合工艺路线如“表面磨削+抛光”的直接衔接,减少中间工序,提升生产效率。
未来,随着3D封装、先进制程对硅片表面质量要求的提升,表面磨削技术将向更精细的粒度控制、更智能的参数自适应及更环保的工艺方向发展,持续推动半导体硅片制造向高精度、低损伤、绿色化方向迈进,支撑集成电路产业向更先进制程、更高可靠性要求的发展。
-
集成电路
+关注
关注
5463文章
12669浏览量
375607 -
芯片制造
+关注
关注
11文章
734浏览量
30527
原文标题:芯片制造——硅片的双面研磨(lapping)和表面磨削 (grinding)
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
【「芯片通识课:一本书读懂芯片技术」阅读体验】了解芯片怎样制造
双面柔性PCB板制造工艺及流程
双面FPC制造工艺
影响硅片倒角加工效率的工艺研究
硅片自旋转磨削法的加工原理和工艺特点的介绍
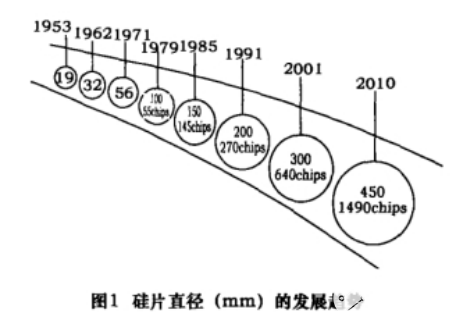
半导体硅材料研磨液研究进展
芯片制造中的硅片倒角加工工艺介绍




 芯片制造中的硅片双面研磨与表面磨削工艺
芯片制造中的硅片双面研磨与表面磨削工艺

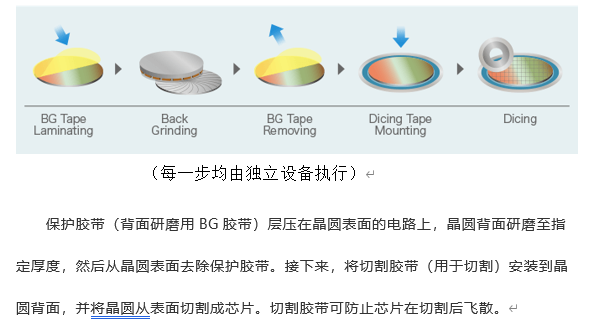








评论