文章来源:Jeff的芯片世界
原文作者:Jeff的芯片世界
在功率MOSFET器件的设计与选型中,单脉冲雪崩能量(Single Pulse Avalanche Energy, EAS)是一个至关重要的参数。它量化了器件在极端过压条件下,单次承受雪崩能量的能力,其单位是焦耳(J)。EAS值越大,意味着器件在遭遇瞬间电压尖峰时越不易损坏。
EAS的基本概念与重要性
EAS,全称为单次雪崩能量,用于衡量MOSFET在漏源(DS)端承受过压应力的能量耐受极限。该参数的形象描述来源于测试过程:当电压升高至临界点后,电流会迅速崩塌,类似雪崩现象。在器件手册中,EAS为设计者提供了明确的耐受能力参考,是评估器件可靠性与电路安全性的关键指标之一。
在实际应用中,EAS主要描述单次雪崩事件。器件手册中还存在另一个参数EAR(可重复雪崩能量),其限定值通常远小于EAS,对芯片长期可靠性的影响较小。因此,电路设计中应重点考虑并避免大能量EAS事件的发生。
EAS的测试原理与评估方法
EAS的测试通常基于感性负载开关电路。其基本原理是:通过栅极信号控制MOSFET导通,为串联的电感充电;关断MOSFET时,电感中储存的能量会通过器件释放,迫使漏源电压VDS上升并可能超过其击穿电压BV_DSS,进入雪崩状态。测试直至器件失效,并根据失效前的电流等参数计算所消耗的能量。
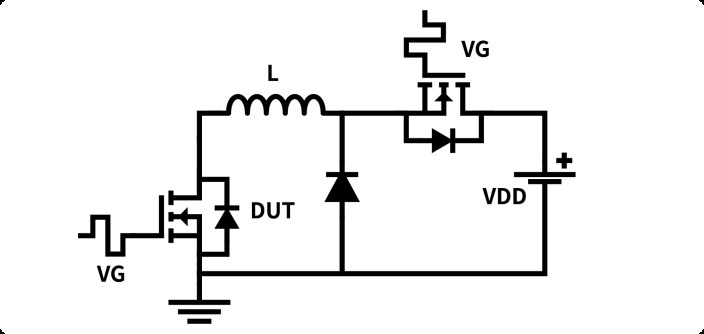
一种典型的测试方法是:设定母线电压V_DD,在栅源极间施加一个脉冲电压(如10V)使器件导通,电感电流上升至特定值I_AS后关断器件。电感能量释放导致雪崩,通过测量或计算得到EAS。需要注意的是,准确的EAS计算应使用实际测试中测得的BV_DSS值,而非直接采用手册标称值,且不同厂家的测试条件可能存在差异,因此不能仅凭规格书数值直接比较不同器件的EAS能力。
影响EAS的关键因素
EAS的大小并非固定值,它受到芯片温度、测试电路电感及电流等多重因素影响。
1. 温度的影响:EAS导致损坏的本质是芯片过热。芯片的初始结温(Tj)直接影响其EAS能力——初始温度越高,可承受的EAS能量越小。在雪崩过程中,能量转化为热量导致温升,其关系可表述为:在电流不变的条件下,温升与吸收的能量成正比。
2. 电感与电流的影响:手册中给出的EAS值通常对应特定的测试电流I_D。EAS能量与电感中储存的能量直接相关。根据能量公式推导,在保持温升和最大雪崩电压不变的条件下,若电感量增加,为了达到相同的温升,所允许的雪崩电流会减小。综合来看,电感量增大数倍,EAS能量会增加,但同时雪崩电流会减小。
EAS的失效模式与机理
当雪崩能量超过器件极限时,会导致破坏性失效,主要模式有两种。
第一种是寄生二极管雪崩烧毁。MOSFET内部存在一个体二极管(寄生二极管)。当器件关断,感性负载续流时,寄生二极管承受反向电压。若电压尖峰使其进入雪崩击穿状态,大电流和高电压将在芯片内部产生大量热量,若无法及时散热,将导致器件因过热而烧毁。
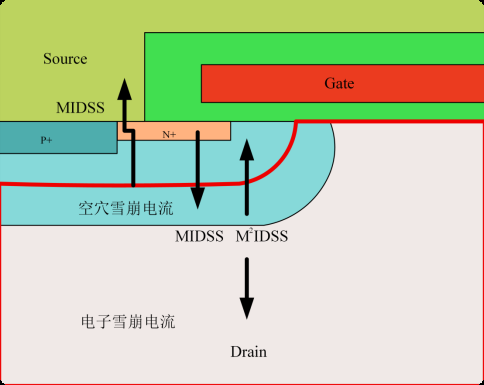
第二种是寄生双极型晶体管(BJT)开启。MOSFET结构内部还存在一个由源极、P基区和N-漂移区形成的寄生NPN晶体管。正常情况下其处于关闭状态。当寄生二极管发生雪崩击穿时,流经P基区横向电阻RB的电流增大,可能导致RB两端的压降超过寄生BJT的开启电压(VBE),从而使其导通。一旦寄生BJT开启,会形成大电流通道,使MOSFET失效短路。为抑制此失效模式,现代MOSFET设计会致力于减小RB电阻。目前,大多数EAS失效案例仍以寄生二极管雪崩击穿过热为主。
EAS烧毁点常集中在栅极焊盘(PAD)附近。这是因为距离栅极越近的元胞,其寄生参数越小,关断速度越快,在雪崩事件中会先于其他区域承受应力并发生击穿。
电路设计中的保护措施
为避免EAS事件损坏器件,可在电路设计中采取保护措施。例如,在变压器或感性负载两端并联RCD吸收回路,以箝位和吸收反向尖峰电压。也可以在MOSFET的漏源极之间并联RC吸收电路。此外,适当增大栅极串联电阻可以减缓关断速度(抑制dv/dt),从而降低电压尖峰,但需权衡由此增加的关断损耗。优化PCB布局,加粗大电流路径并缩短走线,有助于降低线路寄生电感,从根源上减少电压尖峰能量。
-
开关电路
+关注
关注
62文章
569浏览量
68570 -
MOSFET
+关注
关注
151文章
10759浏览量
234828 -
电路设计
+关注
关注
6745文章
2785浏览量
220142 -
晶体管
+关注
关注
78文章
10434浏览量
148542
原文标题:MOSFET参数中的EAS是什么?
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录



 功率MOSFET器件的单脉冲雪崩能量参数解读
功率MOSFET器件的单脉冲雪崩能量参数解读


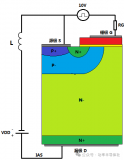
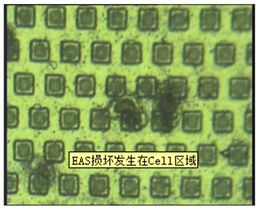
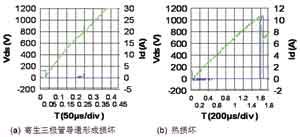
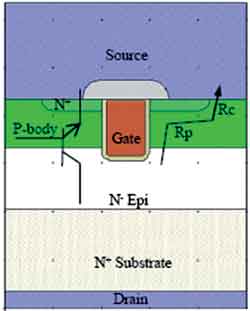

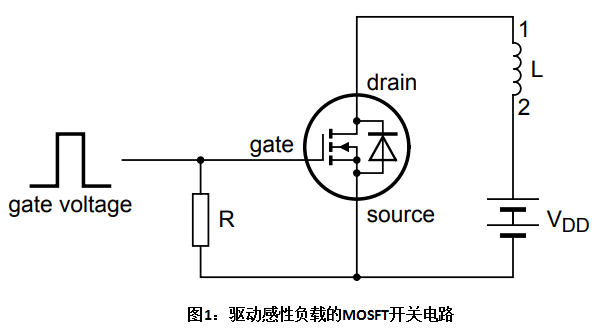






评论