倾佳电子宽禁带时代下的效率优化:SiC MOSFET桥式拓扑中同步整流技术的必然性与精确定量分析

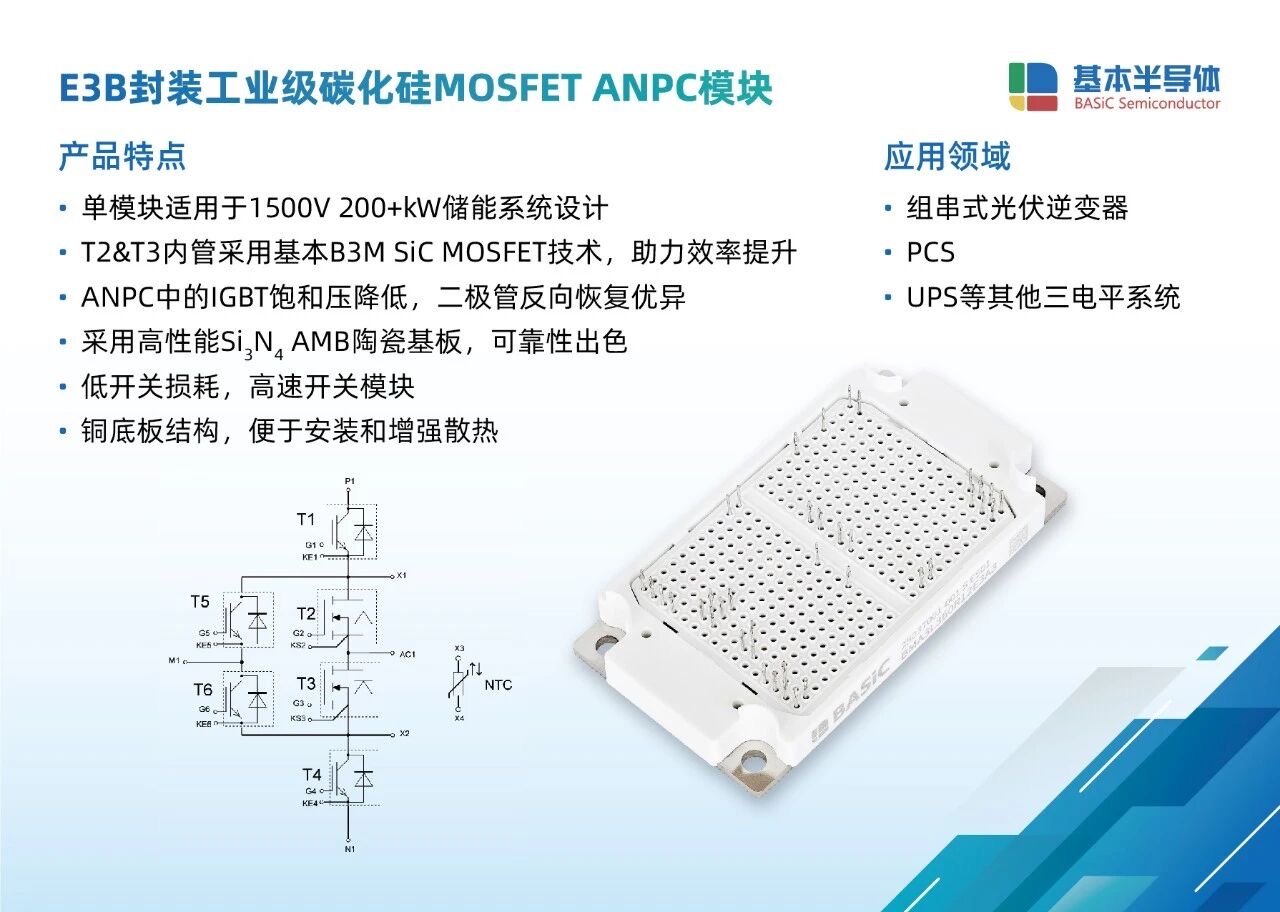

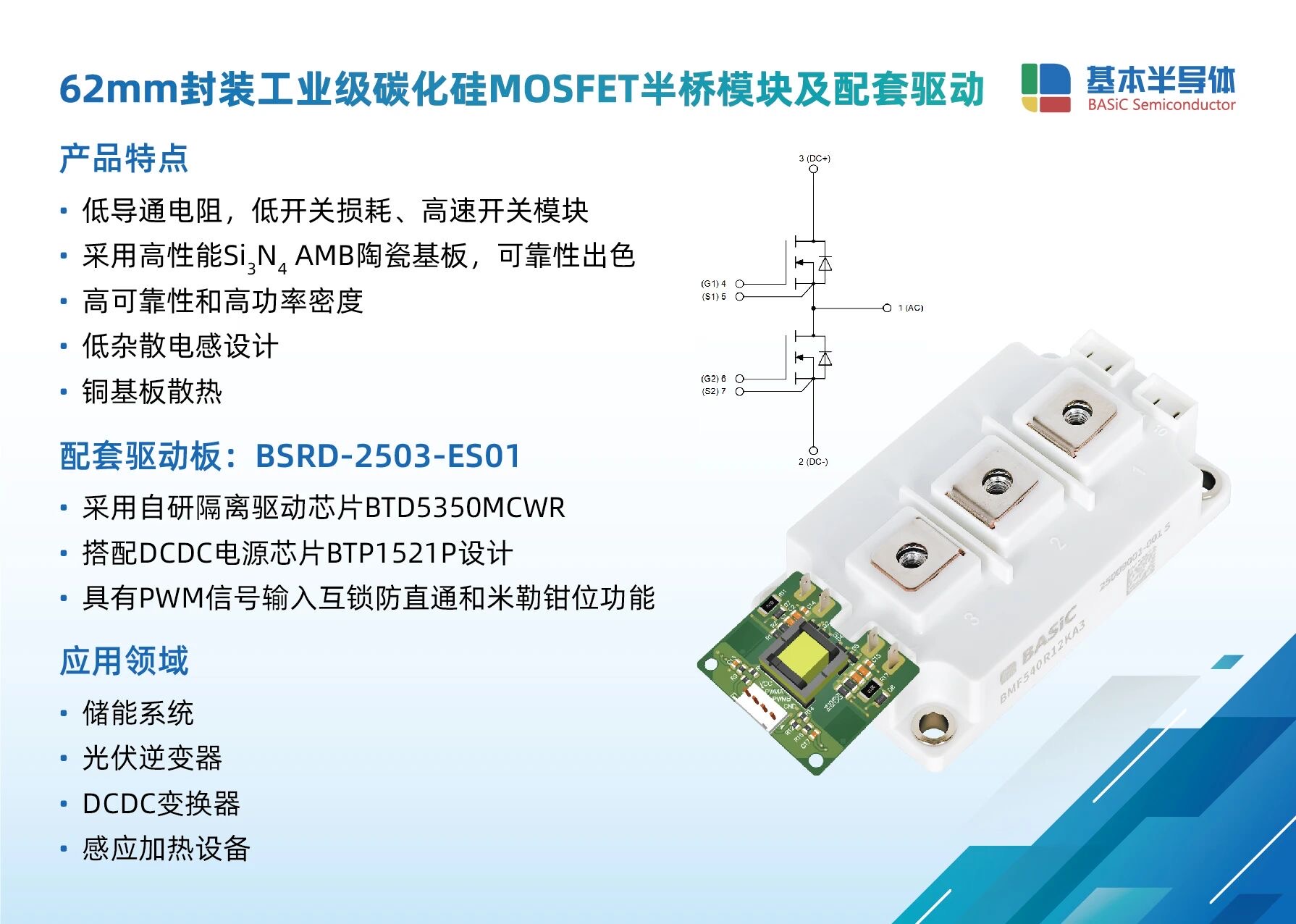

倾佳电子(Changer Tech)是一家专注于功率半导体和新能源汽车连接器的分销商。主要服务于中国工业电源、电力电子设备和新能源汽车产业链。倾佳电子聚焦于新能源、交通电动化和数字化转型三大方向,并提供包括IGBT、SiC MOSFET、GaN等功率半导体器件以及新能源汽车连接器。
倾佳电子杨茜致力于推动国产SiC碳化硅模块在电力电子应用中全面取代进口IGBT模块,助力电力电子行业自主可控和产业升级!
倾佳电子杨茜咬住SiC碳化硅MOSFET功率器件三个必然,勇立功率半导体器件变革潮头:
倾佳电子杨茜咬住SiC碳化硅MOSFET模块全面取代IGBT模块和IPM模块的必然趋势!
倾佳电子杨茜咬住SiC碳化硅MOSFET单管全面取代IGBT单管和大于650V的高压硅MOSFET的必然趋势!
倾佳电子杨茜咬住650V SiC碳化硅MOSFET单管全面取代SJ超结MOSFET和高压GaN 器件的必然趋势!
第一部分:同步整流技术的历史演进与基础理论
1.1. 同步整流(SR)概念的起源与发展初衷
同步整流(Synchronous Rectification, SR)技术的兴起,是电力电子领域为适应日益严苛的效率要求,特别是在低电压、高电流输出应用中,所采取的关键技术飞跃。其历史背景可追溯到20世纪90年代后期,当时个人计算机和通信系统对供电电压的要求逐渐从 5V 降至 1V 甚至更低 。
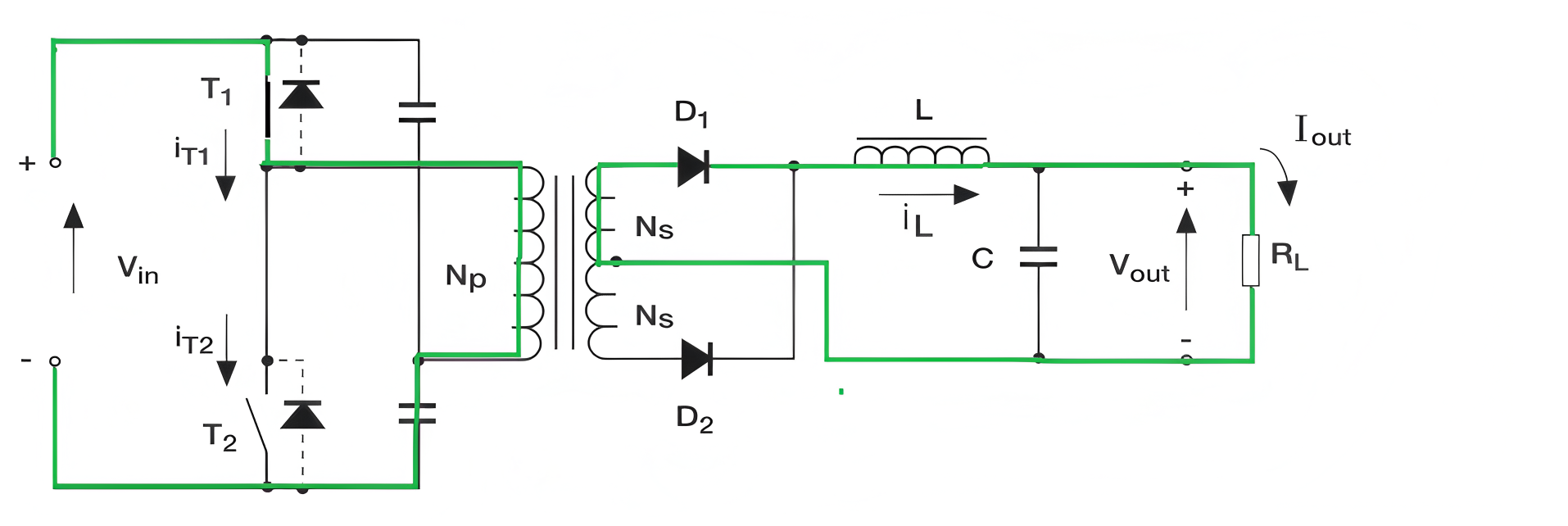
在传统的开关电源(SMPS)二次侧整流中,通常使用PN结二极管或肖特基二极管(Schottky Diode)进行整流。然而,这些传统二极管具有固定的正向导通电压 VF。肖特基二极管的 VF 通常在 0.3V 左右,但这一压降在输出电压极低时,占据了总输出电压的显著比例,导致整流阶段的功耗 P∝VF⋅I 成为主要的效率瓶颈 。物理限制决定了二极管的 VF 很难降低到 0.3V 以下。
SR技术的核心思想是利用场效应晶体管(MOSFET)取代传统二极管。MOSFET在导通状态下表现为纯电阻特性,其导通压降 VDS 由电流和导通电阻 RDS(on) 决定,即 VDS≈I⋅RDS(on)。通过设计和工艺优化,MOSFET的 RDS(on) 可以不断降低,或者通过并联多个晶粒来减小等效电阻 。因此,在给定电流下,SR MOSFET的等效压降能够显著低于传统二极管的 VF,从而大幅提升效率。

1.2. MOSFET替代二极管的原理与量化优势

同步整流模式要求精确控制MOSFET的栅极驱动电压,使其导通与截止时间与被整流电压的变化严格同步 。这种精确控制确保了电流流经低损耗的MOSFET沟道,避免了传统整流器件在电压上升和下降过程中的瞬态损耗。
在实际应用中,例如在快速充电电路的输出级,同步整流 MOSFET 通常选用 40V 到 100V 的低压器件,内阻 RDS(on) 可低至 3mΩ 到 8mΩ 。在设计权衡中,随着负载电流密度的不断增加,传统的 VF 损耗虽然与电流呈线性关系,但其无法继续降低的限制使其在高电流下不可避免地成为瓶颈。相比之下,SR 损耗 P∝I2⋅RDS(on) 虽然对电流的平方敏感,但 RDS(on) 具有持续降低的空间,使其在高电流应用中具有优越的损耗扩展性。
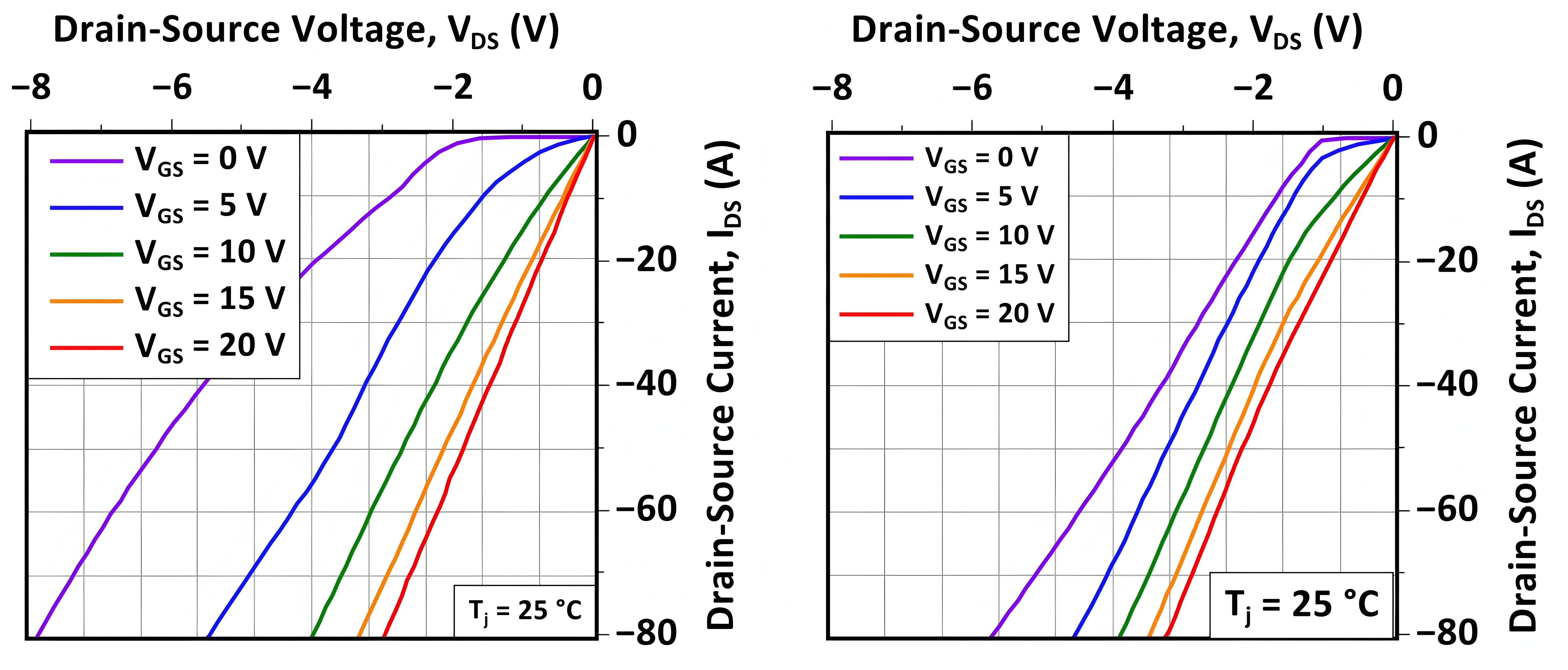
从技术发展历程来看,同步整流技术在低压输出场景下,成功解决了 VF 这一核心效率障碍。然而,在宽禁带(WBG)时代,特别是在高压 1200V 碳化硅(SiC)器件的应用中,同步整流的目标发生了根本性转变:它不再仅仅是用于解决低压 VF 瓶颈,而必须解决高压 SiC 器件在第三象限导通时面临的体二极管(Body Diode)的高正向压降和**反向恢复电荷(Qrr)**问题。这一转变将 SR 技术从纯粹的“效率优化”工具,提升为“确保 SiC 器件安全及高频运行的先决条件”。
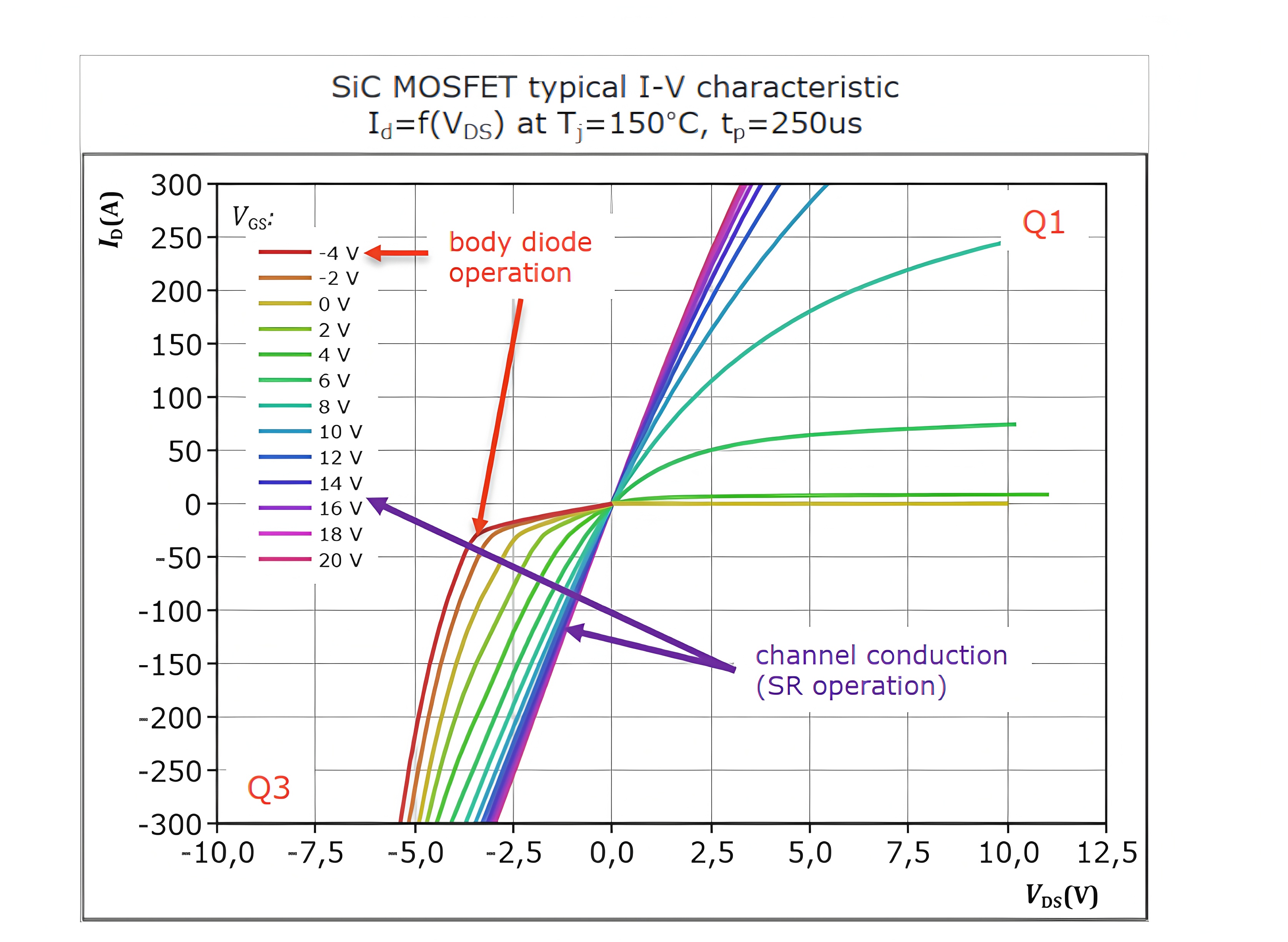
第二部分:碳化硅功率器件(SiC MOSFET)的独特电学特性分析

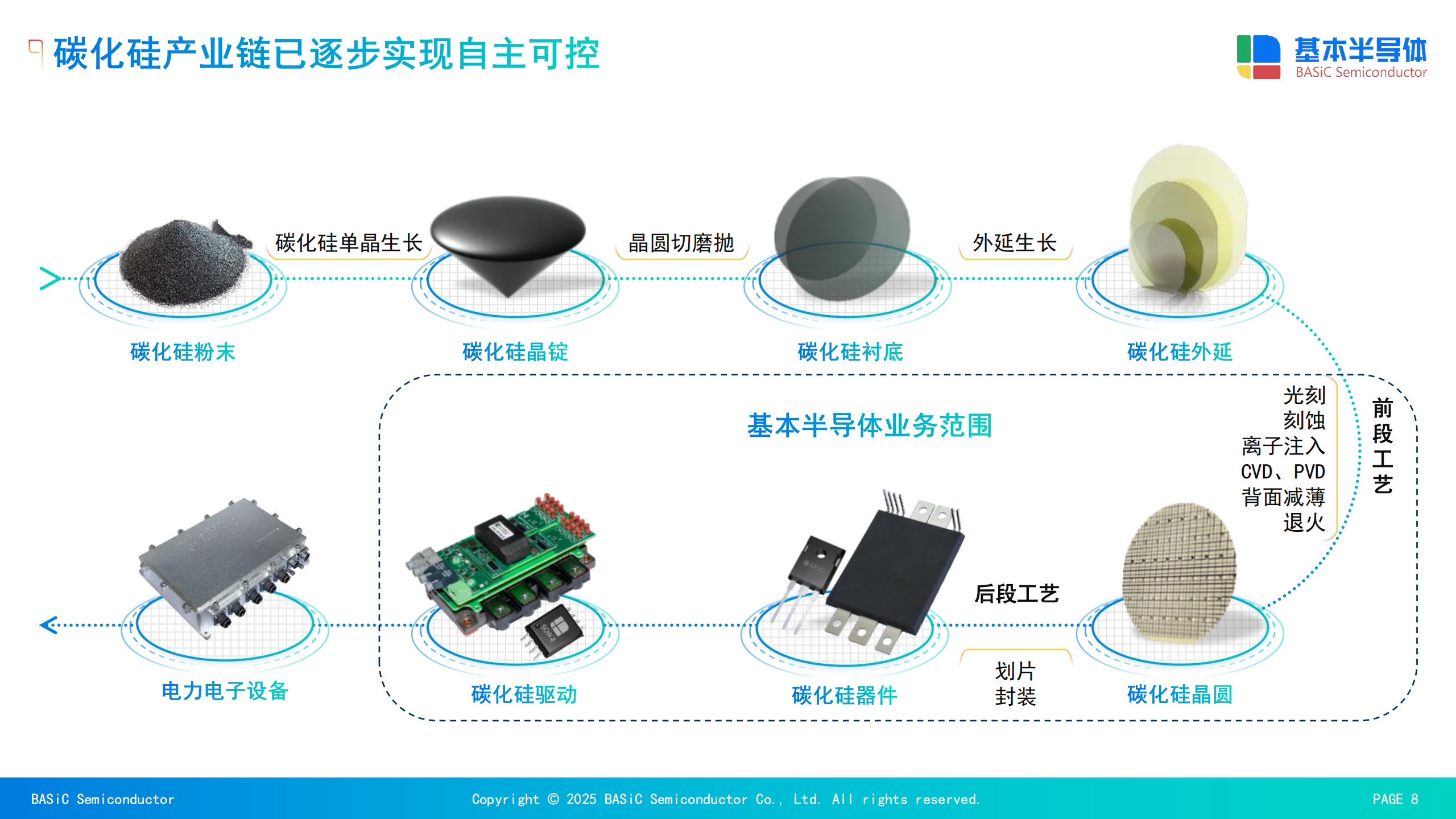
2.1. SiC WBG材料的本质优势及其对系统损耗的影响
碳化硅(SiC)作为一种宽禁带半导体材料,相比传统的硅(Si)器件,具有卓越的电学和热学特性,包括高击穿场强(是 Si 的十倍)、宽禁带(是 Si 的三倍)和高热导率(是 Si 的三倍)。这些特性使得 SiC MOSFET 能够实现极低的导通电阻 RDS(on)、极高的开关速度,并容许更高的工作温度。
以基本半导体的 BMF 系列 1200V SiC MOSFET 模块为例,这些模块专为高频、高功率应用(如电动汽车、储能、DC-DC 变换器)设计 。它们具有低电感设计和优化的热管理结构,如铜基板和 Si3N4 陶瓷衬底,以确保高可靠性和高功率密度。例如,BMF540R12KA3 模块在 VGS=18V 时,典型 RDS(on) 仅为 2.5mΩ 。
2.2. SiC MOSFET沟道导通特性:SR模式下的低损耗基准
在同步整流模式下,MOSFET 的沟道被开启(通常采用 VGS=+18V),使得电流通过低阻抗的沟道流过,此时导通损耗仅取决于 I2RDS(on)。
SiC MOSFET 的 RDS(on) 具有正温度系数,这意味着电阻随结温 Tvj 升高而增加,这有利于多个器件并联时的电流均衡。例如,BMF80R12RA3 模块在 80A 电流下,其 RDS(on) 从 25∘C 时的 15.0mΩ 增加到 175∘C 时的 26.7mΩ 。尽管如此,即使在高结温和大电流下,通过 SR 沟道实现的等效压降仍然非常低。
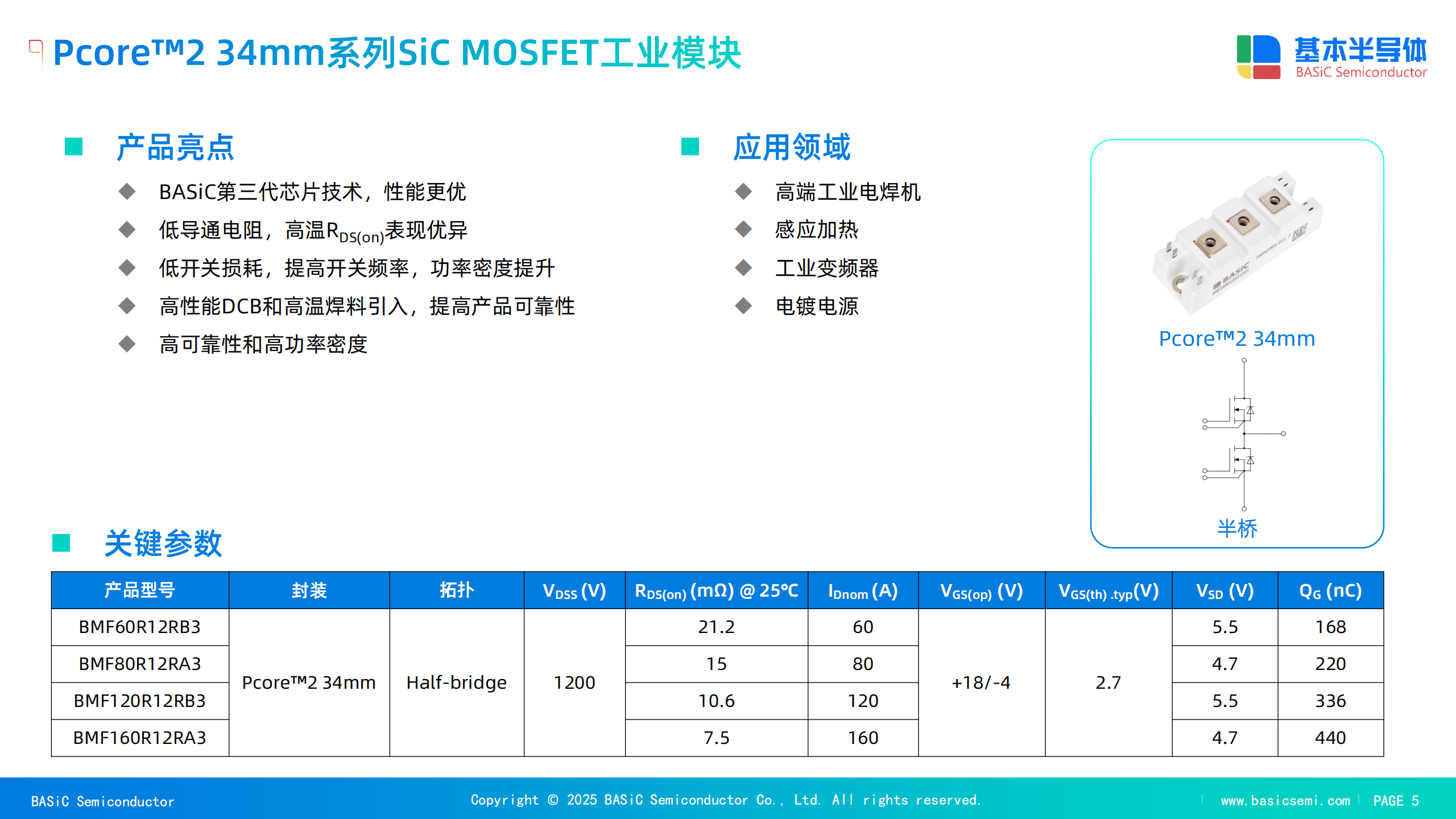
2.3. SiC MOSFET体二极管的固有挑战:高 VSD 的量化确认
然而,SiC MOSFET 的 PN 结体二极管在反向续流时,表现出固有的高正向导通电压 VSD。如果 MOSFET 在死区时间没有被同步开启(例如 VGS=0V 或负偏压,如 −4V),电流将被迫流经这一 PN 结,导致巨大的传导损耗。
为了直观展示这一挑战,下表对比了 SiC 模块在体二极管模式(非 SR)和同步整流模式下的芯片级导通电压 VSD。所有数据均选取结温 Tvj=175∘C,以反映实际工作环境下的最差情况。
SiC MOSFET模块的导通电压特性对比:体二极管模式 vs. 同步整流模式 (Tvj=175∘C)
| 器件型号 | 额定电流 ID (A) | 体二极管模式 VSD (V)(VGS=−4V/-5V) | 同步整流模式 VSD (V)(VGS=+18V) | 压降降低百分比 (%)(近似) | 数据来源 |
|---|---|---|---|---|---|
| BMF80R12RA3 | 80 | 4.09 (chip) | 2.12 (chip) | 48% | |
| BMF120R12RB3 | 120 | 4.69 (chip) | 2.14 (chip) | 54% | |
| BMF360R12KA3 | 360 | 4.47 (chip) | 2.17 (chip) | 51% | |
| BMF540R12KA3 | 540 | 4.47 (chip) | 2.17 (chip) | 51% |
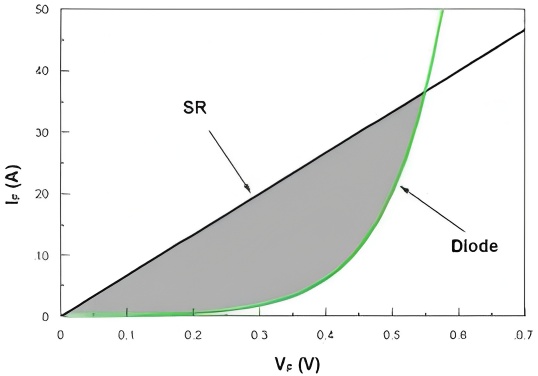
分析显示,在所有测试模块中,体二极管模式下的芯片级 VSD 均在 4.0V 以上,而通过 SR 开启沟道后,等效压降可降低约 50% 以上,降至约 2.1V 左右。这一巨大的压降差距表明,如果电流被迫流经体二极管,将产生不可接受的导通损耗和热量。
这一现象的本质是宽禁带材料的固有特征:SiC PN 结需要更高的启动电压才能承载电流。因此,在 SiC 器件中启用 SR 模式,是规避材料物理限制、利用其低 RDS(on) 优势的唯一有效途径。
2.4. 反向恢复特性(Qrr/ Err):高频应用的隐形杀手
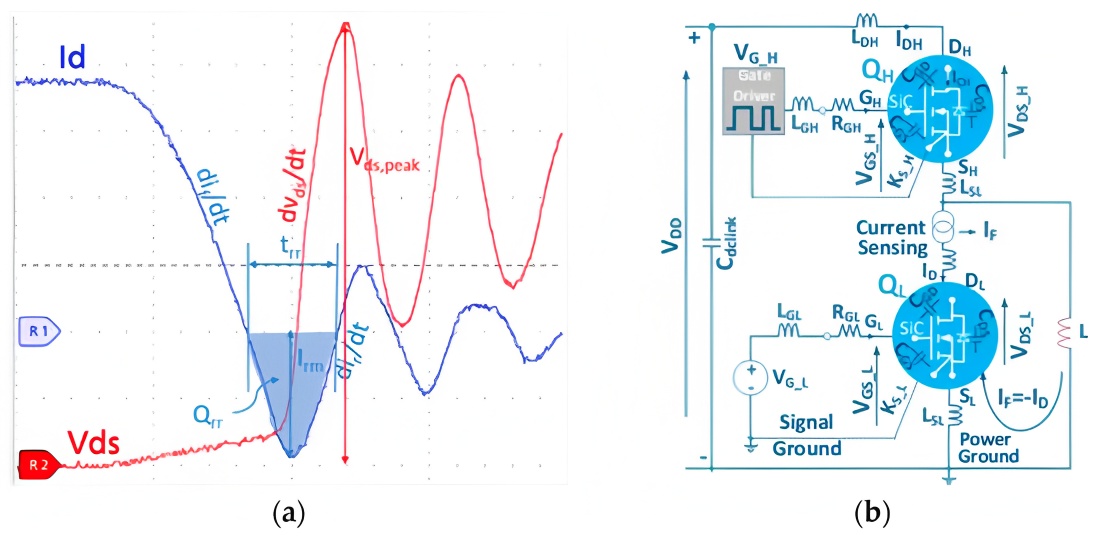
在桥式电路中,当电流从一个 MOSFET 换流到其对臂的 MOSFET 时,如果前一个器件的体二极管参与续流,它会积累反向恢复电荷 Qrr。当对臂 MOSFET 开启时,必须先清除这些 Qrr,这个过程产生反向恢复电流 Irrm 和反向恢复能量 Err 。
虽然 SiC MOSFET 的 Qrr 远低于硅基 MOSFET,但在大电流和高开关频率下,由 Qrr 导致的损耗和瞬态电压应力依然严重。例如,BMF540R12KA3 模块在 175∘C 下,Qrr 达到 9.5uC, Err 达到 3.3mJ 。高 Irrm 与电路中的寄生电感相互作用,会产生巨大的电压尖峰 V=L⋅di/dt 。SiC 器件极高的开关速度( di/dt)使得这一问题更加突出,可能导致器件过压失效或严重的电磁干扰(EMI)。因此,同步整流在 SiC 高频应用中不仅是“节能器”,更是“保护器”,其目的是通过避免体二极管导通,彻底消除 Qrr 相关的损耗和应力。
第三部分:SiC桥式电路中同步整流的必然性论证
3.1. 桥式电路换流模型与死区时间分析
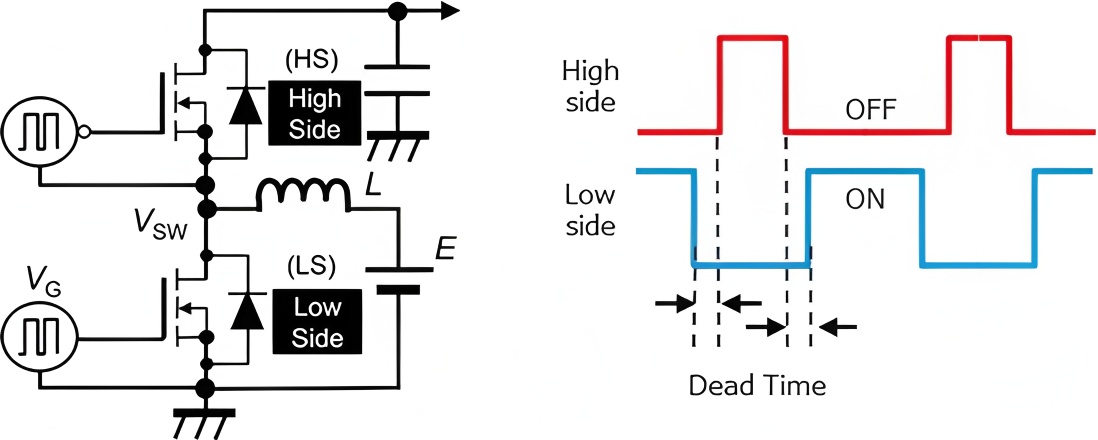
在半桥或全桥电路(如逆变器或双向 DC/DC 变换器)中,为了防止上下桥臂在换流过程中发生短路(直通),必须引入一个短暂的死区时间 TDT。在 TDT 期间,上下开关管均处于关断状态,此时电感电流必须通过桥臂的续流器件续流。
在没有启用同步整流模式的 SiC 桥臂中,这意味着电流将强制流经 SiC MOSFET 的体二极管。如果 TDT 过长或 VGS 驱动不当,体二极管导通的时间占比增加,将直接导致效率崩溃。
3.2. 核心论据:体二极管导通损耗的量化不可接受性
如第二部分所示,SiC 体二极管的导通压降比 SR 沟道高出约 50% 以上。在追求 99% 极致效率的高功率系统中,任何超过 1V 的额外压降都意味着巨大的损耗。
可以进行如下的简化损耗对比:假设一个高功率系统在死区时间 TDT 期间,有 5% 的时间电流流经续流器件,平均电流 IAVG=100A。以 120A 的 BMF120R12RB3 模块在 175∘C 下的数据为例 :
体二极管模式下(非 SR):体二极管 VSD≈4.69V。
体二极管模式下平均损耗 Pdiode≈4.69V×100A×0.05≈23.45W。
同步整流模式下(SR):SR 沟道 VSD≈2.14V。
SR 模式下平均损耗 PSR≈2.14V×100A×0.05≈10.70W。
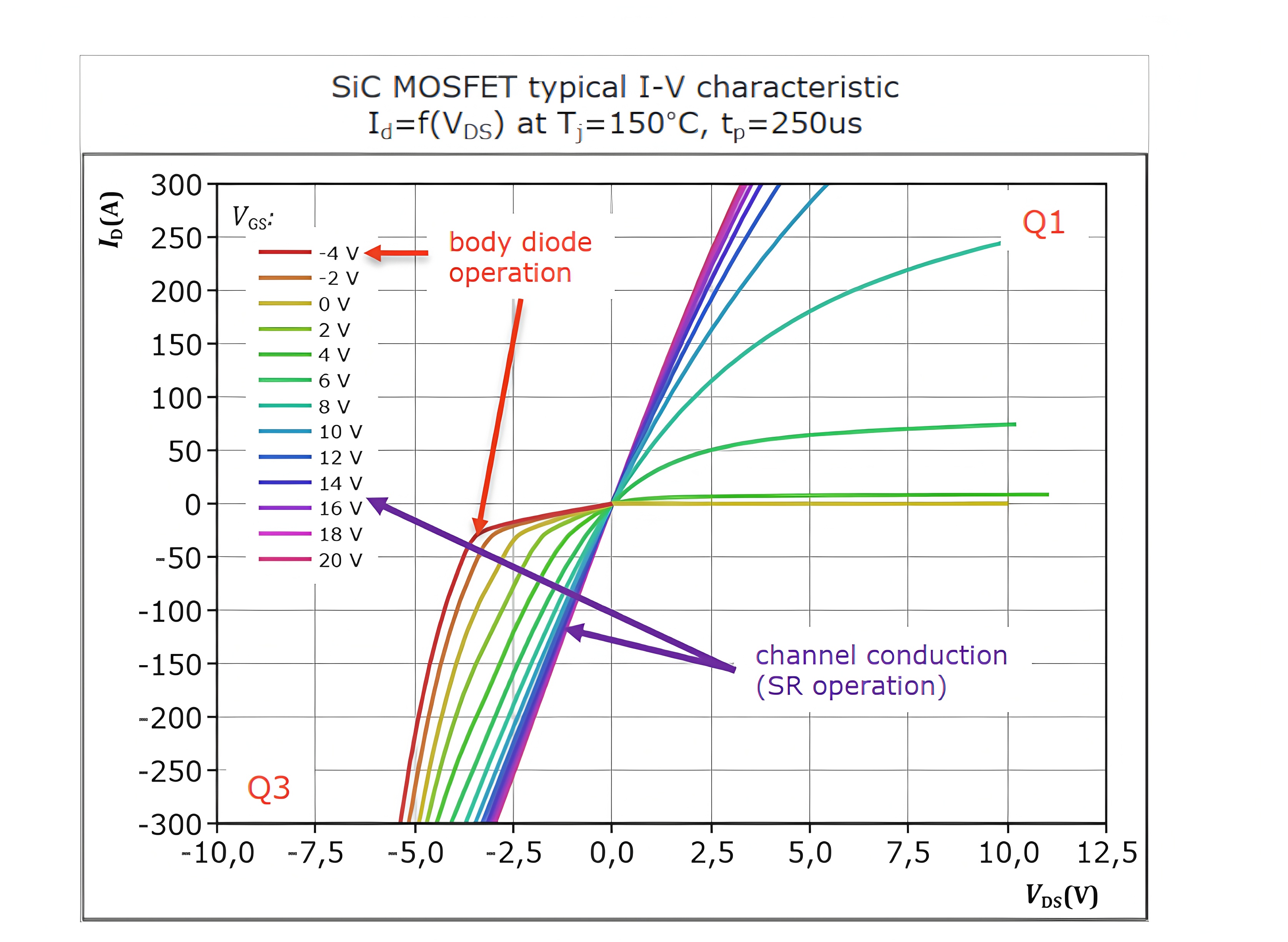
仅仅 5% 的死区时间续流,体二极管就会带来 12.75W 的额外损耗。在高功率、高效率的电动汽车或储能应用中,这种级别的额外热损耗是无法接受的,它会显著增加散热需求,破坏整体效率目标。同步整流通过将高 VSD 损耗转化为低 I2RDS(on) 损耗,实现了导通损耗的最小化。效率每提高 1%,通常可以使散热需求减少约 10% ,从而显著提高功率密度并降低系统成本 。
3.3. 核心论据:Qrr 彻底消除对系统可靠性的决定性贡献
在 SiC 高频应用中,SR 的最大价值在于它消除了体二极管的反向恢复。如果体二极管在 TDT 期间导通并积累电荷 Qrr,当对臂 MOSFET 开启时,这些电荷会引发尖峰电流 Irrm 和反向恢复能量 Err 。
下表量化了 SiC 模块在体二极管模式下产生的反向恢复特性:
SiC MOSFET模块的开关损耗特性:体二极管模式下反向恢复分析 (Tvj=175∘C)
| 器件型号 | 测试电流 ISD (A) | 反向恢复电荷 Qrr (μC) | 反向恢复能量 Err (μJ/mJ) | 峰值反向恢复电流 Irrm (A) | SR 模式下 Qrr | 数据来源 |
|---|---|---|---|---|---|---|
| BMF80R12RA3 | 80 | 1.6 | 608.5uJ | 65.4 | ≈0 | |
| BMF120R12RB3 | 120 | 2.24 | 735uJ | 97 | ≈0 | |
| BMF540R12KA3 | 540 | 9.5 | 3.3mJ | 338 | ≈0 |
以 BMF540R12KA3 为例,其 Irrm 峰值高达 338A,即使在 175∘C 下 Err 也达到 3.3mJ 。如果系统工作在
50kHz,由此带来的开关损耗 Prr=fsw⋅Err 将高达 165W。这种巨大的瞬态损耗不仅严重降低效率,更重要的是,高 Irrm 在寄生电感中产生的电压尖峰,会对器件造成严重的过压应力。
精确的同步整流意味着 MOSFET 在续流期间通过沟道导通,完全绕过了体二极管的 PN 结。在这种模式下,Qrr 约为零,从而彻底消除了
Err 相关的开关损耗和电压尖峰。在 SiC 器件固有的高 di/dt 特性下,消除 Irrm 这一应力源,是确保 SiC 模块在高频下具备高可靠性的决定性因素。因此,同步整流是 SiC 桥式电路中实现极致效率和高可靠性,并充分发挥 SiC 宽禁带材料优势的唯一技术路径。
第四部分:SiC同步整流的实现挑战与精确定量控制策略
SiC MOSFET 启用同步整流模式带来了巨大的效率收益,但也对控制系统提出了更高的挑战,要求控制精度必须适应 SiC 器件的超快开关速度和对体二极管导通的零容忍。
4.1. 挑战一:SiC高 di/dt 对控制电路的干扰

SiC MOSFET 的极快开关速度,其上升时间 (tr) 和下降时间 (tf) 通常在 20ns 到 60ns 范围内 ,导致极高的 di/dt。高 di/dt 与功率回路的寄生电感相互作用,在 VDS 上产生强烈的电压振荡(Ringing)。依赖 VDS 变化的同步整流控制器极易被这些振荡误触发 。此外,SiC 器件 RDS(on) 的不断降低意味着 I2RDS(on) 损耗与体二极管高 VSD 损耗之间的差距进一步扩大,因此任何微小的控制失误,导致体二极管短暂导通,都会带来不成比例的巨大效率惩罚,对控制器的精度要求呈指数级提高。
4.2. 挑战二:实现精确的自适应死区时间控制
死区时间 TDT 的设置是同步整流控制的核心难点。如果 TDT 过长,电流会流经高损耗的体二极管;如果 TDT 过短,则可能导致上下桥臂直通,引发灾难性故障 。理想的 TDT 并非固定值,而是必须随输入电压、负载电流和工作温度动态变化。传统的固定时间控制难以满足 SiC 系统对极致效率的要求。
4.3. 关键控制策略:VDS 传感器的精确零电流检测 (ZCD)
为了应对这些挑战,先进的同步整流控制器(如 NEX81801DA)采用 VDS 传感器进行精确的零电流检测(Zero Current Detection, ZCD),实现自适应控制 。
这些控制器通过实时监测同步整流 MOSFET 的 VDS 极性变化来确定电流方向。当 VDS 从负值(MOSFET 导通)变为正值时,表明电流方向即将反转,SR FET 必须快速关断,以最小化体二极管的导通时间。
为了解决高 di/dt 振荡导致的误触发问题,控制器必须具备可外部调节的导通消隐时间(Blanking Time)。只有在 VDS 变化持续时间超过这个消隐时间后,控制信号才会被识别。此外,SR 控制器必须能够自适应地调节 SR 导通时间,以优化轻载条件下的效率,从而改善电源在整个负载范围内的平均效率。
4.4. 针对 SiC 的数字与硬件辅助控制优化
为了实现 SiC 系统所需的极致精度,数字控制和硬件辅助控制策略被广泛应用:
数字自适应控制:针对特定拓扑(如双向 LLC 谐振变换器),研究提出了基于二阶拟合模型的数字同步整流控制算法 。该算法能够准确计算并动态调节同步整流管的导通时间,从而显著降低导通损耗。在实验中,该方法在 300kHz 开关频率下,相比传统算法可减少 27.7W 的同步整流管损耗 。
硬件辅助死区时间调整:通过脉冲产生单元、RC 单元和比较单元的组合,可以构建具有死区时间调整的桥式同步整流电路 。这种方法提供了增强的鲁棒性,适用于全桥和半桥拓扑。
下表总结了高效率同步整流控制策略的对比:
高效率同步整流控制策略对比与 SiC 适应性
| 控制策略 | 实现机制 | 对SiC应用的益处 | 主要挑战 | 数据来源 |
|---|---|---|---|---|
| 传统定时控制 | 固定开关周期或死区时间 | 实现简单,成本低 | 无法适应动态工况,极易导致体二极管损耗 | |
| VDS 传感 ZCD | 实时监测 VDS 极性变化 | 实时性高,提高了轻载和变频效率 | 寄生电感振荡干扰,需要精确消隐时间 TBLANK | |
| 数字自适应控制 | 基于二阶拟合模型动态计算 TDT | 精确最小化体二极管导通时间,显著降低导通损耗 | 算法和计算资源要求高,动态响应速度是关键 |
值得注意的是,先进的 SR 控制器(如 NEX81801DA)即使是低功耗芯片,也采用低热阻的 TSOT23-6 封装 。这从侧面反映了 SiC 高频应用环境的热密度极高,对包括控制芯片在内的所有元件的热性能提出了严苛的要求。这证实了在 SiC 系统中,热管理策略必须从功率器件扩展到整个控制链,实现热量的“源头抑制”而非仅仅依赖“散热处理”。
第五部分:SiC同步整流技术的未来发展趋势与应用前景
5.1. 拓扑创新与效率提升
SiC 同步整流技术正在推动电力电子拓扑向更高频率和双向功率流发展。在谐振变换器(如 LLC)中,SiC SR 是实现高频和双向性的核心 。通过数字控制和 SiC 器件的超低 RDS(on) 及近零 Qrr 特性,LLC 拓扑能够在 300kHz 甚至更高的频率下维持 98% 以上的效率 。
未来的发展趋势是将损耗最小化控制从单向系统扩展到双向系统,例如在模块化多电平变换器(MMC)子模块中,利用 SiC MOSFET 沟道的双向导通特性,通过调整同步整流和非同步整流模式的占比,实现器件损耗的自适应均衡 。
5.2. 系统集成度提升与封装优化
SiC 功率模块正朝着标准化和 SiC 优化封装方向发展,以提高系统级效率和功率密度 。基本半导体提供的 BMF 系列 34mm 和 62mm 半桥模块是这一趋势的代表 。这种模块化设计有助于降低系统寄生电感,从而在超高频下实现更可靠的同步整流控制。
同时,SiC 材料制造工艺的成熟,特别是晶圆尺寸从 6” 向8” 的迈进,预计将显著降低 SiC 器件的制造成本 ,加速 SiC 同步整流技术在电动汽车、能源存储和工业电源中的普及。

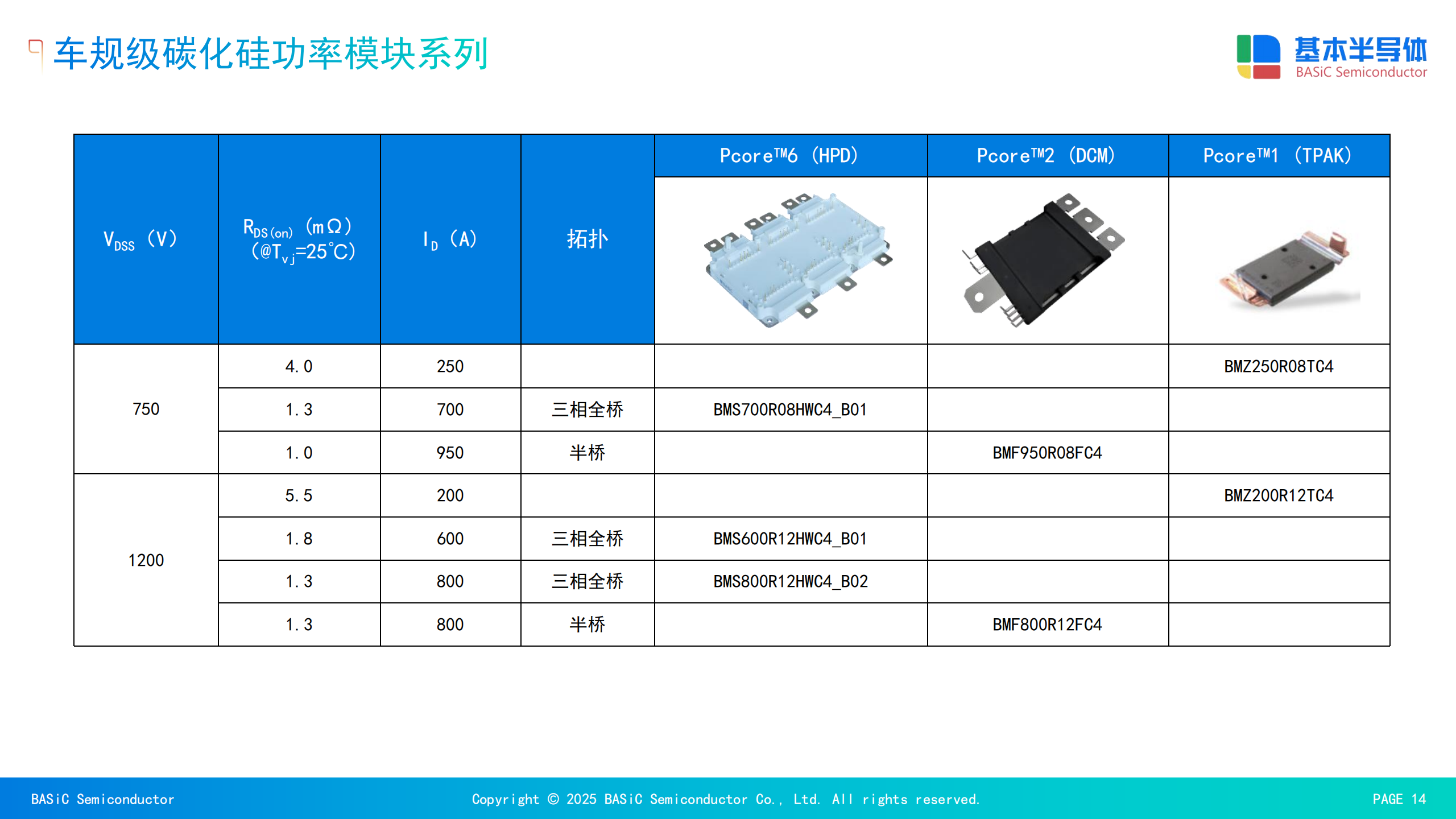
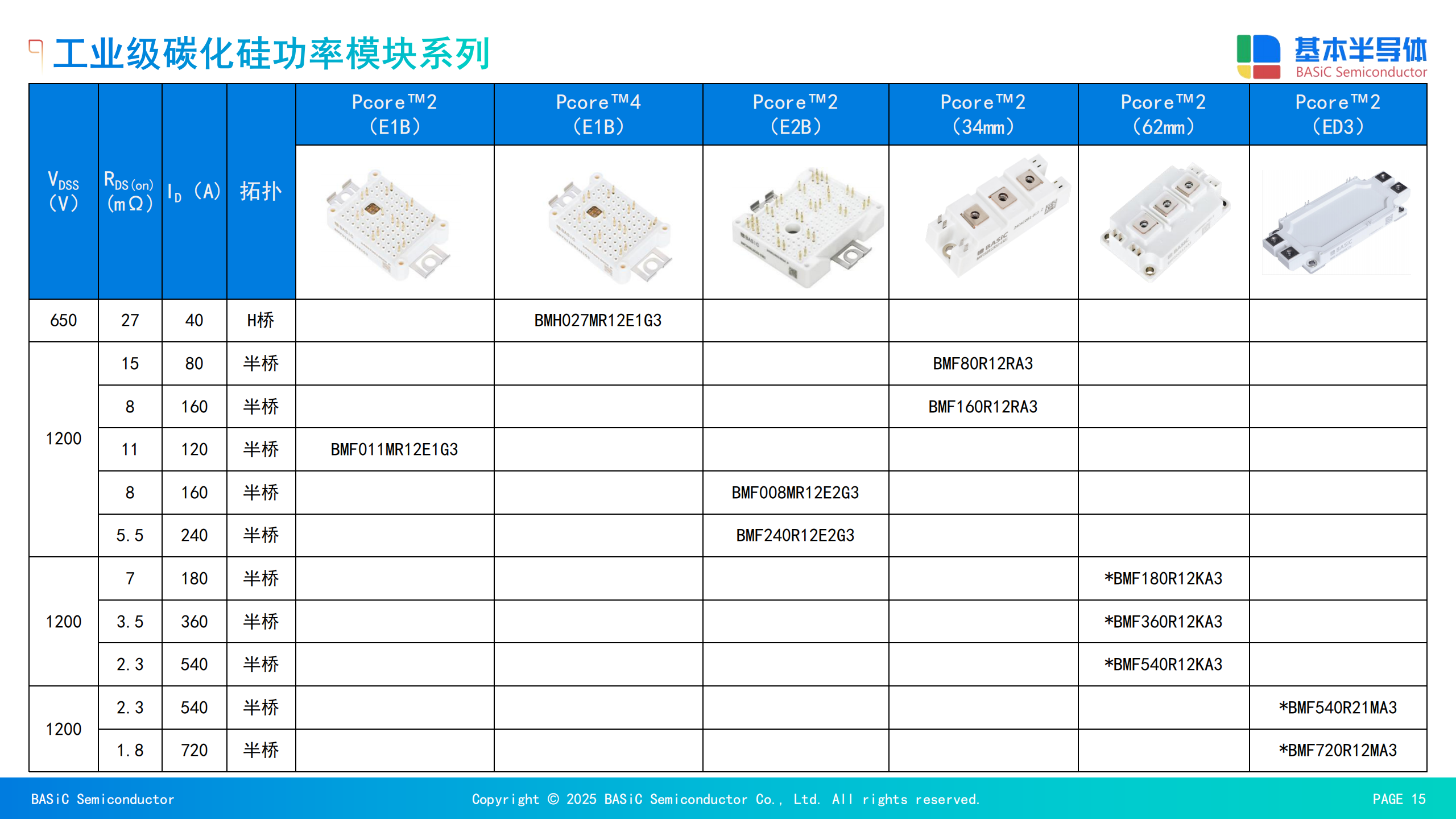


5.3. 迈向更高的开关频率与极致效率
SiC 同步整流技术支持系统工作在更高的开关频率,从而能够减小无源元件(如变压器和电感)的体积和重量,实现更高的功率密度 。在现代世界,减少电力转换过程中的损耗至关重要,因为在每个转换阶段,总功率中约有 2% 至 15% 会以热量的形式浪费 。同步整流是实现下一代电力系统(如电动汽车逆变器和高密度 DC-DC 转换器)超过 99% 效率目标的核心技术。
当 SiC SR 技术将半导体开关和导通损耗最小化后,未来的效率瓶颈将转向无源元件(如磁性元件和电容)和拓扑结构的固有损耗。这要求设计人员将精力集中在新型材料科学和拓扑结构创新上,以充分利用 SiC SR 所实现的超高开关频率。
5.4. 重点应用领域与市场影响

SiC 同步整流技术在多个高增长领域具有决定性影响:
电动汽车(eMobility):应用于高效车载充电器和主逆变器,利用 SiC 的高效率和高功率密度特性 。
工业应用:包括新能源逆变器和高密度 DC-DC 转换器 。
电网和能源:UPS 系统、数据中心电源、SST固态变压器,大型能源存储系统,这些领域对可靠性和极致效率有最高要求 。
SiC SR 技术的普及和成熟正在重新定义电力电子系统的设计原则。过去的设计通常需要在开关损耗和导通损耗之间进行性能妥协,并容忍二极管的固有缺陷。现在,SiC SR 使得设计者能够同时最小化这两种关键损耗,从而推动电力电子设计从“妥协”转向“性能驱动”,加速实现更高电压、更高频率、更高功率密度的系统目标 。
深圳市倾佳电子有限公司(简称“倾佳电子”)是聚焦新能源与电力电子变革的核心推动者:
倾佳电子成立于2018年,总部位于深圳福田区,定位于功率半导体与新能源汽车连接器的专业分销商,业务聚焦三大方向:
新能源:覆盖光伏、储能、充电基础设施;
交通电动化:服务新能源汽车三电系统(电控、电池、电机)及高压平台升级;
数字化转型:支持AI算力电源、数据中心等新型电力电子应用。
公司以“推动国产SiC替代进口、加速能源低碳转型”为使命,响应国家“双碳”政策(碳达峰、碳中和),致力于降低电力电子系统能耗。
需求SiC碳化硅MOSFET单管及功率模块,配套驱动板及驱动IC,请搜索倾佳电子杨茜
结论

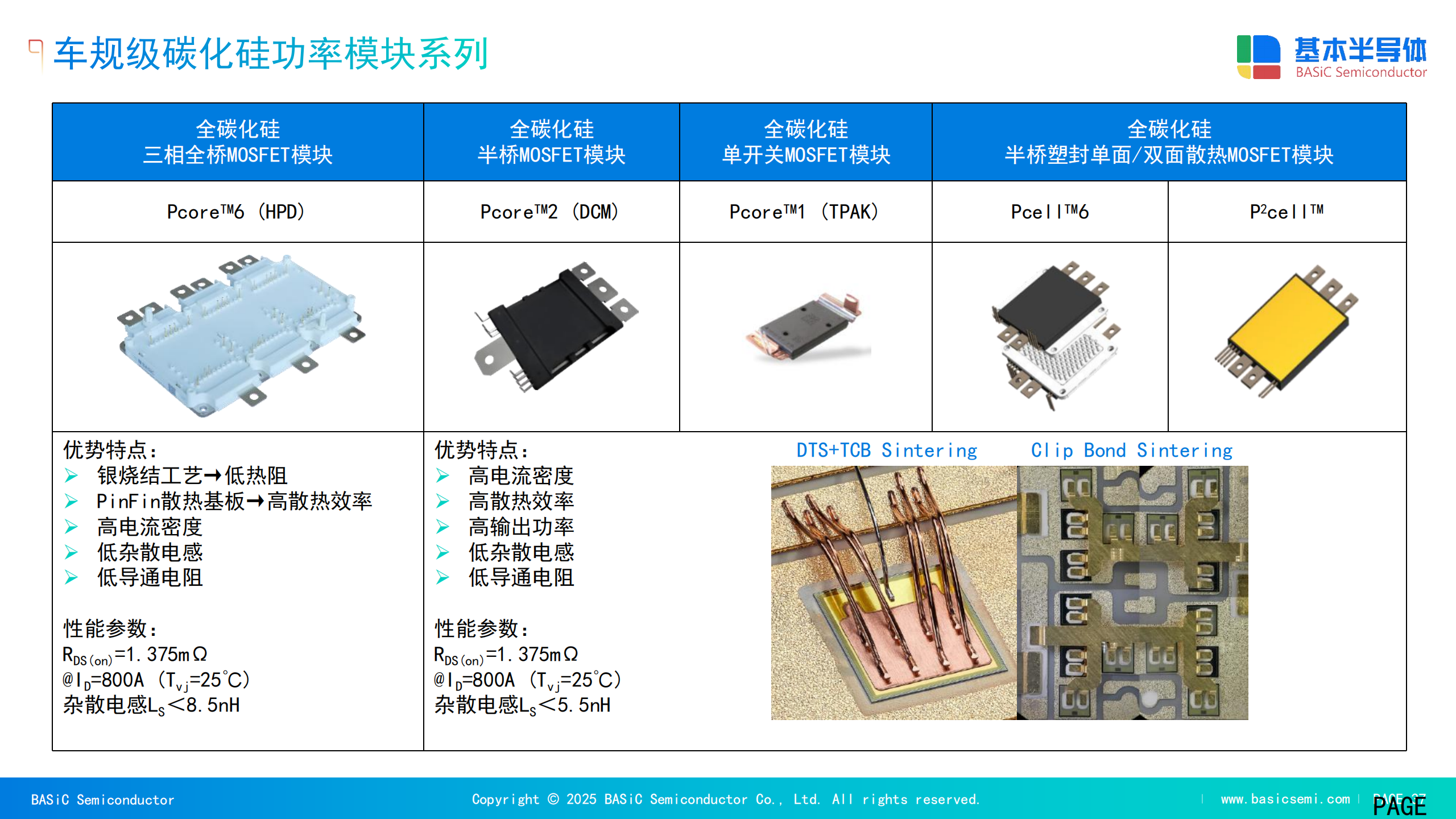
在 1200V SiC MOSFET 桥式拓扑中,启用同步整流(SR)模式并非仅是效率提升的优化手段,而是基于 SiC 器件电学特性和高频高功率系统性能要求的技术必然性。
1. 导通损耗危机是主要驱动力:SiC MOSFET 固有的 PN 结体二极管在高工作结温 (175∘C) 下会产生高达 4.1V 至 5.1V 的导通压降 VSD。在桥式电路的死区时间,若电流流经体二极管,会造成巨大的传导损耗,这在高功率、追求 99% 效率的系统中是不可接受的。启用 SR 模式,利用低 RDS(on) 的沟道导通,可将等效导通压降降低 50% 以上(至约 2.1V),从而实现导通损耗的最小化。
2. Qrr 消除是高频可靠性的前提:尽管 SiC 器件的体二极管 Qrr 较低,但它在大电流下的反向恢复能量 Err 和峰值电流 Irrm(如 BMF540R12KA3 的 Irrm 高达 338A)仍然巨大,足以在高 di/dt 环境下引发严重的开关损耗和过电压尖峰。精确的同步整流控制通过完全避免体二极管导通,使得 Qrr≈0,彻底消除了反向恢复相关的开关应力和损耗。这是确保 SiC 器件能够在 100kHz 甚至更高频率下高效、安全运行的绝对先决条件。
综上所述,SiC 功率器件只有通过精密的同步整流控制,才能最大化其宽禁带材料带来的高速度和低电阻优势。同步整流不仅优化了导通损耗,更保障了高频开关的可靠性,是实现下一代高功率密度和极致效率电力电子系统的核心技术支柱。
审核编辑 黄宇
-
同步整流
+关注
关注
11文章
322浏览量
52151 -
SiC MOSFET
+关注
关注
1文章
171浏览量
6818
发布评论请先 登录
倾佳电子基于SiC MOSFET 的 3kW 高频 (100kHz) CCM 图腾柱 PFC 设计、分析与效率建模
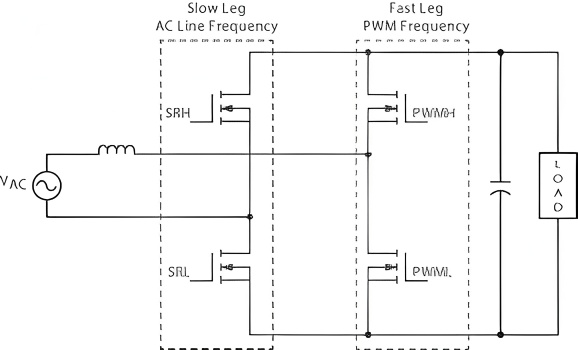
倾佳电子SiC厨房革命:B3M042140Z MOSFET取代RC-IGBT在电磁炉应用中的技术与商业分析




 倾佳电子宽禁带时代下的效率优化:SiC MOSFET桥式拓扑中同步整流技术的必然性与精确定量分析
倾佳电子宽禁带时代下的效率优化:SiC MOSFET桥式拓扑中同步整流技术的必然性与精确定量分析




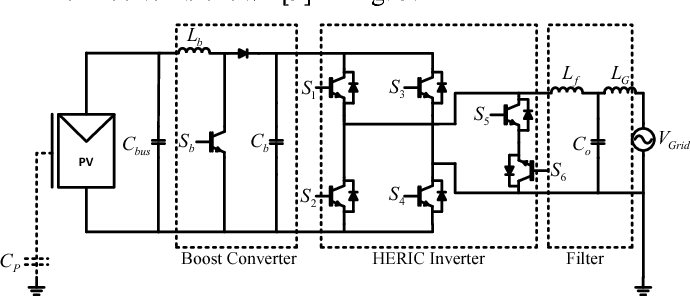


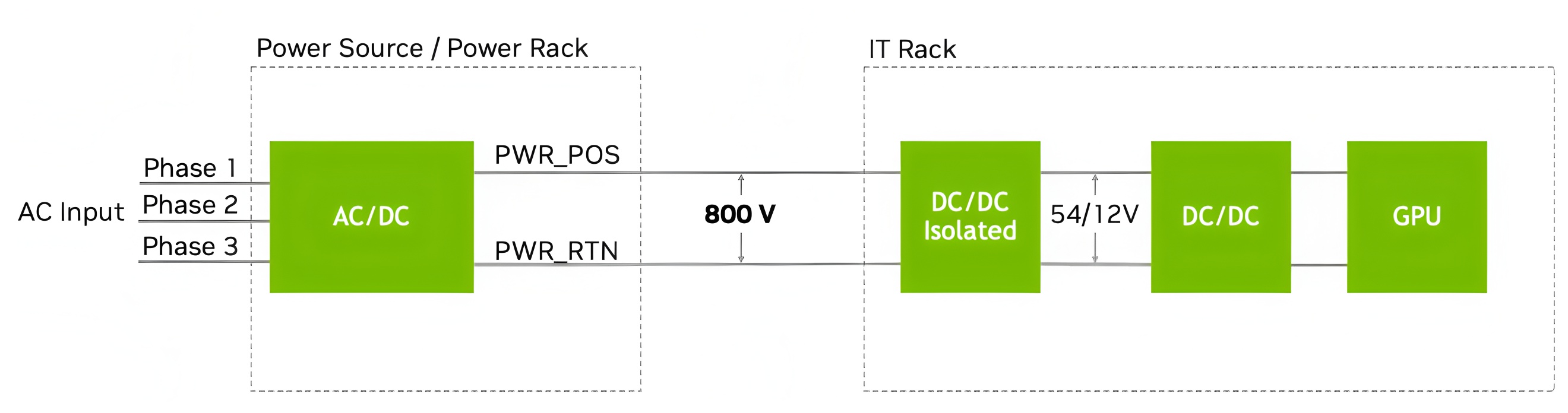

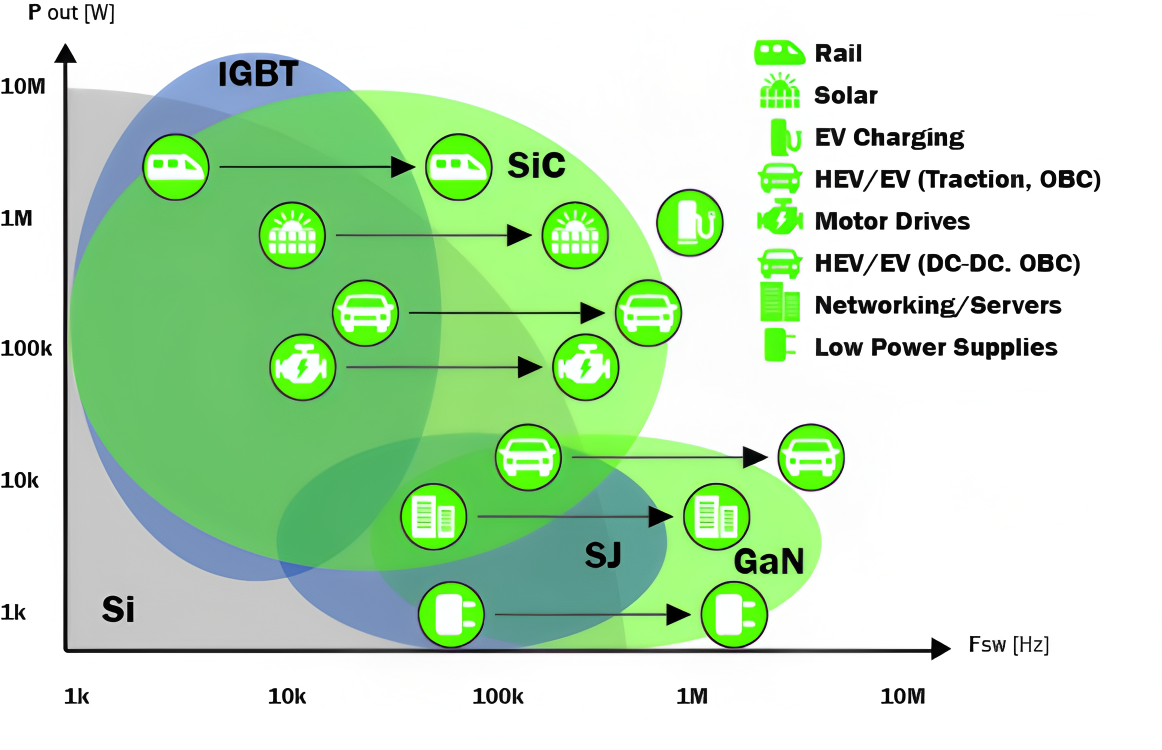



评论