文章来源:学习那些事
原文作者:前路漫漫
本文主要讲述封装缺陷。
概述
在电子器件封装过程中,会出现多种类型的封装缺陷,主要涵盖引线变形、底座偏移、翘曲、芯片破裂、分层、空洞、不均封装、毛边、外来颗粒以及不完全固化等。
引线变形
引线变形现象,多发生于塑封料流动阶段,表现为引线出现位移或形态改变。衡量这一缺陷程度,常采用引线最大横向位移 x 与引线长度 L 的比值 x/L 作为量化指标。在高密度 I/O 器件封装场景中,引线弯曲极易引发电器短路故障;同时,弯曲产生的应力还可能致使键合点开裂,削弱键合强度。而封装设计、引线布局、引线材料与规格、模塑料特性、引线键合工艺以及封装流程等,均会对引线键合产生影响;至于引线直径、长度、断裂载荷、密度等参数,更是与引线弯曲程度紧密相关。
底座偏移
底座偏移指的是芯片载体(即芯片底座)发生形变与位置偏离。塑封料的流动性能、引线框架的组装设计方案,以及塑封料和引线框架的材料特性,均是导致底座偏移的关键因素。像薄型小尺寸封装(TSOP)、薄型方形扁平封装(TQFP)这类封装器件,由于引线框架较薄,在封装过程中更易出现底座偏移与弓脚变形问题,底座偏移情况可参考下图。
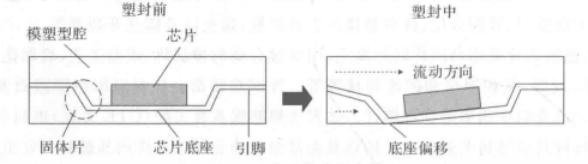
翘曲
封装器件在平面之外发生的弯曲与形变,被称为翘曲。塑封工艺引发的翘曲不仅会带来分层、芯片开裂等可靠性隐患,还会在制造环节造成诸多问题。以塑封球栅阵列(PBGA)器件为例,翘曲会导致焊料球共面性不佳,使得器件在回流焊组装至印刷电路板时出现故障。
在封装工艺中,贴装问题里的翘曲现象存在内凹、外凸以及组合模式这三种类型,具体形态如下图所示。塑封料成分、模塑料湿气含量、封装几何结构等,都是引发翘曲的潜在因素。通过精准把控塑封材料及其成分、优化工艺参数、调整封装结构并管理封装前环境条件,能够最大程度减少封装翘曲。在部分场景下,还可采用对电子组件封装背面进行处理的方式来补偿翘曲。例如,大陶瓷电路板或多层板的外部连接集中在同一侧时,对其背面实施封装操作,可有效降低翘曲程度。

芯片破裂
此外,封装工艺过程中产生的应力会致使芯片破裂,而且往往会加剧前道组装工序中已形成的微裂缝。晶圆或芯片减薄、背面研磨、芯片黏结等操作步骤,均可能促使芯片裂缝产生。值得注意的是,出现破裂、机械失效的芯片,并不一定会立即出现电气失效情况。芯片破裂是否会引发器件瞬间电气故障,与裂缝的延伸路径密切相关。比如,若裂缝产生于芯片背面,或许不会对芯片内部敏感结构造成影响。由于硅晶圆质地薄且脆,晶圆级封装更容易出现芯片破裂问题。因此,在转移成型工艺中,需严格管控夹持压力、成型转换压力等工艺参数,以此防范芯片破裂。而在 3D 堆叠封装领域,叠层工艺的特性使得芯片破裂风险显著增加,芯片叠层结构、基板厚度、模塑体积、模套厚度等设计因素,都会对 3D 封装中芯片破裂情况产生影响 。
分层
分层或黏结不牢,本质上是塑封料与相邻材料界面出现分离的现象。这类缺陷可能出现在塑封微电子器件的任意区域,无论是封装过程、后封装制造环节,还是器件使用阶段,都有可能发生。其中,封装工艺导致的界面黏结不良,是引发分层的关键因素。界面空洞、封装时的表面污染以及固化不完全等情况,均会致使黏结效果不佳。此外,固化与冷却过程中产生的收缩应力、翘曲,以及塑封料和相邻材料间热膨胀系数(CTE)不匹配引发的热 - 机械应力,也都是分层问题的诱因。
空洞
在封装工艺里,气泡嵌入环氧材料形成空洞的情况,可能贯穿转移成型、填充、灌封、塑封料印刷等各个阶段。通过排空或抽真空等减少空气量的手段,能够有效降低空洞出现的概率。据相关研究,采用1--300Torr(1 个大气压760Torr,1Torr = 1.01325×10⁵Pa)的真空压力范围可取得较好效果。填模仿真分析显示,底部熔体前沿与芯片接触会阻碍流动性,部分熔体前沿向上经芯片外围大开口区域填充半模顶部,新老熔体前沿在此交汇,进而产生起泡现象。
不均封装
塑封体厚度不均会引发翘曲和分层问题。传统的转移成型、压力成型、灌注封装等技术,较少出现此类缺陷;而晶圆级封装因其工艺特性,更容易导致塑封厚度不一致。为保障塑封层厚度均匀,需固定晶圆载体,尽量减小其倾斜度,以便刮刀安装;同时,还需精准控制刮刀位置,维持刮刀压力稳定。在塑封料硬化前,若填充粒子局部聚集、分布不均,或者塑封料混合不充分,都会造成材料组成不一致。
毛边
毛边是塑封成型时,模塑料通过分型线沉积在器件引脚上形成的。夹持压力不足是产生毛边的主因,若不及时清除引脚上的模料残留,会在组装阶段引发诸多问题,如后续封装过程中键合或黏附不充分。树脂泄漏则属于较为轻微的毛边形态。
外来颗粒及不完全固化
当封装材料接触受污染的环境、设备或其他材料时,外来粒子会在封装内部扩散,并附着在 IC 芯片、引线键合点等金属部位,进而引发腐蚀及其他可靠性问题。固化时间不足、温度偏低,或是两种封装料灌注时混合比例出现偏差,都会导致不完全固化。为充分发挥封装材料性能,不仅要确保其完全固化,在许多封装工艺中,还可采用后固化工艺辅助;同时,必须严格把控封装料的配比精度。
-
芯片
+关注
关注
463文章
54475浏览量
469797 -
封装
+关注
关注
128文章
9341浏览量
149091 -
工艺
+关注
关注
4文章
721浏览量
30403
原文标题:封装缺陷分类
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
软件代码缺陷分类及其应用
一文详解封装互连技术
一文详解封装互连技术
基于FFmpeg解封装WMV和M4V格式
一文详解封装基板的制备工艺
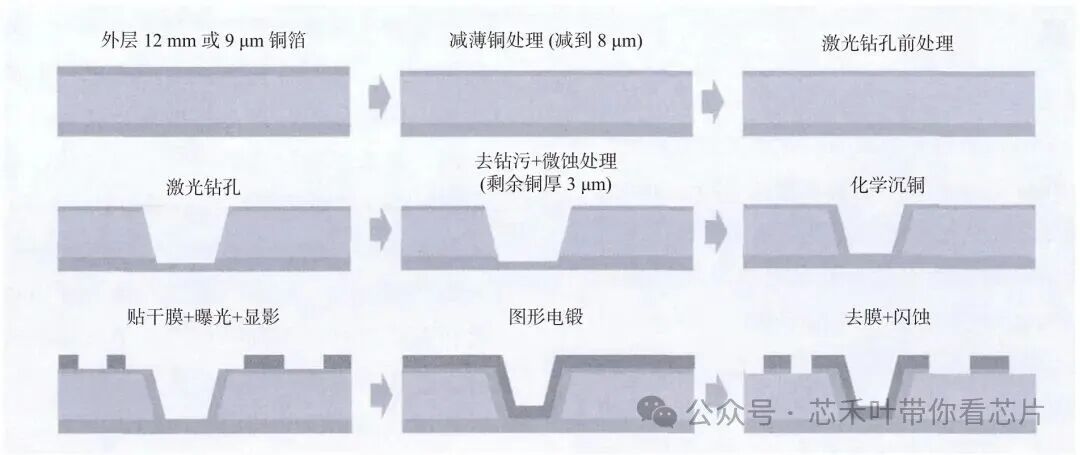



 一文详解封装缺陷分类
一文详解封装缺陷分类


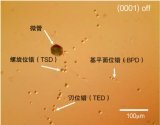



评论