以下文章来源于学习那些事,作者小陈婆婆
失效机理
本文介绍内容为:半导体集成电路失效机理中与封装有关的失效机理,分述如下
封装材料α射线引起的软误差
水汽引起的分层效应
金属化腐蚀:铝互连线的腐蚀问题
1封装材料α射线引起的软误差
产生机理
铀或钍等放射性元素是集成电路封装材料中天然存在的杂质。这些材料发射的α粒子进入硅中时,会在粒子经过的路径上产生电子-空穴对。这些电子-空穴对在电场的作用下被电路结点收集,从而引起电路误动作。具体表现为动态存储器存储电荷丢失、静态随机存储器(RAM)存储单元翻转、动态逻辑电路信息丢失或其他逻辑单元电路漏极耗尽区中存储的信息丢失。
吸收一个4MeV的α粒子能产生10^6^个电子-空穴对,电荷数量等于或大于动态存储单元中存储的电荷。在一个包含1000个16KB存储器件的存储系统中,典型的软错误率可能是每1000小时发生一次软误差的数量级,相当于器件失效率为1000FIT(失效时间间隔)。
改进措施
针对封装材料α射线引起的软误差问题,可以采取以下改进措施:
·提高封装材料的纯度:通过减少封装材料中铀、钍等放射性元素的含量,可以降低α粒子的来源,从而减少软误差的发生。
·片表面涂阻挡层:在芯片表面涂覆一层阻挡层,如聚酸胺系列有机高分子化合物等,可以有效阻止α粒子射入芯片中,从而降低软误差率。
·优化器件设计:从器件设计入手,增加存储单元单位面积的电荷存储容量。例如,采用介电系数大的材料或沟槽结构电容来增大存储电容面积,或者在衬底中加隐埋层,提高杂质浓度并使杂质分布优化,以降低电荷收集效率而不提高结电容,从而保持电路性能。
·优化电路设计:采用纠错码(ECC)技术来优化电路设计。ECC技术可以检测和纠正数据传输或存储过程中出现的错误,从而降低软误差对系统性能的影响。
·改进时序控制电路:在DRAM等存储器中,采用复杂的时序控制电路来缩短位线电压的浮动时间。这有助于减少因α粒子引起的电路误动作,从而降低软误差率。
综上所述,通过提高封装材料的纯度、涂覆阻挡层、优化器件和电路设计以及改进时序控制电路等措施,可以有效降低封装材料α射线引起的软误差率,提高集成电路的稳定性和可靠性。
2水汽引起的分层效应
塑封IC与水汽分层效应概述
塑封IC,即以塑料等树脂类聚合物材料封装的集成电路,在封装过程中及后续使用中,可能因水汽吸附引发分层效应,导致器件失效。这种分层效应,俗称“爆米花”效应,对集成电路的稳定性和可靠性构成严重威胁。
失效机理
塑封料中的水分在高温环境下会迅速膨胀,这种膨胀力导致塑封料与其附着的金属框架和芯片之间发生分离。当膨胀力达到一定程度时,塑封体甚至可能爆裂,严重损伤芯片、使钝化层破裂、拉断键合引线,从而导致器件失效。
危害
水汽引起的分层效应对集成电路的危害主要体现在以下几个方面:
·损伤芯片:分层效应可能导致芯片表面或内部受到机械损伤,影响芯片的正常功能。
·钝化层破裂:钝化层是保护芯片免受外界环境影响的关键层,其破裂将降低芯片的防护能力。
·拉断键合引线:键合引线是连接芯片与外部电路的关键部分,其断裂将导致信号传输中断。
水汽进入途径
水汽主要通过以下途径进入塑封IC:
·塑料体渗透:水汽通过塑料材料本身的微小孔隙渗透进入封装体内部。
·交界面进入:水汽从塑料与金属框架(外引线)的交界面处渗透进入封装体。
改进措施
针对水汽引起的分层效应,可以采取以下改进措施:
减少封装体内部气泡:在IC后道封装的塑封过程中,优化环氧模塑料的充填成型工艺,确保空气及挥发性物质在压实阶段完全排出,避免内部气泡的产生。采用树脂预热时温差工艺,通过合理的温度梯度控制,使树脂在熔化过程中更有效地排出空气。
减小金属框架对封装的影响:选择铜质引线框架,以提高塑封IC的热匹配性,减少因热应力引起的分层效应。增加去除塑封冲制成形时毛刺的工序,减小应力集中,提高封装的可靠性。
电装要求:拆包后的器件应尽快进行装配,避免长时间暴露在空气中吸附水汽。未及时装配的器件应保存在干燥的环境中,或在高温烘烤后去除表面吸附的水汽后再进行电装。
通过采取上述改进措施,可以有效降低水汽引起的分层效应对塑封IC的影响,提高器件的稳定性和可靠性。
3金属化腐蚀:铝互连线的腐蚀问题
在集成电路中,金属铝因其价格便宜和易于大量生产而被广泛用作互连线材料。然而,铝是一种化学活泼金属,容易受到水汽的腐蚀。特别是在树脂包封的集成电路中,水汽可以穿透树脂层到达铝互连线处,与其发生化学反应或电化学反应,导致铝互连线的腐蚀。这种腐蚀现象对集成电路的稳定性和可靠性构成了严重威胁。
失效机理
金属铝的腐蚀主要分为化学腐蚀和电化学腐蚀两种机制:
·化学腐蚀:当集成电路存放在高温高湿环境中时,铝会发生化学腐蚀。在干燥空气中,铝表面会形成一层氧化铝(Al₂O₃)保护膜,防止化学腐蚀的发生。但在潮湿环境中,这层保护膜会被破坏,形成氢氧化铝(Al(OH)₃),该物质既溶于酸也溶于碱。

当有外部物质(如酸性或碱性物质)到达铝表面时,会发生化学反应,导致铝的腐蚀。特别是在引线键合处的Pad部分,金属铝是暴露于表面的,因此更容易受到化学腐蚀的攻击。
·电化学腐蚀:当集成电路工作于高温高湿环境中时,还会发生电化学腐蚀。根据铝电极的电势是正还是负,电化学腐蚀分为阳极腐蚀和阴极腐蚀。阳极腐蚀时,铝电极是正电位,负离子(如Cl⁻)被吸引过来,与铝发生化学反应,导致腐蚀。
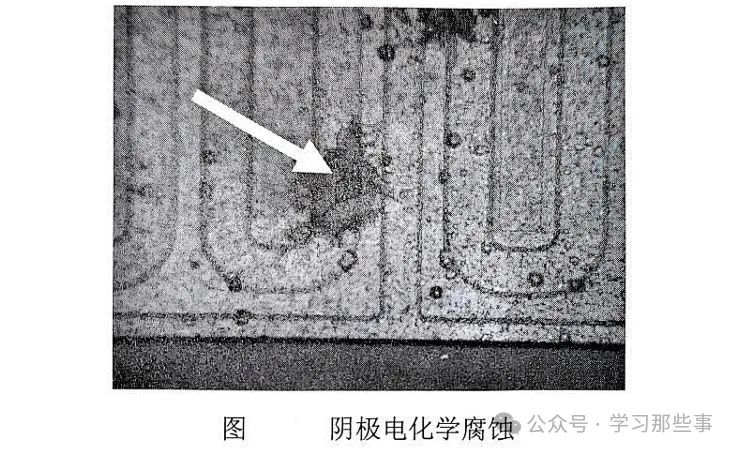
阴极腐蚀时,铝电极是负电位,正离子(如Na⁺、K⁺)被吸引过来,与水电离产生的OH⁻离子反应,形成氢氧化铝,从而产生腐蚀。
危害与影响
金属铝的腐蚀会导致互连线电阻增加、信号传输性能下降,甚至引起电路开路或短路,严重影响集成电路的稳定性和可靠性。此外,腐蚀还会破坏芯片表面的钝化膜,进一步降低芯片的防护能力。
改进措施
为了防止铝的腐蚀,可以采取以下改进措施:
·控制加工过程和装配工艺的清洁度:确保在加工和装配过程中,避免杂质和污染物的引入,降低封装树脂中的杂质浓度。
·使用陶瓷密封包装:陶瓷材料具有良好的密封性和化学稳定性,可以有效防止水汽和杂质的渗透,保护铝互连线不受腐蚀。
·去除残余氯的钝化方法:在片子腐蚀后而暴露于大气之前,立即用CF₄—O或O₂等离子体处理去掉残余的氯,进一步提高铝互连线的稳定性。
·热氧化金属:通过热氧化处理,可以在铝表面形成一层致密的氧化铝保护膜,提高铝的耐腐蚀性。
·控制介质中的磷含量:在磷硅玻璃中保持6%的最小磷含量,可以减少对铝合金结构的侵蚀。
综上所述,通过采取上述改进措施,可以有效降低金属铝在集成电路中的腐蚀风险,提高集成电路的稳定性和可靠性。集成电路外引线及键合引线相关失效问题及改进措施。
-
集成电路
+关注
关注
5464文章
12688浏览量
375742 -
半导体
+关注
关注
339文章
31248浏览量
266598 -
封装
+关注
关注
128文章
9333浏览量
149047
原文标题:封装有关的失效机理
文章出处:【微信号:芯长征科技,微信公众号:芯长征科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录



 半导体集成电路封装失效机理详解
半导体集成电路封装失效机理详解


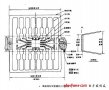





评论