正性光刻对掩膜版的要求主要包括以下几个方面:
基板材料:掩膜版的基板材料需要具有良好的透光性、稳定性以及表面平整度。石英是常用的基板材料,因为它具有较低的热膨胀系数,能够在温度变化时保持尺寸稳定。
遮光膜:遮光膜是掩膜版上的关键组成部分,用于定义图案的边界。硬质遮光膜材料通常包括铬、硅、硅化钼、氧化铁等。铬因其机械强度高且能形成细微图形,成为硬质遮光膜的主流材料。
分辨率:掩膜版需要具备足够的分辨率,以便能够准确地转移精细的图案到光刻胶上。分辨率受到光刻胶、曝光光源和掩膜版本身等多种因素的影响。
套刻精度:套刻精度是指不同层图案之间的对准精度。对于正性光刻而言,掩膜版上的图案需要与硅片上的已有图案精确对齐,以确保多层结构的正确构建。
关键尺寸(CD)控制:关键尺寸是指图案中最窄线宽或空间的尺寸。在正性光刻中,掩膜版需要能够精确控制这些关键尺寸,以满足设计规格的要求。
综上所述,正性光刻对掩膜版的要求涉及材料选择、图案定义、分辨率、套刻精度和关键尺寸控制等多个方面。这些要求共同确保了光刻过程的准确性、重复性和最终产品的质量。
免责声明:文章来源汶颢www.whchip.com以传播知识、有益学习和研究为宗旨。转载仅供参考学习及传递有用信息,版权归原作者所有,如侵犯权益,请联系删除。
审核编辑 黄宇
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
光刻
+关注
关注
8文章
367浏览量
31399 -
掩膜
+关注
关注
0文章
28浏览量
12042
发布评论请先 登录
相关推荐
热点推荐
中国打造自己的EUV光刻胶标准!
电子发烧友网报道(文/黄山明)芯片,一直被誉为 人类智慧、工程协作与精密制造的集大成者 ,而制造芯片的重要设备光刻机就是 雕刻这个结晶的 “ 神之手 ”。但仅有光刻机还不够,还需要光刻胶、掩
芯片制造真正的“底片”——Reticle(掩膜版)全解析
从DUV到EUV,掩膜版为什么越来越难?Reticle的结构、制造与缺陷在晶圆厂里,最像“押运黄金”的物件之一不是晶圆,而是Reticle(倍缩式掩模/掩膜版):一块看似普通的玻璃板,


厚声贴片电阻的厚膜工艺与薄膜工艺有何区别?
厚声贴片电阻的厚膜工艺与薄膜工艺在 膜层厚度、制造工艺、性能表现、应用场景及成本结构 上存在显著差异,具体分析如下: 一、膜层厚度:物理维度的核心差异 厚膜工艺 :

光刻胶涂层如何实现纳米级均匀性?椭偏仪的工艺控制与缺陷分析
光刻胶(亦称光致抗蚀剂)是集成电路制造中的关键材料,其纯度直接决定光刻图形的质量与芯片良率。随着光刻技术向极紫外(EUV,13.5 nm)工艺节点演进,光刻胶的

泽攸科技 | EBL和EUV光刻机有何区别?如何影响半导体行业?
从技术路径上看,电子束光刻和大家熟悉的EUV光刻并不是同一类问题的解法。电子束光刻本质上是一种直接写入技术,利用聚焦电子束在抗蚀剂上逐点曝光,通过电磁控制精确描绘图形。这种方式不依赖掩模,在设计频繁迭代的研发阶段非常有优势,尤其


为什么光刻要用黄光?
通过使用光掩膜和光刻胶在基板上复制流体图案的过程。基板将涂覆硅二氧化层绝缘层和光刻胶。光刻胶在被紫外光照射后可以容易地用显影剂溶解,然后在腐
光刻工艺中的显影技术
一、光刻工艺概述 光刻工艺是半导体制造的核心技术,通过光刻胶在特殊波长光线或者电子束下发生化学变化,再经过曝光、显影、刻蚀等工艺过程,将设计在掩膜
清华大学在激光干涉光刻全局对准领域取得新进展
图1.拼接曝光加工系统 衍射光栅广泛应用于精密测量、激光脉冲压缩、光谱分析等领域。干涉光刻作为一种无掩膜曝光光刻方法,在衍射光栅加工制造方面具有高效率、高灵活度的优势。但干涉

跨越摩尔定律,新思科技掩膜方案凭何改写3nm以下芯片游戏规则
。 然而,随着摩尔定律逼近物理极限,传统掩模设计方法面临巨大挑战,以2nm制程为例,掩膜版上的每个图形特征尺寸仅为头发丝直径的五万分之一,任何微小误差都可能导致芯片失效。对此,新思科技(Synopsys)推出制造解决方案,尤其是
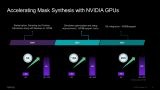
光刻图形转化软件免费试用
光刻图形转化软件可以将gds格式或者gerber格式等半导体通用格式的图纸转换成如bmp或者tiff格式进行掩模版加工制造,在掩膜加工领域或者无掩膜
发表于 05-02 12:42



 正性光刻对掩膜版有何要求
正性光刻对掩膜版有何要求







评论