目前市场上普遍采用的面射型雷射元件主流技术为选择性氧化法,绝大多数面射型雷射操作特性纪录均是由选择性氧化局限技术所达成,例如低操作电压[14]、低临界电流[15]、高电光转换效率[16]17、高调变频率[18][19]等,其他蚀刻空气柱状结构所需的蚀刻制程以及离子布植法同样需要的金属电极制程也都与氧化局限技术中采用的制程参数相同,因此本节将针对氧化局限面射型雷射制程技术进行介绍,让读者能对面射型雷射制程技术有一个全面的概念。选择性氧化面射型雷射制程步骤大致如下图5-8所示,关键制程会在本节详细介绍。
与蚀刻空气柱状结构和离子布植法制作面射型雷射所需的磊晶成长结构最显著的差异在于靠近活性层增益区必须成长一层或数层厚度约数十奈米的高铝含量砷化铝镓层以供后续氧化制程形成电流局限孔径,通常该层铝含量会在95%以上以获得足够的氧化速率。典型的氧化局限面射型雷射磊晶结构如下图5-9所示,该结构具有n型(Si掺杂浓度3X1018cm-3)与p型(C掺杂浓度3X1018cm-3)DBR各39.5对与22对,等效四分之一波长厚度的高折射率Al0.12Ga0.88As与低折射率Al0.92Ga0.08As层之间有20nm的渐变层(graded interface)以降低介面电阻,活性层增益区为三层8nm厚的GaAs量子井被Al0.3Ga0.7As量子能障包围以提供优异的载子局限效果,元件发光波长为850nm。


-
制程
+关注
关注
1文章
99浏览量
16806 -
雷射
+关注
关注
0文章
25浏览量
10422
原文标题:面射型雷射制程技术
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
扇出型晶圆级封装技术介绍

浅谈铝制程芯片去层核心分析方法

晶圆工艺制程清洗方法

湿法清洗和干法清洗,哪种工艺更适合先进制程的硅片

如何修复液晶面板制程中的亮点缺陷?

激光对射测距:精准丈量世界的科技之眼

国产芯片真的 “稳” 了?这家企业的 14nm 制程,已经悄悄渗透到这些行业…
高精度大靶面工业镜头,守护mini/micro LED的高品质生产

光阻去除属于什么制程
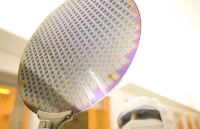
台积电引领全球半导体制程创新,2纳米制程备受关注

激光器电源技术电子书
PanDao应用:面形参数
以“光”为尺 对射光纤传感器:精准感知赋能千行百业

英特尔持续推进核心制程和先进封装技术创新,分享最新进展




 面射型雷射制程技术介绍
面射型雷射制程技术介绍





评论