深视智能3D相机系列2.5D模式高度差测量SOP操作指南旨在协助用户更加全面地了解我们的传感器设备。
以塔台标定板为例:01
图 | 塔台标定板
在软件中进行参数调整:02 图 |2.5D模式高度差测量SOP在公共设定中将3D模式改为2.5D模式:03
图 |2.5D模式高度差测量SOP在公共设定中将3D模式改为2.5D模式:03 图 |2.5D模式高度差测量SOP激活测量设定:04
图 |2.5D模式高度差测量SOP激活测量设定:04
图 |2.5D模式高度差测量SOP
在注册主控中选择注册:05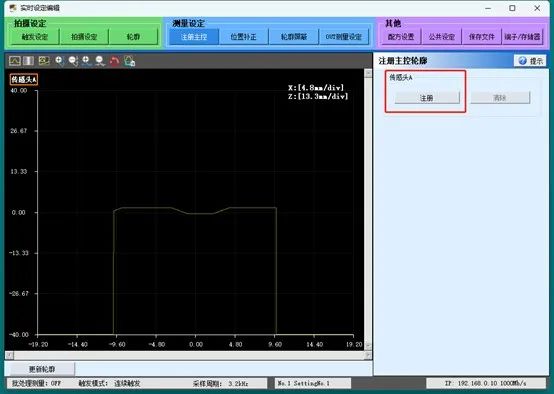
图 |2.5D模式高度差测量SOP
在位置补正中进行补正:06

图 |2.5D模式高度差测量SOP
点击设定进入模式选择,选择需要的测量项(如检测高度差信息):07
图 |2.5D模式高度差测量SOP
返回主页面,点击开始测量:08
图 |2.5D模式高度差测量SOP
点击测量值,即可监控数值:09
图 |2.5D模式高度差测量SOP
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
测量
+关注
关注
10文章
5509浏览量
116072 -
SOP
+关注
关注
0文章
97浏览量
28551 -
3D相机
+关注
关注
0文章
134浏览量
8897
发布评论请先 登录
相关推荐
热点推荐

3D曲面玻璃的特点与2.5D玻璃屏幕的作用介绍及其之间的区别
C 产品设计需求。3C 产品设计如智能手机、智能手表、平板计算机、可穿戴式智能产品、仪表板等陆续出现 3D 产品,已经明确引导
发表于 09-30 09:32
•22次下载
2.5D/3D芯片-封装-系统协同仿真技术研究
2.5D/3D 芯片包含 Interposer/ 硅穿孔 (Through Silicon Via, TSV) 等复杂结构,通过多物理场
仿真可以提前对 2.5D/3D 芯片的设计进
发表于 05-06 15:20
•19次下载
智原推出2.5D/3D先进封装服务, 无缝整合小芯片
来源:《半导体芯科技》杂志 ASIC设计服务暨IP研发销售厂商智原科技(Faraday Technology Corporation)宣布推出其2.5D/3D先进封装服务。通过独家的芯片中介层
2.5D和3D封装的差异和应用
2.5D 和 3D 半导体封装技术对于电子设备性能至关重要。这两种解决方案都不同程度地增强了性能、减小了尺寸并提高了能效。2.5D 封装有利于组合各种组件并减少占地面积。它适合高性能计算和人工

探秘2.5D与3D封装技术:未来电子系统的新篇章!
随着集成电路技术的飞速发展,封装技术作为连接芯片与外部世界的重要桥梁,也在不断地创新与演进。2.5D封装和3D封装作为近年来的热门技术,为电子系统的小型化、高性能化和低功耗化提供了有力支持。本文将详细介绍2.5D封装和

技术资讯 | 2.5D 与 3D 封装
本文要点在提升电子设备性能方面,2.5D和3D半导体封装技术至关重要。这两种解决方案都在不同程度提高了性能、减小了尺寸并提高了能效。2.5D封装有利于组合各种器件并减小占用空间,适合高性能计算和AI

2.5D和3D封装技术介绍
整合更多功能和提高性能是推动先进封装技术的驱动,如2.5D和3D封装。 2.5D/3D封装允许IC垂直集成。传统的flip-chip要求每个IC单独封装,并通过传统PCB技术与其他IC

多芯粒2.5D/3D集成技术研究现状
面向高性能计算机、人工智能、无人系统对电子芯片高性能、高集成度的需求,以 2.5D、3D 集成技术为代表的先进封装集成技术,不仅打破了当前集成芯片良率降低、成本骤升的困境,也是实现多种类型、多种材质、多种功能芯粒集成的重要手段。






 深视智能3D相机2.5D模式高度差测量SOP流程
深视智能3D相机2.5D模式高度差测量SOP流程













评论