高压CoolGaN GIT HEMT(高电子迁移率晶体管)可靠性和验证的白皮书共33页,被翻译成中文和日文,主要介绍了英飞凌如何实现CoolGaN技术和器件使用寿命,且大幅超过标准的规定,详细阐述了英飞凌用于验证CoolGaN器件的四个方面的流程。
硅的故障机制清晰,验证方法非常成熟,但传统的硅验证工艺无法直接应用于GaN技术产品,因为GaN器件的材料和结构特性与硅器件有显著差异。
我们对目标应用条件下硅器件的故障机制已经很清楚,这包括TDDB(发生在硅器件栅极氧化物中)、疲劳表征、电迁移(由导体中的高电流密度导致)和腐蚀(由湿度和偏压导致)。尽管其中大半也发生于GaN器件,但在验证GaN器件时,还需加入更多条件。GaN器件需要新的验证方案来确保其在实际应用中的可靠运行,特别是在高电压、高频率和高温度条件下。
为此白皮书重点介绍了验证GaN器件的四个方面的流程:
1
应用概况:了解器件在特定应用中的应力条件,包括电压、电流、温度和湿度等,以及预期的工作寿命和质量要求。
2
质量要求概况:收集应用的一般描述、目标使用寿命、最大允许累积故障率、ESD额定值等参数。
3
开发过程中的可靠性研究:通过Weibull图等工具分析故障数据,区分内在故障和外在故障,并通过工艺和设计变更减少外在故障。
4
退化模型:开发关键故障模式的退化模型,如DC偏置和开关SOA模型,动态导通电阻,以预测器件在使用寿命内的故障率。
白皮书以通讯电源为例,分析了在图腾柱、硬开关PFC拓扑中使用时,如何满足典型的工业使用寿命和质量(累积故障率)目标。
白皮书最后提出CoolGaN HEMT作为通用的功率开关,在各种拓扑中的应用条件和建议。

《高压CoolGaN GIT HEMT的可靠性和鉴定---CoolGaN技术和器件如何大幅超出标准使用寿命要求》目录一览:

-
高压
+关注
关注
6文章
669浏览量
33156 -
晶体管
+关注
关注
78文章
10439浏览量
148607 -
白皮书
+关注
关注
0文章
95浏览量
20876 -
HEMT
+关注
关注
2文章
80浏览量
14538
发布评论请先 登录
海光信息深度参编的超节点技术体系白皮书正式发布
沐曦股份参与编撰的超节点技术体系白皮书正式发布
华为在MWC 2026联合发布高品质万兆AI园区建网技术白皮书
多合一空气质量传感器对比白皮书
华润微CD7377CZ/7388车载功放芯片 技术白皮书
华为联合发布园区自智网络技术白皮书
华为乾崑智能汽车解决方案网络安全白皮书发布
PI技术白皮书 1250V/1700V PowiGaN HEMT在800VDC AI数据中心架构中的应用
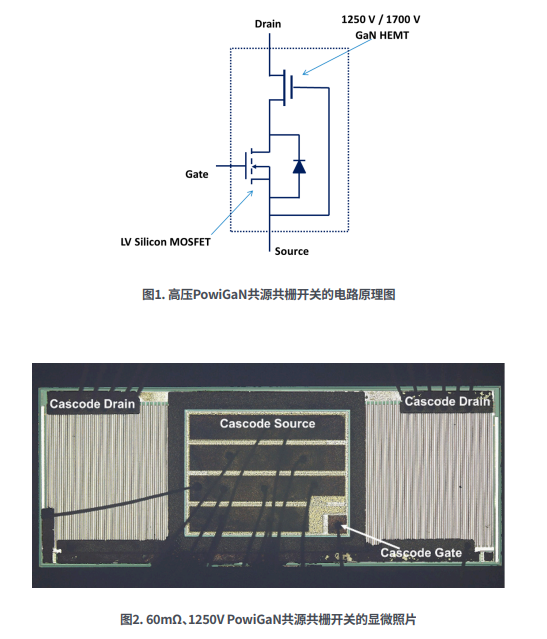
华为发布高品质万兆AI园区建网技术白皮书
“端云+多模态”新范式:《移远通信AI大模型技术方案白皮书》正式发布




 抢先领取!高压CoolGaN™ GIT HEMT可靠性白皮书推荐
抢先领取!高压CoolGaN™ GIT HEMT可靠性白皮书推荐




评论