来源:集成电路材料研究
日本电气玻璃与VIA Mechanics于11月19日宣布,双方已签署共同开发协议,以加速玻璃及玻璃陶瓷制成的半导体封装用无机芯板的开发。
目前的半导体封装中,核心基板主要采用玻璃环氧树脂基板等有机材料基板。然而,针对未来高性能半导体的封装需求,核心基板上的电路和微孔(通孔,via)需要实现更高的微细化和高密度化,同时具备支持高速传输的优良电气特性。这些需求使得有机材料基板难以满足。因此,玻璃作为替代材料受到越来越多的关注。
然而,在普通玻璃基板中,若使用CO2激光进行打孔,容易出现裂纹(破裂),导致基板损坏。为了解决这一问题,需要采用激光改性和蚀刻工艺来形成通孔。然而,这种加工方法存在工艺难度高、加工时间长等问题。
此次的共同开发旨在通过合作解决上述课题,将日本电气玻璃多年来积累的玻璃与玻璃陶瓷技术经验与VIA Mechanics的激光加工技术相结合。为此,日本电气玻璃引入了VIA Mechanics的激光加工设备,以加速无机芯板的早期开发。
在共同开发中,日本电气玻璃的职责包括以下三个方面:
1. 针对无机芯板所需的玻璃基板及玻璃陶瓷基板核心材料的设计与开发;
2. 为玻璃基板及玻璃陶瓷基板的量产开发相关技术;
3. 提供试制品,并提出解决技术课题的方案。
而VIA Mechanics的职责包括以下两点:
1. 支援开发基于CO2激光的无裂纹通孔形成技术;
2. 提出实现无机芯板实用化的评价方法。
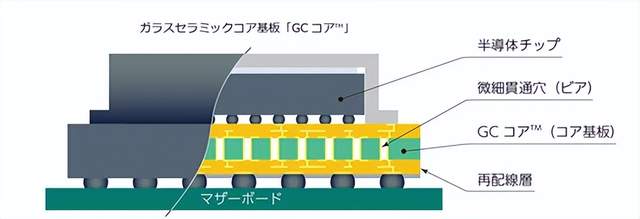
图1:日本电气玻璃的面向半导体封装的玻璃陶瓷核心基板“GC Core”示意图(来源:日本电气玻璃)
声明:本网站部分文章转载自网络,转发仅为更大范围传播。 转载文章版权归原作者所有,如有异议,请联系我们修改或删除。联系邮箱:viviz@actintl.com.hk, 电话:0755-25988573
审核编辑 黄宇
-
封装
+关注
关注
128文章
9325浏览量
149032 -
半导体封装
+关注
关注
4文章
327浏览量
15267
发布评论请先 登录
DirectScan 技术解析:下一代半导体电子束检测的创新路径与应用

键合玻璃载板:半导体先进封装的核心支撑材料
艾迈斯欧司朗:推出面向下一代汽车激光雷达应用的新型激光器

罗姆面向下一代800 VDC架构发布电源解决方案白皮书
AMEYA360 | 罗姆面向下一代800 VDC架构发布电源解决方案白皮书

半导体无机清洗是什么意思
Telechips与Arm合作开发下一代IVI芯片Dolphin7
意法半导体推进下一代芯片制造技术 在法国图尔工厂新建一条PLP封装试点生产线
意法半导体携手Flex推动下一代移动出行发展
恩智浦与长城汽车深化合作,围绕电气化、下一代电子电气架构
下一代高速芯片晶体管解制造问题解决了!
NVIDIA 采用纳微半导体开发新一代数据中心电源架构 800V HVDC 方案,赋能下一代AI兆瓦级算力需求
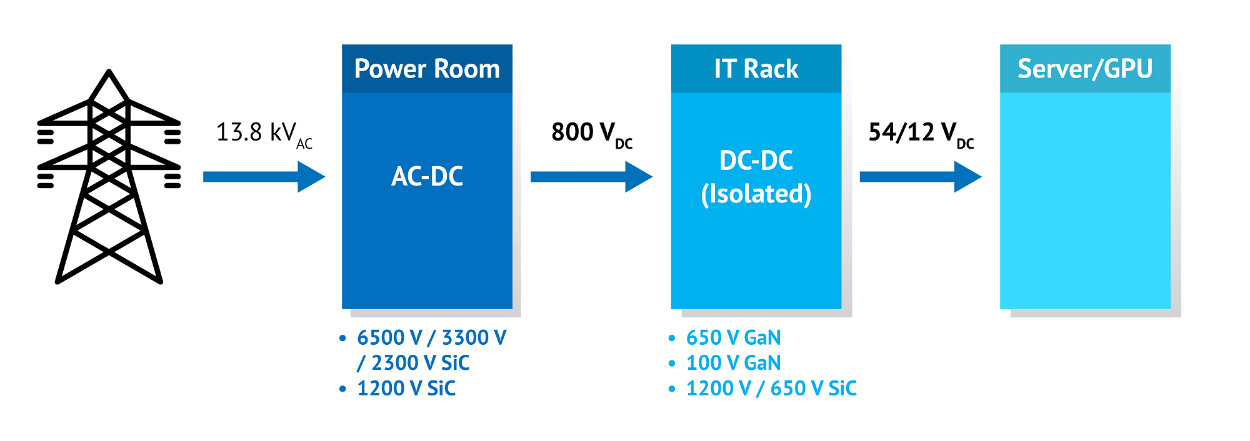
Rambus推出面向下一代AI PC内存模块的业界领先客户端芯片组
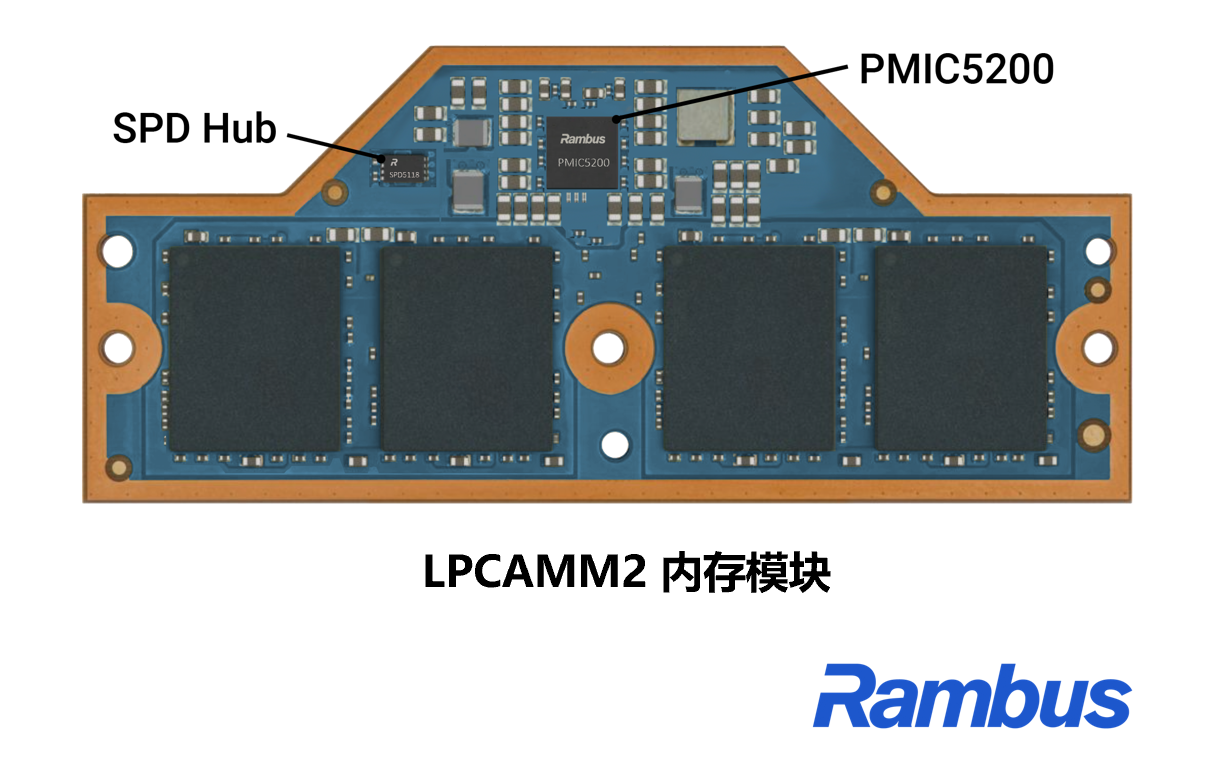



 日本电气玻璃与VIA Mechanics签署面向下一代半导体封装的无机芯板开发协议
日本电气玻璃与VIA Mechanics签署面向下一代半导体封装的无机芯板开发协议





评论