IMD3工艺包括 IMD3a工艺和IMD3b工艺。IMD3a 工艺是形成 VIA2 的介质隔离材料,同时 IMD3a 会隔离第二层金属和第三层金属,IMD3b 工艺是形成第三层金属的介质隔离材料。IMD3的材料也是 ULK SiCOH材料。
1)淀积SiCN 刻蚀停止层。利用 PECVD淀积一层厚度约为600A的 SiCN,SiCN 作刻蚀停止层和 M2的覆盖层,SiCN可以防止Cu 扩散。这样 Ta/TaN 和 SiCN 就形成一个容器包裹着Cu,防止Cu向外扩散。图4-266 所示为淀积 SiCN 的剖面图。
2)淀积 IMD2a SiCOH 层。利用 PECVD淀积一层厚度4500A 的SiCOH。利用 DEMS(Di-甲基乙氧基硅烷)和 CHO(氧化环乙烯或C6H10O),可以淀积具有CxHy的OSG 有机复合膜。利用超紫外(UV)和可见光处理排除有机气体,最终形成多孔的 SiCOH 介质薄膜。SiCOH 作为内部金属氧化物隔离层,可以有效减小金属层之间的寄生电容。
3)淀积SiCN 刻蚀停止层。利用PECVD 淀积一层厚度约为600A的 SiCN,SiCN 作刻蚀停止层。图4-267所示为淀积 SiCN的剖面图。
4)淀积 IMD2b SiCOH 层。利用 PECVD淀积一层厚度6000A的SiCOH。利用DEMS(Di-甲基乙氧基硅烷)和CHO(氧化环乙烯或C6H10O),可以淀积具有CxHy的OSG有机复合膜。利用超紫外(UV)和可见光处理排除有机气体,最终形成多孔的Si-COH 介质薄膜。SiCOH 作为内部金属氧化物隔离层,可以有效减小金属层之间的寄生电容。
5)淀积 USG。通过PECVD淀积一层厚度约为500A的USG。淀积的方式是利用 TEOS在400°C发生分解反应形成二氧化硅淀积层。USG 和TiN 硬掩膜可以防止去光刻胶工艺中的氧自由基破坏 ULK 介电薄膜。
6)淀积 TiN 硬掩膜版层。利用PVD淀积一层厚度约为300A的TiN。通入气体 Ar 和N2轰击Ti靶材,淀积 TiN 薄膜。TiN为硬掩膜版层和抗反射层。图4-268所示为淀积TiN的剖面图。
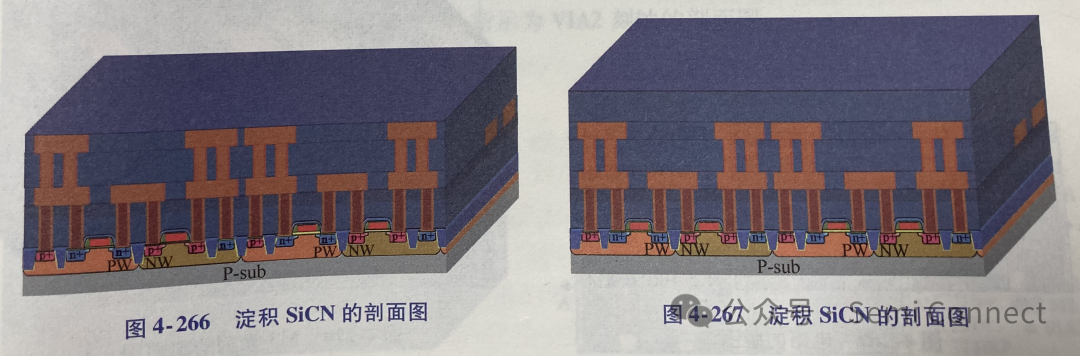
-
工艺
+关注
关注
4文章
720浏览量
30397 -
材料
+关注
关注
3文章
1593浏览量
28695 -
刻蚀
+关注
关注
2文章
224浏览量
13828
原文标题:IMD3 工艺-----《集成电路制造工艺与工程应用》 温德通 编著
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
如何更改IMD700 WM_MOTOR_CONTROL_01斜坡速度?
TRF37T05的输出匹配电容的值对应不同的频率怎么计算?
DM8127上DMVAL算法IMD调用尝试。
请问AD9364芯片IIP3指标是如何测试出来的?
基于光载无线系统的非线性特征的两个不同源分析
一款满足WCDMA基站性能要求的不对称Doberty功率放大器设计
满足WCDMA基站性能要求的不对称Doberty功率放大器设计
如何通过SCPI的PNA-X IMD调平配置功率?
IMD模内注塑控制面板将是外壳界一匹黑马
带自适应控制的直放站线性功率放大器
IMD IML IMR IMF IME工艺的特点和区别
通用RF器件的邻道泄漏比(ACLR)来源
IMD4工艺是什么意思




 IMD3工艺是什么意思
IMD3工艺是什么意思






评论