近日,据韩国媒体报道,全球领先的半导体制造商三星即将在今年推出其高带宽内存(HBM)的3D封装服务。这一重大举措是三星在2024年三星代工论坛上正式宣布的,同时也得到了业内消息人士的证实。
三星的3D封装技术被誉为将彻底改变未来芯片制造的格局。据悉,该技术将为2025年底至2026年的HBM4集成铺平道路,预示着三星在内存和芯片封装技术领域的持续领先地位。
三星的3D封装技术平台名为SAINT(三星先进互连技术),它集成了三种不同的3D堆叠技术,以满足不同应用场景的需求。SAINT-S针对SRAM(静态随机存取存储器)进行优化,而SAINT-L则专为逻辑电路而设计。最令人瞩目的是SAINT-D,它允许在CPU或GPU等逻辑芯片之上堆叠DRAM(动态随机存取存储器),为高性能计算提供了前所未有的可能。
自2022年三星正式宣布推出SAINT-D以来,该公司一直在进行深入研究和技术开发。经过数年的努力,SAINT-D技术预计将在今年正式商用。这标志着三星作为全球最大内存制造商和领先代工厂的一个重要里程碑,也预示着整个半导体行业将迎来一场技术革命。
随着3D封装技术的普及和应用,未来的芯片将能够拥有更高的性能、更低的功耗和更小的体积。三星的这一创新技术无疑将推动整个行业的发展,为未来的智能设备、云计算和数据中心等领域带来更加出色的性能和能效表现。
-
半导体
+关注
关注
339文章
31292浏览量
266840 -
HBM
+关注
关注
2文章
435浏览量
15887 -
三星
+关注
关注
1文章
1782浏览量
34475
发布评论请先 登录

2D、2.5D与3D封装技术的区别与应用解析

浅谈2D封装,2.5D封装,3D封装各有什么区别?
HBM技术在CowoS封装中的应用
传三星 HBM4 通过英伟达认证,量产在即
曝三星S26拿到全球2nm芯片首发权 三星获特斯拉千亿芯片代工大单
突破堆叠瓶颈:三星电子拟于16层HBM导入混合键合技术




 三星将于今年内推出3D HBM芯片封装服务
三星将于今年内推出3D HBM芯片封装服务




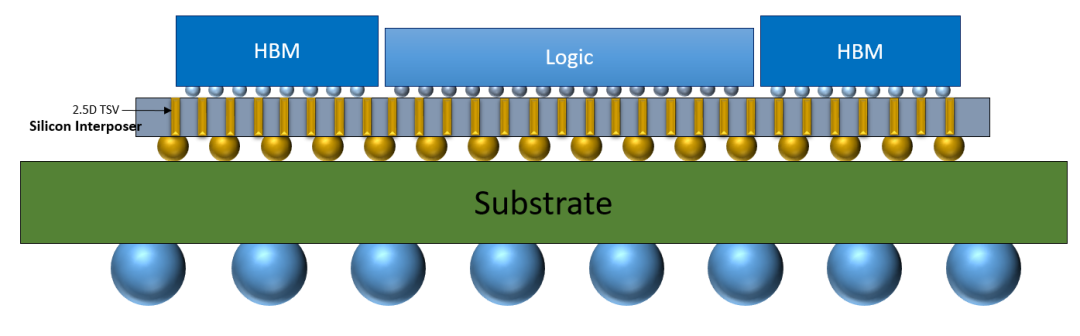



评论