共读好书

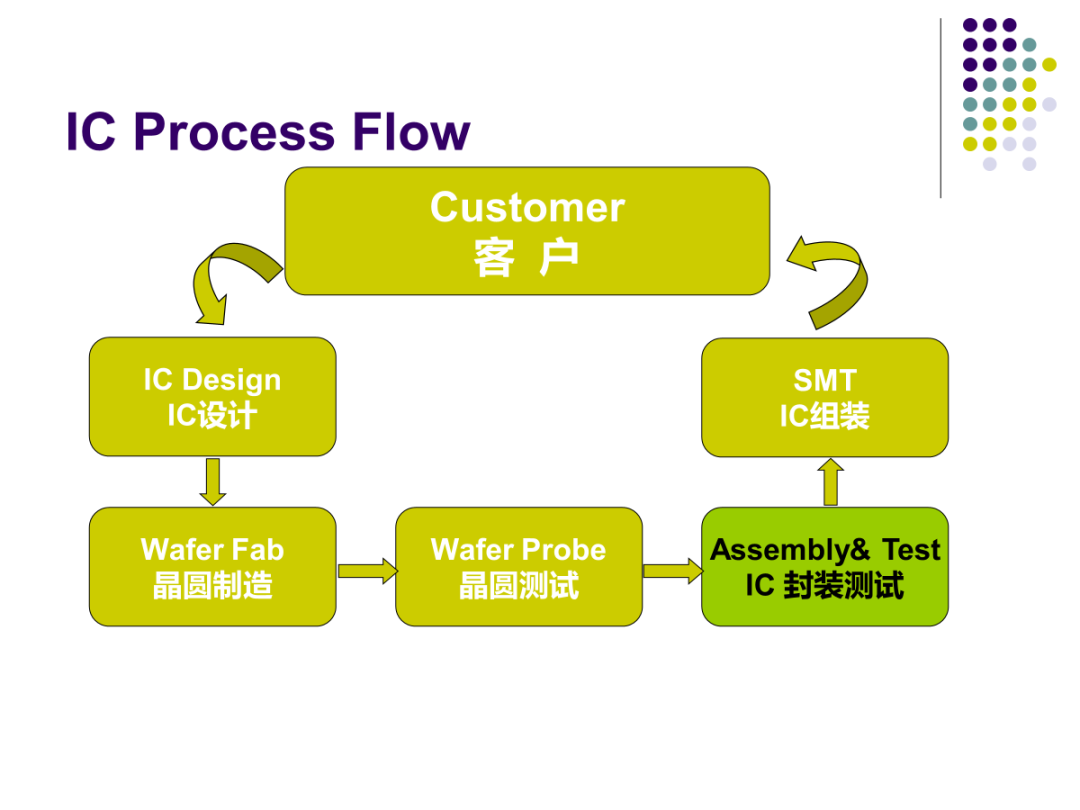


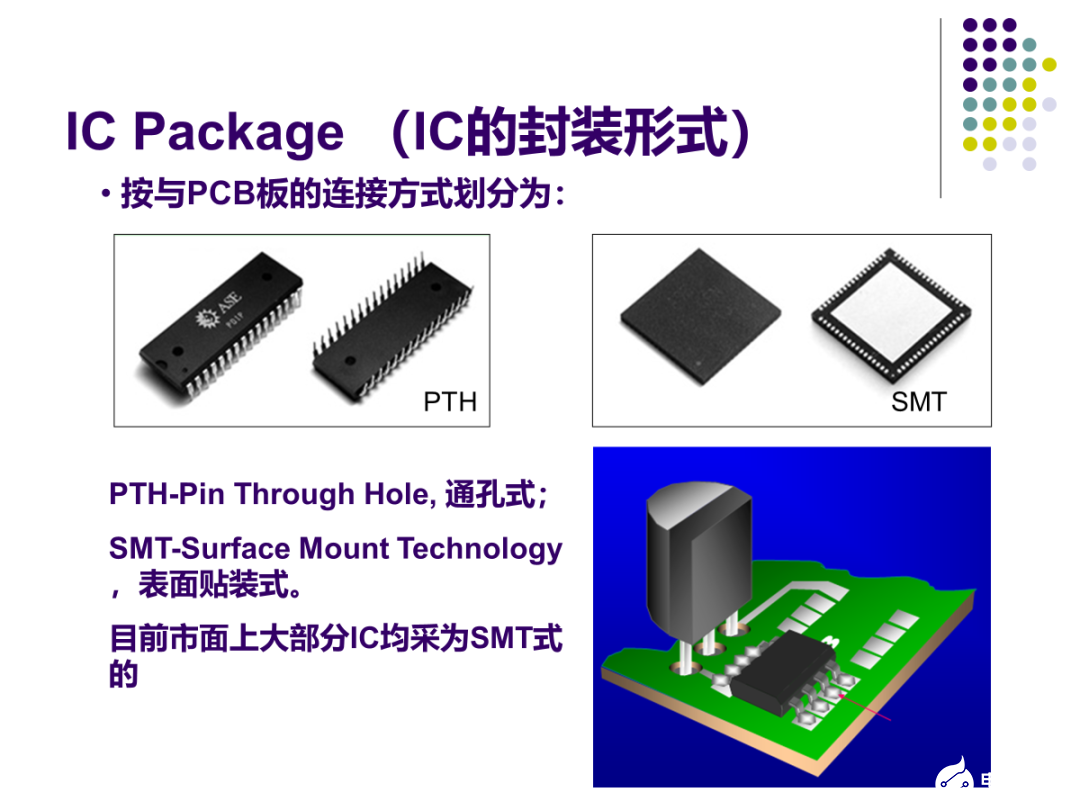


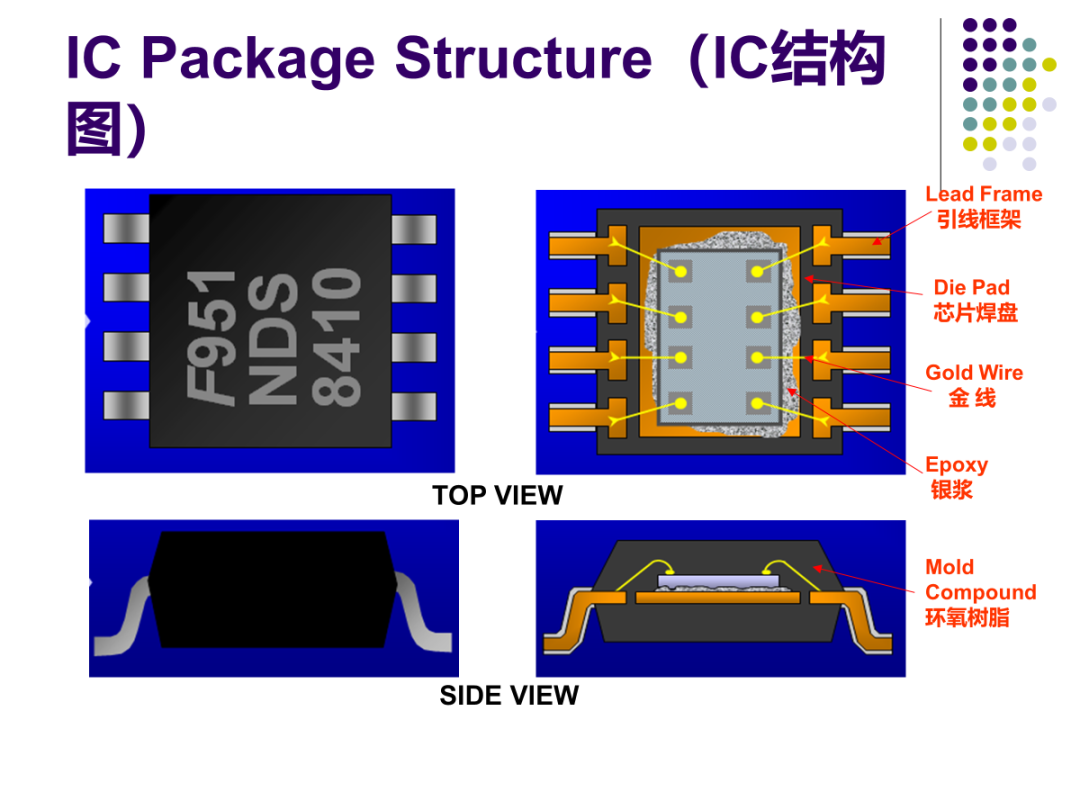

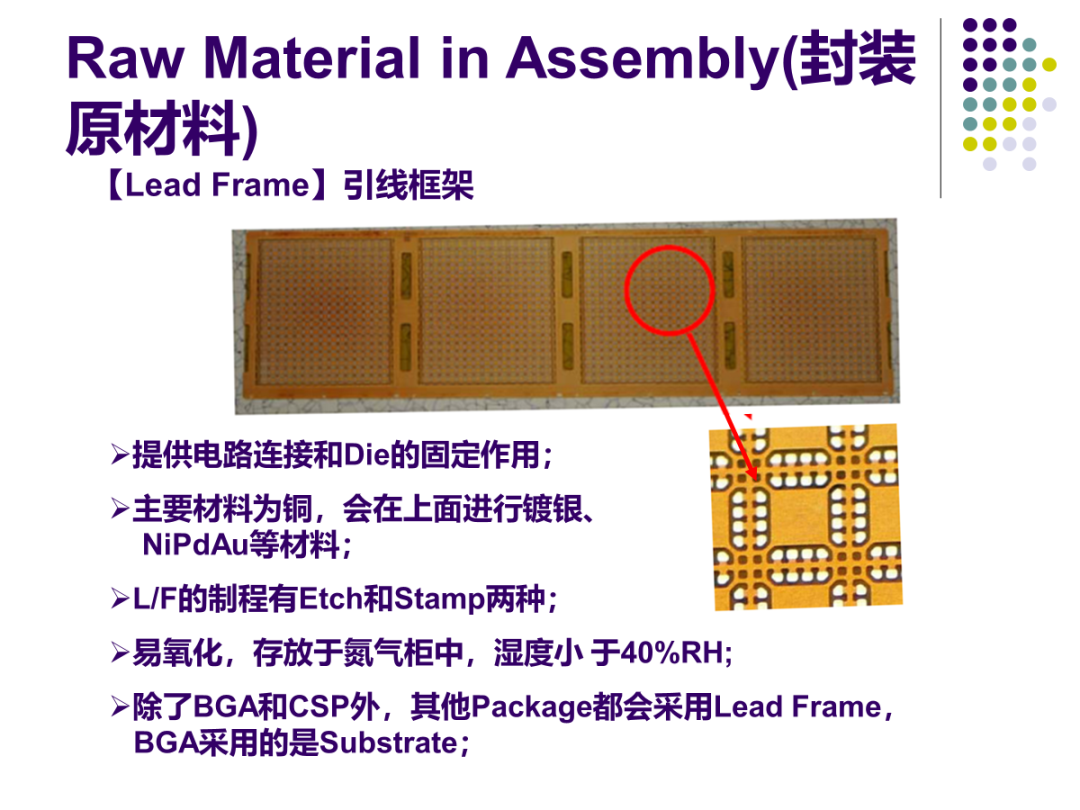



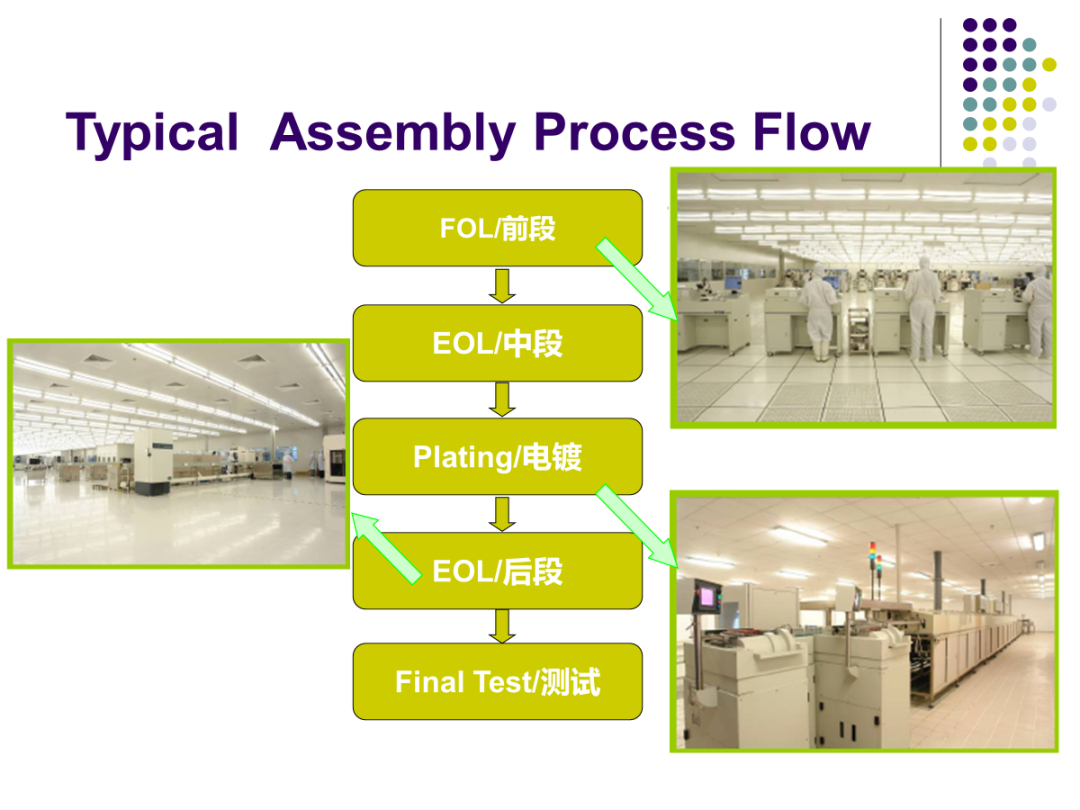
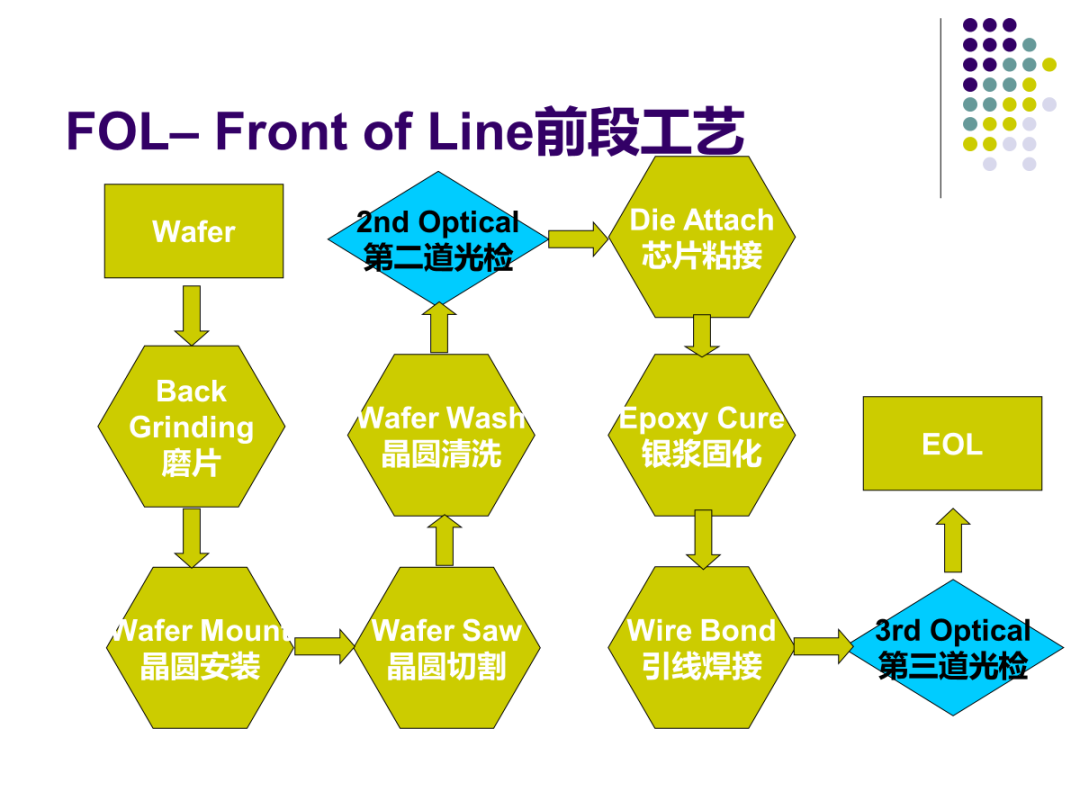
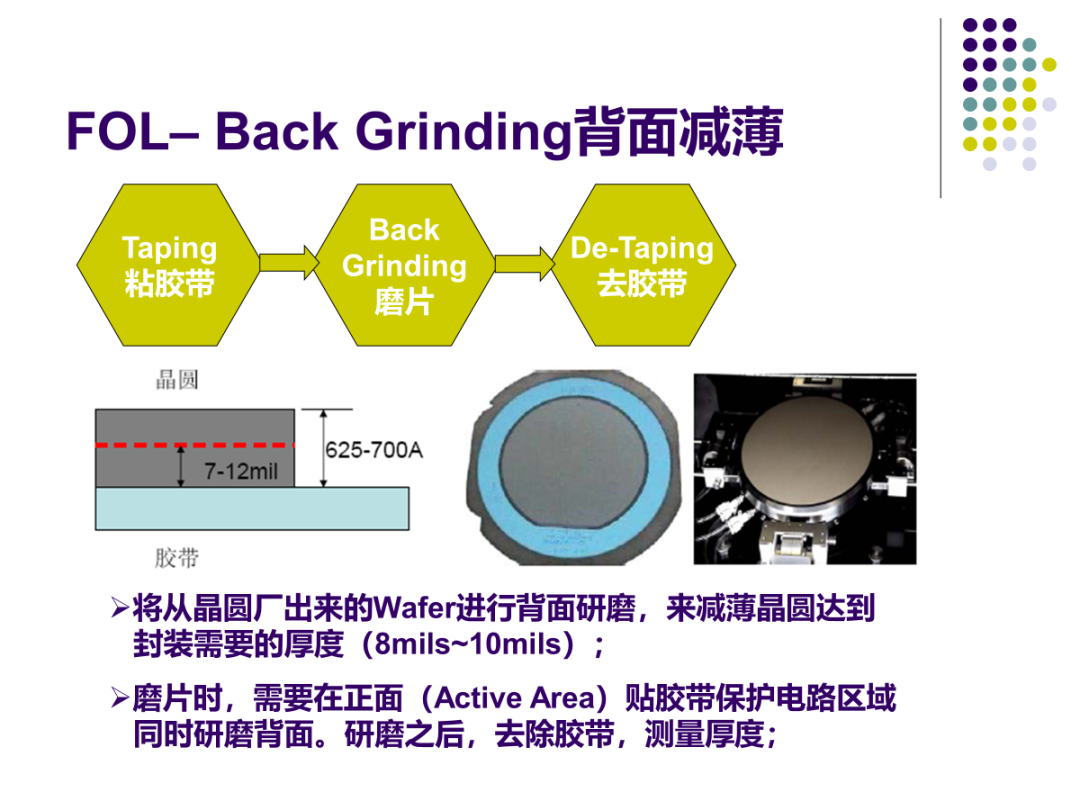
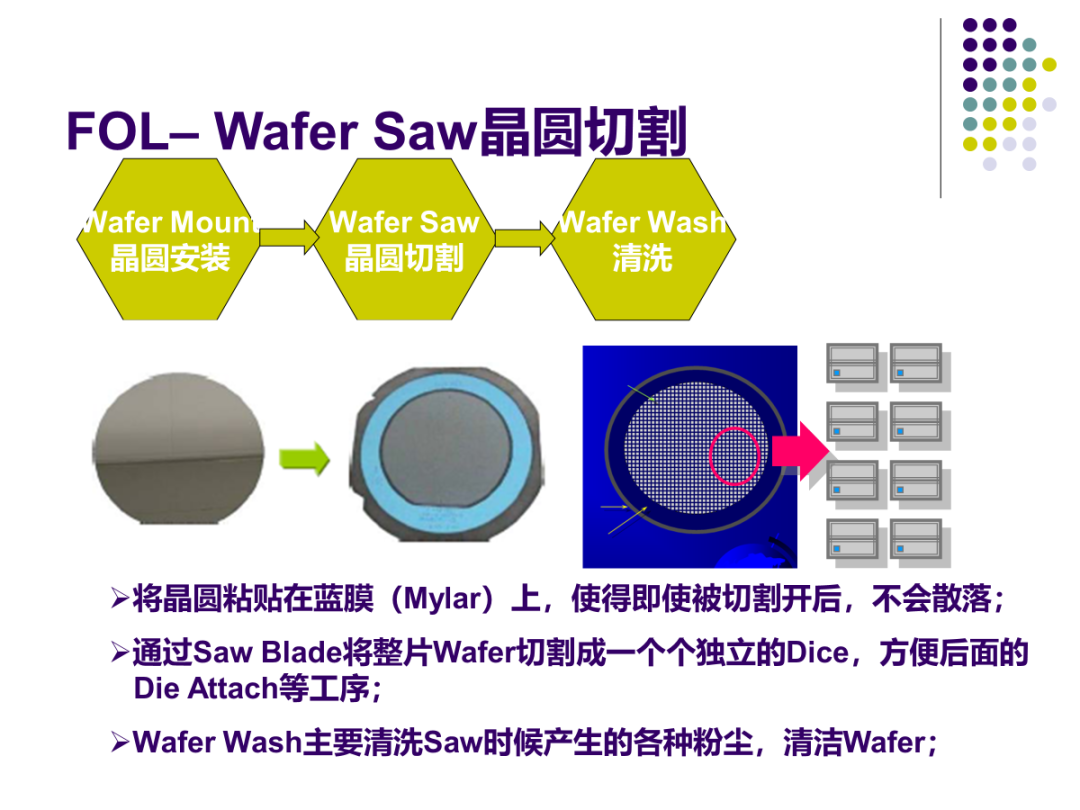




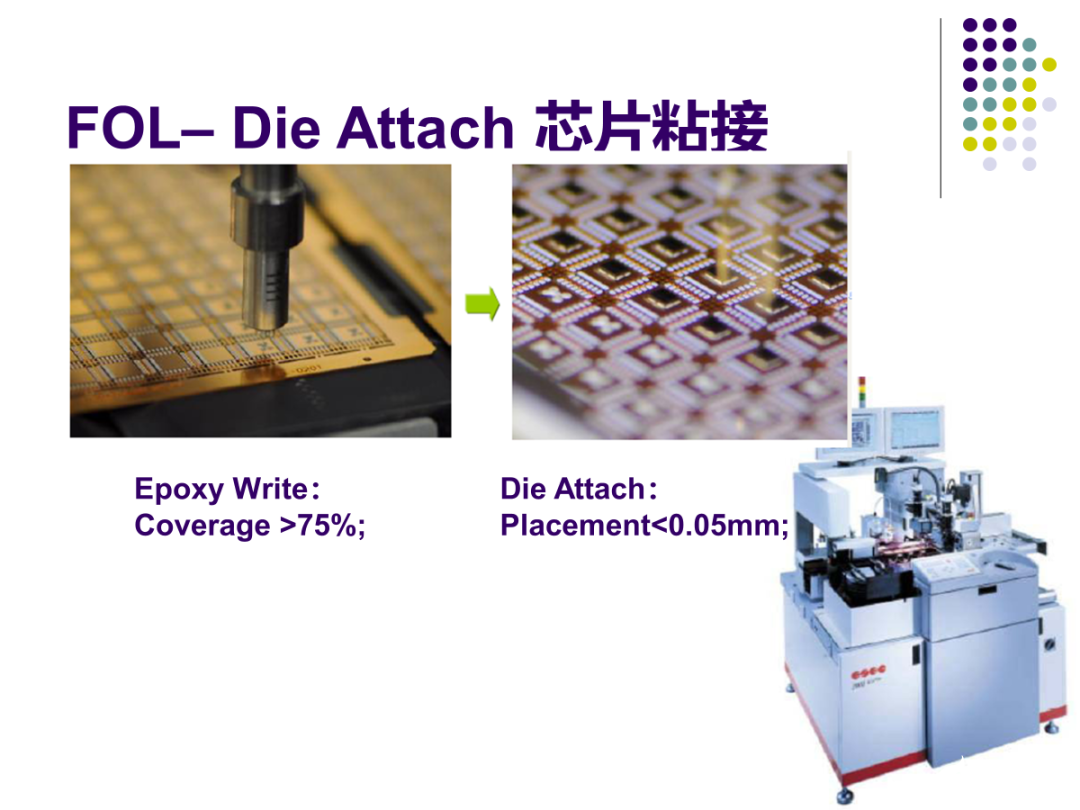





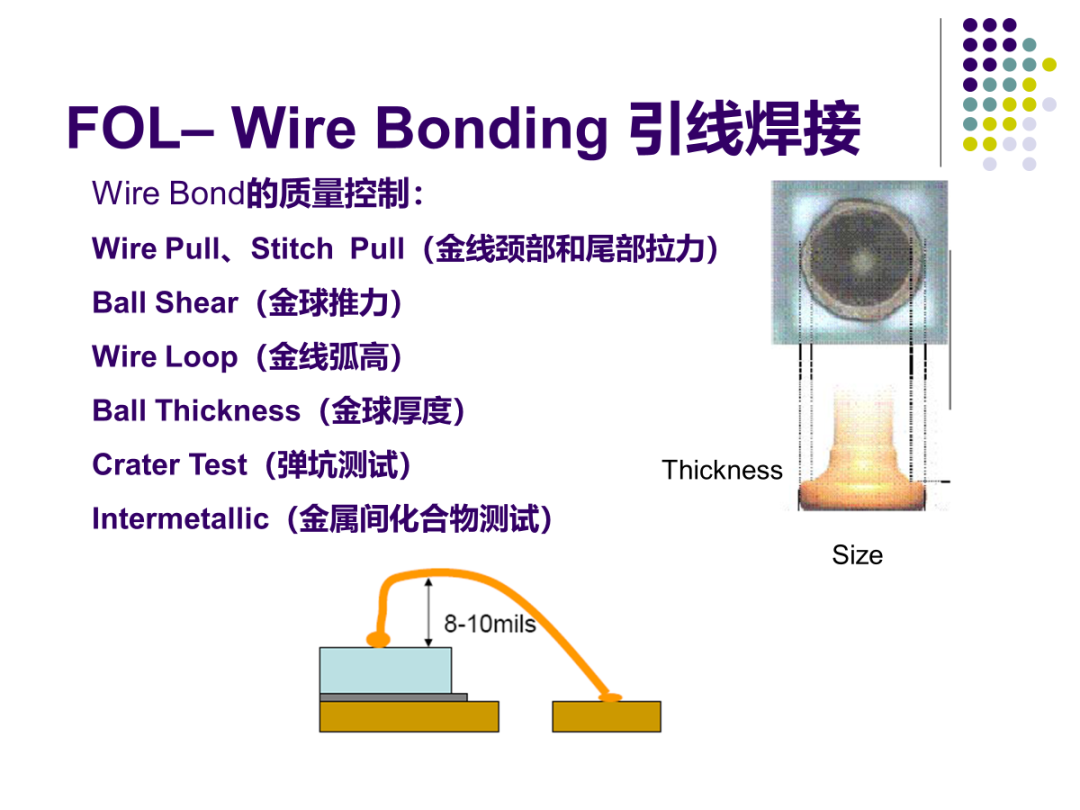

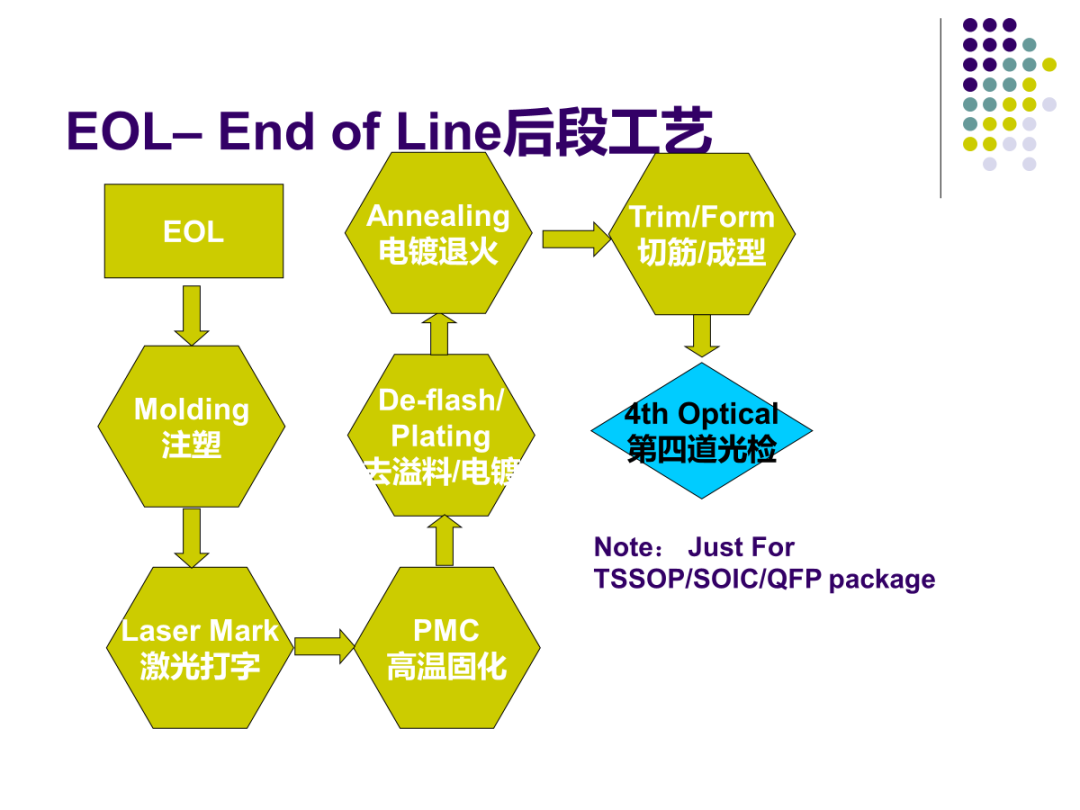
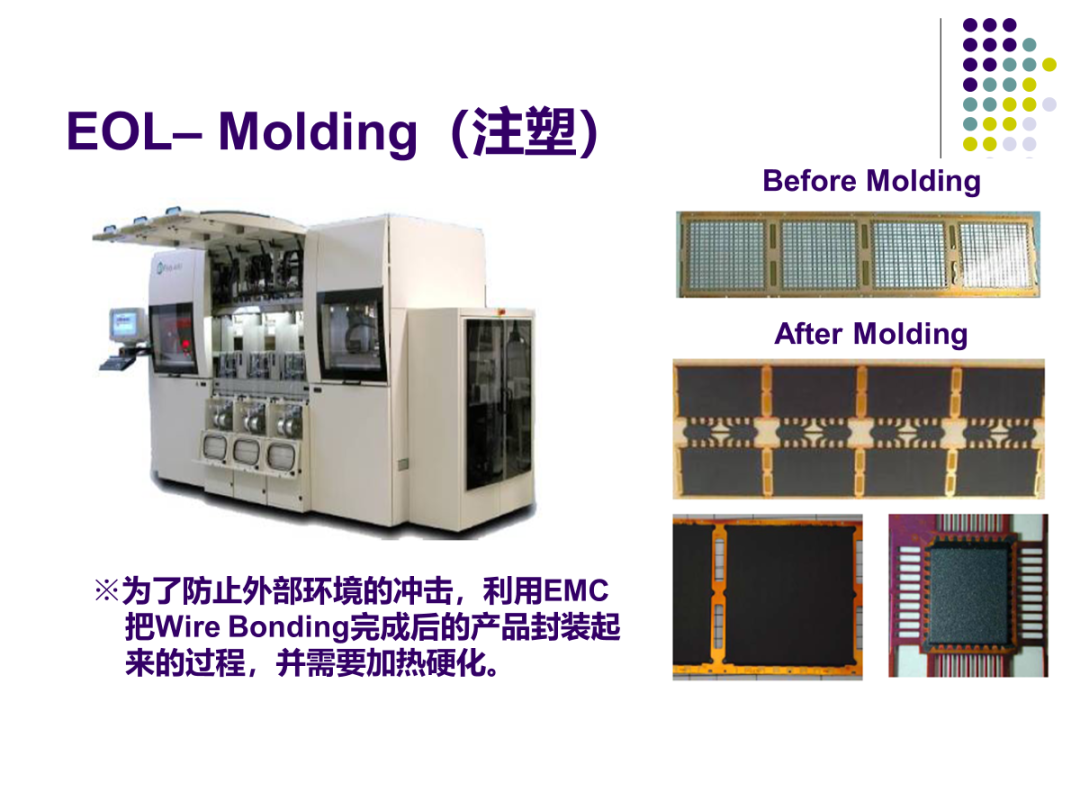
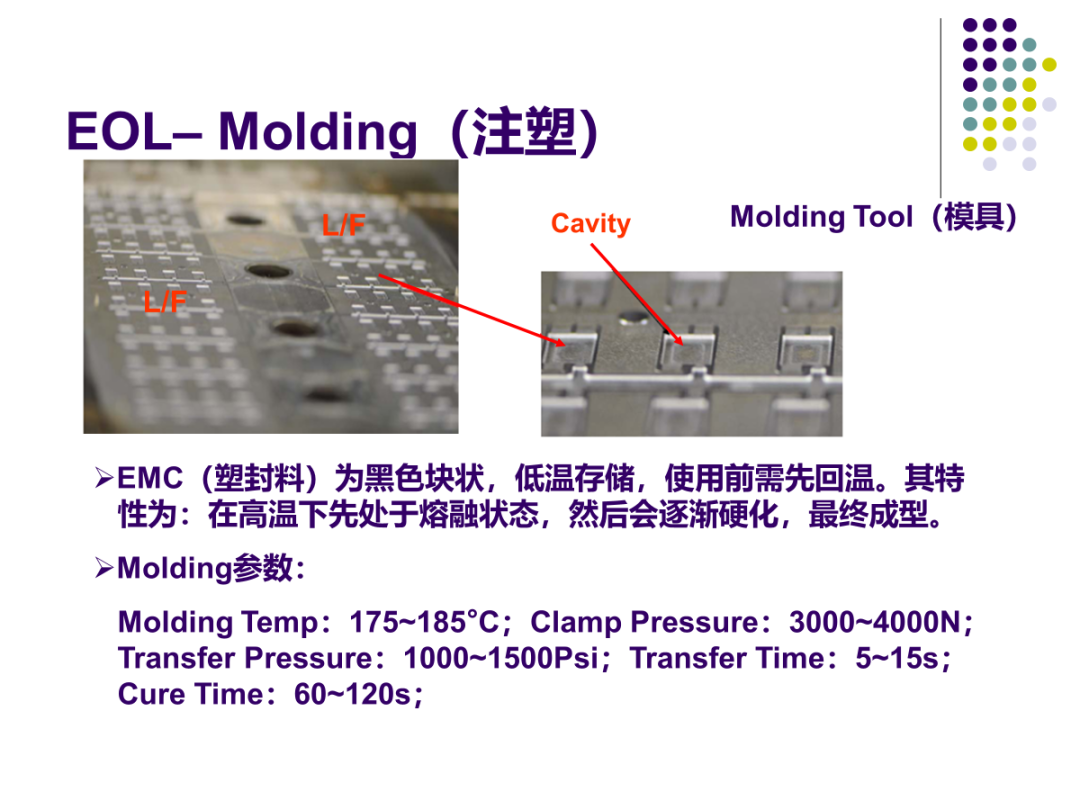
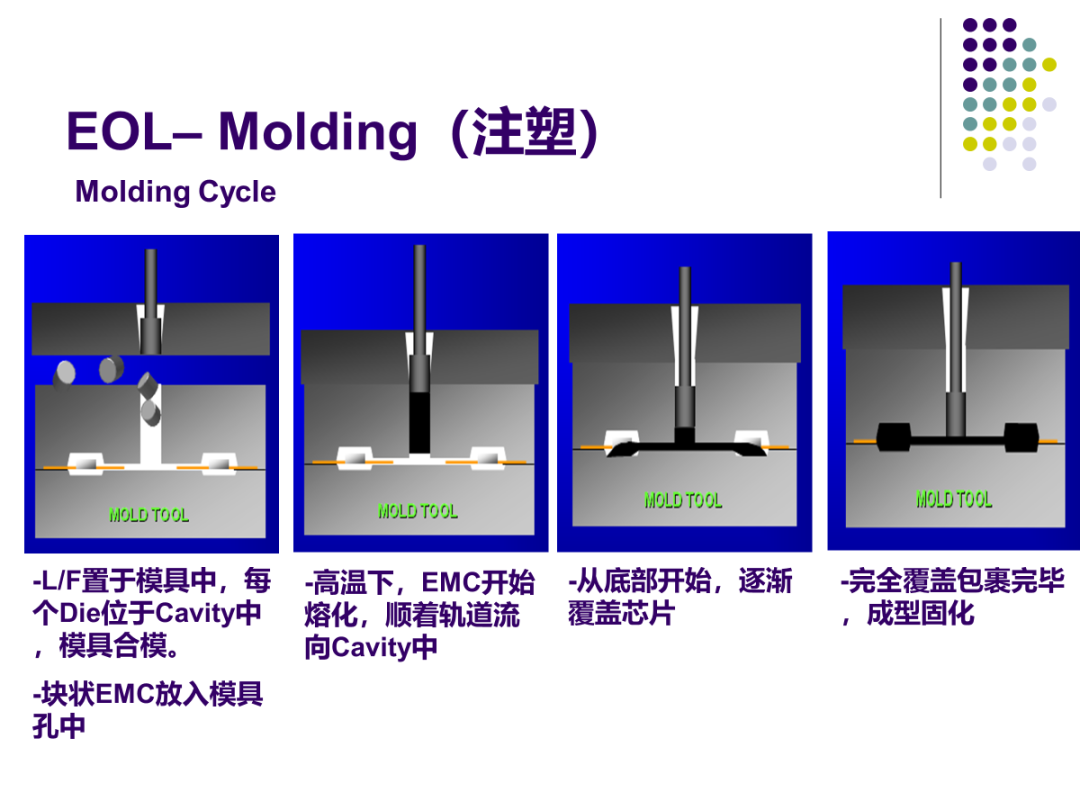
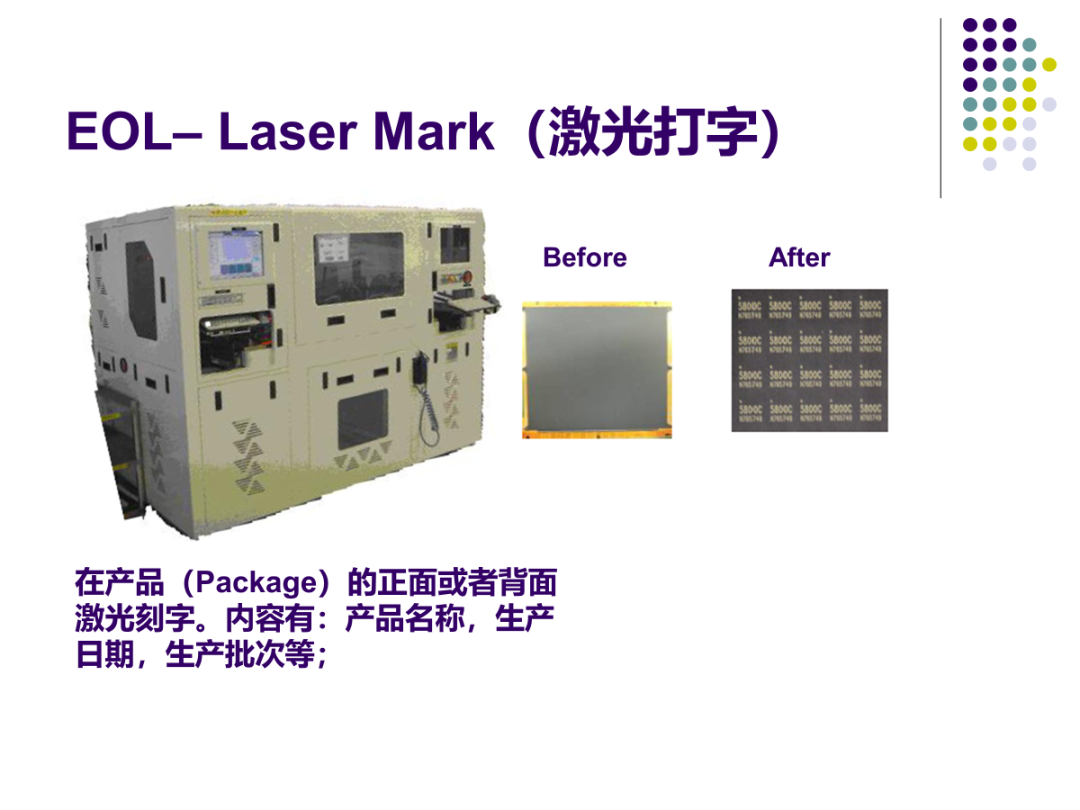
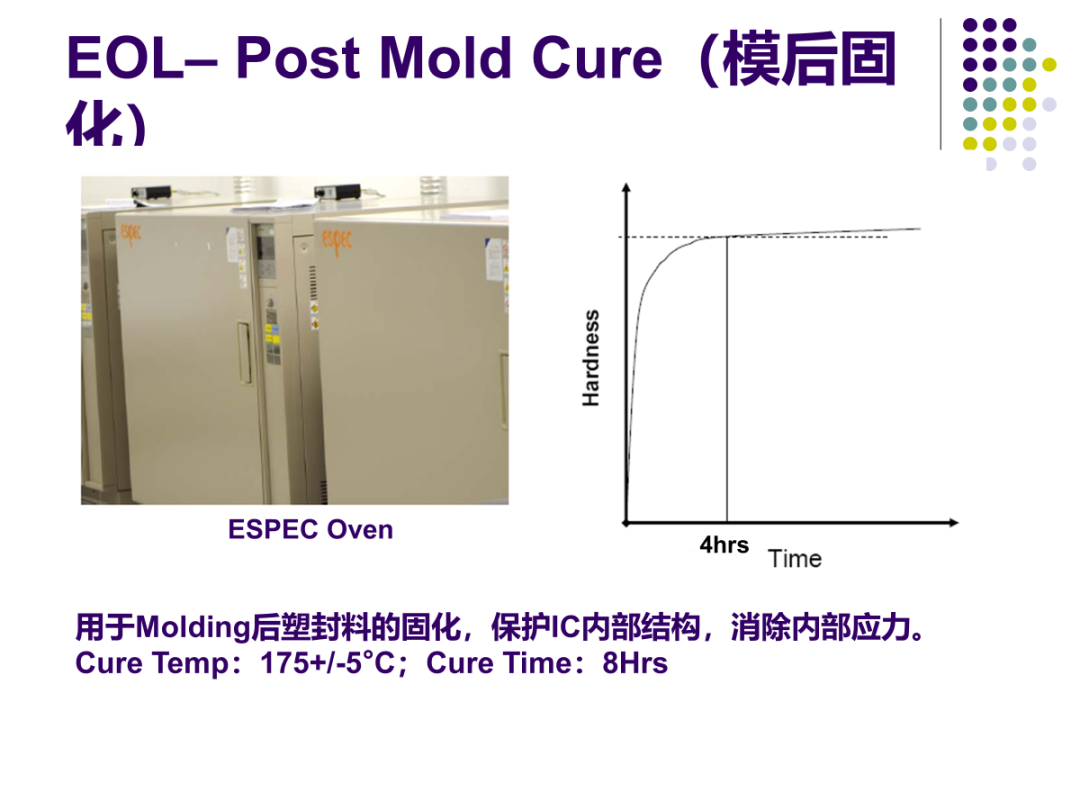
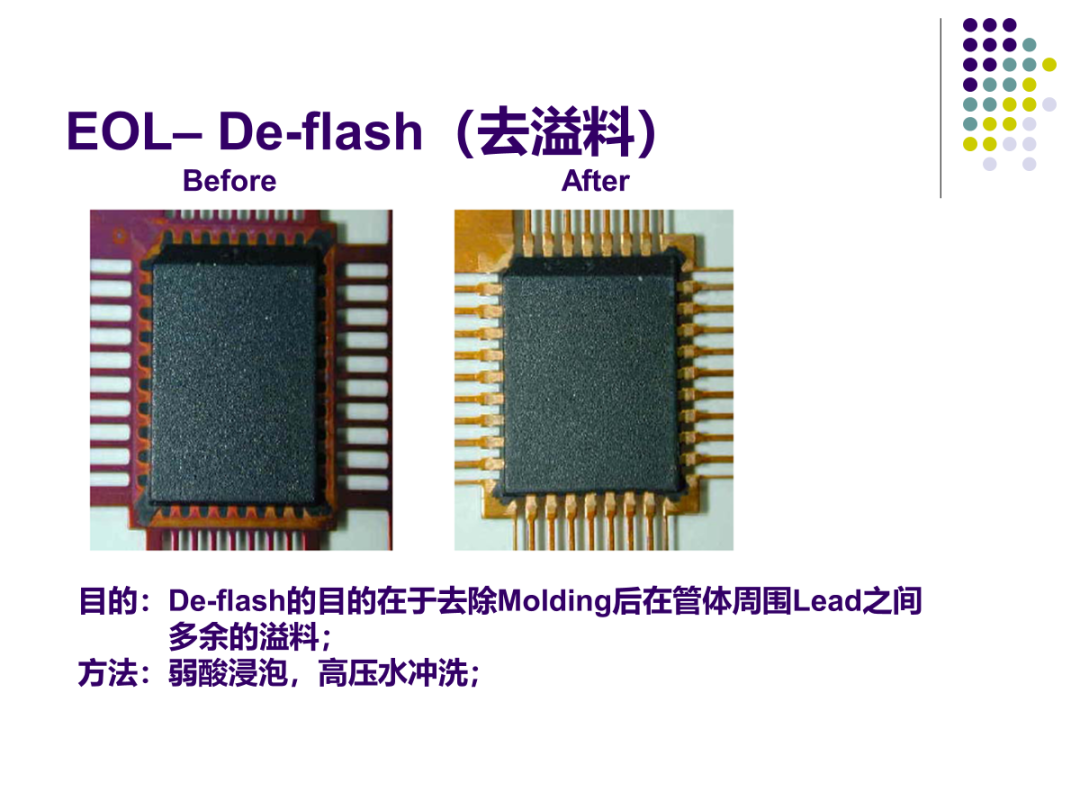
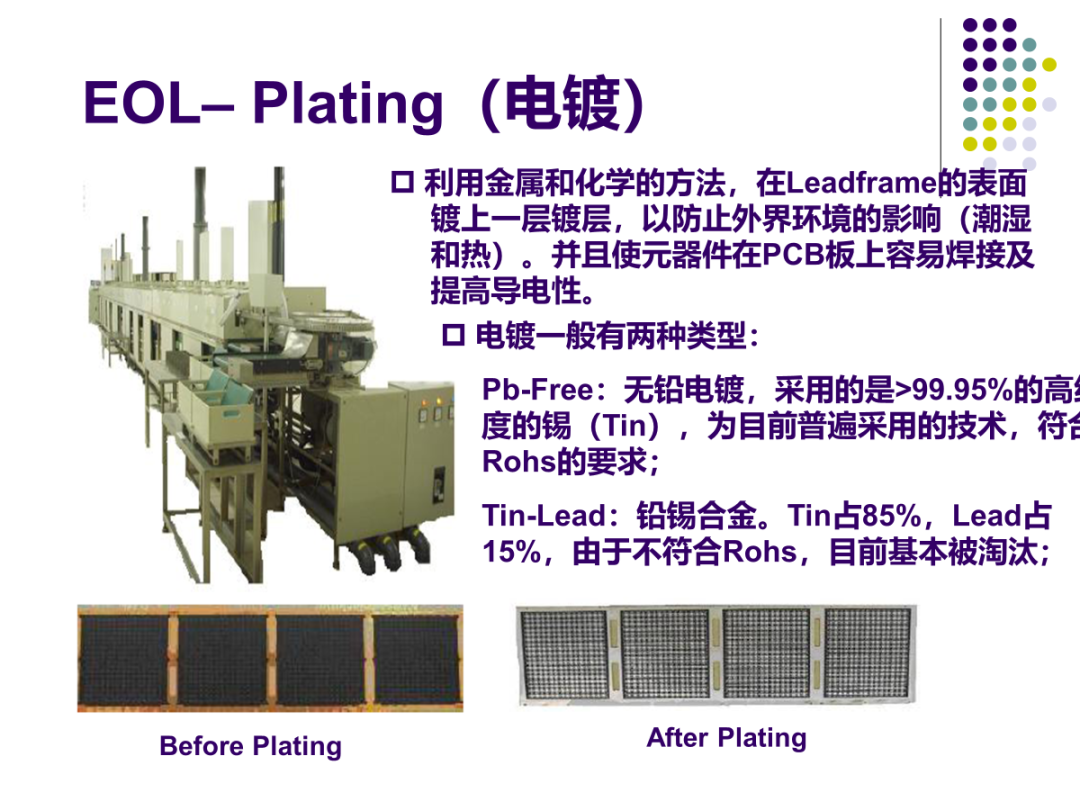
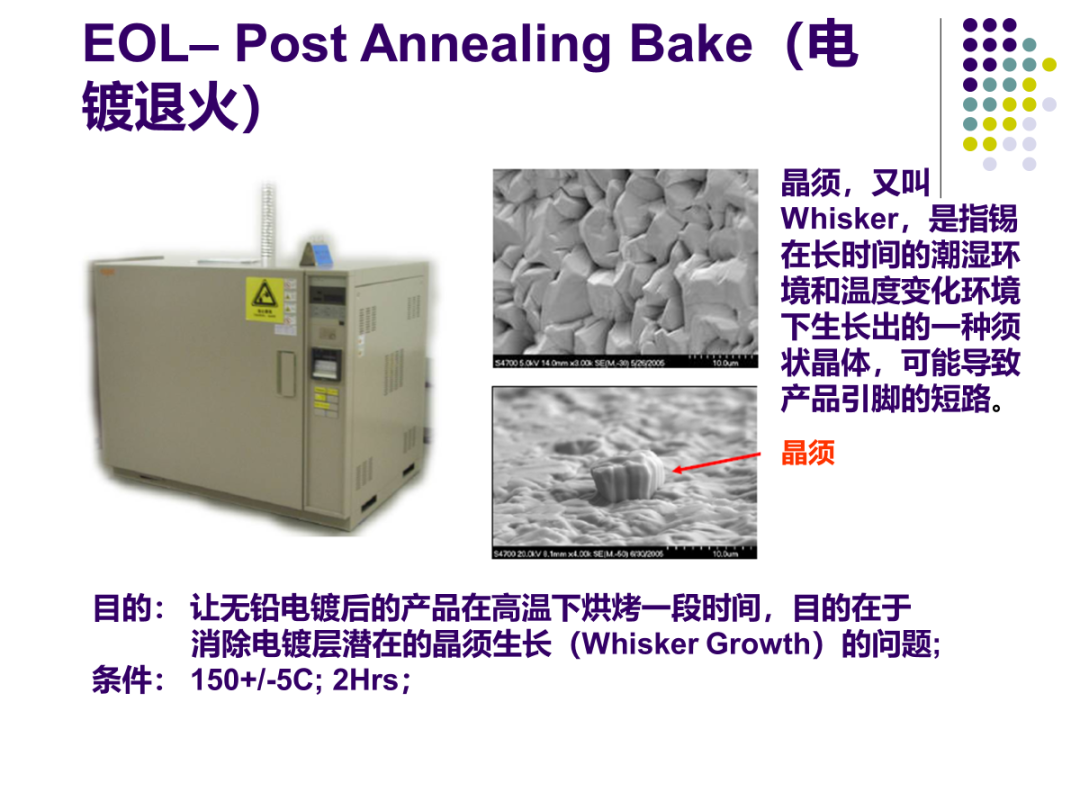




审核编辑 黄宇
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
IC封装
+关注
关注
4文章
197浏览量
27765
发布评论请先 登录
相关推荐
热点推荐
无源晶振三大封装工艺详解:金属焊封、玻璃封装与激光焊接的区别与应用
无源晶振的制造工艺正朝着高气密性、高小型化、高可靠性的方向演进。玻璃封装满足基础需求,金属焊封提供主流保障,而激光焊接还需要市场的验证。
在实际设计中,工程师应根据PCB空间、成本预算及终端环境(如温升和震动频率)来综合评估。

LED晶膜屏的FPC基材选型与COB封装工艺研究(源头厂家技术白皮书)
LED晶膜屏作为新型透明显示产品,其核心技术在于柔性基材、封装工艺和驱动方案。本文从工程实践角度,详细分析FPC基材的关键参数、COB封装的热管理、驱动IC的选型与调校,并给出可靠性测试数据。本文
双面散热IGBT功率器件 | 封装工艺
IGBT全称为绝缘栅双极型晶体管,特点是可以使用电压控制、耐压高、饱和压降小、切换速度快、节能等。功率模块是电动汽车逆变器的核心部件,其封装技术对系统性能和可靠性有着至关重要的影响。传统的单面冷却

CoWoS(Chip-on-Wafer-on-Substrate)先进封装工艺的材料全景图及国产替代进展
这张图是CoWoS(Chip-on-Wafer-on-Substrate)先进封装工艺的材料全景图,清晰展示了从底层基板到顶层芯片的全链条材料体系,以及各环节的全球核心供应商。下面我们分层拆解:一

85页PPT,看懂芯片半导体的封装工艺!
经过半导体制造(FAB)工序制备的电路图形化晶圆容易受温度变化、电击、化学和物理性外部损伤等各种因素的影响。为了弥补这些弱点,将芯片与晶圆分离后再进行包装, 这种方法被称为“半导体封装

云台驱动板拆装工艺与硬件结构拆解分析
云台驱动板作为姿态控制核心执行单元,集成了功率驱动、主控逻辑、传感器接口、电源管理等功能模块,其结构设计呈现 “高密度布局、多维度固定、强热耦合” 特征。规范的拆装工艺是保障设备维修可靠性、结构
短距离光模块 COB 封装与同轴工艺的区别有哪些
在短距离光通信领域,光模块封装工艺直接影响产品性能、成本及应用场景适配性。COB 封装(Chip On Board,板上芯片封装)与同轴工艺作为两种主流技术,在结构设计、性能表现等方面

人工智能加速先进封装中的热机械仿真
为了实现更紧凑和集成的封装,封装工艺中正在积极开发先进的芯片设计、材料和制造技术。随着具有不同材料特性的多芯片和无源元件被集成到单个封装中,翘曲已成为一个日益重要的问题。翘曲是由封装材

SK海力士HBS存储技术,基于垂直导线扇出VFO封装工艺
垂直导线扇出(VFO)的封装工艺,实现最多16层DRAM与NAND芯片的垂直堆叠,这种高密度的堆叠方式将大幅提升数据处理速度,为移动设备的AI运算提供强有力的存储支撑。 根据早前报道,移动HBM通过堆叠和连接LPDDR DRAM来增加内存带宽,也同样采用了

TSV技术的关键工艺和应用领域
2.5D/3D封装技术作为当前前沿的先进封装工艺,实现方案丰富多样,会根据不同应用需求和技术发展动态调整,涵盖芯片减薄、芯片键合、引线键合、倒装键合、TSV、塑封、基板、引线框架、载带、晶圆级薄膜

传统封装与晶圆级封装的区别
在芯片制造的最后环节,裸片(Die)需要穿上“防护铠甲”——既要抵抗物理损伤和化学腐蚀,又要连接外部电路,还要解决散热问题。封装工艺的进化核心,是如何更高效地将硅片转化为功能芯片。
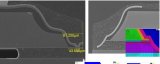



 IC封装工艺讲解
IC封装工艺讲解







评论