BGA混装工艺中,存在关于铅相扩散不完整的误区。随着全球无铅工艺的普及,大多数BGA器件已采用无铅工艺,但由于特殊需求部分企业仍使用有铅制程进行焊接。对于不涉及BGA器件的产品,其工艺可以完全按照有铅工艺进行操作。只有含有无铅BGA的有铅制程才属于真正的混装工艺。对此,业界存在不同的观点。
观点1:更换锡球派(SJ派)
此观点认为在无铅BGA用于有铅工艺时必须更换锡球,即清除原有的无铅锡球,替换为有铅锡球,并进行适当的清洁后再使用。
这种观点的好处是可以彻底执行
有铅工艺,但也存在不利因素:
1)清除无铅锡球并植入有铅锡球会造成两次热冲击,影响器件的寿命;
2)除球过程中可能导致BGA焊盘的脱落或损坏;
3)现在BGA器件的锡球数量极多,更换锡球会增加植球的不良率;如果是手工植球,则会耗时耗力。更糟的是,如果某个球的植球存在缺陷,而没有有效的BGA器件测试工具,则会增加焊的接困扰。
观点2:不更换锡球派(XJ派)
XJ派观点认为无需更换锡球,直接使用有铅锡膏进行焊接,称为混装工艺。XJ派混装工艺被认为是主流,但在内部也存在两种具体的细分观点。
一种观点认为,在无铅BGA中使用有铅锡膏焊接时,不需要担心无铅锡球是否熔化,可以完全按照有铅工艺进行操作。这是因为高铅BGA锡球不熔化,只有锡膏会熔化并润湿锡球,从而完成焊接。这种焊接方式的可靠性同样满足Class 3产品的要求。
另一种观点认为无铅BGA锡球应完全熔化,但为了降低器件本体热冲击影响,焊接温度曲线应在无铅工艺的下限和有铅工艺的上限之间。IPC-7350中建议混合工艺下BGA焊点的温度为228°C到232°C,实际上,同一颗BGA内部焊点和外部焊点的温度差异都会超过4°C。这种混合工艺的建议焊接温度曲线即熔融时间在60~90秒内,无铅BGA锡球的熔化时间及所受热能有限,会出现所谓的混合工艺铅相扩散不均匀的现象。

图1. ENIG混装工艺铅相向锡球内扩散
铅相扩散均匀与焊点可靠性
铅相扩散不均匀的现象是指已经熔化的有铅锡膏中的铅元素在BGA无铅锡球熔化后开始扩散进入锡球,铅在底部焊锡膏内,如图1所示。而铅相扩散均匀是指在完全熔化焊接完成的基础上,给予更多的热量和焊接时间,使金属原子混合更均匀,铅相扩散均匀。铅相扩散均匀的同时会产生较厚的IMC层,部分IMC过度生长可能会因基体无力承载导致焊点失效。

图2. 铅相均匀的混装工艺
那么,铅相扩散均匀是否代表焊点的强度和可靠性更高?还是铅相集中在PCB一侧使焊点可靠性更好一些?从逻辑上来说,有铅焊点的强度大于无铅焊点,而铅相扩散的不均匀并不会降低焊点的强度和可靠性。
需要指出的是,无论是铅相扩散均匀还是不均匀,焊点的可靠性都受到多个因素的影响,包括焊接温度曲线、焊接时间、焊接材料的特性等。同时,焊接工艺的控制、质量检测和可靠性测试也是确保焊点可靠性的重要环节。
在实际生产中,如果焊点的可靠性符合要求,没有发现焊接缺陷或故障,那么无需过分担心铅相扩散的均匀性或不均匀性。然而,如果产品出现焊点故障或不良问题,铅相扩散不均匀性可能成为问题的一个指示因素。
审核编辑 黄宇
-
工艺
+关注
关注
4文章
720浏览量
30395 -
混装
+关注
关注
0文章
4浏览量
6536 -
BGA
+关注
关注
5文章
586浏览量
51958
发布评论请先 登录
磁环电感选型:避开那些常见误区
云台驱动板拆装工艺与硬件结构拆解分析
变频器应用误区的探讨



GT-BGA-2002高性能BGA测试插座
解析LGA与BGA芯片封装技术的区别

高频混压板层压工艺
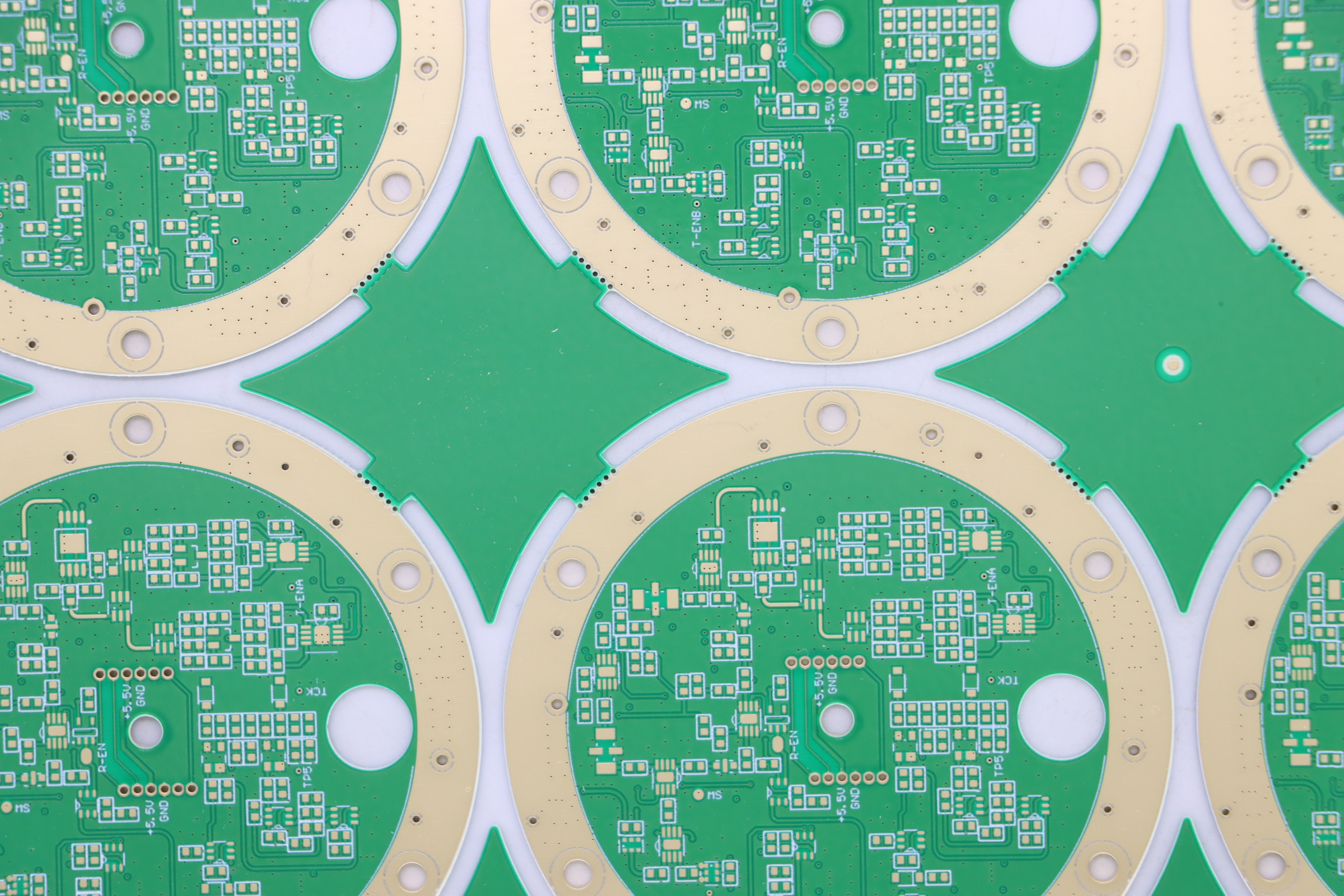
分析负载特性时,有哪些常见的错误或误区?
蓄电池运维的常见误区及解决方法

晶振常见封装工艺及其特点

半导体封装工艺流程的主要步骤




 常见的BGA混装工艺误区分享
常见的BGA混装工艺误区分享





评论