4 月 19 日,韩国 SK 海力士发布声明,已与中国台湾地区的台积电签署谅解备忘录(MOU),共同推进高带宽内存(HBM)技术的下一代研发及封装应用。预计于 2026 年实现 HBM4 的量产。
据协议内容,双方首先致力于提升 HBM 封装中的基础裸片(Base Die)性能。HBM 由多个 DRAM 裸片(Core Die)堆叠在基础裸片之上,再经由 TSV 技术进行垂直互连,基础裸片同时连接到 GPU,其重要性不言而喻。
自 HBM3E(第五代 HBM 产品)起,SK 海力士的 HBM 产品基础裸片均采用自家工艺生产;然而,从 HMB4(第六代 HBM 产品)开始,该公司将转用台积电的先进逻辑(Logic)工艺。
据悉,双方将密切合作,探索利用台积电的 CoWoS 技术封装 SK 海力士的 HBM 产品,以期在性能和效率等方面更好地满足客户对定制化(Customized)HBM 产品的需求。
今年 2 月,SK 海力士提出“One Team”战略,计划借助台积电构建 AI 半导体联盟,进一步强化其在 HBM 领域的领先地位。
展望未来,AI 半导体将从 HBM 时代的 2.5D 封装迈向 3D 堆叠逻辑芯片和存储芯片的新型高级封装。存储企业与芯片代工+高级封装企业的深度合作有助于推动相关研发进程。
-
DRAM
+关注
关注
41文章
2409浏览量
189778 -
封装
+关注
关注
128文章
9395浏览量
149237 -
gpu
+关注
关注
28文章
5335浏览量
136241 -
HBM
+关注
关注
2文章
438浏览量
15915 -
HBM4
+关注
关注
0文章
59浏览量
624
发布评论请先 登录
GPU猛兽袭来!HBM4、AI服务器彻底引爆!
SK海力士正式发布控温散热存储技术“iHBM”
AI加速器需求倒逼HBM4量产加速,三家国际存储巨头亮出进度表

SK海力士投资19万亿韩元在韩国建设先进封装厂
KV缓存黑科技!SK海力士“H³存储架构”,HBM和HBF技术加持!
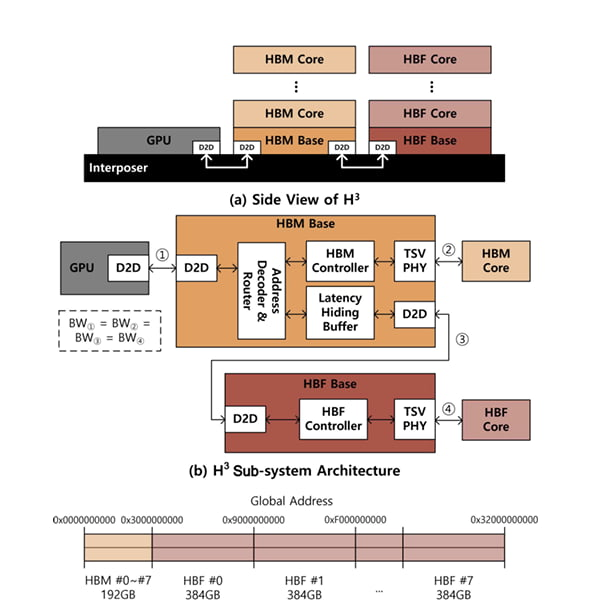



 SK海力士与台积电达成研发合作,推动HBM4和下一代封装技术发展
SK海力士与台积电达成研发合作,推动HBM4和下一代封装技术发展 






评论