文章来源“先进制程贴近物理极限,算力需求Chiplet迎来黄金发展期(精华)”,研究机构IBS 统计对比16nm至3nm 的单位数量的晶体管成本指出,随着制程工艺的推进,单位数量的晶体管成本的下降幅度在急剧降低。比如从 16nm 到 10nm,每10亿颗晶体管的成本降低了23.5%,而从5nm到3nm成本仅下降了 4%。 随着先进制程持续推进,单位晶体管所需要付出的成本降低的速度正在持续放缓,即意味着摩尔定律正在放缓。Chiplet 诞生背景是在摩尔定律放缓。
1、Chiplet 在成本、良率、设计灵活性等方面优势明显
Chiplet俗称“芯粒”或“小芯片组”,通过将原来集成于同一 SoC 中的各个元件分拆,独立 为多个具特定功能的 Chiplet,分开制造后再通过先进封装技术将彼此互联,最终集成封装 为一个系统芯片。 由于Chiplet芯粒可以独立设计和组装,因此制造商可以根据自己的需要来选择不同类型、不同规格和不同供应商的芯粒进行组合,很大程度上提高了芯片设计的灵活性和可定制化程度;并且制造商可以依赖于预定好的芯片工具箱来设计新产品,缩短芯片的上市时间。同时,Chiplet技术可以将大型 7nm 设计的成本降低高达 25%;在 5nm 及以下的情况下,节省的成本更大。
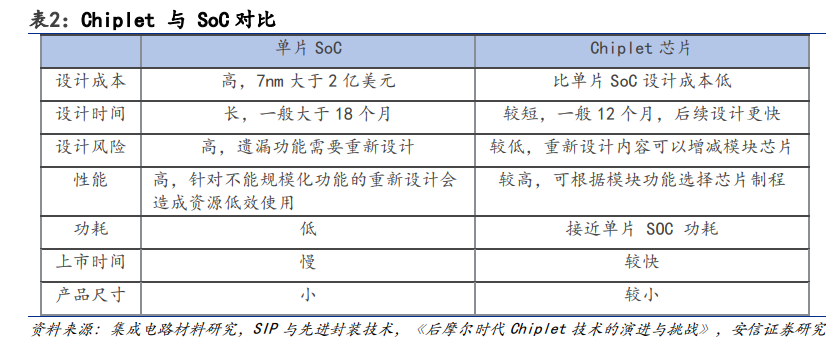
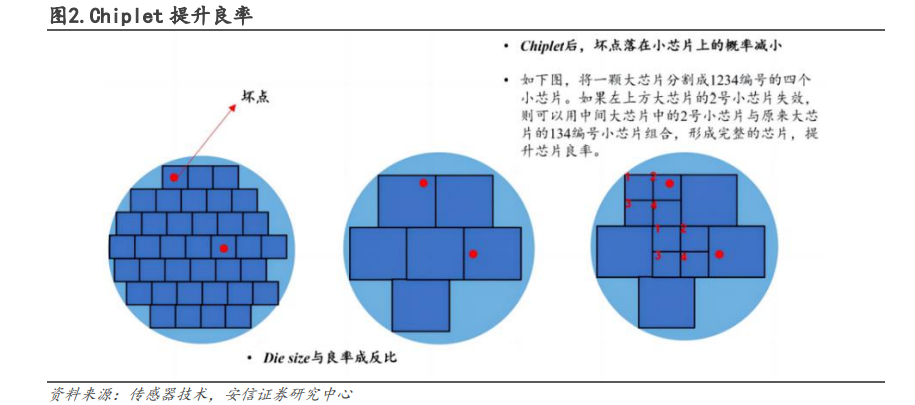
Chiplet 技术被视为“异构”技术的焦点,也是当下最被企业所认可的新型技术之一。2022年 3 月,英特尔、AMD、Arm、高通、三星、台积电、日月光、Google Cloud、Meta、微软等全球领先的芯片厂商共同成立了 UCIe 联盟,旨在建立统一的 die-to-die 互联标准,促进Chiplet 模式的应用发展,目前联盟成员已有超过 80 家半导体企业,越来越多的企业开始研发 Chiplet 相关产品。
2、Chiplet市场规模快速成长
根据 Gartner 数据统计,基于 Chiplet 的半导体器件销售收入在 2020 年仅为 33 亿美元,2022 年已超过 100 亿美元,预计 2023 年将超过 250 亿美元,2024 年将达到 505 亿美元,复合年增长率高达 98%。超过 30%的 SiP 封装将使用芯粒(Chiplet)来优化成本、性能和上市时间。

MPU占据Chiplet 大部分应用应用场景,Omdia 预测 2024 年用于 MPU 的 Chiplet 约占Chiplet 总市场规模的 43%。 随着 Chiplet 技术的发展,Chiplet 产业链各环节逐渐完善,即由 Chiplet 系统级设计、EDA/IP、芯粒(核心、非核心、IO Die、Base Die)、制造、封测组成的完整 Chiplet 生态链。

Chiplet产业链主链有四大环节,包括芯粒、芯片设计、封装生产和系统应用,支撑环节包括芯粒生产、设计平台、EDA 工具、封装基板、封测设备等领域。
3、IC 制造及封测厂加码布局Chiple
目前全球封装技术主要由台积电、三星、Intel 等公司主导,主要是 2.5D 和 3D 封装。2.5D 封装技术已非常成熟,广泛应用于 FPGA、CPU、GPU 等芯片,目前是 Chiplet 架构产品主要的封装解决方案。3D 封装能够帮助实现 3D IC,即晶粒间的堆叠和高密度互连,可以提供更为灵活的设计选择。但 3D 封装的技术难度更高,目前主要有英特尔和台积电掌握 3D 封装技术并商用。台积电比三星、英特尔更早采用 Chiplet 的封装方式。
1)、台积电3DFabric封装技术
台积电推出了3D Fabric,搭载了完备的3D硅堆栈(3D Silicon Stacking)和先进的封装技术。3DFabric 是由台积电前端 3D 硅堆栈技术 TSMC SoIC 系统整合的芯片,由基板晶圆上封装(Chip on Wafer on Substrate, CoWoS)与整合型扇出(Integrated Fan-Out, InFO)的后端 3D 导线连接技术所组成,能够为客户提供整合异质小芯片(Chiplet)的弹性解决方案。该项技术先后被用于赛灵思的 FPGA、英伟达的 GPU 以及 AMD 的 CPU。
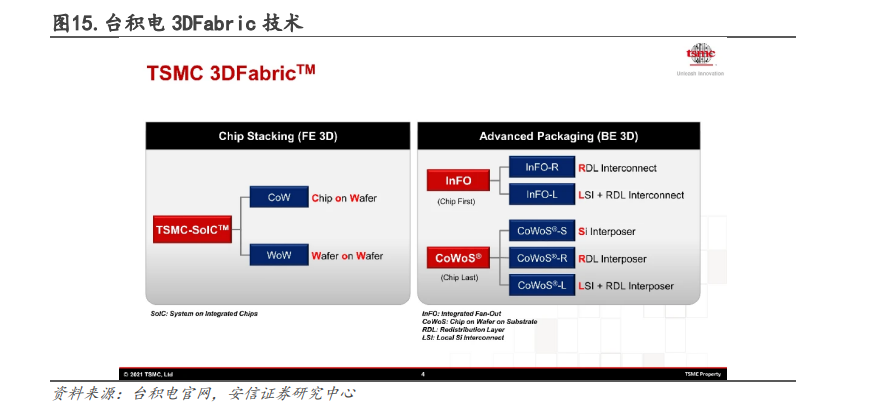
2)、Intel2.5D封装技术EMIB
Intel主导的 2.5D 封装技术为 EMIB,使用多个嵌入式包含多个路由层的桥接芯片,同时内嵌至封装基板,达到高效和高密度的封装。由于不再使用 interposer 作为中间介质,可以去掉原有连接至 interposer 所需要的 TSV,以及由于 interposer 尺寸所带来的封装尺寸的限制,可以获得更好的灵活性和更高的集成度。 相较于 MCM 和 CoWoS 技术,EMIB 技术获得更高的集成度和制造良率。英特尔对各种先进封装产品组合 (如 Foveros、EMIB 和 Co-EMIB) 的投资是实施公司新领导层所公布的 IDM2.0 战略的关键。
3)、三星X Cube 3D封装技术
三星也在积极投资先进的封装技术,以满足 HPC 应用在异质芯片整合的快速发展。2020 年 8 月,三星公布了 X Cube 3D 封装技术。在芯片互连方面,使用成熟的硅通孔 TSV 工艺。目前X Cube 能把 SRAM 芯片堆叠在三星生产的 7nm EUV 工艺的逻辑芯片上,在更易于扩展 SRAM 容量的同时也缩短了信号连接距离,提升了数据传输的速度。此后发布的 I-Cube 可以将一个或多个逻辑Die 和多个 HBM die 水平放置在硅中介层,进行异构集成。
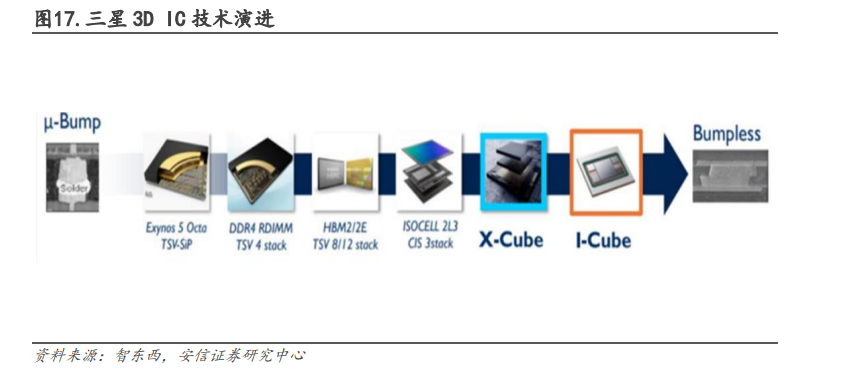
4)、日月光FOCoS先进封装技术
日月光凭借在FOCoS先进封装技术的布局,是目前在封测代工厂中唯一拥有超高密度扇出解决方案的供应商。日月光的 FOCoS提供了一种用于实现小芯片集成的硅桥技术,称为 FOCoSB(桥),它利用带有路由层的微小硅片作为小芯片之间的封装内互连,例如图形计算芯片(GPU)和高带宽内存(HBM)。硅桥嵌入在扇出 RDL 层中,是一种可以不使用硅中介层的 2.5D 封装方案。与使用硅中介层的 2.5D 封装相比,FOCoS-B 的优势在于只需要将两个小芯片连接在一起的区域使用硅片,可大幅降低成本。
5)、长电科技2.5D TSV-less封装技术
长电科技推出的面向Chiplet小芯片的高密度多维异构集成技术平台 XDFOI可实现 TSV-less 技术,达到性能和成本的双重优势,重点应用领域为高性能运算如 FPGA、5G、自动驾驶、智能医疗等。 XDFOI是一种以 2.5D TSV-less 为基本技术平台的封装技术,在线宽/线距可达到 2μm/2μm 的同时,还可以实现多层布线层,以及 2D/2.5D 和 3D 多种异构封装,能够提供小芯片(Chiplet)及异构封装的系统封装解决方案。目前长电先进 XDFOI 2.5D 试验线已建设完成,并进入稳定量产阶段,同步实现国际客户 4nm 节点多芯片系统集成封装产品出货。
-
封装技术
+关注
关注
12文章
605浏览量
69358 -
半导体器件
+关注
关注
12文章
810浏览量
34267 -
chiplet
+关注
关注
6文章
499浏览量
13643 -
先进封装
+关注
关注
2文章
561浏览量
1057
原文标题:百家争鸣:Chiplet先进封装技术哪家强?
文章出处:【微信号:架构师技术联盟,微信公众号:架构师技术联盟】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
高算力AI芯片主张“超越摩尔”,Chiplet与先进封装技术迎百家争鸣时代

百家争鸣 智能物联网应用未来如何发展
5G全新空口技术的挑战
六款主流电子电路仿真软件介绍
MWC国产手机百家争鸣 魅族下午5点亮底牌
半自动驾驶技术“百家争鸣”

国内AI芯片百家争鸣_如何抗衡全球技术寡头
工业机器人市场百家争鸣,未来前景良好
智能汽车产业的风口已经形成 智能车载系统百家争鸣

国内物联网:“百花齐放,百家争鸣”
多款5G集成手机芯片发布,产品百家争鸣,技术优势最强集成
先进封装Chiplet的优缺点与应用场景

政策助高端医械补齐短板,Medtec创新活动促品牌“百家争鸣”

大型储能技术路线百家争鸣,PCS控制到底怎么选?




 百家争鸣:Chiplet先进封装技术哪家强?
百家争鸣:Chiplet先进封装技术哪家强?




评论