博捷芯:半导体划片设备之脆性材料切割方式
单次划片,即一次完全划片硅片,切割深度达到UV膜厚的1/2,如下图所示。 该方法工艺简单,适用于切割超薄材料。 但刀具在切削过程中磨损严重,切削路径边缘易产生崩刃和毛刺。 由于磨削力的影响,材料的表面和亚表面容易产生裂纹等缺陷。
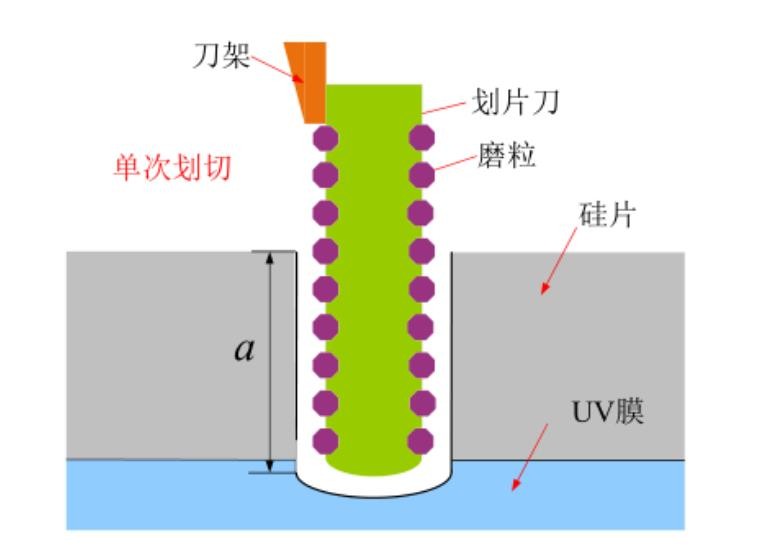
针对硬脆材料划切工艺存在的缺陷,本文提出分层划切工艺方法,如下图所示。 根据被切削材料的厚度,在切削深度方向采用分层(阶梯式)进给方式进行切削。 首先进行开槽切削,采用比较小的进给深度,保证对刀具的受力小,减少刀具。 磨损,减少切割线正面的崩边,然后沿第一条切割线继续切割。
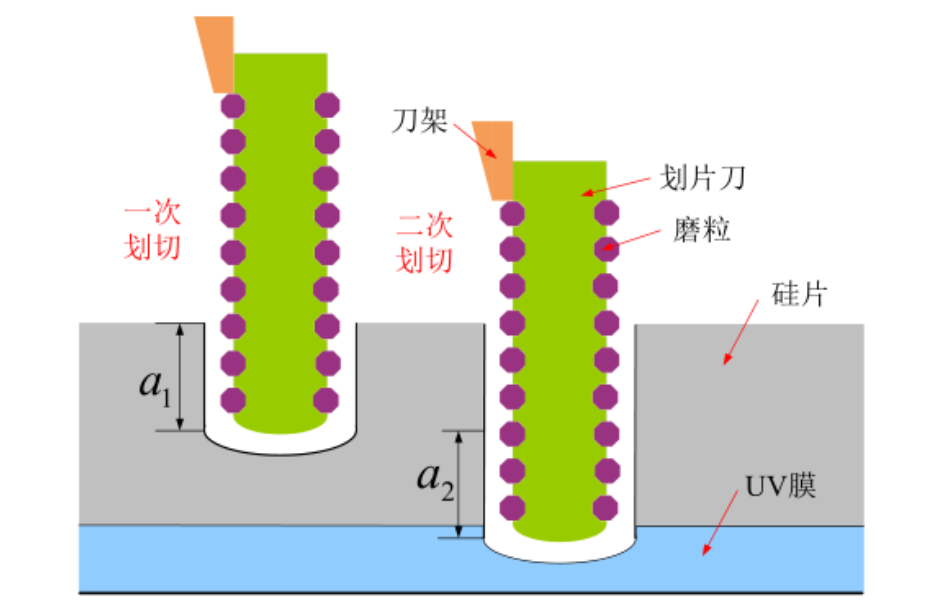
需要保证两种切割方式切割过程中切割膜的厚度。 切膜过深时,会切穿膜,导致工件板失去真空能力,无法固定硅片; 切膜过浅会造成硅片背面塌陷。 因此,严肃地说,切割过程必须保证最后切割的深度。

声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
半导体
+关注
关注
339文章
31470浏览量
267551 -
划片机
+关注
关注
0文章
205浏览量
11860
发布评论请先 登录
相关推荐
热点推荐
精准赋能 精密切割——博捷芯陶瓷划片机,解锁氧化铝氧化锆加工新高度
、稳定性和适配性提出了极高要求,传统切割工艺易出现崩边、裂纹、尺寸偏差等问题,严重影响产品良率与终端性能。为破解这一行业痛点,博捷芯(深圳)半导体

博捷芯精密划片方案赋能MEMS传感器与光电器件制造
精密划片机的刀片在压电陶瓷上划过,切割崩边始终稳定在5微米以内,相当于一根头发丝的十六分之一。在医学影像设备的核心部件——超声探头的制造领域,压电陶瓷材料的精密




 博捷芯:半导体划片设备之脆性材料切割方式
博捷芯:半导体划片设备之脆性材料切割方式








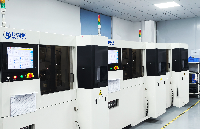






评论