我们知道,单颗芯片里集成的晶体管越变越多,
现已容纳超过500亿个,
这简直就是个天文数字。
眼看平面上即将无处安放,
是不是“纵向发展”更有机会呢?
没错!造芯片就好比盖房子。
传统的结构像是单层平房;
再高级点好似联排小区,
更先进就是摩天大楼了。
从2D到3D
以前,芯片的结构是单层的,
一个封装里通常只有一个裸芯,
通过引脚或焊球连接到电路板上,
为芯片提供电气和力学支持。

这种2D封装方式真香:
成本低、易制造、可靠性相当高。
然而,随着摩尔定律的发展和工艺的演进,
2D封装开始难以满足日益膨胀的性能需求。
开发者们脑洞大开,要不垂直堆叠多个裸芯试试?
这一叠,打开了新世界的大门。
三维短程垂直互连替代了二维长程互连,
不仅提高了信号传输速度,
还能降低功耗和成本。

至此,这种3D封装方式堪称封神,
可是新的麻烦又接踵而至。
由于多个裸芯堆叠在一个小空间中,
散热问题变得十分棘手,
可靠性问题也令人头秃。
为了解决这些难题,
将2D和3D封装的优势锻造融合,
一种全新的封装方式
“2.5D封装”闪亮登场。


2.5D封装通过一片中介层连结,
实现了多块裸芯的系统级封装。
3D封装则将多个裸芯纵向堆叠在一起,
利用垂直互连技术提高芯片的性能。
打个比方,2.5D结构就像平面版乐高像素画,
在一个底面上水平固定积木块;
3D结构则类似于立体版乐高积木,
把功能模块一层层垂直叠高高。

2.5D封装拥有较高的性价比,
出色的热管理,较短的开发时间,
实现了成本、性能和可靠性的平衡,
3D封装拥有超大带宽和更高性能,
广泛应用于高性能计算领域,
如数据中心、网络、服务器等。
3D结构的种种优点,

2.5D和3D都是先进的封装与集成方式,
但从2.5D到3D并不算迭代关系,
它们不是水火不容的竞争对手,
而是一对需求互补的“好丽友”,
在不同的应用场景里满足各种芯片的设计需求。
从3D向未来
人们对高维世界的探索从未止步。
盗梦空间里垂直的地面,
高高悬挂于地面的建筑,
都像极了未来的四维折叠城市。

由于地心引力等因素的存在,
4D折叠城市暂时还无法建造,
但4D芯片设计已不再是梦。
4D封装的概念并不难理解:
将多块基板弯曲和折叠,
每块基板上安装不同的芯片和器件,
连接方式也可以多种多样。
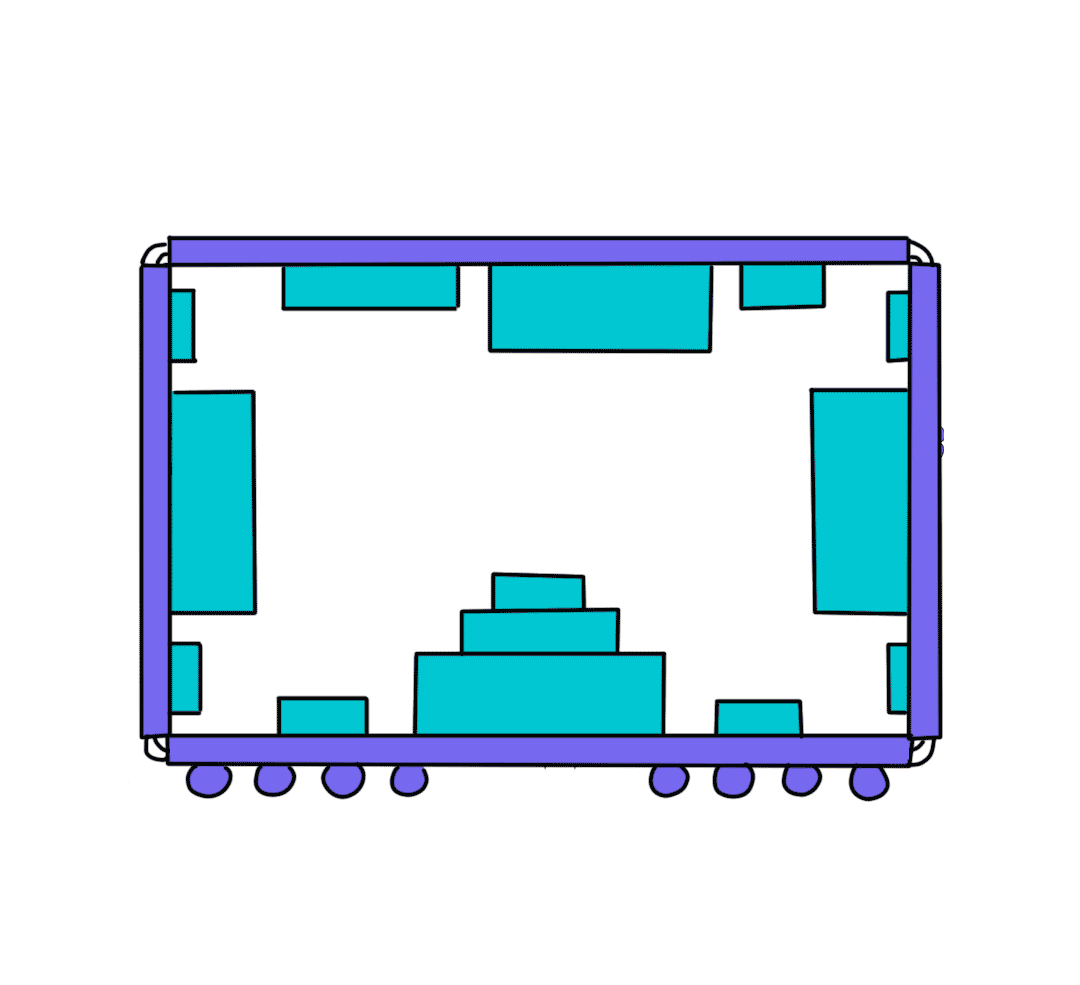
可以说,4D封装与集成就是集2D/2.5D/3D之大成,
不仅提供了更灵活的安装空间,
还解决了气密、抗震的问题,
在高温、高压等复杂环境中也毫无压力,
必定会在更多应用中大放异彩。

新思科技3DIC Compiler系统级协同设计统一平台
帮助开发者从多维度考虑设计策略,
不管是2D/2.5D/3D还是4D封装与集成,
3DIC Compiler统统都能搞定。
不仅减少了迭代次数,
还能提供功耗、热量和噪声感知优化,
轻松实现最佳PPAC目标,让产品闪电上市。

-
新思科技
+关注
关注
5文章
979浏览量
52989
原文标题:3D封装:芯片 “盖楼”大法好
文章出处:【微信号:Synopsys_CN,微信公众号:新思科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
2D、2.5D与3D封装技术的区别与应用解析

常见3D打印材料介绍及应用场景分析

浅谈2D封装,2.5D封装,3D封装各有什么区别?

【海翔科技】玻璃晶圆 TTV 厚度对 3D 集成封装可靠性的影响评估

玩转 KiCad 3D模型的使用

3D封装的优势、结构类型与特点

华大九天推出芯粒(Chiplet)与2.5D/3D先进封装版图设计解决方案Empyrean Storm

Chiplet与3D封装技术:后摩尔时代的芯片革命与屹立芯创的良率保障




 3D封装:芯片 “盖楼”大法好
3D封装:芯片 “盖楼”大法好







评论