是什么推动了Multi-Die系统的发展?由于AI、超大规模数据中心、自动驾驶汽车等应用的高速发展,单片片上系统(SoC)已经不足以满足人们对芯片的需求了。Multi-Die系统是在单个封装中集成了多个裸片或小芯片(chiplets),因此系统规模十分庞大和复杂,但对于解决不断趋近极限的摩尔定律和系统复杂性挑战而言,Multi-Die无疑是非常不错的方案。
Multi-Die系统内部各组件之间相互依赖,虽然在流片之前的步骤与SoC相似,但若想实现出色的PPA,就必须从概念到生产进行全局性的开发,从非常全面的角度完成整个过程。
- 如何才能确保Multi-Die系统按预期运行?
- 如何高效地完成相关工作?
- 从系统角度看,从设计探索到现场监测,需要考虑的关键步骤都有哪些?
今天就与各位开发者一起讨论下这几个问题。
适用于单片片上系统的技术未必适合Multi-Die系统架构。幸运的是,支持Multi-Die系统的生态系统正在迅速走向成熟,为设计团队提供了各种工具来实现这些系统具备的优势:
-
以经济高效的方式更快地扩展系统功能
-
降低风险并缩短上市时间
-
降低系统功耗并提高吞吐量
-
快速打造新的产品型号
一是分解法,即将一个大芯片分解成几个小芯片,与单个大芯片相比,这样可以提高系统良率并降低成本。这种方法适用于异构和同构设计。 二是将不同工艺的裸片进行组装,以达到优化系统功能和性能的目的。这类系统可能包含分别用于数字计算、模拟、存储和光学计算的裸片,并且每个裸片各自采用适合其目标功能的工艺技术。从长远来看,与大型单片片上系统相比,包含多个小裸片的设计能够显著提高制造良率。 硅中介层、重布线层(RDL)和混合键合封装等先进封装技术的出现为Multi-Die系统的发展铺平了道路。各项行业标准也在保障质量、一致性和互操作性方面发挥着重要作用,例如适用于高密度内存的HBM3和适用于安全Die-to-Die连接的UCIe。 Multi-Die系统的设计和验证流程也是一个挑战。在2D设计领域,团队通常只要完成自己的部分,然后将成果交给下一个团队即可。对于Multi-Die系统,团队需要一起应对各项挑战,合作分析功耗、信号完整性、邻近效应和散热等参数的相互影响。 不仅Multi-Die系统设计过程中需要全面考量整个过程,EDA公司在开发工具流程时也需要全面地思考。一个可扩展、可靠且全面的统一Multi-Die系统解决方案可以提高生产力,同时助力团队实现PPA目标并及时上市。 点击阅读原文,下载白皮书《Multi-Die系统如何推动电子设计变革:一种全面的异构晶粒集成方法》,进一步了解如何从Multi-Die系统的角度来阐述架构探索、系统实现、Die-to-Die连接、软件开发、验证、签核、芯片生命周期管理和测试等步骤。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
新思科技
+关注
关注
5文章
923浏览量
52631
原文标题:芯片革命:Multi-Die系统引领电子设计进阶之路
文章出处:【微信号:Synopsys_CN,微信公众号:新思科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
热点推荐
新思科技助力UCIe 3.0快速落地
芯片已从单一整体式芯片发展为集成多个芯粒的 Multi-Die 设计,其中每个芯粒都针对处理、内存和数据传输等特定功能进行了优化。
新思科技以AI驱动EDA加速Multi-Die创新
Multi-Die设计将多个异构或同构裸片无缝集成在同一封装中,大幅提升了芯片的性能和能效,因而在高性能计算(HPC)、人工智能(AI)、数据分析、先进图形处理和其他要求严苛的应用领域中至关重要。
新思科技UCIe IP解决方案实现片上网络互连
通用芯粒互连技术(UCIe)为半导体行业带来了诸多可能性,在Multi-Die设计中实现了高带宽、低功耗和低延迟的Die-to-Die连接。它支持定制HBM(cHBM)等创新应用,满足了I/O裸片
新思科技网页端虚拟原型工具的工作流程
片上系统(SoC)和基于芯粒的半导体的复杂性持续增长。随着Multi-Die架构、AI加速器和日益增加的内存带宽成为常态,在设计周期的早期解决性能和功耗问题变得尤为重要。
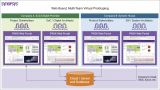
倾佳电子:SiC碳化硅功率器件革新混合逆变储能系统,引领能效革命
倾佳电子:碳化硅功率器件革新混合逆变储能系统,引领能效革命 功率半导体领域的技术变革,正在重塑新能源世界的能源转换效率边界。 全球能源转型浪潮下,混合逆变器和储能变流器(PCS)已成
HMC347A-Die单刀双掷(SPDT)
HMC347A-Die单刀双掷(SPDT)HMC347A-Die 是ADI生产制造的一款宽带、非反射式、砷化镓(GaAs)假晶高电子迁移率晶体管(pHEMT)单刀双掷(SPDT)单片微波集成电路
发表于 06-20 09:49
利用新思科技Multi-Die解决方案加快创新速度
Multi-Die设计是一种在单个封装中集成多个异构或同构裸片的方法,虽然这种方法日益流行,有助于解决与芯片制造和良率相关的问题,但也带来了一系列亟待攻克的复杂性和变数。尤其是,开发者必须努力确保

新思科技全新40G UCIe IP解决方案助力Multi-Die设计
随着物理极限开始制约摩尔定律的发展,加之人工智能不断突破技术边界,计算需求和处理能力要求呈现爆发式增长。为了赋能生成式人工智能应用,现代数据中心不得不采用Multi-Die设计,而这又带来了许多技术要求,包括高带宽和低功耗Die-to-Die连接。
新思科技助力晶圆代工厂迎接Multi-Die设计浪潮
过去几十年来,单片芯片一直是推动技术进步的主力。但就像工业革命期间,役畜被更高效强大的机器所取代一样,半导体行业如今也处于类似变革的阶段。
新思科技引领EDA产业革新,展望2025年芯片与系统创新之路
2024年,EDA(电子设计自动化)领域,被誉为“半导体皇冠上的明珠”,经历了前所未有的变革与挑战,特别是AI技术的迅猛发展,为EDA领域带来了深远的影响。在这一背景下,我们荣幸地邀请到了全球芯片到
利用Multi-Die设计的AI数据中心芯片对40G UCIe IP的需求
。为了快速可靠地处理AI工作负载,Multi-Die设计中的Die-to-Die接口必须兼具稳健、低延迟和高带宽特性,最后一点尤为关键。本文概述了利用Multi-Die设计的AI数据中心芯片
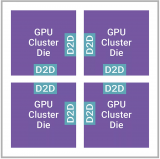
EMS网关引领能源监控领域智能化革命
应用案例EMS网关引领能源监控领域智能化革命在当今新能源技术日新月异的时代,能源监控系统的智能化和高效化成为了行业发展的必然趋势。英康仕EMS网关,作为一款专为分布式能源系统设计的边缘

新思科技Multi-Die系统如何满足现代计算需求
的处理需求。为此,我们不断创新工程技术,Multi-Die系统也应运而生。这种在单一封装中实现异构集成的技术突破,不仅带来了更优越的系统功耗和性能,还提高了产品良率,加速了更多系统功能





 芯片革命:Multi-Die系统引领电子设计进阶之路
芯片革命:Multi-Die系统引领电子设计进阶之路












评论