现代汽车中越来越多的电子功能必须在给定的空间内实现。这种空间限制导致印刷电路板(PCB)上的器件密度不断增加,因此需要缩小元件尺寸。然而,较小的封装需要在更小的占位面积上散发相同的热量,从而在电路板上实现更高的功率密度。DFN 封装具有紧凑的尺寸和热性能,是取代 PCB 上笨重的引线封装的正确选择。
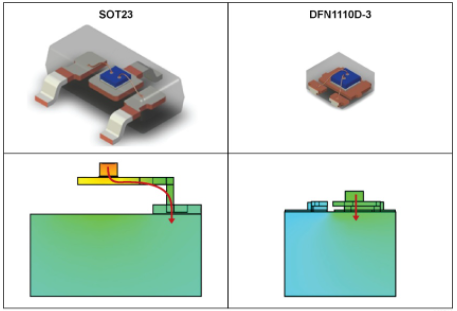
几十年来,引线SMD封装一直是分立电子设备的行业标准。也许最突出的封装结构是SOT23,其中芯片位于引线框架上,引线框架与金属焊盘一起完全封装。
这意味着热传导是主要的传热机制,因为在给定的结构和温度范围内,热对流和辐射几乎无关紧要。产生的热量通过芯片贴装层传导到引线框架中,然后从那里通过长引线流入PCB。图1显示了SOT23封装器件沿引线框架和封装中间的横截面,突出显示了热路径。
直达板
对于DFN1110D-3(Nexperia的DFN对应产品SOT23),没有外部引线。DFN 封装无引线且键合线长度较短,与引线封装相比,寄生电感更小。金属焊盘也更紧凑,更靠近引线框架。这样,封装尺寸显著减小,同时芯片下方的引线框尺寸仍相同。引线框架有效地用作封装底部的裸露散热器和电触点,允许热量直接从芯片流入PCB。
尽管DFN封装的尺寸非常紧凑,但它具有出色的功耗能力。然而, 使用具有低热阻和足够导热性的 PCB 是强制性的,以允许适当的横向散热.图2中的红外图片显示了高功率密度,显示了SOT23和DFN2020D-3在相同功率(250 mW)下消耗的比较。DFN2020D-3具有更高的功率密度和良好的耗散,尤其是在封装上没有白点的情况下。

SOT23 和 DFN 封装上的红外测量
DFN1110D-3 与 SOT23 的比较
在仿真测试中,使用具有 4 μm 厚铜 (Cu) 通道且环境温度为 35 °C 的标准 FR25 PCB,假设耗散功率为 250 mW,因此 SOT130 的结温为 23 °C,DFN115D-1110 的结温为 3 °C。DFN封装中芯片在给定耗散功率水平下的较低结温也可以用作额外的裕量,如果由于特定应用的可靠性标准而需要降低最大结温。在这里,该器件运行温度要低得多,同时可显著节省PCB空间。

DFN1110D-3(右)与SOT23(左)的热性能仿真。
实现出色导热性能的解决方案
符合汽车标准的DFN封装具有紧凑的尺寸,是替代PCB上笨重的引线封装的正确选择。密集的PCB带来的更高功率密度要求封装具有出色的热能力。得益于其裸露的散热器和优化的热路,DFN 封装满足了这一要求。但是,为了充分利用DFN封装,建议使用具有更高导热性的PCB类型。
审核编辑:郭婷
-
pcb
+关注
关注
4424文章
24027浏览量
427281 -
电路板
+关注
关注
140文章
5366浏览量
109382 -
散热器
+关注
关注
2文章
1145浏览量
39856
发布评论请先 登录
新ESD技术减小芯片的I/O尺寸
PCB提高中高功耗应用的散热性能
PQFN封装技术提高性能
电阻电容常见元器件的封装信息以及性能尺寸
影响单个LFPAK器件在不同配置的pcb上的热性能的因素
研究不同的模式对PCB设计热性能的影响
SIP封装和采用SiP工艺的DFN封装是什么
Nexperia发布超小尺寸DFN MOSFET

如何在采用 SOT563 封装的 TPS56x242-7 上实现更良好的热性能




 DFN封装如何在提供热性能的同时减小器件尺寸
DFN封装如何在提供热性能的同时减小器件尺寸






评论