光刻是半导体行业的核心技术。自仙童半导体公司的罗伯特诺伊斯在1960年发明单片集成电路以来,光刻技术一直是主要的光刻技术。
本质上,阴影掩模(shadow mask)用来协助一种称为光刻胶的光敏材料进行图案化,从而能够进行图案化沉积和蚀刻工艺。而光刻工艺的最终解决方案是由所用光源的波长决定的。
在开发更短波长的光刻源方面取得了进步。这使得以摩尔定律为特征的电路密度不断增加。历史上使用汞放电灯,例如 365 nm i-Line,但最近使用 248 nm 的 KrF 或 193 nm 的 ArF 准分子激光器成为首选光源。当使用液体浸没技术时,ArF 激光器获得的最终分辨率约为 50 nm,其中透镜和半导体晶片浸入水中,水中的折射率高于空气。
过去二十年见证了193 nm以下波长光刻技术的发展。在使用 F2 准分子激光器开发基于 157 纳米的光刻技术方面付出了一些努力,但主要关注点是使用 13.5 纳米软 X 射线作为光源的极紫外 (EUV) 光刻技术。
荷兰公司 ASML 在 EUV 技术的开发中发挥了主导作用,他们的工具集现在被包括英特尔、三星和台积电在内的主要先进 CMOS 代工厂用于生产。
光刻方法的实践
应用许多光刻方法来产生单芯片设计。TechInsights 最近对三星 5LPE 工艺进行了详细分析。图 1 显示了器件 CPU 逻辑区域中栅极和鳍片布局的平面图 TEM 图像。
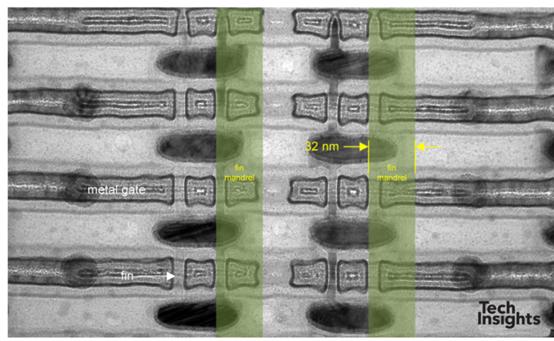
图 1:Samsung 5LPE Gate and Fin Layout
自对准四重图案化 (SAQP) 几乎可以肯定用于对鳍进行图案化。图像注释中显示了 fin mandrels的大致位置,该位置将使用 ArF 193 nm 浸入式 (ArF 193i) 光刻进行图案化。然后将通过在mandrel上创建 sidewall spacers来形成最终的 fin pattern。mandrel将具有 108 nm 的间距(pitch)。然后移除mandrel,然后使用第一个侧壁间隔物( sidewall spacer)图案来创建第二组侧壁间隔物,最终的鳍间距为 27 nm。
两组侧壁间隔物的大致位置和尺寸如图 2所示,这是一张横截面 TEM 图像,显示逻辑区域中三星 5LPE 工艺的 27 nm 间距鳍结构.
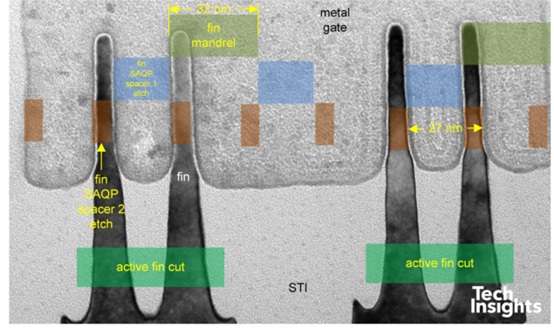
图 2:Samsung 5LPE Fin Cross Section
然后将使用有源鳍(active fin)切割掩模去除不需要的鳍并用浅沟槽隔离 (STI:shallow trench isolation) 替换它们。图 1中所示的金属栅极很可能是使用自对准双图案化 (SADP) 技术形成的,其中mandrel上的侧壁间隔物直接用于图案化多晶硅栅极,后来被金属栅极取代。
目前正在生产的先进半导体器件的尺寸明显小于使用 ArF 浸没式光刻技术可获得的约 50 nm 最小半间距。这需要开发越来越复杂的工艺技术方案。例如,根据最近的 TechInsights 分析结果,三星 5 纳米 LPE 工艺使用了多种先进的光刻方法,包括 EUV,如表 1 所示。
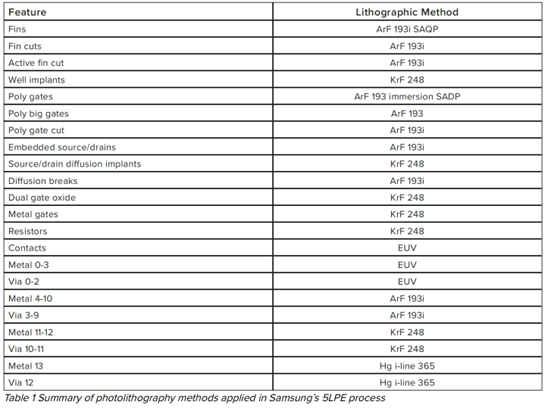
表 1
SAQP光刻技术可以产生非常精细的间距特征;但是,它仅限于创建沿单个方向定向的单轴结构( uniaxial structures)。线路末端需要特殊切割( Special cut)的掩模,以防止相邻线路之间短路。EUV 光刻没有这些限制,但成本较高。
图 3 显示了三星 5LPE 设备的 CPU 逻辑区域中metal 0 布局的平面图 TEM 显微照片。观察到的最小金属间距约为 44 nm。此外,布局包括在两个正交方向上定向的线。这在使用 SADP 或 SAQP ArF 193i 光刻方法时通常是不可能的。
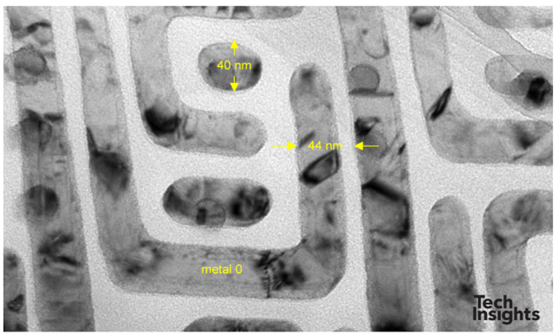
图 3:Samsung 5LP Metal 0 Layout
纳米压印光刻和直接自组装光刻
EUV 设备和工艺非常复杂和昂贵,因此业界一直在研究替代品。三个主要竞争者是:
1. 纳米压印光刻 (NIL:Nano-Imprint Lithography)
2. 直接自组装 (DSA:Direct Self-Assembly) 光刻
3. 电子束光刻 (EBL:Electron Beam Lithography)
其中,EBL 提供非常高的空间分辨率(优于 10 nm),但配置和执行速度较慢,本文将不作进一步考虑。EBL 确实有商业应用,但不是在大批量先进节点制造中。
纳米压印光刻技术最早由明尼苏达大学的Stephen Chu 提出。该技术基于聚甲基丙烯酸甲酯 (PMMA) 的压缩成型。Chu 和他的合著者在 1996 年发表在《科学》杂志上的一篇论文中报告了 25 nm 分辨率的图案化。他们于 1995 年发布了开创性专利 US5772905A。NIL 技术于 2003 年被添加到 ITRS 路线图中,该领域一直是持续研究和开发的领域。佳能是全球主要的光刻设备供应商之一,并且他们现在提供 NIL 产品线,东芝是他们的早期客户之一,建议的应用是 NAND 闪存生产。
直接自组装光刻取决于嵌段共聚物(block-copolymers)在预图案化基板上的直接定向。该技术类似于 SADP 和 SAQP,因为使用较粗的间距模板(coarser pitch template)来创建较细的间距结构( finer pitch structure)。DSA 技术于 1990 年代首次提出,并于 2007 年成为 ITRS 路线图的一部分。DSA 的主要支持者是 IMEC 的一个研究小组。2021 年,他们展示了使用 DSA 形成 18 纳米间距线图案。据我们所知,直接自组装尚未被任何主要半导体代工厂用于大批量生产。在过去的二十年里,这项技术进行了大量的研发和专利活动,但还没有商业用途。
先进光刻的创新专利
TechInsights与 Cipher 合作,一直在探索先进光刻市场的创新。目前,基于光学光刻的技术主导着半导体市场,其中 ArF 193i 是用于图案化细间距特征的主要方法。基于 EUV 的光刻开始出现在最先进的 CMOS 技术中,例如上一节中讨论的三星 5LPE。
不幸的是,EUV 方法非常昂贵,并且可能存在与 ASML 交付 EUV 硬件相关的供应链问题。我们预计该行业将积极寻求替代方案。Cipher 一直与 TechInsights 合作开发专利分类器,可用于监控特定领域的创新步伐,例如 EUV、NIL 和 DSA 光刻。
Cipher 专利分类器使 TechInsights 能够绘制出 EUV、NIL 和 DSA 先进光刻专利的概况。图 4 显示了按技术排名前 5 位的专利组织的表格。

图 4:Top 5 Companies by NIL, EUV and DSA Patent Holdings
表格显示:
• 佳能显然对 NIL 技术寄予厚望;
• ASML 对 EUV 的投资最多,但也积极参与 NIL 和 DSA 研究;
• 从先进光刻研发的角度来看,台积电显然是领先的代工厂。他们是对 EUV 投资最多,但在 NIL 和 DSA 方面也很活跃;
• 三星排在第五位,也在两面下注,尽管他们的专利活动水平远低于台积电;
• Karl-Zeiss 排在第四位,他们作为光刻供应商的主要关注点是 EUV 也就不足为奇了;
该表未显示包括GlobalFoundries、IBM 和 Intel 在内的北美主要组织,它们的排名更靠后,分别位于第 16 位、第 17 位和第 32 位。
图 5 根据 Cipher 专利分类器获得的结果,将中国排名前 10 位实体的专利格局与世界其他地区进行比较,按组织和光刻技术类型列出了当前活跃专利家族的数量。

图 5:Counts of Current Active Patent Families by Organization and Technology for China
图 6显示了按年份和先进光刻技术提交的专利族数量仅供中国公司使用的空间。专利总数相当少,但有持续的EUV、DSA 和 NIL 这三个技术领域的专利活动呈上升趋势。

图 6:Number of Patent Families Filed by Year and Technology for China
相比之下,图 7显示了世界其他地区(不包括中国)在先进光刻领域按年份和技术提交的专利族数量。

图 7:Number of Patent Families Filed by Year and Technology for Rest of World
当然,世界其他地区的专利数量要多于中国。数据显示 EUV 专利活动呈持续上升趋势;然而,大约在 2013 年之后,DSA 专利活动和 NIL 技术专利活动在大约 2018 年之后有所下降。这也许并不奇怪,因为 ASML EUV 技术现已商用,从而减少了寻找替代品的动力。
结论
先进的光刻技术对于摩尔定律扩展的延续至关重要。该行业目前正在押注EUV,辅以先进的 193i 技术,如 SADP 和 SAQP,将继续缩小到上面讨论的 5 纳米技术以下。不幸的是,EUV 取决于使用极其复杂和昂贵的设备,因此该行业继续寻找替代品,例如作为 NIL 或 DSA,这可能会提供一条替代途径。
审核编辑 :李倩
-
摩尔定律
+关注
关注
4文章
640浏览量
81191 -
光刻技术
+关注
关注
1文章
151浏览量
16583 -
EUV
+关注
关注
8文章
615浏览量
89019
原文标题:EUV光刻的两大挑战者,谁扛大旗?
文章出处:【微信号:光刻人的世界,微信公众号:光刻人的世界】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
中国打造自己的EUV光刻胶标准!
俄罗斯亮剑:公布EUV光刻机路线图,挑战ASML霸主地位?

台阶仪在集成电路制造中的应用:高端光刻胶材料纯化研究进展

垄断 EUV 光刻机之后,阿斯麦剑指先进封装
泽攸科技 | EBL和EUV光刻机有何区别?如何影响半导体行业?

第三届开放原子大赛OpenTenBase两大赛项圆满落幕
华宝新能美学曲面光伏瓦亮相两大行业盛会
白光干涉仪在EUV光刻后的3D轮廓测量
【「AI芯片:科技探索与AGI愿景」阅读体验】+半导体芯片产业的前沿技术
EUV光刻胶材料取得重要进展
中科院微电子所突破 EUV 光刻技术瓶颈

改善光刻图形线宽变化的方法及白光干涉仪在光刻图形的测量

华为OceanProtect跻身Gartner®备份与数据保护平台魔力象限“挑战者”
ASML杯光刻「芯 」势力知识挑战赛正式启动




 EUV光刻的两大挑战者,谁扛大旗?
EUV光刻的两大挑战者,谁扛大旗?





评论