导读:Cadence公司在2019年推出 Clarity 3D Solver场求解器,正式进军快速增长的系统级分析和设计市场。与传统的三维场求解器相比,Cadence Clarity 3D Solver场求解器在精度达到黄金标准的同时,拥有高达10倍的仿真性能和近乎无限的处理能力。得益于最先进的分布式并行计算技术,Clarity 3D 场求解器有效地解决了芯片、封装、PCB、接插件和电缆设计等复杂的3D结构设计中的电磁(EM)挑战,为任何拥有桌面电脑、高性能计算(HPC)或云计算资源的工程师提供真正的3D分析支持。Clarity 3D 场求解器可以轻松读取所有标准芯片、IC封装和PCB设计实现平台的数据,同时为使用Cadence Allegro 和Virtuoso 设计实现平台的团队提供专属集成优势。
一、关于Clarity 3D Solver
基于有限元电磁场的商业软件,通常包括三个仿真阶段:初始化网格、网格迭代、频率扫描。传统的并行计算仅仅会在频率扫描阶段,将多个频点分配到不同的计算机节点上。但是在求解每一个频点时,仿真时间并没有减少而且仍然需要很大的内存。并且,对于复杂的电磁结构仿真,传统的软件很难在仿真之前预测所需要的内存,因此经常会在仿真进程过半后由于内存不足而终止仿真,浪费前期的所有工作。
Clarity 3D Solver 采用了全新的分布式计算平台以及突破性的网格和矩阵分解技术,在初始化网格、网格迭代以及频率扫描三个阶段都支持多机并行的分布式计算。

二、分布式网格划分
Clarity 3D Solver 2022版本新增了分布式网格划分算法,进一步发展了其先进的网格划分技术,包括基于层结构的 LMesh 和任意三维结构的XMesh 两种方法。这两种技术都能将初始网格处理速度提高 10 倍以上,意味着大幅减少的仿真运行时间。
1、Xmesh - 大规模分布式并行网格划分技术
初始网格和自适应网格都支持多机分布式并行处理
不损失准确性,但模拟结果比没有并行网格划分时的 Clarity 版本快 3 倍
新的3D网格划分技术无需用户提供额外输入并且更加稳定
2、Lmesh – 基于层结构的大规模分布式并行网格划分技术
超快速预处理
前所未有的网格生成成功率(自动修复)
初始网格和自适应网格都支持多机分布式并行处理
对于复杂的布局设计,甚至比 XMesh 更快
仅在 Clarity 3D Layout 中可用
新的3D网格划分技术无需用户提供额外输入并且更加稳定
三、网格迭代和频率扫描
区别于传统的直接求解完整有限元矩阵,Clarity 3D Solver 采用了先进的矩阵分解技术,能够在多个较小内存的机器群组上完成复杂电磁结构仿真。Clarity 3D Solver的并行分布式技术特点如下:
1、没有任何精度的损失
2、几乎无限的容量,即使只有一台32核/256GB内存的电脑,也可以仿真几千万网格规模,而不会出现内存不足的问题
3、强大的可扩展性。对于复杂设计, 通过增加计算机CPU资源来达到几乎线性的仿真效率提高
4、充分利用已有机器。可以利用增加多个32G内存机器来加速大规模电磁仿真
总结

四、成功案例
案例1:2个倒装芯片封装安装在6层PCB的仿真

从结果对比来看,除效率有了明显的提升之外,精度方面,在0-20GHz、回波损耗和插入损耗上,Clarity 3D Solver的结果和第三方软件都有很好的吻合。
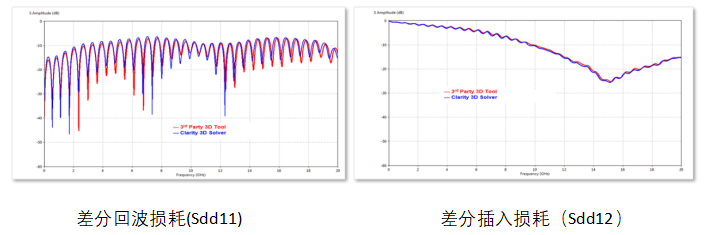
案例2:HBM InFO 3D Modeling
这是一个拥有两个芯片(SOC芯片和HBM芯片)的4 层晶圆级封装结构,线宽和线间距都是2um。仿真包含了128根信号和2个电源以及一个地网络,总共有868个端口。对于传统的仿真工具而言,这一创新型的封装结构过于复杂,难以在较短时间内准确仿真。
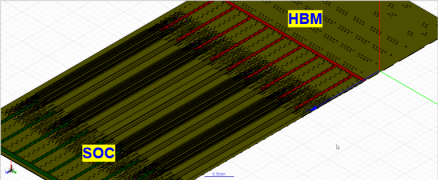
Clarity 3D Solver 利用128 CPU以及每个CPU配置的8G内存机器,在此配置下7. 2小时完成了仿真。由于无需拆分设计,既保证了仿真结果的精准度又大幅减少了仿真运行时间,这是其他电磁场软件达不到的效果。
审核编辑:汤梓红
-
3D
+关注
关注
9文章
3021浏览量
115548 -
封装
+关注
关注
128文章
9325浏览量
149031 -
Cadence
+关注
关注
68文章
1026浏览量
147303 -
HBM
+关注
关注
2文章
432浏览量
15880
原文标题:7.2小时完成868个HBM封装端口—— Cadence Clarity 3D Solver 仿真案例详解
文章出处:【微信号:sim_ol,微信公众号:模拟在线】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
2D、2.5D与3D封装技术的区别与应用解析

IT66021FN:支持3D的单端口HDMI 1.4接收器
浅谈2D封装,2.5D封装,3D封装各有什么区别?
技术资讯 I 图文详解 Allegro X PCB Designer 中的 3D 模型映射

【海翔科技】玻璃晶圆 TTV 厚度对 3D 集成封装可靠性的影响评估

HBM技术在CowoS封装中的应用
玩转 KiCad 3D模型的使用

TechWiz LCD 3D应用:FFS仿真

文件嵌入详解(一):在PCB封装库中嵌入3D模型




 7.2小时完成868个HBM封装端口——Cadence Clarity 3D Solver仿真案例详解
7.2小时完成868个HBM封装端口——Cadence Clarity 3D Solver仿真案例详解






评论