样品信息
#1为失效样品,取#1样品中的RG11;#2为非同周期PCB板,取#2样品中的C37。
#1样品
#2样品
分析过程
外观分析
说明:#1样品RG11失效位置呈现无Sn润湿状态或退润湿状态,PAD面平整,有明显助焊剂残留。器件焊端均有明显的Sn润湿。
#1样 SEM分析
对#1失效点进行未润湿点的表征分析,下图为RG11典型PAD的SEM分析:
说明:#1样品RG11未润湿PAD,表面平整,且有明显的助焊剂残留。这说明在回流初期,Sn与这个面发生过作用。但由于润湿不良,导致焊锡无附着或退润湿异常。
#1样 EDS分析
对RG11失效PAD进行EDS成分分析如下:
说明:对失效PAD进行成分分析,未发现异常元素, C元素约占30%(助焊剂主要成分之一)。
#1样 切片分析
取#1样品中的RG11进行切片分析:
断面金相分析
断面SEM分析
断面EDS分析
IMC厚度测量
说明:
金相分析:#1样品RG11进行切片金相分析,不润湿点的焊锡主要收缩到器件端子的位置(图示),PCB PAD上不润湿。润湿良好的焊点延伸出来的PAD上有明显焊锡。
SEM&EDS断面分析:
#1样品RG11未润湿PAD表层呈现合金化状态(IMC层裸露),以Cu、Sn组成,整体比例约40:60,说明合金层(IMC)构成为Cu6Sn5 。
#1样品RG11未润湿PAD的IMC厚度最大3.23μm,IMC厚度最小1.05μm。
#2样 镀层厚度分析
针对未回流的PCB测试下记标识点位PAD:
说明:通过对#2的镀层分析可见,Cu+Sn(喷锡工艺),Sn的厚度Min1.055μm,Max 9.217μm,平均4.245μm。
#2样 断面分析
取#2样品C37对PAD位置进行切片分析:
断面SEM分析
断面EDS分析
说明:对#2样品C37 PAD位置进行断面SEM分析, PAD表层呈现合金化状态(部分位置IMC层裸露),IMC厚度最大1.23μm,IMC厚度最小0.93μm,IMC层的Cu、Sn比例约40:60,说明IMC构成为Cu6Sn5。
分析结果
原因分析
结合上述分析来看,对PCB PAD不润湿的失效分析如下:
1.PCB焊盘的表面处理方式为热风整平(喷锡);
2.失效焊点PAD上无明显Sn(锡膏)附着,未发现异常元素, C元素约占30%(助焊剂主要成分之一);
3.断面分析表明未润湿位置具有典型特征:表面合金化,即IMC层裸露。通过元素分析,IMC层的Cu、Sn比例约40:60,说明IMC构成为Cu6Sn5。
4.PCB的镀层分析Sn的厚度Min1.055μm,Max9.217μm,平均4.245μm。#2样品C37对PAD位置进行断面SEM分析, PAD表层呈现合金化状态。
失效机理解析
PCB表面Sn镀层厚度不均匀,导致局部位置焊盘表面的镀层合金化,即IMC层(Cu6Sn5)裸露。由于IMC含有大量的Cu,其熔点远高于锡焊料,从而造成焊盘表面可焊性降低,回流焊接时易发生焊盘不润湿,焊锡爬至器件焊端的现象。
典型失效图示:
注:锡厚度不均匀导致的镀层合金化是热风整平(喷锡)工艺PCB常见的失效模式。
新阳检测中心有话说:
本篇文章介绍了PCB熔锡不良失效分析的案例。如需转载本篇文章,后台私信获取授权即可。若未经授权转载,我们将依法维护法定权利。原创不易,感谢支持!
新阳检测中心将继续分享关于PCB/PCBA、汽车电子及相关电子元器件失效分析、可靠性评价、真伪鉴别等方面的专业知识,点击关注获取更多知识分享与资讯信息。
审核编辑 黄昊宇
-
焊接
+关注
关注
38文章
3597浏览量
63486 -
PCB
+关注
关注
1文章
2368浏览量
13204
发布评论请先 登录
PCB智造中盲孔失效会带来哪些影响?

富捷科技如何解决电阻应力失效问题

PCBA加工中产生不良的原因有哪些?
IGBT与SiC MOSFET功率模块的失效机理、诊断方法与防护策略

LCM液晶面板电性不良的激光修复方法及电测治具与流程

电子元器件典型失效模式与机理全解析

IGBT 芯片表面平整度差与 IGBT 的短路失效机理相关性

电阻失效机理全解析
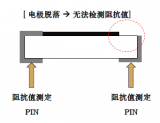
几种晶振失效,不起振原因分享

LED失效的典型机理分析
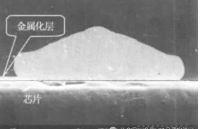



 PCB熔锡不良现象背后的失效机理
PCB熔锡不良现象背后的失效机理








评论