多晶硅栅的形成是集成电路工艺中最关键的步骤,因为它包括了最薄的栅氧化层的热生长(干氧和湿氧),形成多晶硅栅的先进且复杂的光刻技术和干法刻蚀技术,以及需要精确控制且复杂的侧墙工艺。
多晶硅栅结构通常是一代集成电路工艺中物理尺度最小的结构,也是形成晶体管的关键。多晶硅栅形成的一般流程是,首先使用高温热氧化生成栅氧化膜,膜的厚度约为 1~10nm(由于在集成电路中有不同工作电压的场效应晶体管,所以栅氧化层的厚度也不相同,需要采取多个步骤才能完成不同厚度的栅氧化层),然后进行多晶硅栅的化学气相沉积和掺杂(扩散或离子注入),最后进行光刻和干法刻蚀。
多晶硅栅光刻工艺使用的光刻机是同一技术代集成电路工艺线中最先进、最昂贵的设备,它采用 UV 光源进行曝光,波长从g线(436nm)到DUV(248pm 和 193nm),以及 193nm 浸没式;在光刻掩模版上采用了 OPC和PSM等技术;在光刻工艺中采用了抗反射层、硬光刻胶技术、多重曝光技术等。
多晶硅栅的刻蚀采用的是最精细的刻蚀设备和技术,通常采用 NF3、 SF6~HBr、CL2,等气体,要求与 SiO2有极高的选择比。多晶硅栅的检测技术也是最精细的检测技术,用于光刻和刻蚀完成后多晶硅栅线宽和形状等的检测。
虽然在 45nm 以下的超大规模集成电路制造工艺中,为了解决多晶硅栅耗尽效应,以及多晶硅与高K介质高界面态密度等问题,多采用了高K金属栅工艺,多晶硅栅的重要性有所降低,但是多晶硅栅工艺仍然被认为是集成电路的标志性工艺之一。
审核编辑 :李倩
-
集成电路
+关注
关注
5467文章
12720浏览量
376076 -
多晶硅
+关注
关注
3文章
250浏览量
30739
原文标题:多晶硅栅(Poly-Si Gate)
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
气体检测仪在多晶硅生产车间的重要作用

技术报告 | Gate 和 Fin Space Variation 对应力调制及 FinFET 性能的影响

破解高耗能困局:虚拟电厂绿色微电网驱动多晶硅产业零碳转型

智多晶AXI视频通讯DEMO方案介绍

半导体薄膜厚度测量丨基于光学反射率的厚度测量技术

PECVD硼发射极与poly-Si钝化接触共退火,实现高效TOPCon电池

多晶硅在芯片制造中的作用
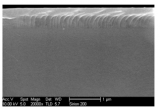
TOPCon电池提效:激光氧化集成TOPCon前表面poly-finger接触

2025智多晶FPGA技术研讨会成功举办
TOPCon电池poly-Si层的沉积掺杂工序提效优化

基于厚度梯度设计的TOPCon多晶硅指状结构,实现25.28%量产效率突破

智多晶FPGA设计工具HqFpga接入DeepSeek大模型
使用共聚焦拉曼显微镜进行多晶硅太阳能电池检测




 多晶硅栅(Poly-Si Gate)
多晶硅栅(Poly-Si Gate)






评论