高电压防电弧
通常,当测试晶圆上的高电压时,探针之间将存在放电(电弧),这也发生在DUT(被测器件)和相邻器件(垂直布局)或其他测试pad(横向布局)之间。此外,在高于1000 V的电压下,晶圆载物台和周围探针台之间可能发生电弧放电。
探针与器件的低接触电阻
实现精确高电流测量的另一个关键挑战是尽可能降低探针与器件的接触电阻。这将确保可以在晶圆上测量到器件的完整性能,并与封装器件性能完全一致。这使得用于终端的应用电源模块的已知良好芯片(KGD)的成本显著降低。
晶圆和载物台之间的均匀接触和热阻
为了获得晶片上每个器件的准确数据,重要的是在晶片背面和卡盘顶面之间具有均匀的物理接触。首先,这可以通过确保从器件产生的全部热量远离每个器件来分散热误差,而不管晶片上的器件位置如何。其次,对于卡盘作为电触点之一的垂直器件(如IGBT),这可实现超低接触电阻 - 这是克服RDS(on)非开尔文测试的电阻误差的关键需求。只有解决了这两个挑战,才能在测试数据中看到每个设备的最大性能。
电路设计师的精确器件模型
产品特性分析工程师面临的挑战是同时满足测量高电压/高电流的能力和精确的低漏电性能,以创建完整的器件模型。这将有助于电路设计人员优化其功率IC设计,以实现最大的商业价值。平衡高电压/电流切换与在不工作时(断开状态)器件功耗是这项工作的重点。
审核编辑:符乾江
-
测试
+关注
关注
8文章
6049浏览量
130788 -
半导体
+关注
关注
336文章
30056浏览量
259053
发布评论请先 登录
半导体器件的通用测试项目都有哪些?

BW-4022A半导体分立器件综合测试平台---精准洞察,卓越测量
功率半导体器件——理论及应用
华大半导体与湖南大学成功举办SiC功率半导体技术研讨会
功率半导体展 聚焦 APSME 2025,共探功率半导体发展新征程

湿度大揭秘!如何影响功率半导体器件芯片焊料热阻?






 功率半导体测试将会面临哪些挑战
功率半导体测试将会面临哪些挑战





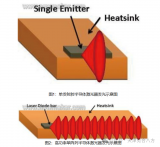












评论