摘要
高效指间背接触太阳能电池有助于减少太阳能电池板的面积,需要提供足够数量的能源供家庭消费。我们认为适当的采用光阱技术的IBC电池即使在厚度不足的情况下也能保持20%的效率。文章全部详情:壹叁叁伍捌零陆肆叁叁叁本工作采用光刻和刻蚀技术对晶圆进行深度刻蚀,使晶圆厚度小于20μm。
关键词:IBC太阳能电池,掩模蚀刻,光刻,反应离子蚀刻,TMAH蚀刻
介绍
太阳能显示出供应潜力,这个因素取决于对高效率光伏器件和降低制造成本的需求。IA是光伏产业面临的主要挑战以与化石燃料竞争的成本生产足够数量的能源。这个因素取决于对高效率光伏器件和降低制造成本的需求。据报道,太阳能电池的效率在规模上高于20%。商用太阳能电池使用晶体硅材料。这种类型的PV电池是指间背接触太阳能电池。
实验
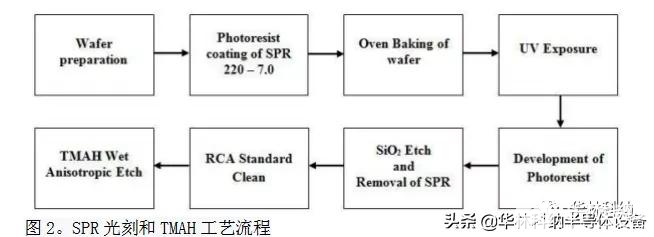
审核编辑:符乾江
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
半导体
+关注
关注
336文章
29985浏览量
258361 -
蚀刻
+关注
关注
10文章
428浏览量
16463
发布评论请先 登录
相关推荐
热点推荐
半导体晶圆(Wafer)减薄&划片工艺技术课件分享;
如有雷同或是不当之处,还请大家海涵。当前在各网络平台上均以此昵称为ID跟大家一起交流学习! 晶圆减薄(Grinder)是半导体制造过程中一个关键的步骤,它主要是为了满足芯片在性能、封装、散热等方面的需求。随着


晶圆减薄工艺分为哪几步
“减薄”,也叫 Back Grinding(BG),是将晶圆(Wafer)背面研磨至目标厚度的工艺步骤。这个过程通常发生在芯片完成前端电路制造、被切割前(即晶圆仍然整体时),是连接芯片制造和封装之间的桥梁。
减薄对后续晶圆划切的影响
前言在半导体制造的前段制程中,晶圆需要具备足够的厚度,以确保其在流片过程中的结构稳定性。尽管芯片功能层的制备仅涉及晶圆表面几微米范围,但完整厚度的晶圆更有利于保障复杂工艺的顺利进行,直至芯片前制程

半导体封装工艺流程的主要步骤
半导体的典型封装工艺流程包括芯片减薄、芯片切割、芯片贴装、芯片互连、成型固化、去飞边毛刺、切筋成型、上焊锡、打码、外观检查、成品测试和包装出库,涵盖了前段(FOL)、中段(EOL)、电

半导体清洗SC1工艺
半导体清洗SC1是一种基于氨水(NH₄OH)、过氧化氢(H₂O₂)和去离子水(H₂O)的化学清洗工艺,主要用于去除硅片表面的有机物、颗粒污染物及部分金属杂质。以下是其技术原理、配方配比
最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测
。 第1章 半导体产业介绍 第2章 半导体材料特性 第3章 器件技术 第4章 硅和硅片制备 第5章 半导体制造中的化学品 第6章
发表于 04-15 13:52
华林科纳半导体PTFE隔膜泵的作用
特性,使其在特殊工业场景中表现出色。以下是华林科纳半导体对其的详细解析: 一、PTFE隔膜泵的结构与工作原理 结构 :主要由PTFE隔膜、驱动机构(气动、电动或液压)、泵腔、进出口阀门

减少减薄碳化硅纹路的方法
碳化硅(SiC)作为一种高性能半导体材料,因其出色的热稳定性、高硬度和高电子迁移率,在电力电子、微电子、光电子等领域得到了广泛应用。在SiC器件的制造过程中,碳化硅片的减薄是一个重要环






 《华林科纳-半导体工艺》减薄硅片的蚀刻技术
《华林科纳-半导体工艺》减薄硅片的蚀刻技术




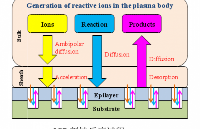










评论