近年来摩尔定律增速不断放缓,而新型应用对高效节能芯片的要求越来越强烈,半导体业界正在积极探索解决方案,包括 3D 封装等技术。
发展技术才是硬道理
作为全球先进芯片生产厂商,三星已经在制程工艺上取得了很大的成功。近日,三星又对外宣布其全新的芯片封装技术 X-Cube,称该技术可以使封装完成的芯片拥有更强大的性能以及更高的能效比。
目前现有的芯片都是 2D 平面堆叠的,随着芯片数量的增多,占用的面积越来越大,不利于提高集成度。关于 3D 芯片封装,就是将芯片从平面堆叠变成了垂直堆叠,类似搭积木那样一层层叠加,减少了芯片面积,提高了集成度。
衡量一个芯片封装技术先进与否的重要指标是:芯片面积与封装面积之比,这个比值越接近 1 越好,封装时主要考虑的因素:
①芯片面积与封装面积之比,为提高封装效率,尽量接近 1:1。
②引脚要尽量短以减少延迟,引脚间的距离尽量远,以保证互不干扰,提高性能。
③基于散热的要求,封装越薄越好。
先进封装技术受到热捧
目前业界领头羊都在 3D 封装技术上面努力着,在三星推出 X-Cube 时,全球主要的三家半导体代工厂均已经拥有 3D 或 2.5D 的封装技术了。
前有台积电的 CoWoS,Intel 的 Foveros,现在三星也公布了自家的 3D 封装技术 X-Cube。显而易见的是,未来我们买到的电子产品中,使用 3D 封装技术的芯片比例会越来越高。
台积电的 CoWoS 封装是一项 2.5D 封装技术,它可以把多个小芯片封装到一个基板上,这项技术有许多优点,但主要优势是节约空间、增强芯片之间的互联性和功耗降低,AMD 的 Fury 和 Vega 系列显卡就是使用这一技术把 GPU 和 HBM 显存封装在一起的,NVIDIA 的高端 Tesla 计算卡也是用这种封装。
英特尔 Foveros3D 堆叠封装技术,可以通过在水平布置的芯片之上垂直安置更多面积更小、功能更简单的小芯片来让方案整体具备更完整的功能。官方表示,除了功能性的提升之外,Foveros 技术对于产业来说最吸引的地方在于他可以将过去漫长的重新设计、测试、流片过程统统省去,直接将不同 IP、不同工艺的各种成熟方案封装在一起,从而大幅降低成本并提升产品上市速度。
X-Cube 3D 可大规模投产
而三星的 X-Cube 意为拓展的立方体。不同于以往多个芯片平行封装,全新的 X-Cube 3D 封装允许多枚芯片堆叠封装,使得成品芯片结构更加紧凑。而芯片之间的通信连接采用了 TSV 技术,而不是传统的导线。
据三星介绍,目前该技术已经可以将 SRAM 存储芯片堆叠到主芯片上方,以腾出更多的空间用于堆叠其他组件,目前该技术已经可以用于 7nm 甚至 5nm 制程工艺的产品线,也就是说离大规模投产已经十分接近。
三星封装将发展更多领域
三星表示,TSV 技术可以大幅减少芯片之间的信号路径,降低功耗的同时提高了传输的速率。该技术将会应用于最前沿的 5G、AI、AR、HPC、移动芯片已经 VR 领域,这些领域也都是最需要先进封装工艺的地方。
至于芯片发展的路线,三星与各大芯片厂商保持一致,将会跳过 4nm 的制程工艺,直接选用 3nm 作为下一代产品的研发目标。目前三星计划和无晶圆厂的芯片设计公司继续合作,推进 3D 封装工艺在下一代高性能应用中的部署。
结尾:
无论从哪个层面来看,封装技术在很大程度上都能够成为推动摩尔定律继续向前发展的第二只轮子,这也让整个半导体行业开辟了全新的发展路径和空间。
责任编辑:pj
-
芯片
+关注
关注
463文章
54463浏览量
469720 -
半导体
+关注
关注
339文章
31284浏览量
266804 -
3D
+关注
关注
9文章
3024浏览量
115633
发布评论请先 登录
半导体先进封装之“2.5D/3D封装技术”的详解;

【「AI芯片:科技探索与AGI愿景」阅读体验】+半导体芯片产业的前沿技术
iTOF技术,多样化的3D视觉应用
华大九天推出芯粒(Chiplet)与2.5D/3D先进封装版图设计解决方案Empyrean Storm




 半导体业界正在积极探索3D 封装等技术解决方案
半导体业界正在积极探索3D 封装等技术解决方案









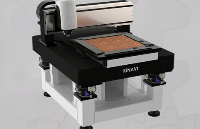



评论