本技术简介讨论了IC封装的热设计技术,例如QFN,DFN和MLP,它们包含一个裸露的散热垫。
大多数设计人员现在都非常熟悉集成 - 除了元件的电源,接地和信号连接外,还包含“裸露焊盘”或“散热焊盘”的电路封装。这些导热垫与各种封装缩写相关联 - QFN(四方扁平无引脚),DFN(双扁平无引线),MLF(微引线框架),MLP(微引线框封装)和LLP(无引线引线框封装) ,仅举几例。
以下是一个例子:ADI公司的LFCSP(引脚架构芯片级封装)音频功率放大器(部件号SSM2211):
热垫组件的一个主要优点是,不足为奇的是,提高了热性能。
包装内部是半导体芯片,该芯片包含在工作期间产生热量的电路。在模具下面(并连接到它)是导热垫;热量可以很容易地从芯片流到导热垫,因此芯片可以在不超过最大结温的情况下耗散更多功率 - 当然,假设PCB设计人员确保热量可以很容易地从导热垫流到周围环境环境。
QFN封装的正确热设计通常基于在PCB焊接到导热垫的部分中使用过孔。如果您有足够的可用电路板空间,则更简单的方法是使用大型铜区域,其中包括与导热垫的连接。不幸的是,这只适用于双行包:

当你的组件有所有四个端子(通常情况下),您唯一的选择是过孔。 (顺便说一句,端子最好称为“焊盘”,因为封装底部的扁平裸露金属不能精确地描述为引脚或引线。)过孔将热量从导热垫传导到其他PCB层,从那里到周围的环境。但是出现了一些问题:
有多少个过孔?
通孔间距应该是多少?
我如何确保过孔不会干扰焊接过程吗?
过孔的数量当然取决于导热垫的尺寸以及您对热传递的关注程度。如果您预计没有高温应力且没有显着的功耗,您可以完全忘记过孔并假设典型的封装到环境热路径就足够了。但在大多数情况下,过孔是有帮助的;如果您的操作功率高于最初预期,它们就是保险,它们可以通过保持零件的内部温度更稳定来帮助提高性能。
专家们的共识似乎如下:过孔应该是间距为中心距约1.2 mm,通孔直径为0.25至0.33 mm。
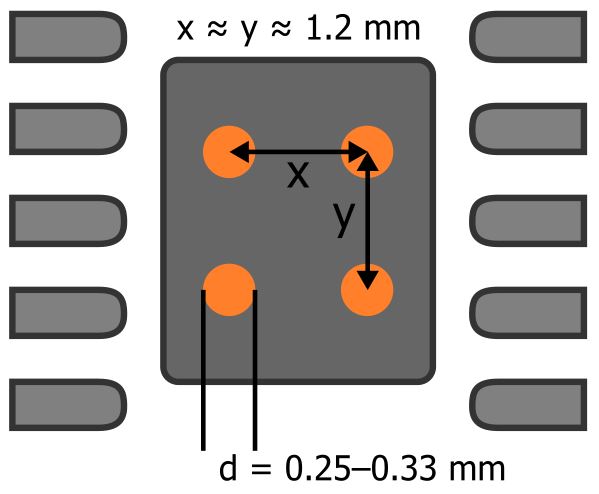
如果想要最大限度地提高散热性能,过孔的数量就会成为几何问题 - 也就是说,在保持建议的尺寸和间距的同时,您可以选择多少过孔。
否QFN布局的讨论将是完整的,不会出现焊料芯吸问题。毛细管作用将熔化的焊料吸入通孔,可能会使元件焊料不足或在PCB的另一侧产生焊料凸点。
您可以通过使用最小的推荐通孔尺寸来缓解问题,但是真正的解决方案是改变通孔本身,以阻止焊料流动。这里的选项,以提高性能(以及因此成本)的顺序,是帐篷,封盖/堵塞和填充。与PCB工厂的对话可以帮助您确定哪种方法最适合您的应用。
-
IC封装
+关注
关注
4文章
196浏览量
27721 -
热设计
+关注
关注
11文章
142浏览量
27422
发布评论请先 登录
烧结银膏在硅光技术和EML技术的应用
像元尺寸为何越来越小?一文看懂红外热成像的技术趋势

一文掌握3D IC设计中的多物理场效应

ALM(应用生命周期管理)解析:一文了解其概念、关键阶段及Perforce ALM工具推荐

PL4807线性ADJ可调输出锂电池充电IC封装技术手册
一文了解电压谐波




 一文了解IC封装的热设计技术
一文了解IC封装的热设计技术











评论