展望2019年,在IC设计、晶圆代工、后段封测的上中下游产业链中,委外封测代工(OSAT)成为国内半导体产业一大突破点。
业者表示,在中高阶芯片、先进封装领域,有客户背书才有意义,举凡如台积电、日月光、矽品等,分别手握苹果(Apple)、华为海思、高通(Qualcomm)、NVIDIA、超微(AMD)等龙头大厂封装订单,力成力拱的面板级扇出封装(FOPLP),也得到联发科等业者表态力挺。
不过,国内OSAT厂通富微电、天水华天、江苏长电等在打线封装争取IC设计如义隆电、瑞昱等非处理器用IC封测订单也毫不手软。相关业者估计,2019年国内封测厂在传统IC打线封装的价格竞争差距持续保持在约10%,积极争取中低阶IC封测订单。
而在AIoT时代中,各类IoT装置用芯片将大量窜出,举凡QFN等封装工艺,都将成为国内厂商重点,另外,BGA封装也是国内业者积极抢进的领域。
如通富微电以FC-BGA封装力求争取CPU订单,另外也声称完成12吋扇出型封装(Fan-out)产线,也传出已经具备承接国际大厂中高阶GPU封测能力。天水华天系统级封装(SiP)指纹辨识模块,则已经获得华为采用。
长电则在中国与韩国工厂强力推进SiP封装,并且开发出可用于手机应用处理器的FC-PoP封装,而长电子公司长电先进则已经成为国内最大扇入型(Fan-in)WLCSP封装基地。
国际芯片大厂要发展高效能产品,在晶圆代工的选择无非就是台积电莫属,自然伴随群聚效应,除了钻石级客户如苹果、赛灵思(Xilinx)等,台积电甚至提供晶圆段延伸的先进封装如CoWoS、InFO等巩固订单。另如高通、NVIDIA等后段封测也是由日月光投控拿下。
国内业者持续耕耘更多针对中高阶芯片的覆晶封装订单也是事实,加上IoT装置所需的芯片仍是采用传统打线封装,这部分将成为具有国家政略资源挹注的OSAT业者擅场。
尽管先前业界预期,全球业者包括中国本土厂商在内,在国内要扩增多座晶圆制造厂,但业界普遍认为新晶圆厂的投产进度要打点折扣,产能也未必能够如期开出,相较之下,国内在半导体上下游具有威胁力的项目,将持续聚焦到IC设计与后段封测端。
封测业者坦言,在客户背书为王的封测业,国内业者最有优势的部分,就是直接以国家战略资源并购国际业者封测工厂,一并拿下既有客户订单,将成为日矽结合之后的主要竞争对手。
-
半导体
+关注
关注
339文章
31559浏览量
267974 -
OSAT
+关注
关注
0文章
10浏览量
7945
原文标题:【IC封测】2019年半导体布局 OSAT成关键突破口
文章出处:【微信号:DIGITIMES,微信公众号:DIGITIMES】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
光谷聚“芯”:OVC 2026武汉半导体展为何成为中西部产业协同新枢纽?

【「芯片设计基石——EDA产业全景与未来展望」阅读体验】+ 全书概览
领跑国产替代的半导体测试公司:杭州加速科技的技术突破与产业赋能之路

广立微亮相2025湾区半导体产业生态博览会

重塑话语权:新时达硬核技术为中国半导体制造打通自主可控关键链路
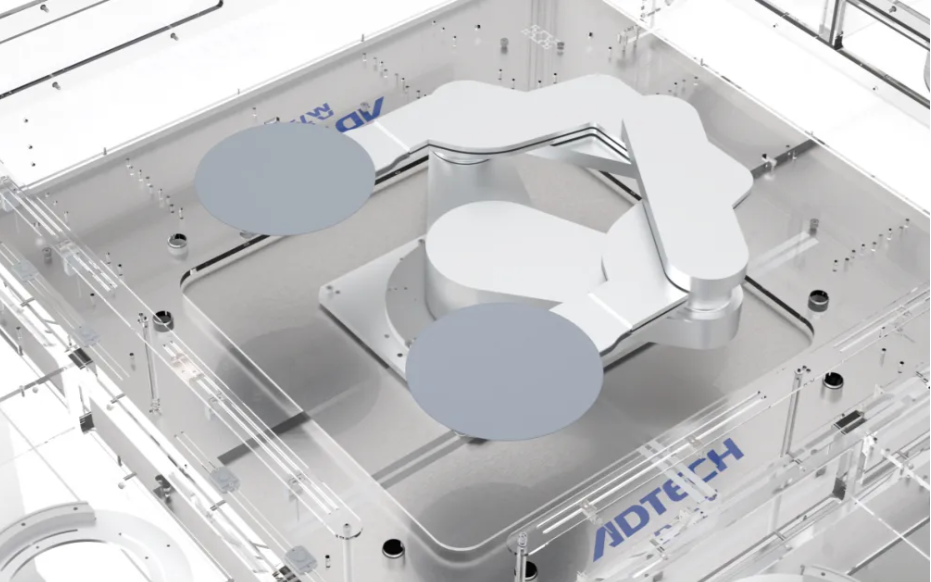
翠展微电子推出全新6-powerSMD封装

加氢站和电力系统,谁是AEM产业化破局的关键?

自主创新赋能半导体封装产业——江苏拓能半导体科技有限公司与 “半导体封装结构设计软件” 的突破之路

慧鼎科技亮相2025智能网联新能源汽车产业集群生态大会
Exensio 应用篇:数据驱动 OSAT 智能化,破解半导体封测效率与品控双难题




 OSAT成为国内半导体产业关键突破口
OSAT成为国内半导体产业关键突破口






评论