1. 基本介绍
在半导体制造中,过程可靠性(Process Reliability)是指通过测试特定的结构,来评估制造工艺本身是否能保证器件在长期使用中的稳定性。封装级可靠性(Package Level Reliability或PLR)是实现这一评估的主要手段(另外一种手段是是晶圆级可靠性 - Wafer Level Reliability或WLR)。PLR通常将测试结构中的器件(如MOSFET,metal lines)进行封装(如采用双列直插式陶瓷封装),然后送入专用的PLR测试设备,进行长时间的加压测试,精确测量某种物理失效。
在PLR中,TDDB、HCI、BTI和EM是评估半导体工艺寿命的“四大支柱”。这些测试不再是看整个芯片好不好用,而是通过封装后的测试结构,把工艺层层拆解,观察最底层的物理失效机制。
2. 传统电学失效机制解析
2.1. TDDB (Time-Dependent Dielectric Breakdown)
经时介质击穿。这是关于“绝缘层”寿命的考验。
· 物理本质: 当给栅极(Gate)施加电场时,氧化层内部会逐渐产生缺陷。当缺陷连成一条线时,绝缘层就会瞬间变导体,导致器件烧毁。
· PLR 测试重点: 由于氧化层越来越薄,击穿非常敏感。PLR 通过施加恒定电压(CVS)或恒定电流(CCS),观察栅极漏电流(Ig)突变的时间点。
· 核心指标: TBD(Time to Breakdown)。通过 PLR 的长期数据,我们可以建立电压加速度模型,预测在正常工作电压(如1.1V)下,氧化层能否撑过10年。
· 物理模型:E-model或者 1/E-model
· 参考标准:JESD92 (针对栅氧化层完整性的测试) 。
2.2. HCI (Hot Carrier Injection)
热载流子注入。这是关于“高频开关”损耗的考验。
· 物理本质: 载流子(电子或空穴)在强电场下获得极高能量(变“热”),冲破势垒并“卡”在氧化层里。这会导致晶体管的阈值电压 (VTH) 发生偏移。
· PLR 测试重点: HCI 主要发生在器件开关的瞬间。在 PLR 中,我们会给漏极(Drain)施加高压,在高温下测量栅极饱和电流 IDSAT或 VTH 的退化百分比(比如退化 10% 即判定失效)。
· 优势: 与 WLR 不同,PLR 能捕捉到更低电压下的长期 HCI 退化趋势。
· 物理模型:Vds加速模型
· 参考标准:JESD28(晶体管级别进行准静态HCI评估方法)和JESD60(专门针对关键热载流子效应的测试过程)。
2.3. BTI (Bias Temperature Instability)
偏置温度不稳定性。包括常见的 NBTI(针对 PMOS)和 PBTI(针对 NMOS)。
· 物理本质: 当栅极处于常开(偏置)状态且温度较高时,界面处的 Si-H 键断裂,产生陷阱电荷,导致阈值电压VTH漂移。
· PLR 测试重点: 阈值电压Vth。但是BTI有一个非常讨厌的特性——恢复效应 (Recovery Effect)。一旦撤掉应力,退化会迅速恢复。
· 优势: 基础 PLR 测试可以在受控的高温炉内进行非常精准的、带偏置的长期监测,从而更好地捕捉这种随温度变化的缓慢退化。
· 物理模型:Arrhenius模型(温度相关)。
· 参考标准:JESD90 (基于物理模型的 BTI 测量方法)。
下图展示了这三种主要失效机制在晶体管结构中发生的具体位置。

2.4. EM (Electromigration)
电子迁移。这是关于“金属连线”物理损耗的考验。
· 物理本质: 高电流密度下,电子像洪水一样“撞击”金属原子,导致原子发生物理位移,最终让导线在某些地方变薄甚至断裂(开路),或者在某些地方堆积导致短路。
· PLR 测试重点: 评估金属线(Al 或 Cu)和通孔(Via)的电流承载能力,以及相关电阻值。
· 优势:EM 测试通常需要数千小时。WLR 虽然有极高电流的快测,但那种极端电流产生的热量(Joule Heating)会干扰物理模型。PLR 才是获取高精度 Ea(活化能)的标准手段。
· 物理模型:Black’s Equation
· 参考标准:JESD61、JESD87、JESD202等
3. BTI测试的痛点:恢复效应与数据失真
传统PLR测试设备在执行 BTI 测试时面临严重挑战 :
· 恢复效应 (Recovery Effect):当测试应力暂停时,器件的损伤会在几毫秒内部分修复。
· 寿命高估:测量速度较慢的传统PLR设备无法捕捉最差情况下的损伤,导致对器件寿命的高估。
· 安全风险:缺乏通道级独立保护,单点失效可能波及器件本身或者相邻器件。
· 工作流断裂:数据往往存在于孤岛中,工程师需导出大量数据至第三方软件才能可视化退化曲线 。

4. 联讯解决方案:在线测量 OTF(On-The-Fly)技术
联讯开发的PLR0010 系统采用了先进的 OTF(On-The-Fly,在线测量) 技术,以消除器件在测量延迟期间产生的“恢复效应(Recovery Effect)”,:
· 连续漏极电流(ID)监控:与MSM(Measure-Stress-Measure)进行测量的传统方法不同,PLR0010 可以在应力阶段保持微小的漏极偏置,并每隔90微秒持续采样漏极电流(ID)。该方法可以捕获真实的退化曲线。
· 快速阈值电压(Vth)提取:对于阈值电压测量,系统具备微秒级的脉冲测试能力,采用基于最大跨导(Gm-max)的高速扫描算法。
· 捕获快速陷阱:将“非应力”时间(中断时间)缩短至约 200µs,确保在“快速陷阱(Fast Traps)”松弛之前将其捕获。
直观对比:OTF 与标准 MSM 方法 下面两图展示了两者之间的关键区别。在标准的“测量-应力-测量(MSM)”模式中,移除应力产生的空档期会导致器件恢复,从而丢失数据。而在 OTF 模式下,应力是连续的,能够捕获到真实的“最差情况”退化。OTF技术确保了更准确的数据捕获。


通过在不撤除应力电压的情况下连续监控器件退化(例如线性漏极电流),PLR0010 能够捕获到传统“测量-应力-测量”(MSM)周期经常遗漏的“快速陷阱”和真实的退化数据。
5. 联讯PLR0010系统架构优势和关键指标
PLR0010 系统专为满足 JEDEC 严苛标准而设计,实现了硬件精度与软件智能的高度集成。
5.1. 硬件性能与稳定性
· 高温环境:支持高达250℃的稳定测试环境,满足高度加速寿命测试要求。
· 通道独立保护:每通道内置独立过流保护逻辑,一旦单个器件失效,立即实现物理隔离,确保昂贵原型器件的安全。
· 无缝流式数据直存:突破传统硬件缓存容量限制,支持测试数据的无上限实时落盘记录。无论测试周期多长,均可确保原始数据的连续高频采集,完美还原复杂退化曲线的每一个微观细节。
5.2. 软件集成与数据分析
· 一站式可视化:内置强大的绘图引擎,支持直接在软件内生成退化曲线、寿命预测图及趋势分析,无需依赖第三方工具。
· 生产自动化:无缝对接设备自动化程序(EAP),确保大规模量产测试中的数据可追溯性。

审核编辑 黄宇
-
测试
+关注
关注
9文章
6374浏览量
131639 -
半导体封装
+关注
关注
4文章
327浏览量
15265
发布评论请先 登录
「聚焦半导体分立器件综合测试系统」“测什么?为什么测!用在哪?”「深度解读」
什么是高可靠性?
芯片可靠性(RE)性能测试与失效机理分析

深爱半导体 代理 SIC213XBER / SIC214XBER 高性能单相IPM模块
半导体行业老化测试箱chamber模拟环境进行可靠性测试

从良率突破到成本优化:PLP解决方案如何改写半导体封装规则
半导体高精度高低温测试设备:多领域可靠性测试的温度解决方案
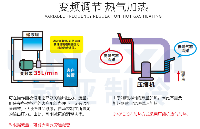
可靠性测试包括哪些测试和设备?




 半导体封装级可靠性的测试挑战和解决方案
半导体封装级可靠性的测试挑战和解决方案








评论