文章来源:学习那些事
原文作者:小陈婆婆
本文介绍了现代微电子器件封装技术。
在现代微电子技术体系中,微电子器件封装技术已演变为连接芯片设计与系统应用的桥梁性学科,其战略地位随AI算力需求爆发与半导体产业重构而持续攀升。
从功能维度审视,微电子封装已超越传统“保护外壳”的定位,演变为系统性能优化的核心载体。其四大基本功能——机械支撑、电气互连、信号传输、散热管理——在先进封装架构下呈现新的技术特征。
现代电子产业对微电子封装的要求
现代电子产业对微电子封装的严苛要求,正驱动着封装技术向系统级集成与性能优化方向加速演进。在军事、宇航、通信、便携计算、汽车及消费电子等领域的持续创新中,封装已从传统的“芯片保护壳”蜕变为支撑系统功能实现的核心载体,其技术演进路径与产业需求形成深度耦合。

在系统集成维度,Chiplet技术的成熟推动封装从“单芯片封装”向“多芯粒协同”升级。以AMD Zen4架构处理器为例,通过混合键合与有机基板集成,实现CPU、GPU、I/O芯粒的异构互连,在提升计算性能的同时降低整体功耗。这种模块化设计不仅缩短了产品开发周期,更通过芯粒复用降低了高端芯片的制造成本,使高性能计算设备在消费级市场的渗透率显著提升。
面向便携与穿戴设备,封装技术正突破“轻薄化”与“高可靠性”的双重约束。采用柔性基板与低温键合工艺的扇出型封装(Fan-Out),在保持0.3mm超薄厚度的同时,实现-40℃至150℃宽温域工作能力,满足汽车电子与工业控制场景的严苛环境要求。而硅光子与CMOS工艺的集成,则通过共封装光学(CPO)技术将光模块与芯片的距离缩短至毫米级,使数据传输速率突破800Gbps,支撑5G基站与数据中心的高带宽需求。
在成本与环保层面,绿色封装技术正成为产业新焦点。欧盟《包装与包装废弃物条例》(PPWR)推动的单一材质可回收封装材料,结合水性环氧树脂与无铅焊料的应用,使封装过程的VOCs排放降低,同时提升材料的循环利用率。国内企业开发的生物基环氧塑封料,通过AEC-Q100认证,在保持电气性能的同时实现碳足迹减少,适配新能源汽车与可再生能源设备的绿色制造需求。
综上所述,现代电子产业对微电子封装的要求已从单一的“性能提升”转向“性能-成本-环保”的三维优化。封装技术通过材料创新、工艺突破与系统集成,不仅支撑着芯片性能的极限释放,更成为推动电子信息产业绿色转型与可持续发展的关键基础设施。
微电子封装的发展历程
微电子封装技术的演进轨迹深刻映射着半导体产业的变革脉络,自1947年晶体管诞生至21世纪20年代,已形成从“通孔插装”到“系统级集成”的跨越式发展范式。20世纪50-70年代,以TO型金属玻璃封装与DIP双列直插式封装为主导,通过金属-玻璃封接工艺实现芯片的基本电气互连与机械保护,但受限于引脚密度与散热能力,仅适用于小规模集成电路(SSI)应用。80年代表面安装技术(SMT)的突破推动封装进入“片式化”时代,LCCC、PLCC、QFP等封装形式通过短引线、小节距设计将封装密度提升3-5倍,同时支持自动化贴装,使消费电子产品实现“体积缩小、重量减轻”的双重突破。

然而,当集成电路进入超大规模(VLSI)阶段后,传统四边引线封装面临I/O数不足、信号完整性劣化等瓶颈,促使90年代出现第二次技术飞跃——BGA球栅阵列封装通过焊球阵列实现面阵互连,将引脚密度提升至每平方厘米数百个,配合倒装焊(FC)技术实现芯片级互连,使CPU、GPU等高性能芯片的电气性能与热管理效率显著提升。
进入21世纪,多芯片组件(MCM)与芯片尺寸封装(CSP)的兴起推动封装向“系统级”演进。MCM-L/C/D技术通过多层布线基板集成多颗裸芯片,实现功能模块的紧凑集成,而CSP技术则通过封装尺寸与芯片尺寸的1:1匹配,将封装厚度压缩至0.5mm以下,支撑移动设备的轻薄化需求。近年来,Chiplet技术的成熟进一步突破单芯片物理极限,通过硅桥(EMIB)、混合键合(Hybrid Bonding)等异构集成方案,实现CPU、GPU、AI加速器等芯粒的模块化组合,在提升计算性能的同时降低制造成本。例如,台积电CoWoS-L技术通过局部硅桥与有机基板结合,在87%面积利用率下实现高带宽互连,支撑AI芯片对万亿参数模型的计算需求;英特尔Foveros技术则通过3D堆叠实现逻辑芯片与存储芯片的垂直互连,将互连延迟降低至纳秒级。
在材料创新层面,玻璃基板凭借低翘曲度与高布线密度优势,在HBM4封装中实现16-Hi堆叠的量产突破,而液态金属导热材料与石墨烯-铜复合散热结构的应用,使高功耗芯片的热导率大幅提升,解决“热墙”问题。环保封装方面,水性环氧树脂与无铅焊料的普及推动VOCs排放降低,生物基环氧塑封料通过AEC-Q100认证,在保持电气性能的同时实现碳足迹减少,适配新能源汽车与可再生能源设备的绿色制造需求。
微电子封装的基本类型
微电子封装的基本类型演进始终围绕“小型化、高密度、高性能”三大核心诉求展开,其技术路径与半导体产业需求形成深度耦合。

20世纪60-70年代,以TO型晶体管罐盒、SIP单列直插、DIP双列直插及PGA针栅阵列为代表的针脚插入型封装占据主导,通过金属-玻璃封接工艺实现芯片与PCB的机械互连与电气连接,但受限于引脚密度与散热能力,仅适用于小规模集成电路应用。80年代表面安装技术(SMT)的突破推动封装进入“片式化”时代,LCCC无引线陶瓷片式载体、PLCC塑料有引线片式载体、QFP四边引线扁平封装等形式通过短引线、小节距设计将封装密度提升3-5倍,配合波峰焊与热压焊工艺实现自动化贴装,使消费电子产品实现“体积缩小、重量减轻”的双重突破,SOP、QFJ、SOJ等衍生形式进一步拓展了表面贴装的应用场景。
90年代后,随着集成电路进入超大规模(VLSI)阶段,传统四边引线封装面临I/O数不足、信号完整性劣化等瓶颈,促使封装技术向“混载封装、3D封装、裸芯片封装”方向演进。BGA球栅阵列封装通过焊球阵列实现面阵互连,将引脚密度提升至每平方厘米数百个,配合倒装焊(FC)技术实现芯片级互连,使CPU、GPU等高性能芯片的电气性能与热管理效率显著提升;MCM多芯片组件技术通过多层布线基板集成多颗裸芯片,实现功能模块的紧凑集成,而CSP芯片尺寸封装则通过封装尺寸与芯片尺寸的1:1匹配,将封装厚度压缩至0.5mm以下,支撑移动设备的轻薄化需求。近年来,Chiplet技术的成熟进一步突破单芯片物理极限,通过硅桥(EMIB)、混合键合(Hybrid Bonding)等异构集成方案,实现CPU、GPU、AI加速器等芯粒的模块化组合,在提升计算性能的同时降低制造成本。
当前,微电子封装正朝“系统级集成”方向加速演进。玻璃基板凭借低翘曲度与高布线密度优势,在HBM4封装中实现16-Hi堆叠的量产突破;液态金属导热材料与石墨烯-铜复合散热结构的应用,使高功耗芯片的热导率大幅提升,解决“热墙”问题;硅光子与CMOS工艺的集成,则通过共封装光学(CPO)技术将光模块与芯片的距离缩短至毫米级,使数据传输速率突破800Gbps,支撑5G基站与数据中心的高带宽需求。环保封装方面,水性环氧树脂与无铅焊料的普及推动VOCs排放降低,生物基环氧塑封料通过AEC-Q100认证,在保持电气性能的同时实现碳足迹减少,适配新能源汽车与可再生能源设备的绿色制造需求。这种技术演进与产业需求的深度融合,将持续驱动封装技术在后摩尔时代创造新的价值增长点。
-
半导体
+关注
关注
339文章
31192浏览量
266321 -
封装技术
+关注
关注
12文章
605浏览量
69358 -
微电子封装
+关注
关注
1文章
32浏览量
7284
原文标题:现代微电子器件封装技术
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录



 现代微电子器件封装技术的发展历程和基本类型
现代微电子器件封装技术的发展历程和基本类型



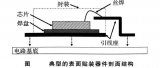

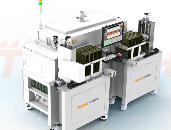



评论