倾佳电子SiC碳化硅MOSFET开关行为深度解析,特别是其本征体二极管的关断特性

倾佳电子(Changer Tech)是一家专注于功率半导体和新能源汽车连接器的分销商。主要服务于中国工业电源、电力电子设备和新能源汽车产业链。倾佳电子聚焦于新能源、交通电动化和数字化转型三大方向,并提供包括IGBT、SiC MOSFET、GaN等功率半导体器件以及新能源汽车连接器。
倾佳电子杨茜致力于推动国产SiC碳化硅模块在电力电子应用中全面取代进口IGBT模块,助力电力电子行业自主可控和产业升级!
倾佳电子杨茜咬住SiC碳化硅MOSFET功率器件三个必然,勇立功率半导体器件变革潮头:
倾佳电子杨茜咬住SiC碳化硅MOSFET模块全面取代IGBT模块和IPM模块的必然趋势!
倾佳电子杨茜咬住SiC碳化硅MOSFET单管全面取代IGBT单管和大于650V的高压硅MOSFET的必然趋势!
倾佳电子杨茜咬住650V SiC碳化硅MOSFET单管全面取代SJ超结MOSFET和高压GaN 器件的必然趋势!

1. 碳化硅(SiC)的基础优势
倾佳电子首先将深入探讨碳化硅(SiC)与传统硅(Si)器件的根本区别,这些区别构成了SiC MOSFET卓越开关性能的物理和材料基础。理解这些基础特性是掌握其复杂动态行为的先决条件。
1.1 材料科学:宽禁带的优势
碳化硅之所以能带来革命性的性能提升,核心在于其宽禁带半导体特性。SiC的禁带能量约为3.26 eV,几乎是硅(1.12 eV)的三倍,这使其能够承受更高的能量而不会发生击穿 。此外,SiC的击穿电场强度高达2至4 MV/cm,比硅高出一个数量级左右 。这一关键特性使工程师能够设计出更薄、掺杂浓度更高的漂移层,从而在给定的耐压等级下,显著降低器件的导通电阻( RDS(on)) 。这种直接的物理优势解释了SiC MOSFET在高压应用中如何实现远低于传统硅器件的导通损耗。
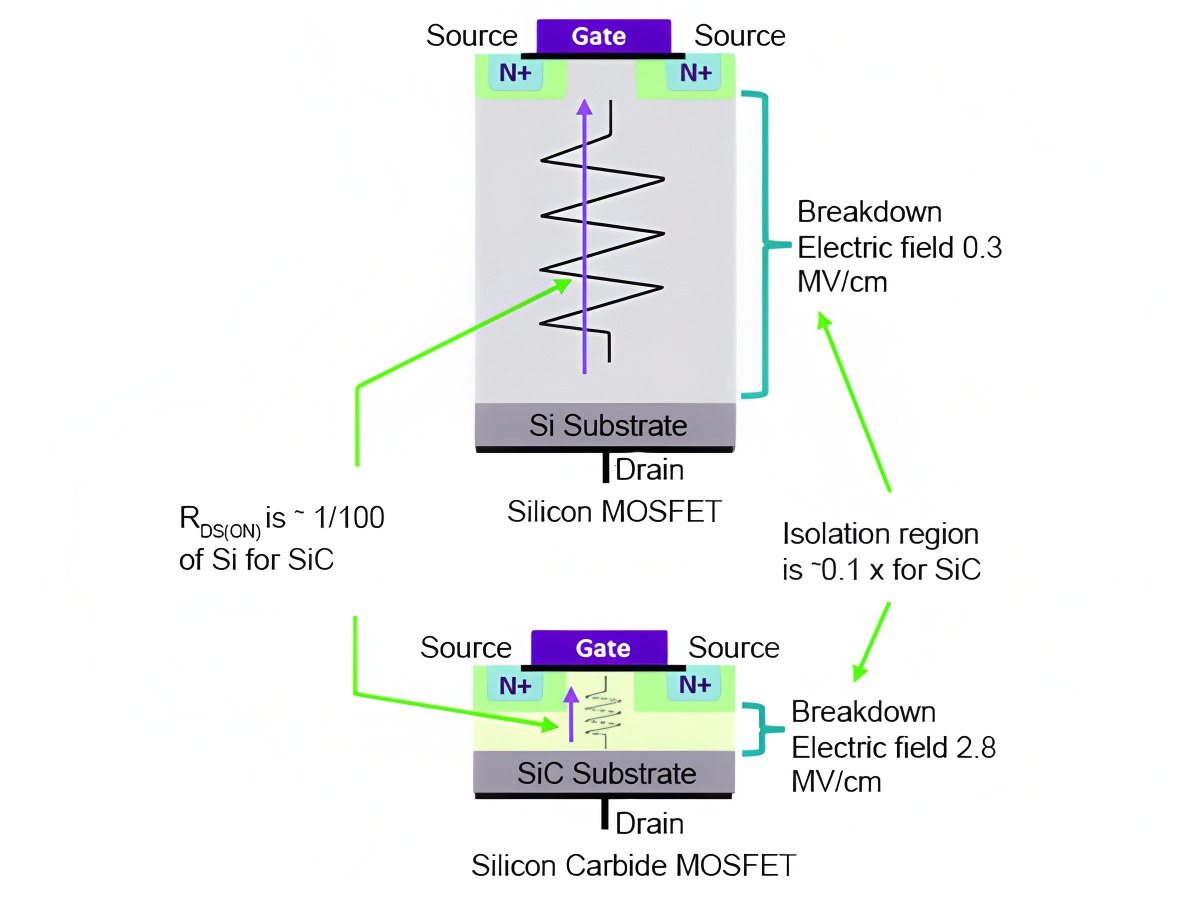
除了电学性能,SiC还具备卓越的导热性能,其导热系数约为硅的三倍 。这种优越的导热性使得器件产生的热量能够更有效地消散,降低了热阻,从而允许更紧凑的电路设计,减少甚至取消庞大的散热器和复杂的冷却系统 。SiC材料的高禁带能量还使其能够承受更高的结温,通常在175°C至200°C之间稳定工作,远超硅器件150°C的最高工作温度限制 。
SiC MOSFET本质上是一种单极性多数载流子器件,这使其能够实现比双极性导通的Si IGBT快得多的开关速度 。这种根本性的载流子机制差异是SiC MOSFET实现几十纳秒甚至更短开关转换时间的核心原因,而相同电压等级的IGBT则需要几百纳秒甚至微秒的转换时间 。正是这种显著的开关速度提升,使得SiC MOSFET的开关损耗( E_{on}和E_{off})大幅降低,从而在给定频率下实现更高的效率 。


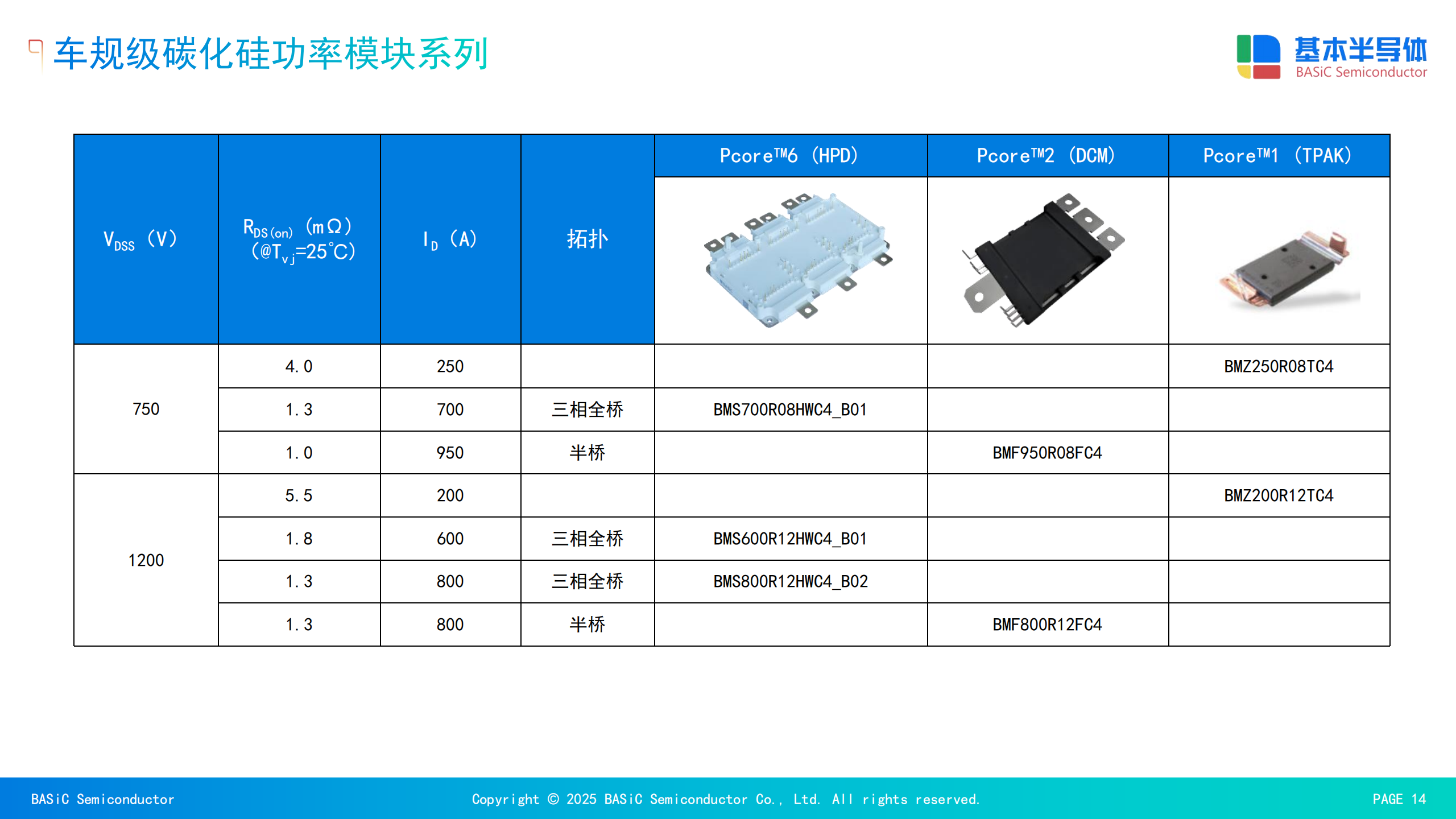
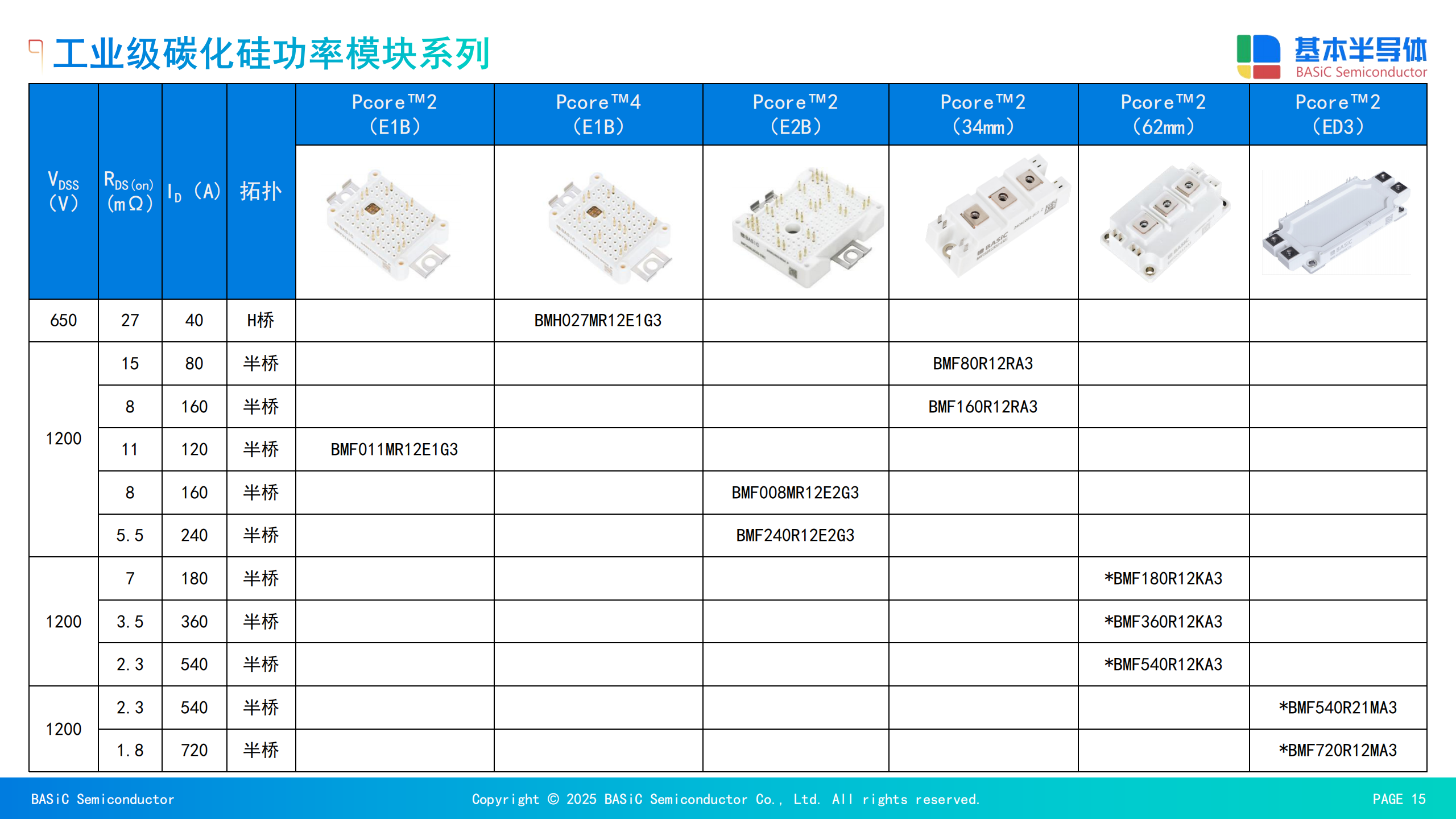
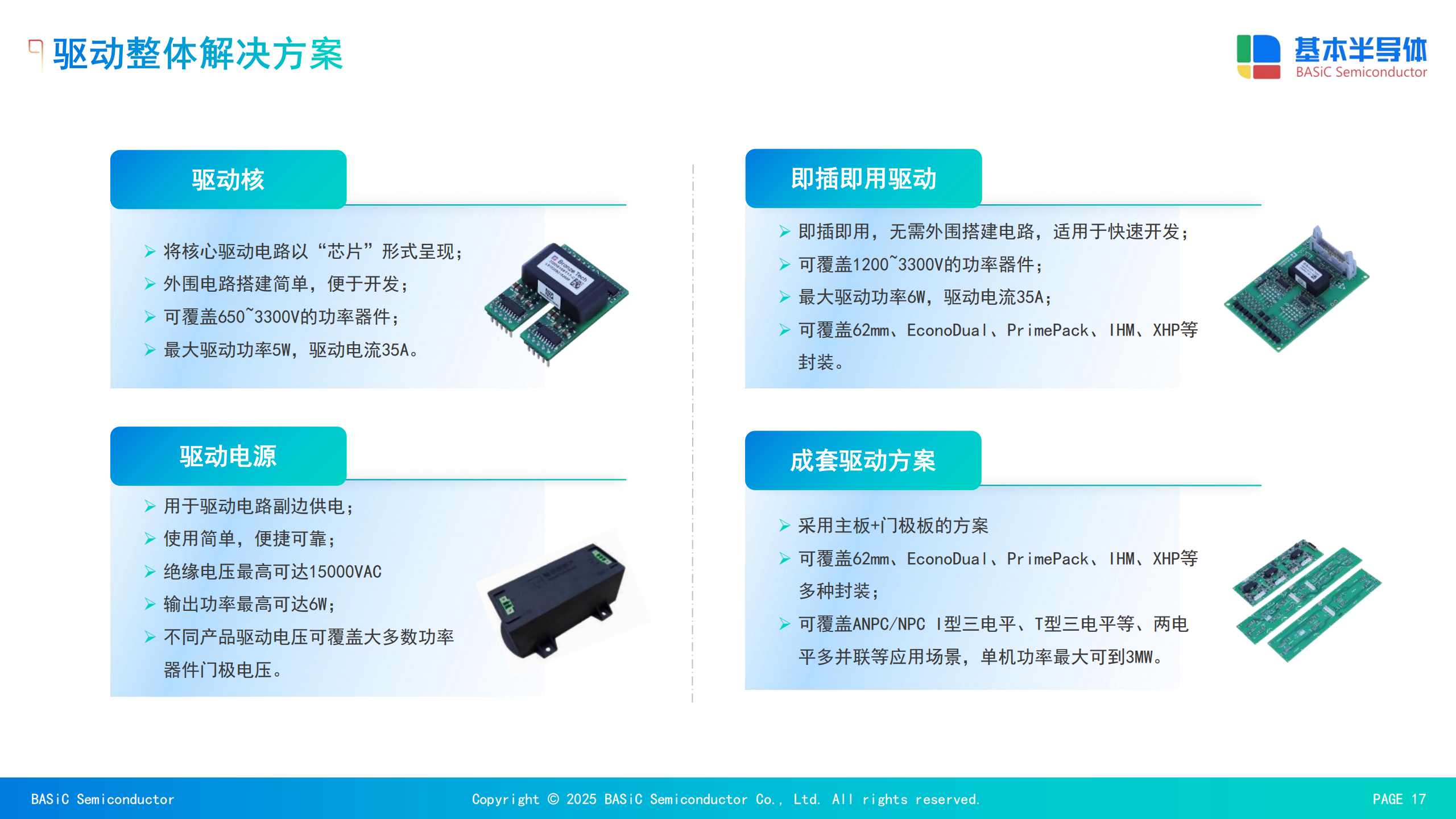
1.2 SiC MOSFET的架构与关键电学特性
SiC MOSFET是一种电压控制型器件,其导通状态下表现出纯电阻特性,这与IGBT的导通电压“膝点”(voltage knee)不同 。这种特性简化了导通损耗的建模,因为损耗可以简单地通过I^2 cdot R_{DS(on)}来估算 。此外,商用SiC MOSFET的额定电压通常在1200 V至1700 V之间,而Si MOSFET通常在900 V处达到极限 。
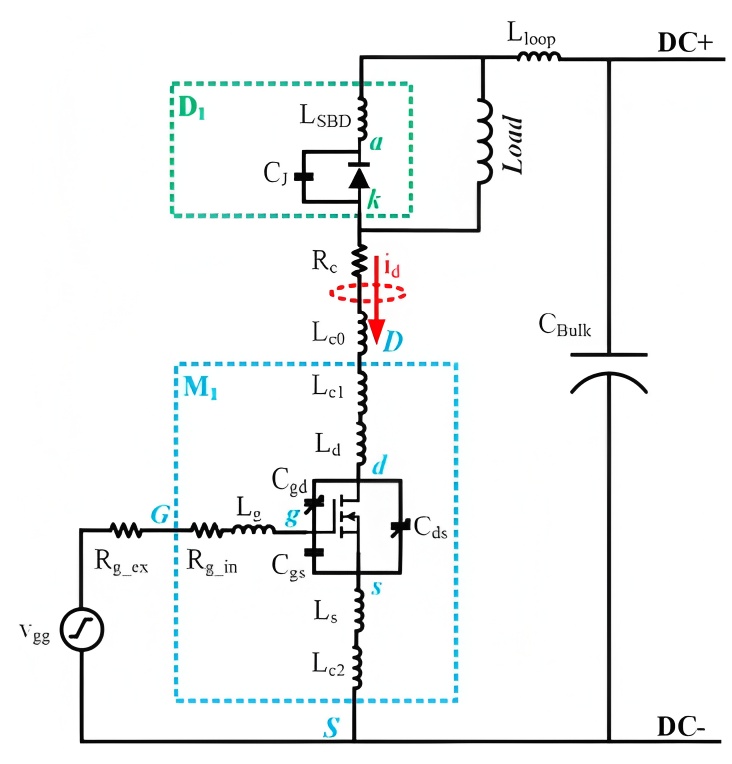
SiC器件的栅极电荷(Qg)特性显著优于其硅基同类产品,这使得栅极驱动损耗更低 。器件的低栅极电荷和电容(特别是输入电容 C_{iss}和米勒电容C_{gd})是其实现超快速开关转换的物理基础 。然而,这种内在的高速能力也带来了一个权衡:为了充分利用其性能,栅极驱动电路必须能够提供非常大、峰值电流高的源/吸电流,并实现纳秒级的快速上升和下降沿 。这直接导致了高di/dt和dV/dt,这不仅增加了电磁干扰(EMI)和潜在的电压过冲,也对系统设计提出了更高的要求 。对于从硅器件过渡到SiC器件的设计者来说,一个不明显的但至关重要的差异是,为了实现与硅器件相同的dV/dt,SiC器件可能需要10到20倍更高的栅极电阻 。
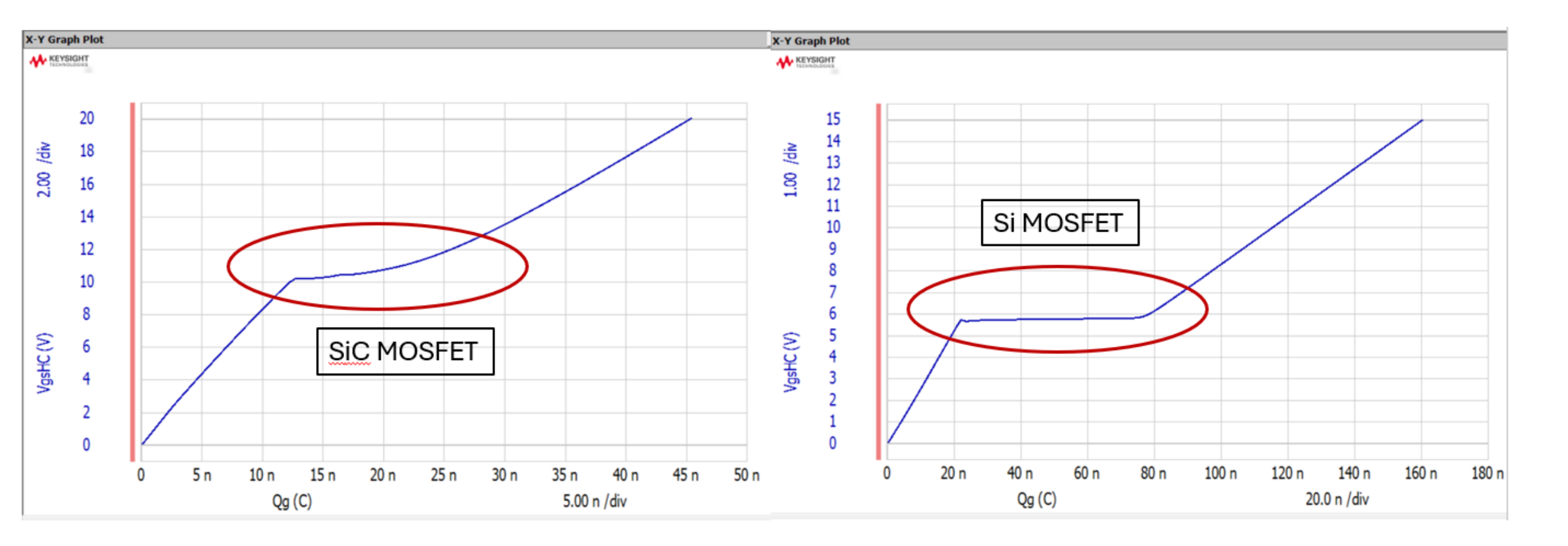
2. SiC MOSFET开关的核心动态
本章节将从材料特性层面转向器件的动态开关过程,定义损耗机制并阐述SiC器件独特的驱动要求。
2.1 开关原理与损耗机制
开关损耗是功率器件在导通和关断转换过程中,漏源电压(VDS)和漏电流(ID)重叠所产生的能量损耗 。导通损耗( Eon)和关断损耗(Eoff)分别通过对V_{DS}和I_D在相应转换期间的乘积进行积分来计算 。在任何高频应用中,开关损耗都是总功耗的主要组成部分 。
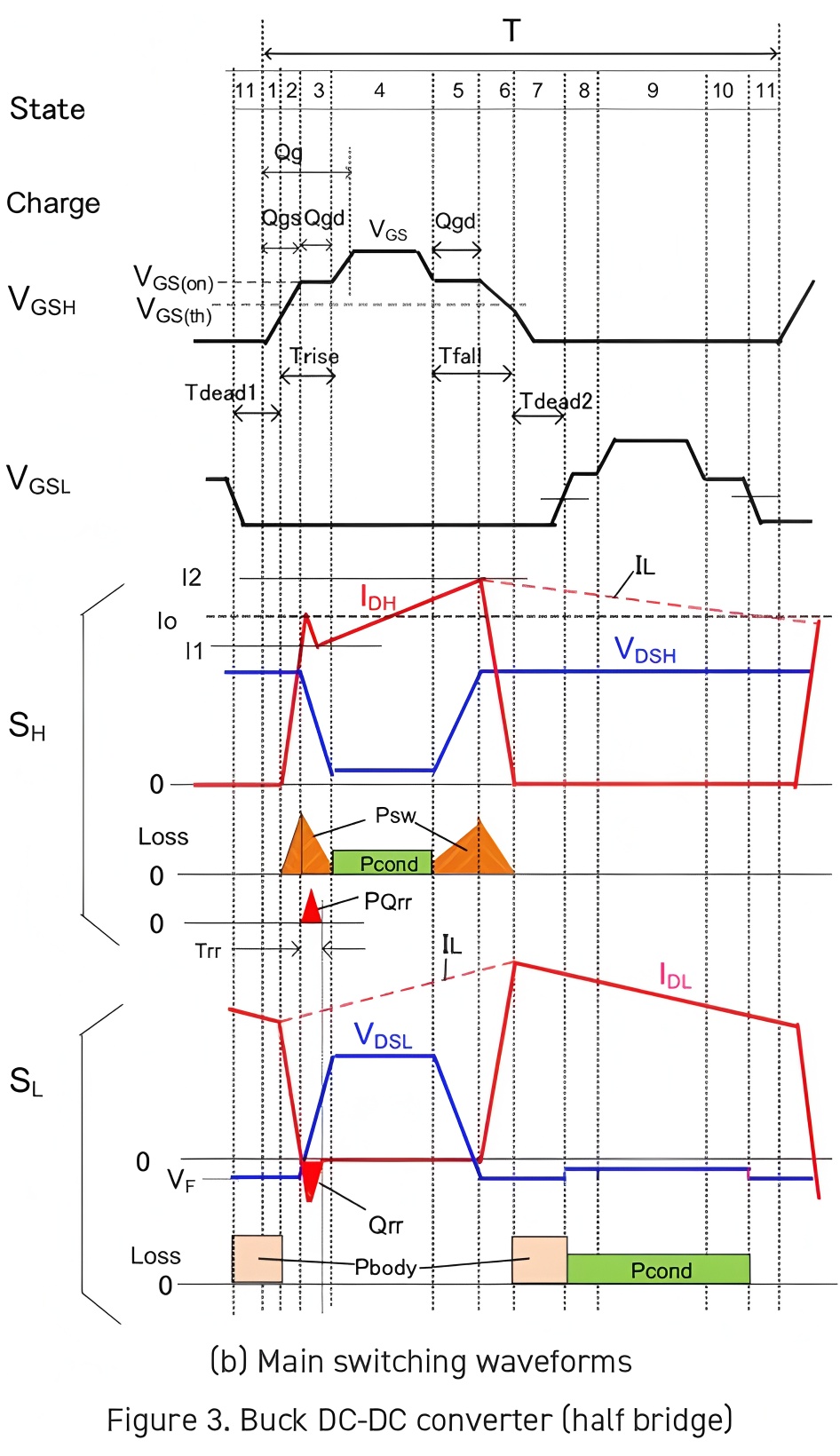
SiC MOSFET之所以能大幅降低开关损耗,根本原因在于其能够实现极短的转换时间 。这种显著的提速是其单极性导通机制和较低寄生电容的直接结果 。更低的开关损耗又构成了一个正向反馈循环:它允许更高的开关频率,这反过来使得电路中的无源元件(如电感和电容)可以做得更小 。最终结果是更高的功率密度和更紧凑的系统设计 。
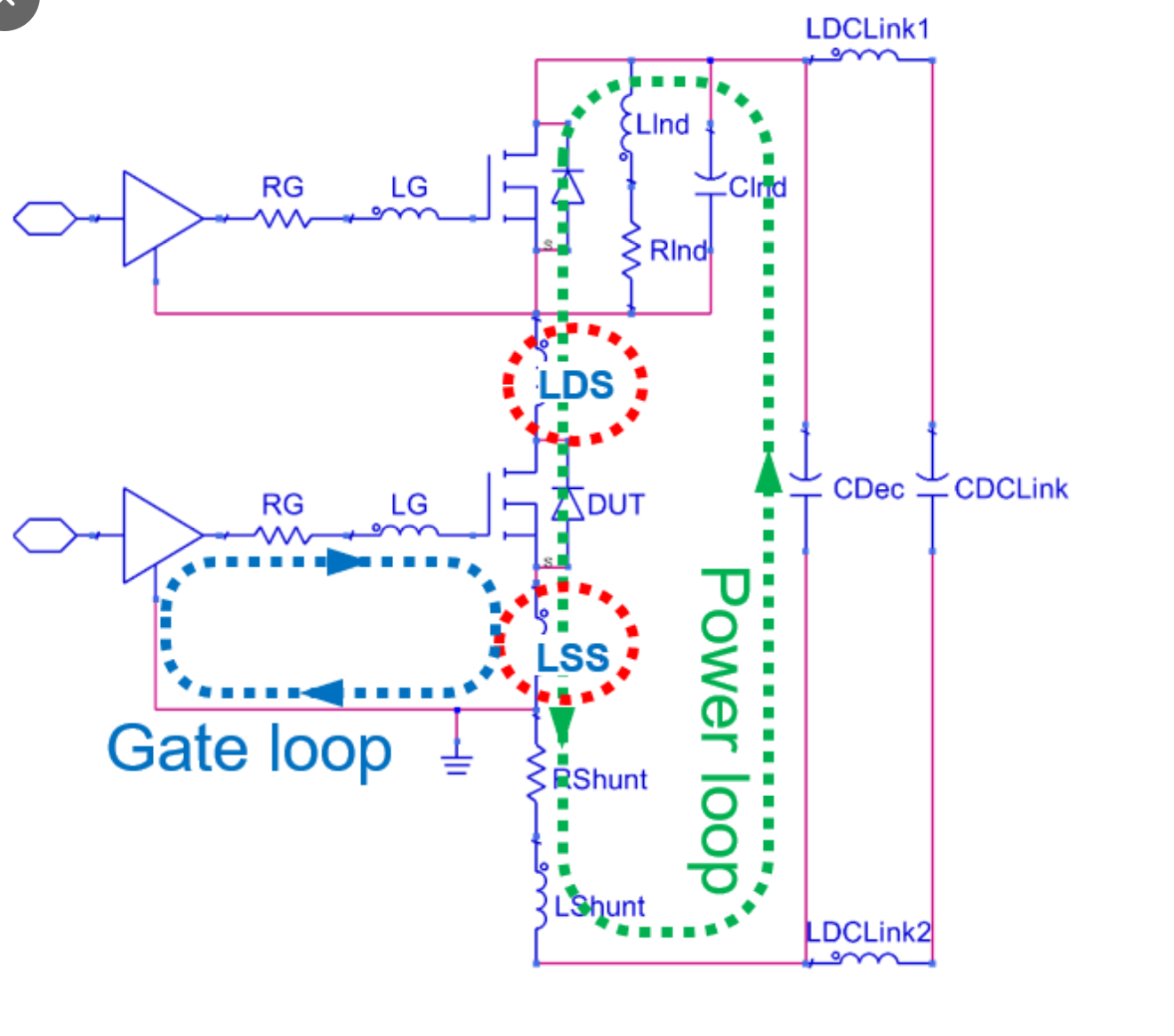
2.2 栅极驱动电路的关键作用
SiC MOSFET的栅极驱动要求非常独特。为了实现最低的导通电阻,通常需要不对称的栅极驱动电压,例如在导通时为+18 V至+20 V,在关断时施加负偏压,通常为-2 V至-5 V 。一些器件甚至可以承受+25 V/-10 V的宽电压摆幅 。
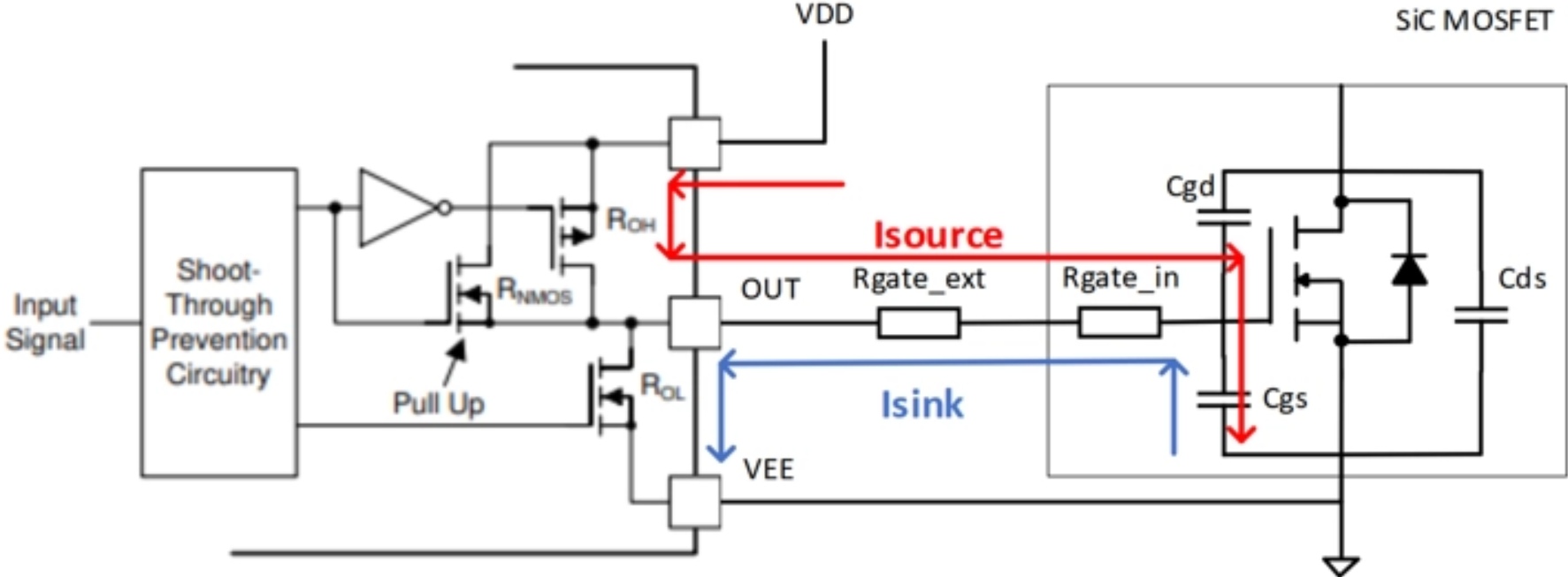
负栅极电压在设计中至关重要,因为SiC MOSFET的栅极阈值电压(Vth)非常低,可能低至1 V 。在半桥或桥式拓扑中,当对侧开关导通时,主开关的漏源电压( VDS)会以极高的dV/dt上升。如果没有负偏压,这种dV/dt变化会通过米勒电容(Cgd)在栅极上耦合出正电压尖峰,这可能导致寄生导通,从而引发灾难性的直通故障(shoot-through) 。因此,负偏压是确保器件在高速开关条件下可靠性的必要条件。
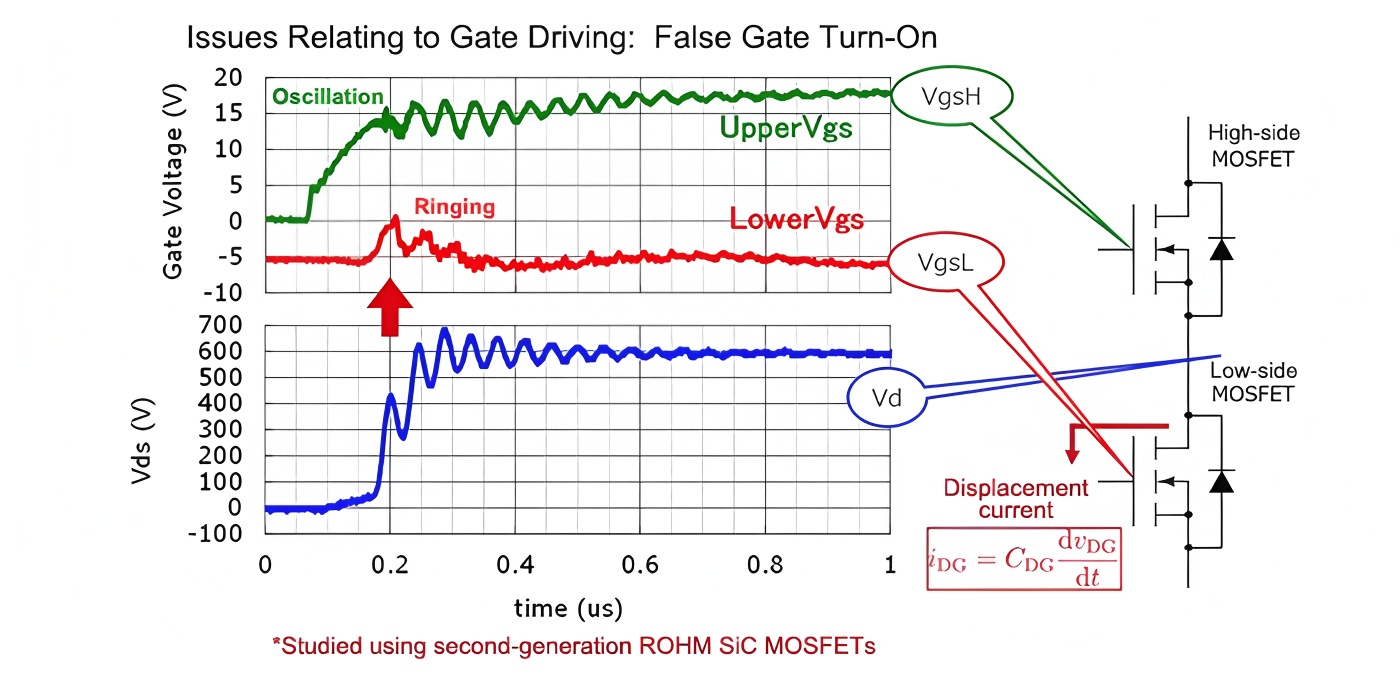
为了实现高效、高速的开关,栅极驱动电路必须具备极低的输出阻抗,以能够提供大的峰值源电流和吸电流,从而快速充放电栅极电容 。此外,栅极电压的上升和下降沿必须在几纳秒量级,以最大限度地减少开关损耗 。这在设计中引入了一个重要的权衡:尽管高速dV/dt有利于降低开关损耗,但它也会产生过高的EMI和电压过冲 。通过增加外部栅极电阻( Rg),可以“软化”开关转换,降低dV/dt和EMI,但代价是开关损耗的增加 。这种复杂的权衡是SiC系统设计的核心挑战之一。
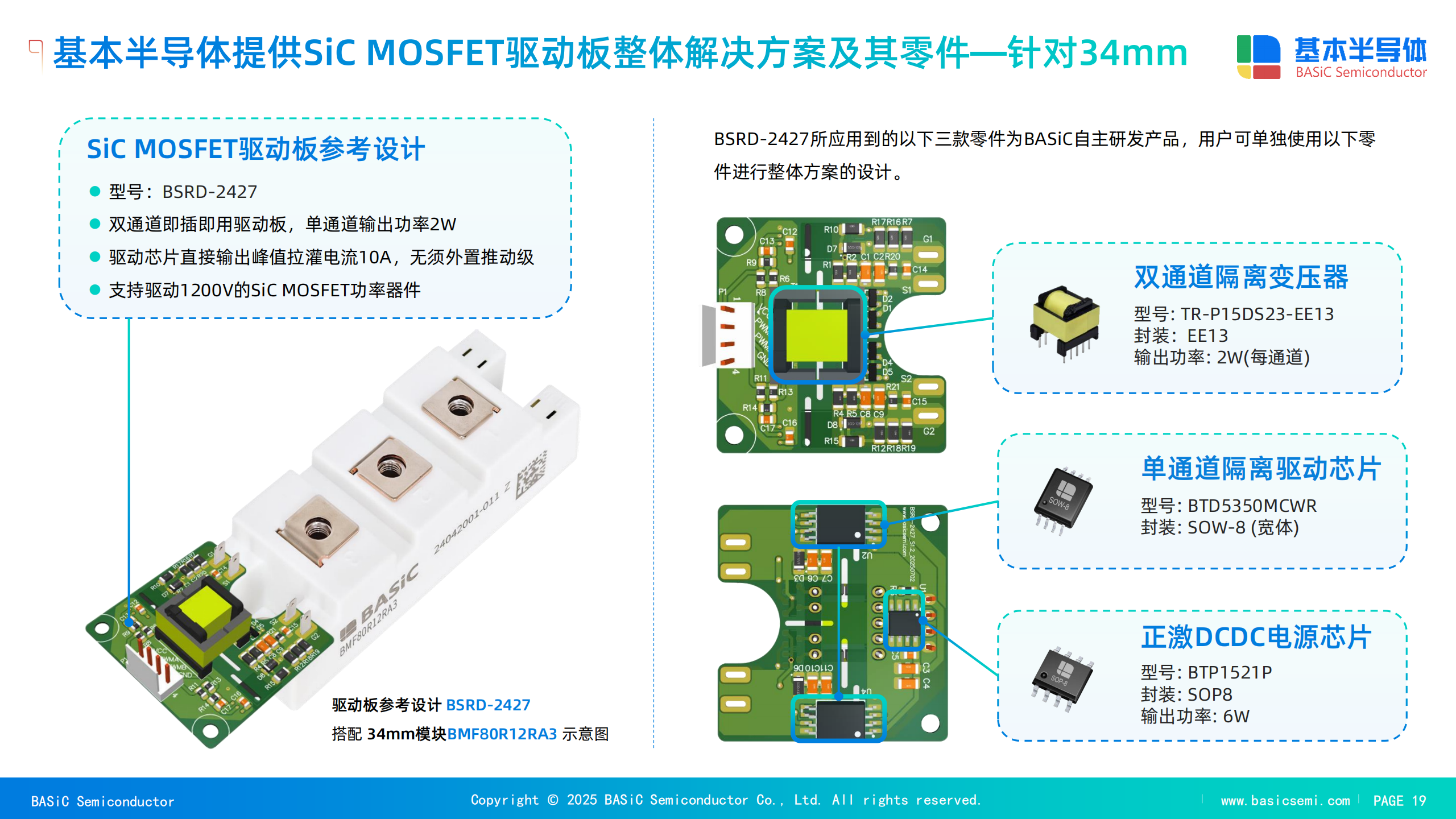
3. SiC MOSFET体二极管:形成与正向导通
本节将介绍SiC MOSFET的本征体二极管,分析其正向导通时的特性及其对系统性能的影响。
3.1 本征体二极管的形成
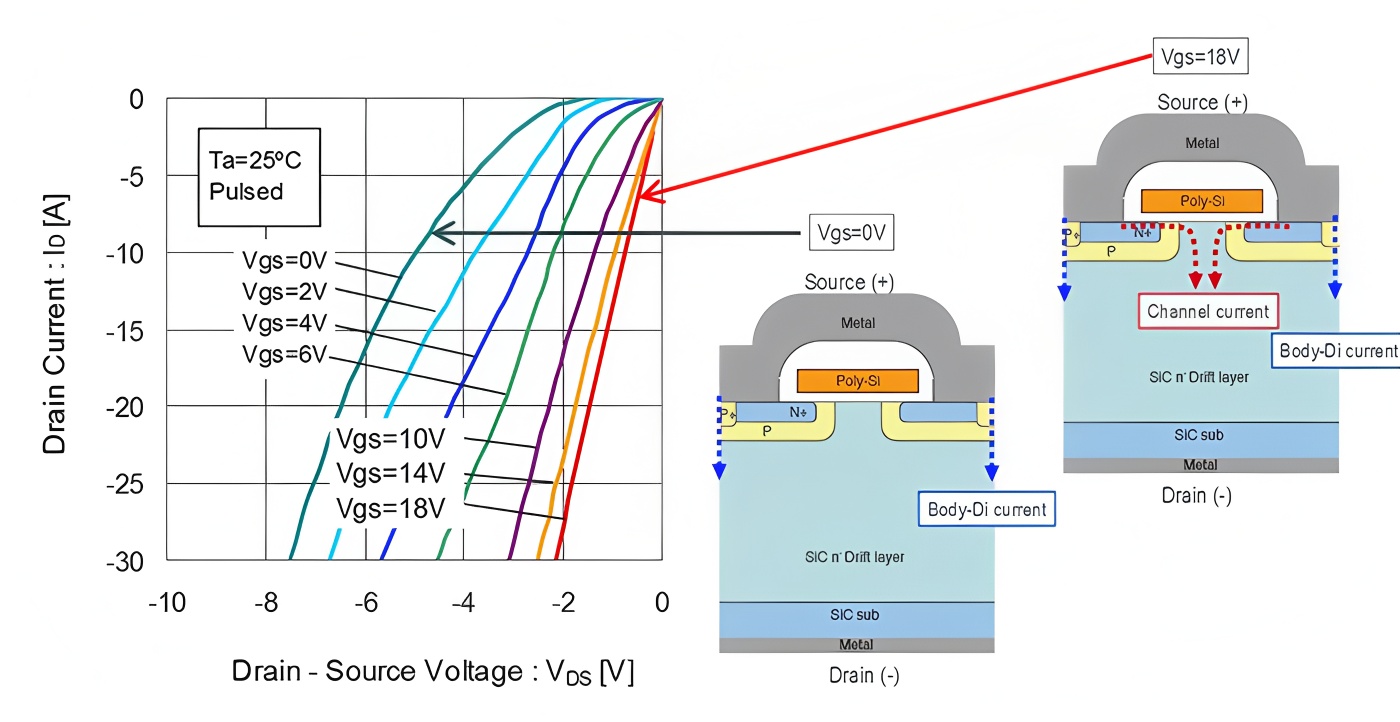
MOSFET结构中天然存在一个寄生二极管,通常被称为体二极管(body diode)或本征二极管(intrinsic diode)。该二极管由P-阱和N-漂移区之间的PN结形成 。与SiC JFET不同,SiC MOSFET的结构中包含了一个内置的体二极管 。在SiC器件中,这个寄生二极管是一种PiN二极管结构 。
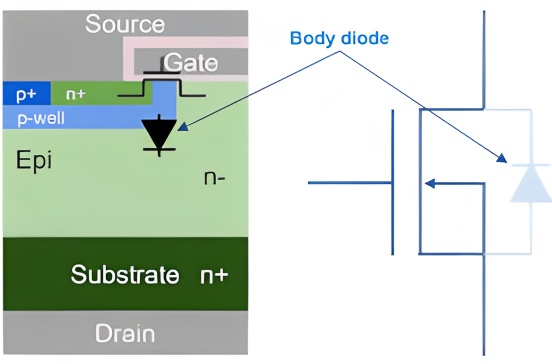
SiC体二极管的一个显著缺点是其高正向压降(VF) 。在SiC MOSFET中,该PN结二极管的 VF可高达4.8 V(在VGS = -5 V、IF = 20 A、25°C条件下),这是SiC宽禁带特性的直接结果 。如此高的压降是导致其在导通时产生可观损耗的主要原因 。
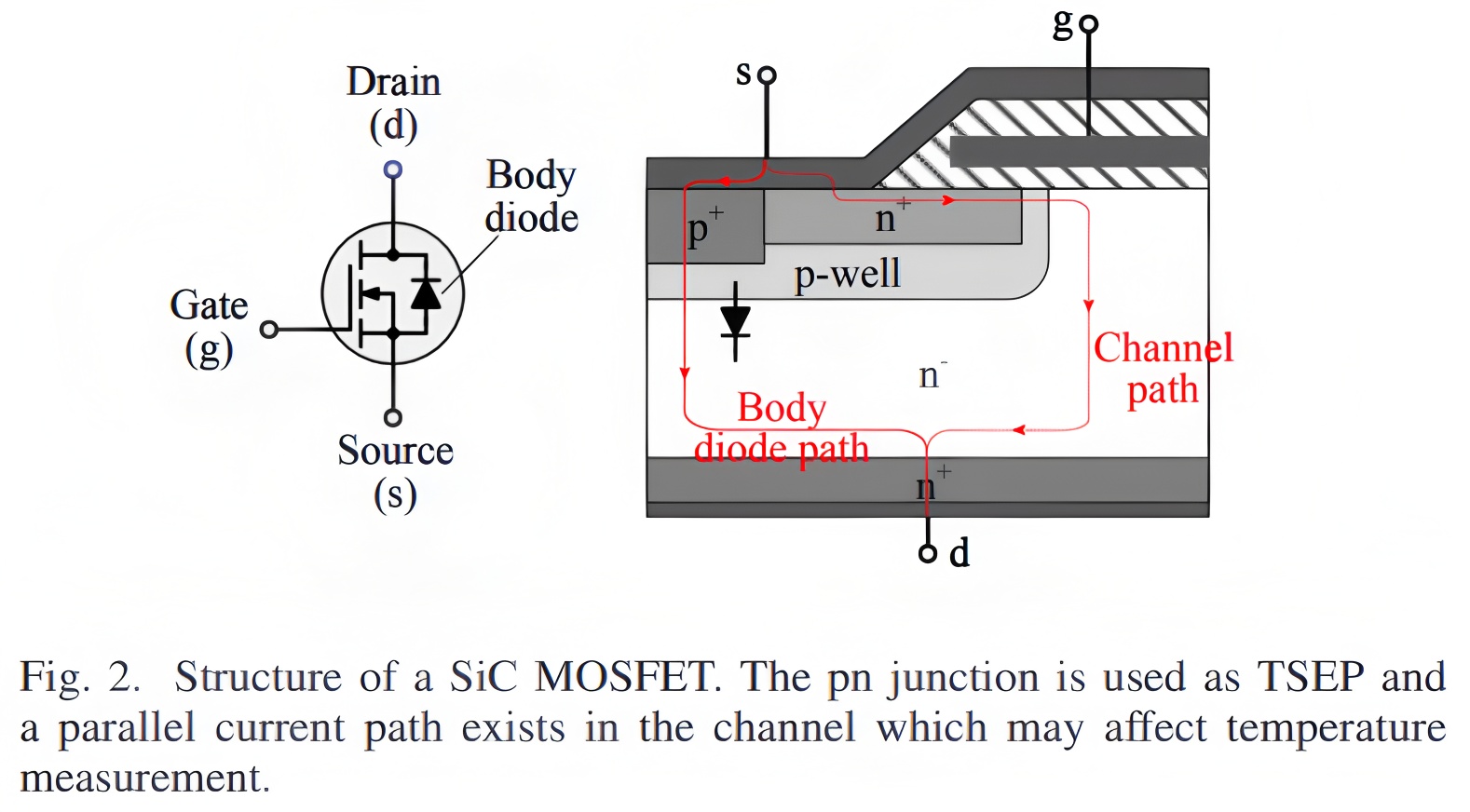
3.2 正向导通与缓解策略
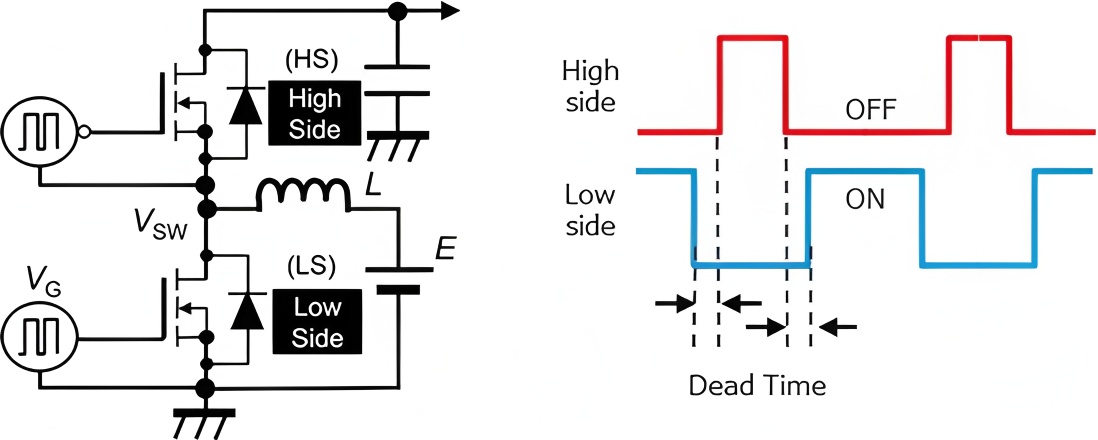
在半桥或全桥拓扑中,体二极管通常在开关器件的“死区时间”(dead time)内充当续流二极管,承载电感电流 。由于SiC体二极管的高
VF会带来显著的导通损耗,这在许多应用中是不可接受的 。
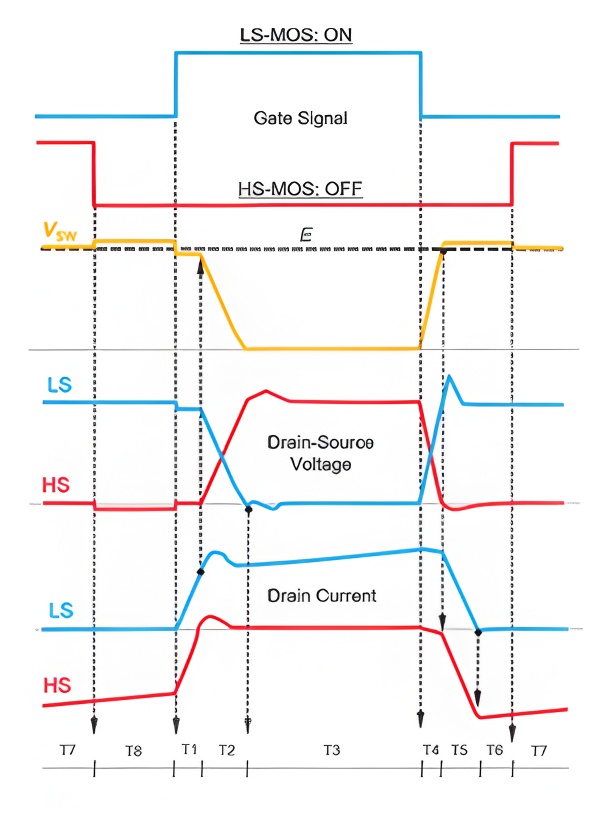
为了缓解这个问题,业界通常采用两种主要策略:
同步整流(Synchronous Rectification):在此模式下,当电流需要反向流过时,器件的栅极会被驱动导通,从而利用低阻抗的MOSFET沟道来分流大部分电流 。这有效地绕过了体二极管,显著降低了导通损耗。
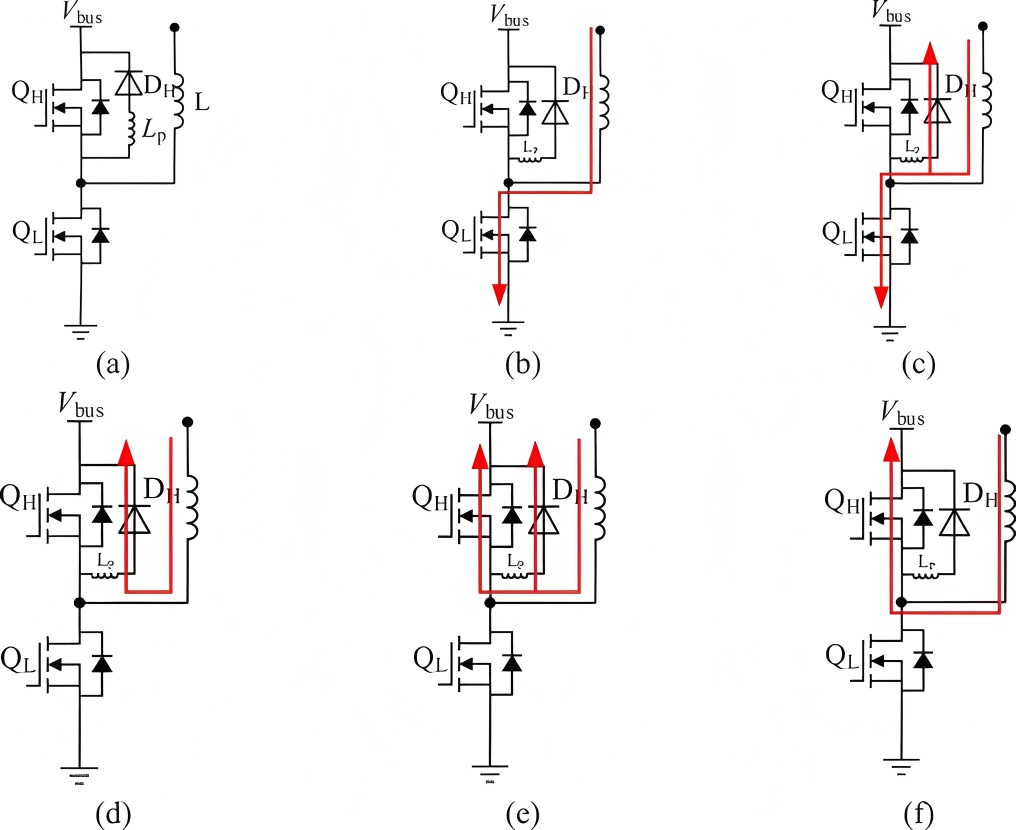
使用反并联肖特基二极管(Anti-parallel Schottky Diode):一种更常见的方法是使用外部或内置的反并联SiC肖特基势垒二极管(SBD)来旁路体二极管 。SiC SBD是一种多数载流子器件,其正向压降显著低于SiC体二极管,通常只有约1.2 V 。
尽管使用SBD可以有效降低导通损耗和反向恢复损耗 ,但它并非没有权衡。SBD的添加会引入额外的非线性电容,这在轻载条件下可能反而会增加开关损耗 。此外,在芯片内部集成SBD还会占用部分MOSFET沟道面积,这可能影响器件的导通电阻和短路耐受能力 。因此,SBD的使用需要根据具体的应用工况进行细致的权衡。
4. SiC MOSFET体二极管的反向恢复:关键分析
本章节是报告的核心,将深入剖析SiC MOSFET体二极管的关断行为,并阐述其对系统性能的深远影响。
4.1 反向恢复的物理与指标
当二极管从正向导通状态切换到反向阻断状态时,其内部存储的少数载流子必须被移除,这个过程称为反向恢复(reverse recovery) 。移除这些载流子的过程包括两个现象:一个是通过反向电流( Irr)流出,另一个是内部复合 。这一过程有三个关键指标:反向恢复电荷( Qrr)、峰值反向恢复电流(Irr)和反向恢复时间(trr) 。
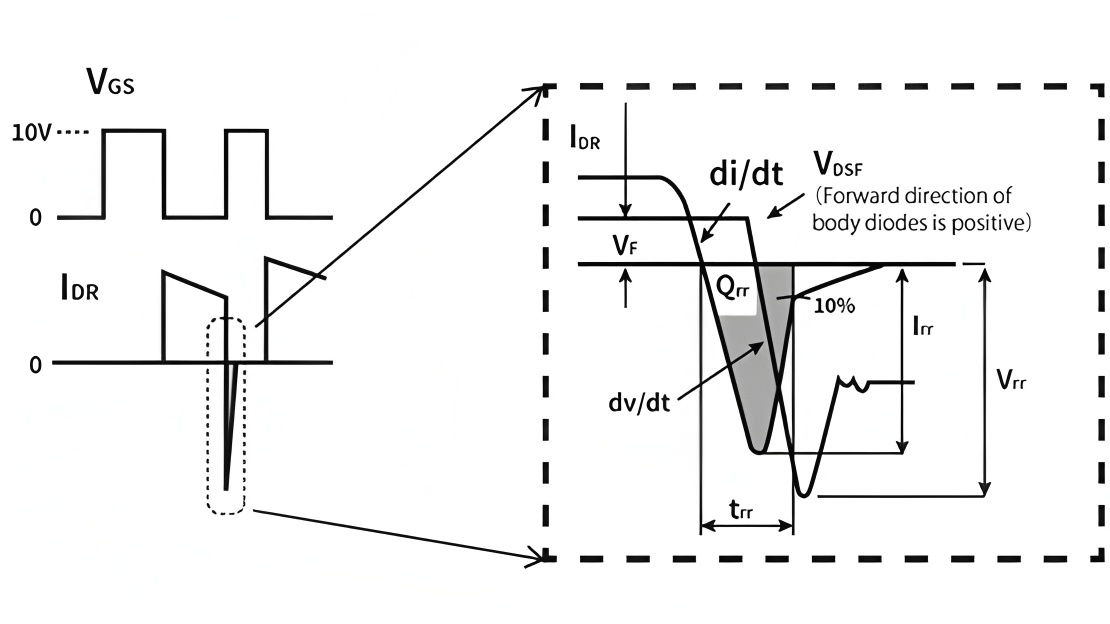
SiC体二极管的反向恢复性能之所以卓越,根本原因在于其材料的物理特性:SiC的少数载流子寿命极短 。这种特性意味着在反向恢复过程中需要清除的存储电荷量非常少,从而使得Q_{rr}极低 。这是SiC体二极管相比Si PN结二极管在动态性能上取得巨大优势的首要原因。
另一个重要的、且微妙的特性是温度依赖性。Si MOSFET的Q_{rr}会随结温升高而显著增加,而SiCMOSFET的Q_{rr}在室温到175°C的宽泛范围内基本保持温度不敏感。然而,在更高的温度下(如超过225°C),载流子寿命可能会急剧增加,从而导致Q_{rr}快速上升 。这个非线性的依赖关系表明,SiC器件并非完全不受温度影响,其特性在极端高温下仍需考虑。
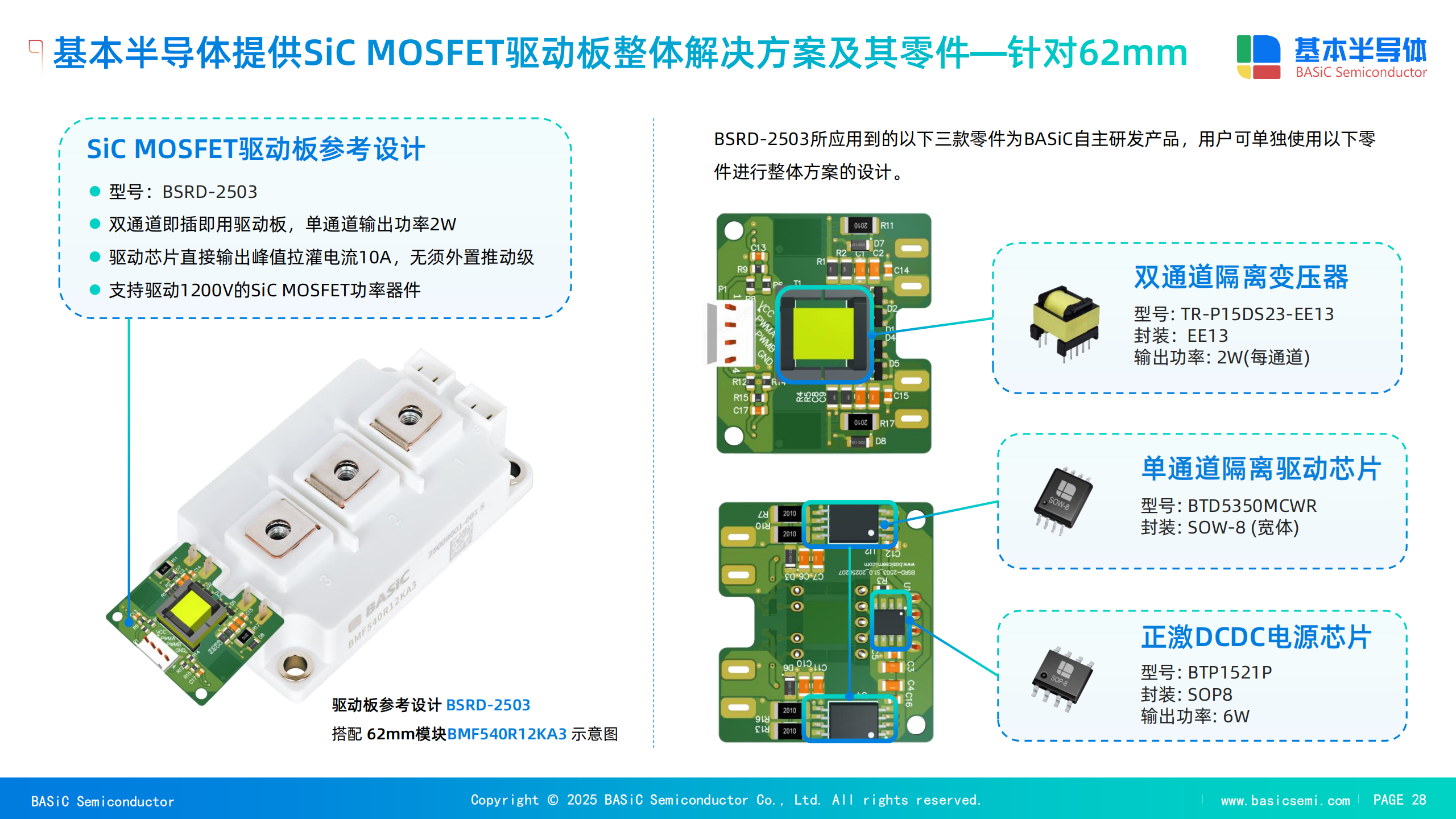
4.2 性能对比与权衡
将SiC体二极管与Si器件和SiC肖特基二极管进行比较,可以更清晰地了解其性能地位。
SiC与Si的比较:SiC体二极管的Q_{rr}比快恢复的Si超结MOSFET低92t_{rr}也比普通Si PN结二极管更快 。许多Si超结MOSFET具有“陡峭”(snappy)的反向恢复行为,这会产生剧烈的电压尖峰和栅极振荡 。相比之下,SiC体二极管展现出“软性”(soft)的反向恢复特性,其dV/dt非常低 。这种软性恢复是其在桥式拓扑中用作续流二极管而无需外部SBD的主要原因之一,因为它能有效避免传统Si器件的灾难性恢复行为 。

SiC体二极管与SiC SBD的比较:专门的SiC SBD具有极低的Qrr(通常小于20 nC),这完全是由结电容而非存储电荷所致 。因此,在反向恢复性能方面,SiC SBD明显优于SiC体二极管 。但值得注意的是,SiC体二极管的反向恢复性能与SiC JBS(结势垒肖特基)二极管相当 。
表2:续流二极管性能比较
| 二极管类型 | 正向压降(VF) | 反向恢复电荷(Qrr) | 反向恢复行为 | Q_{rr}的温度依赖性 |
|---|---|---|---|---|
| Si MOSFET体二极管 | 低 (~0.7-1V) | 高 | 陡峭(Snappy) | 随温度显著增加 |
| SiC MOSFET体二极管 | 高 (~2.5-4.8V) | 极低 | 软性(Soft) | 低温不敏感,高温下增加 |
| SiC 肖特基二极管 | 低 (~1.2-1.7V) | 极低(源于电容) | 软性(Soft) | 基本不敏感 |
4.3 对系统级性能的影响
体二极管的反向恢复对系统性能的影响是多方面的。
首先,它直接导致了互补开关的导通能量损耗(Eon)增加 。在半桥电路中,当一个开关导通时,它必须清除另一个开关体二极管中残留的存储电荷。体二极管的反向恢复电流会叠加到主开关的导通电流上,导致 ID和V_{DS}的重叠面积增大,从而增加E_{on} 。
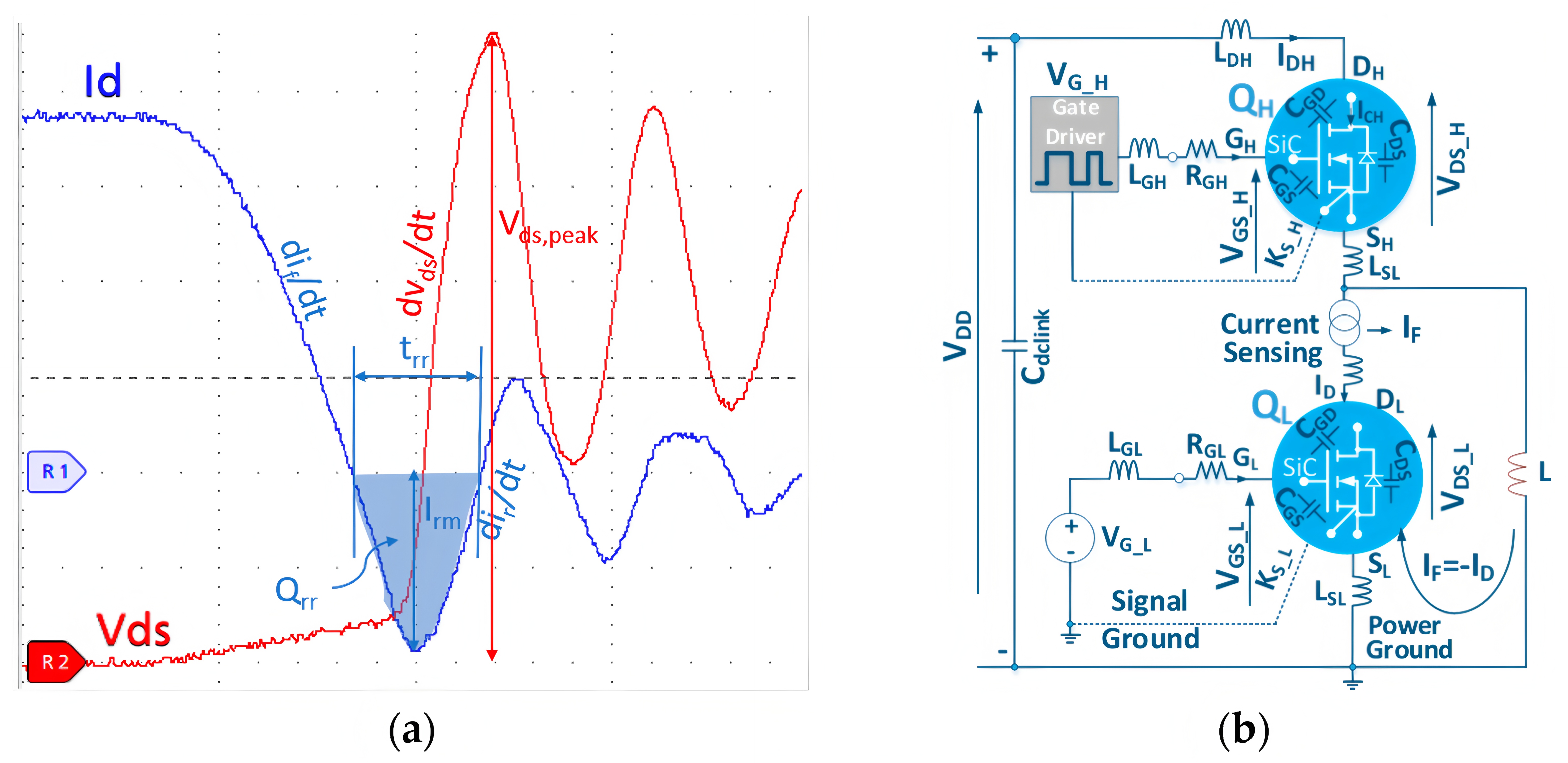
其次,反向恢复过程中高di/dt和dV/dt会导致严重的EMI问题 。这种高dv/dt和高di/dt与电路中的寄生电感相互作用,会产生高频振荡和电压过冲 。这些振荡可能通过米勒效应(Miller coupling)和寄生源电感耦合到栅极信号,从而引起栅极电压的寄生振荡,甚至导致互补开关的意外导通或损坏 。
最后,死区时间的选择与反向恢复性能密切相关。缩短死区时间可以减少体二极管的导通时间,从而降低导通损耗 。在SiC器件中,适当缩短死区时间甚至可以减少存储电荷,使得反向恢复过程更“软” 。然而,如果死区时间过短,也可能导致意想不到的开关行为甚至直通故障 。因此,死区时间是一个需要精心优化的关键参数。
5. 稳健SiC系统设计与优化策略
本节将基于前文的分析,为工程师提供实用的设计建议,以充分发挥SiC技术的优势并确保系统可靠性。
5.1 栅极驱动优化
栅极驱动是控制SiC MOSFET开关行为的关键。如前所述,采用负栅极关断电压是至关重要的,它可以有效防止由高dV/dt引起的米勒效应误导通 。尽管研究表明,相比于0V关断,使用负栅极电压可能会导致更高的峰值反向恢复电流和电荷 ,但这种为了可靠性而做的权衡是值得的。因为防止误导通带来的系统稳定性远比反向恢复的轻微恶化更有价值。
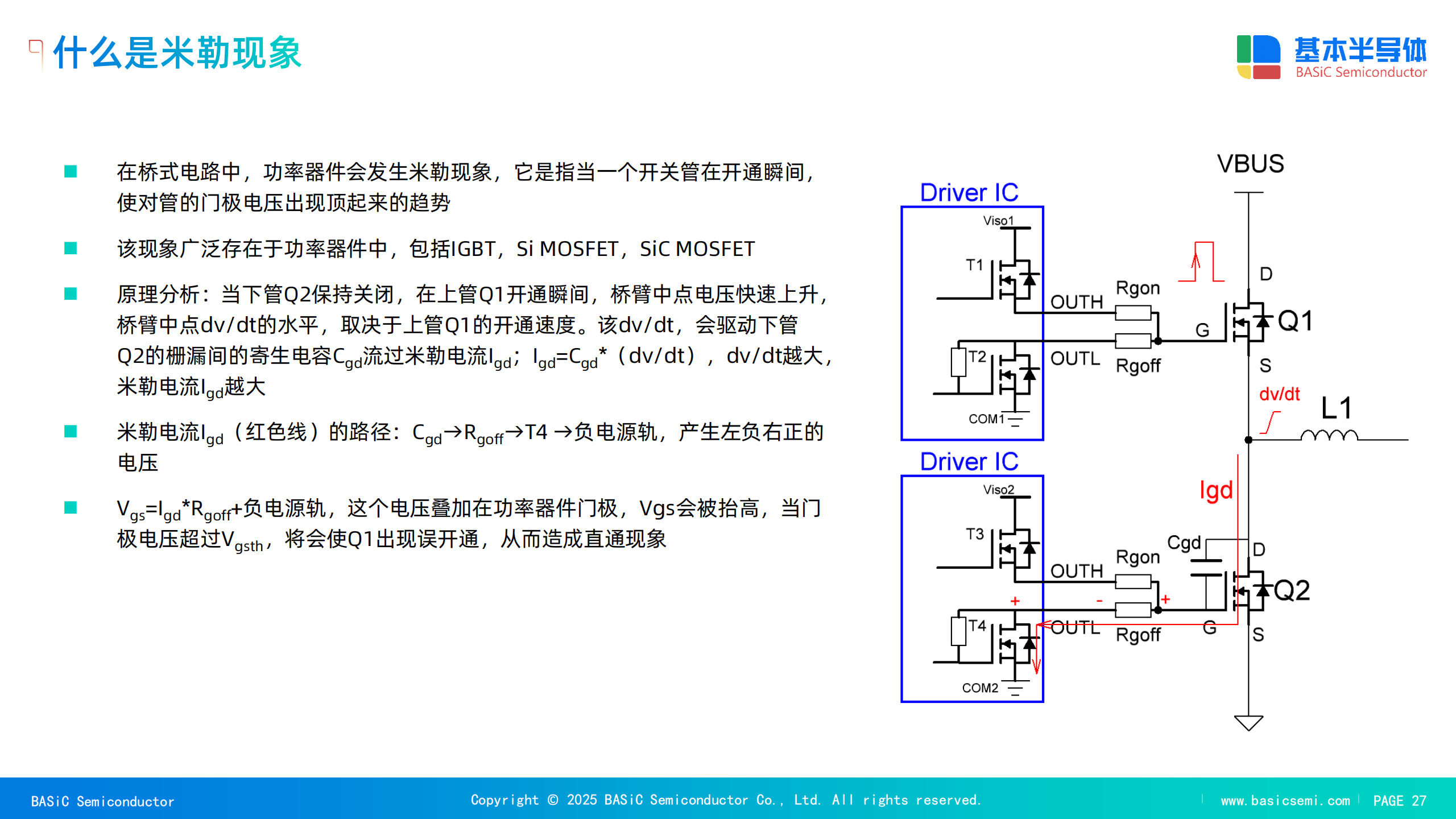

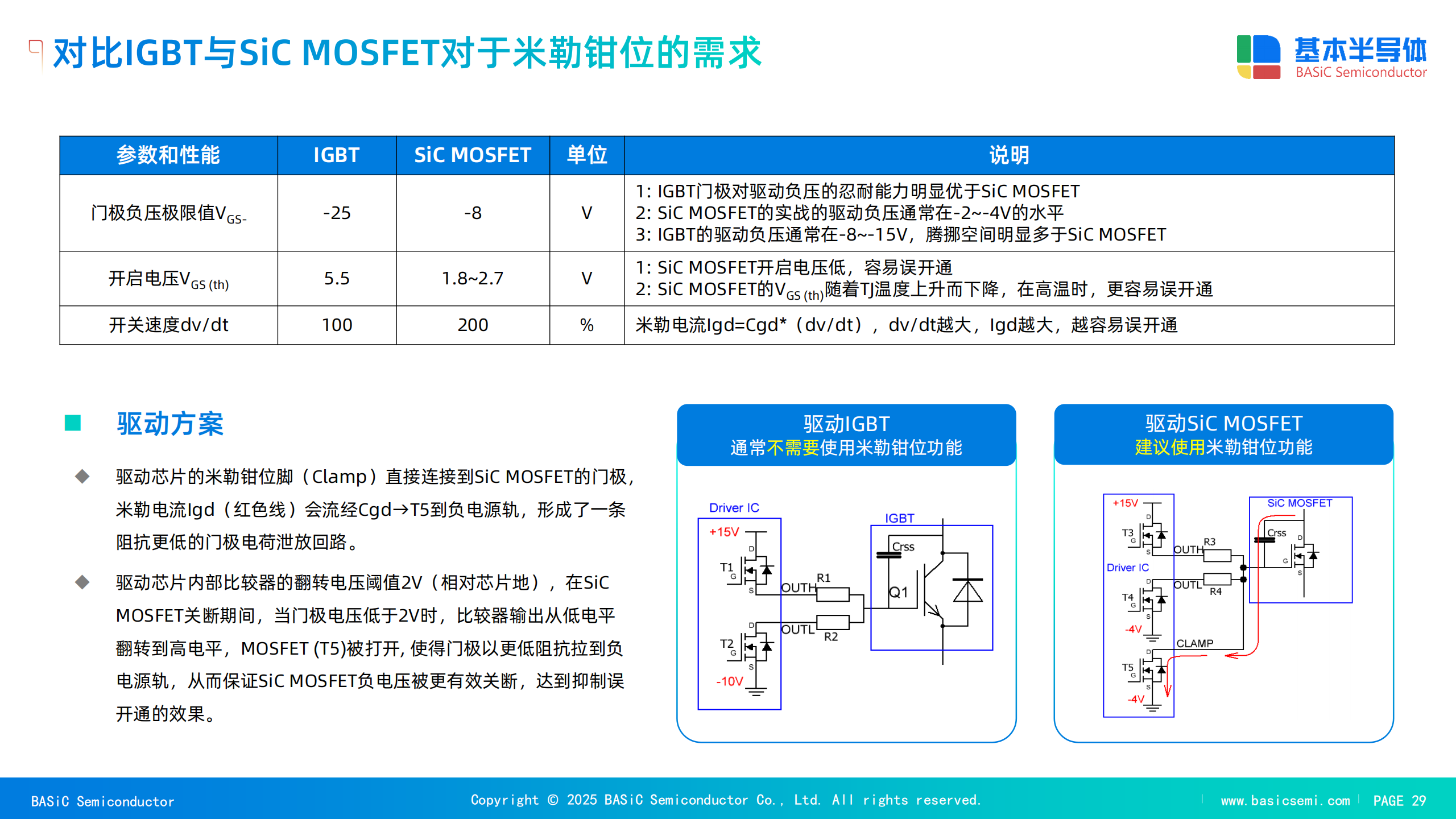
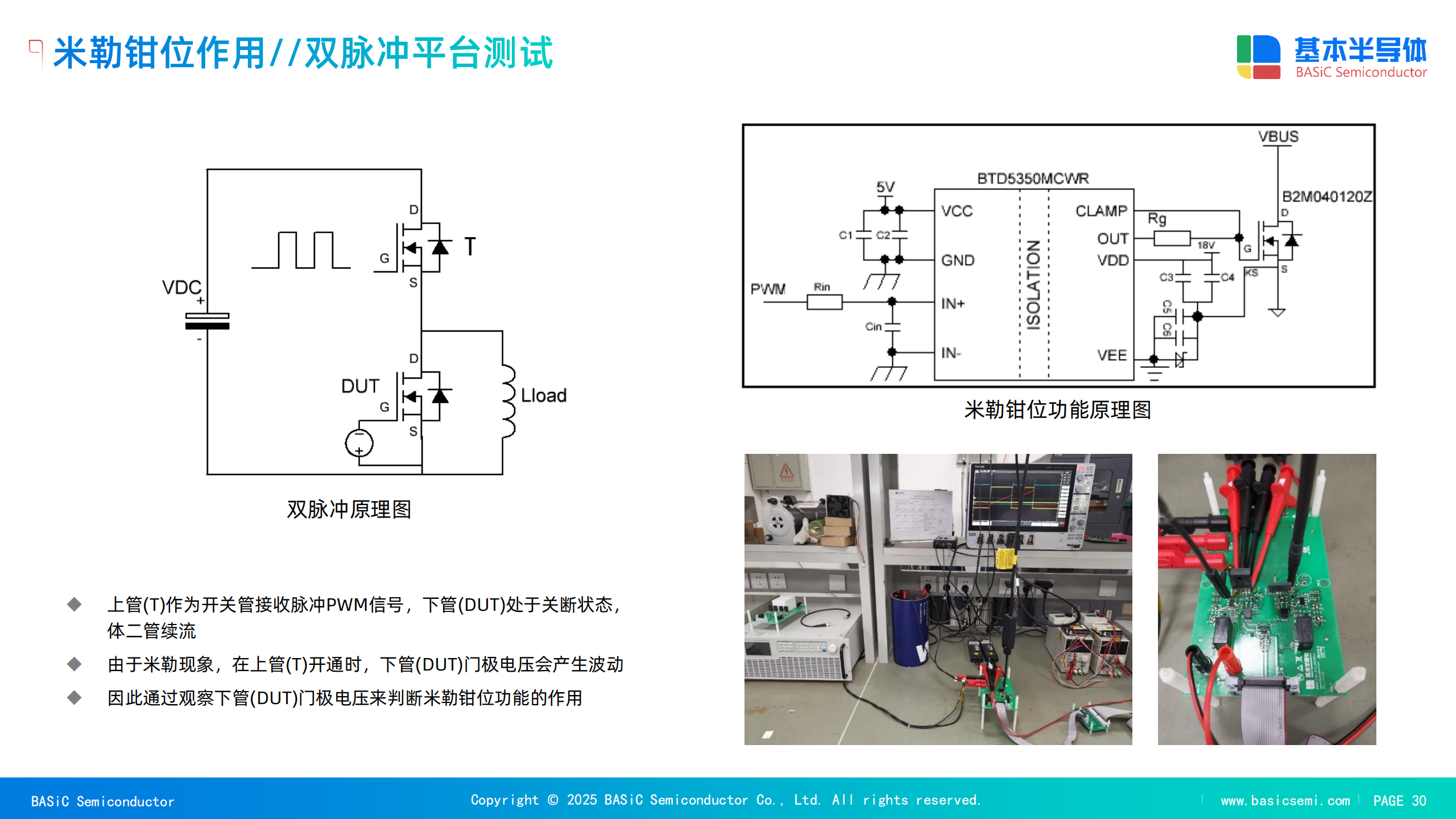

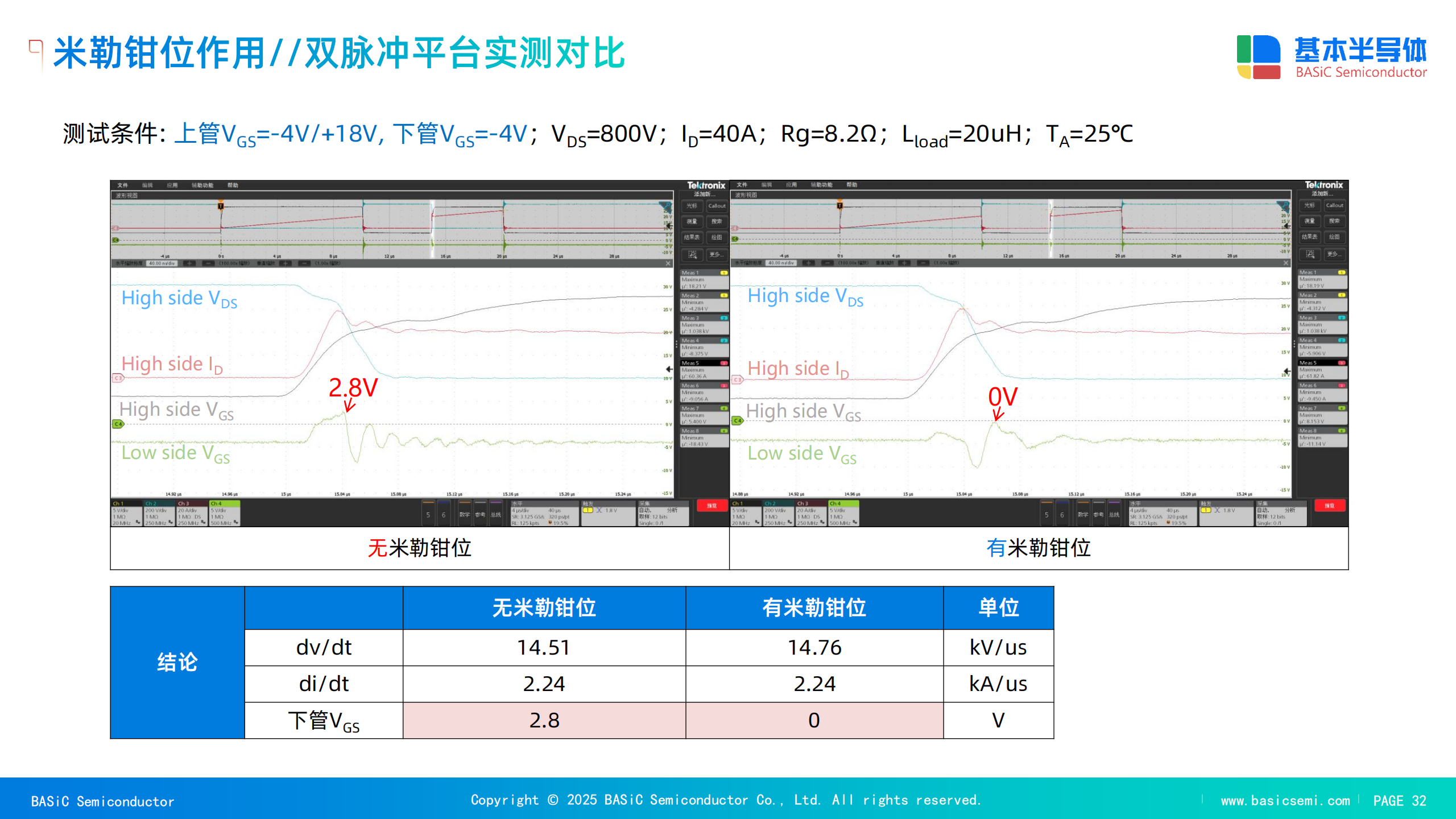
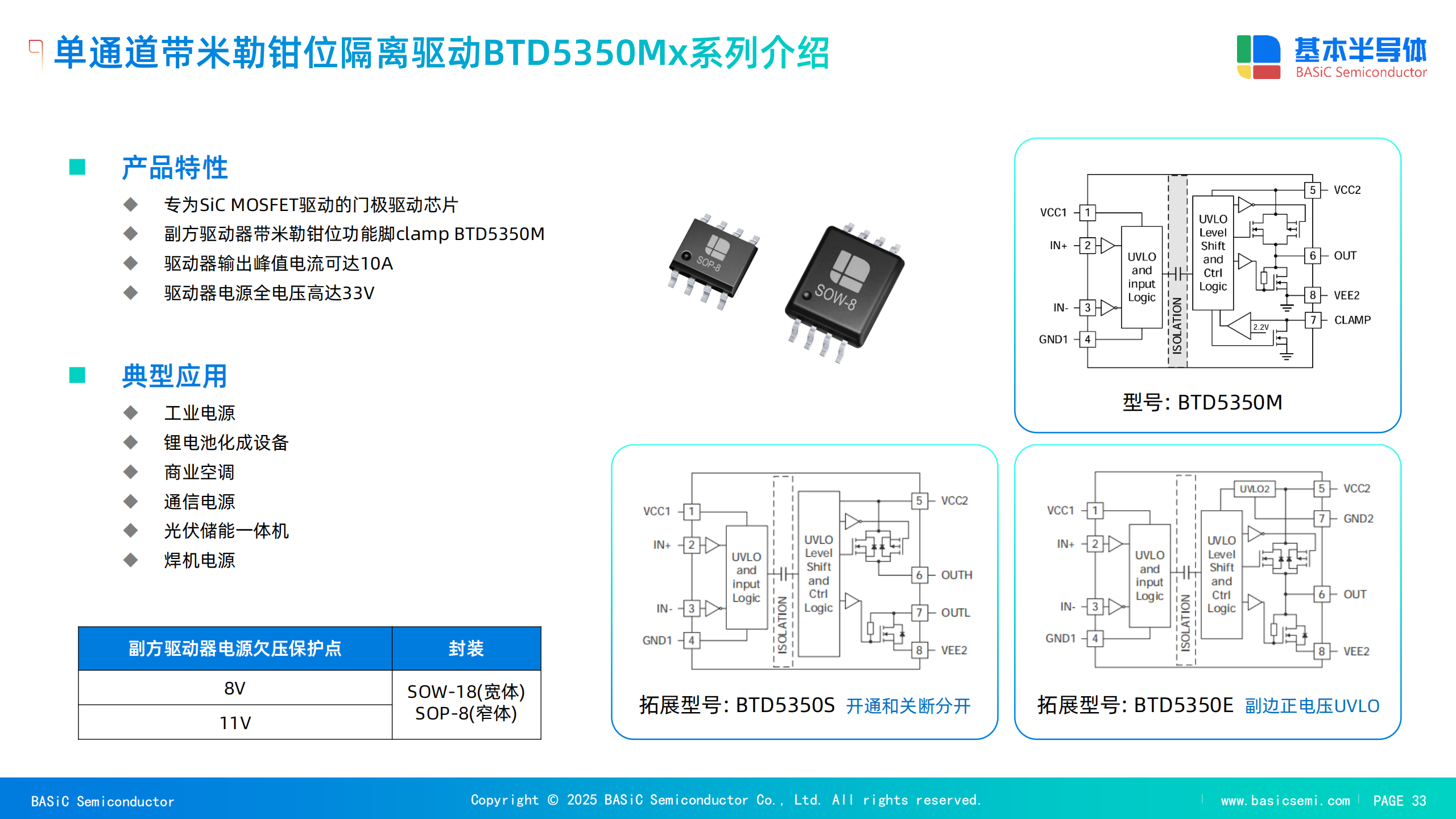
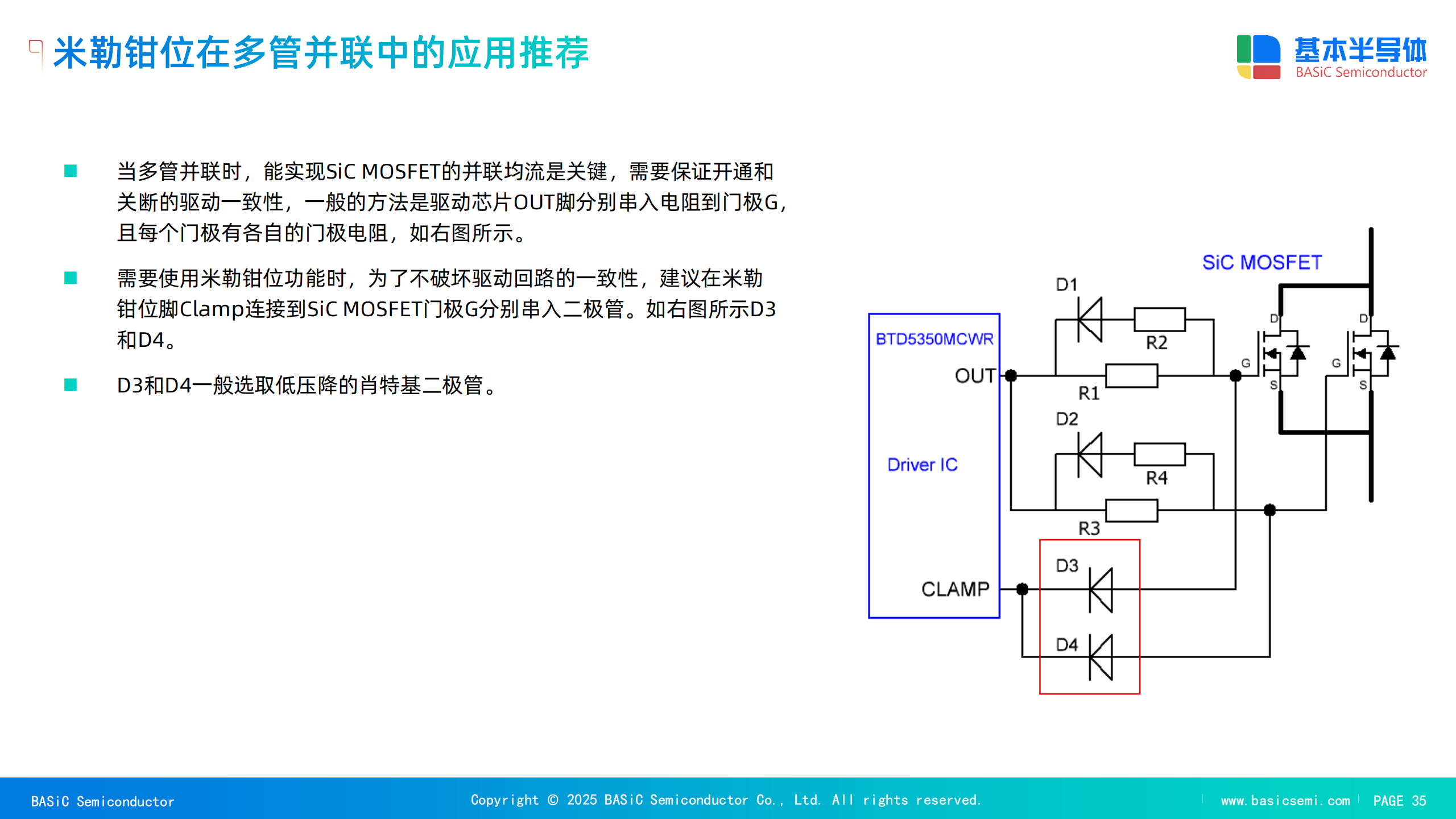
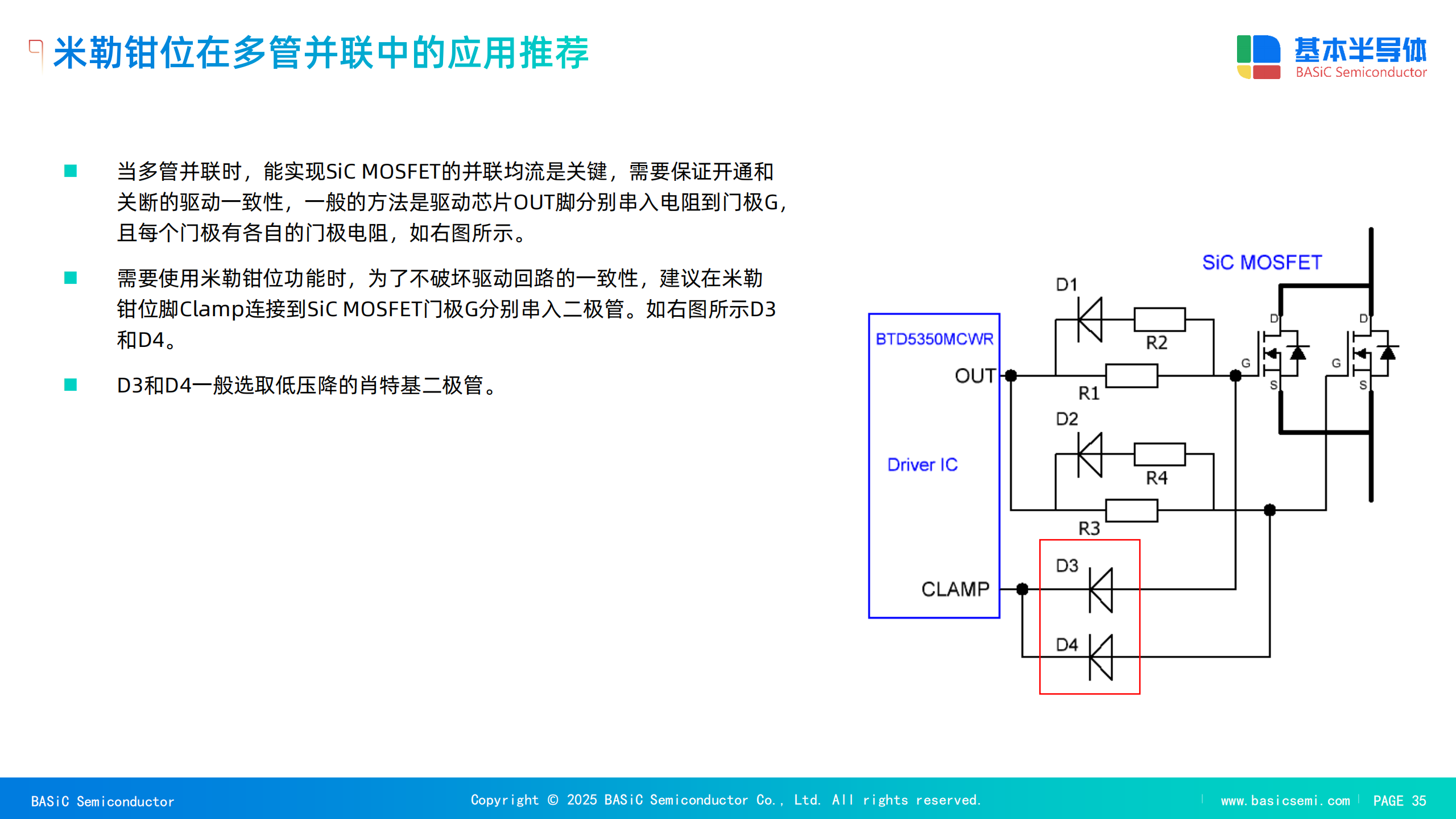
外部栅极电阻(Rg)是用于平衡开关速度、损耗和EMI的主要工具。增加Rg会降低di/dt和dV/dt,这可以有效减少峰值反向恢复电流、反向恢复电荷和互补开关的导通损耗 。然而,这种“软化”转换的代价是开关损耗的增加和开关时间的延长 。在设计中,需要根据应用对效率、EMI和可靠性的不同优先级,通过优化 Rg来找到最佳平衡点 。
表3:设计参数对体二极管反向恢复的影响
| 设计参数 | 对关键指标的影响(dI/dt, dV/dt, Irr, Qrr) | 对$E_{on}$的影响 | 对系统整体的影响 |
|---|---|---|---|
| 外部栅极电阻(Rg)增加 | 降低dI/dt, dV/dt, Irr, Qrr | 降低,但开关时间延长 | 降低EMI,但效率可能因开关时间延长而降低 |
| 负栅极偏压(VGS(off)) | 可能增加Irr, Qrr | 可能增加 | 显著增强抗寄生导通能力,提升可靠性 |
| 结温升高 | 在175℃以下影响小;在225℃以上可显著增加Qrr | 在高温下$E_{on}$可能增加 | 在极端高温下,反向恢复行为可能劣化 |
5.2 反并联二极管的战略作用
由于SiC体二极管高VF和非零反向恢复电荷的局限性,使用反并联SiC肖特基二极管(SBD)成为一种有效的性能优化策略 。SiC SBD具有低正向压降(~1.2 V),可显著降低死区时间内的导通损耗 。更重要的是,作为多数载流子器件,SiC SBD几乎没有反向恢复电荷,这彻底消除了由反向恢复引起的开关损耗和EMI 。

然而,这种策略也并非万能。如前文所述,额外增加的SBD电容在轻载条件下可能导致总开关损耗增加 。此外,在单片芯片上集成SBD会占用一部分硅片面积,这可能对MOSFET的导通电阻和短路耐受能力产生影响 。因此,在具体设计中,需要根据应用负载和频率特性,权衡是使用独立的SBD还是选择集成了SBD的SiC MOSFET。
5.3 优化死区时间与PWM控制
死区时间的优化是实现SiC系统高效率的另一个关键。由于SiC体二极管的反向恢复性能远超硅器件,其死区时间可以比Si系统短得多 。这不仅减少了体二极管的导通损耗,也使得更高的开关频率成为可能,从而减小了无源元件的尺寸。

研究表明,存在一个特定的死区时间,可以最大限度地减少导通损耗并增强开关稳定性 。过短的死区时间必须配合稳健的负栅极偏压来防止直通 ,而过长的死区时间则会增加不必要的体二极管导通损耗。因此,体二极管优越的反向恢复特性使得工程师能够进行更精细的死区时间优化,这是实现SiC MOSFET系统高频高效性能的关键。
深圳市倾佳电子有限公司(简称“倾佳电子”)是聚焦新能源与电力电子变革的核心推动者:
倾佳电子成立于2018年,总部位于深圳福田区,定位于功率半导体与新能源汽车连接器的专业分销商,业务聚焦三大方向:
新能源:覆盖光伏、储能、充电基础设施;
交通电动化:服务新能源汽车三电系统(电控、电池、电机)及高压平台升级;
数字化转型:支持AI算力电源、数据中心等新型电力电子应用。
公司以“推动国产SiC替代进口、加速能源低碳转型”为使命,响应国家“双碳”政策(碳达峰、碳中和),致力于降低电力电子系统能耗。
需求SiC碳化硅MOSFET单管及功率模块,配套驱动板及驱动IC,请搜索倾佳电子杨茜
6. 结论











倾佳电子深入分析了SiC MOSFET的开关行为,特别是其本征体二极管的复杂关断特性。SiC凭借其宽禁带材料的物理优势,实现了远超硅器件的开关速度、效率和功率密度。然而,其本征体二极管的高正向压降及其反向恢复特性,即使性能远优于硅,仍然是系统级设计中不可忽视的挑战。
倾佳电子的主要结论可概括为以下几点:
SiC MOSFET的低导通电阻和高开关速度源于其宽禁带和单极性导通机制。这些特性使得更高开关频率和更紧凑的系统设计成为可能。
SiC体二极管的反向恢复电荷(Qrr)极低且对温度不敏感(在工作范围内),这使其成为比Si PN结二极管更优越的续流二极管。
尽管性能优越,体二极管的高正向压降和反向恢复电流仍会对系统产生不利影响,例如增加互补开关的导通损耗,并与寄生电感相互作用产生电压振荡和EMI。
通过精心设计的栅极驱动(如不对称电压和优化的栅极电阻)和战略性地使用反并联SiC肖特基二极管,可以有效缓解上述问题,从而在效率、EMI和可靠性之间实现最佳平衡。
总而言之,SiC MOSFET并非硅器件的简单替代品,而是一种需要采用全新系统级设计思维的先进技术。仅仅追求高开关速度而忽视其对EMI、损耗和可靠性(通过体二极管反向恢复)的连锁影响,并非一种可行的设计策略。未来的发展方向包括开发更稳健的器件结构(如沟槽型MOSFET)、提升栅极氧化层的可靠性,以及集成更先进的栅极驱动IC,以自动化地管理这些复杂的权衡,从而进一步释放SiC技术的全部潜能。
审核编辑 黄宇
-
二极管
+关注
关注
149文章
10309浏览量
176389 -
MOSFET
+关注
关注
150文章
9411浏览量
229475 -
SiC
+关注
关注
32文章
3501浏览量
68046 -
碳化硅
+关注
关注
25文章
3305浏览量
51705
发布评论请先 登录
SiC碳化硅二极管公司成为国产碳化硅功率器件行业出清的首批对象
为什么BASiC基本公司SiC碳化硅肖特基二极管全面取代FRD快恢复二极管
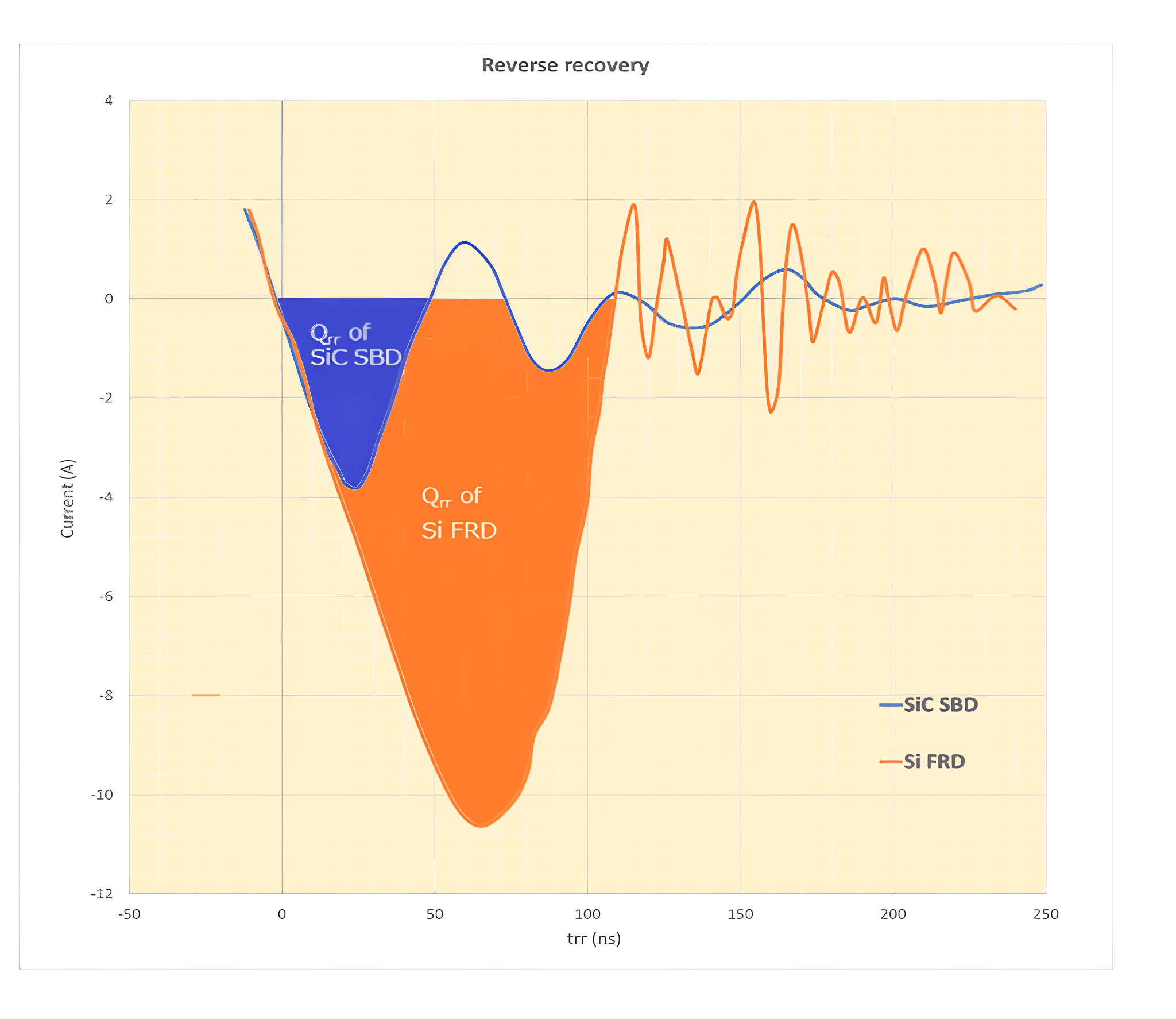





 倾佳电子SiC碳化硅MOSFET开关行为深度解析及体二极管的关断特性
倾佳电子SiC碳化硅MOSFET开关行为深度解析及体二极管的关断特性






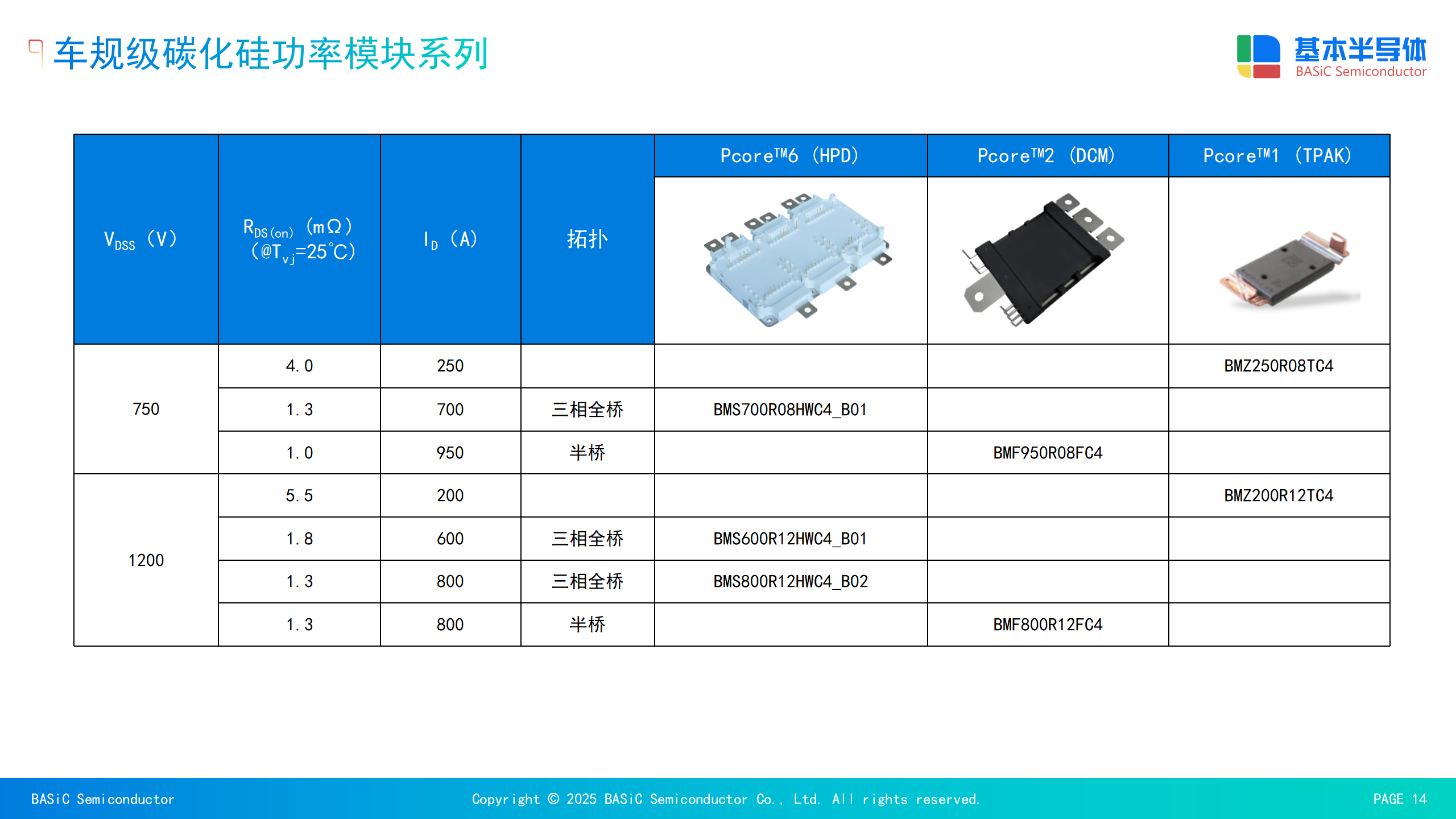
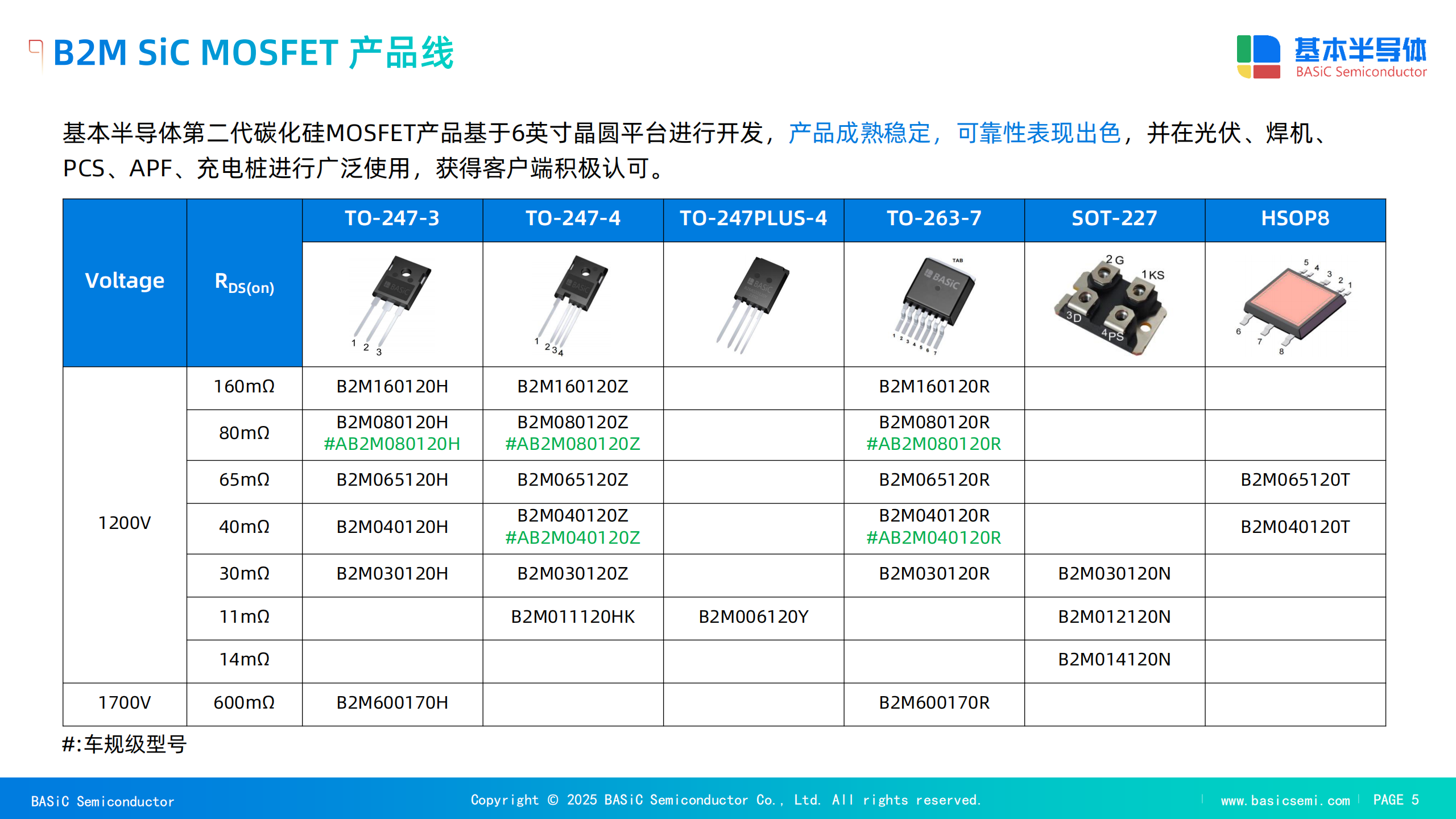
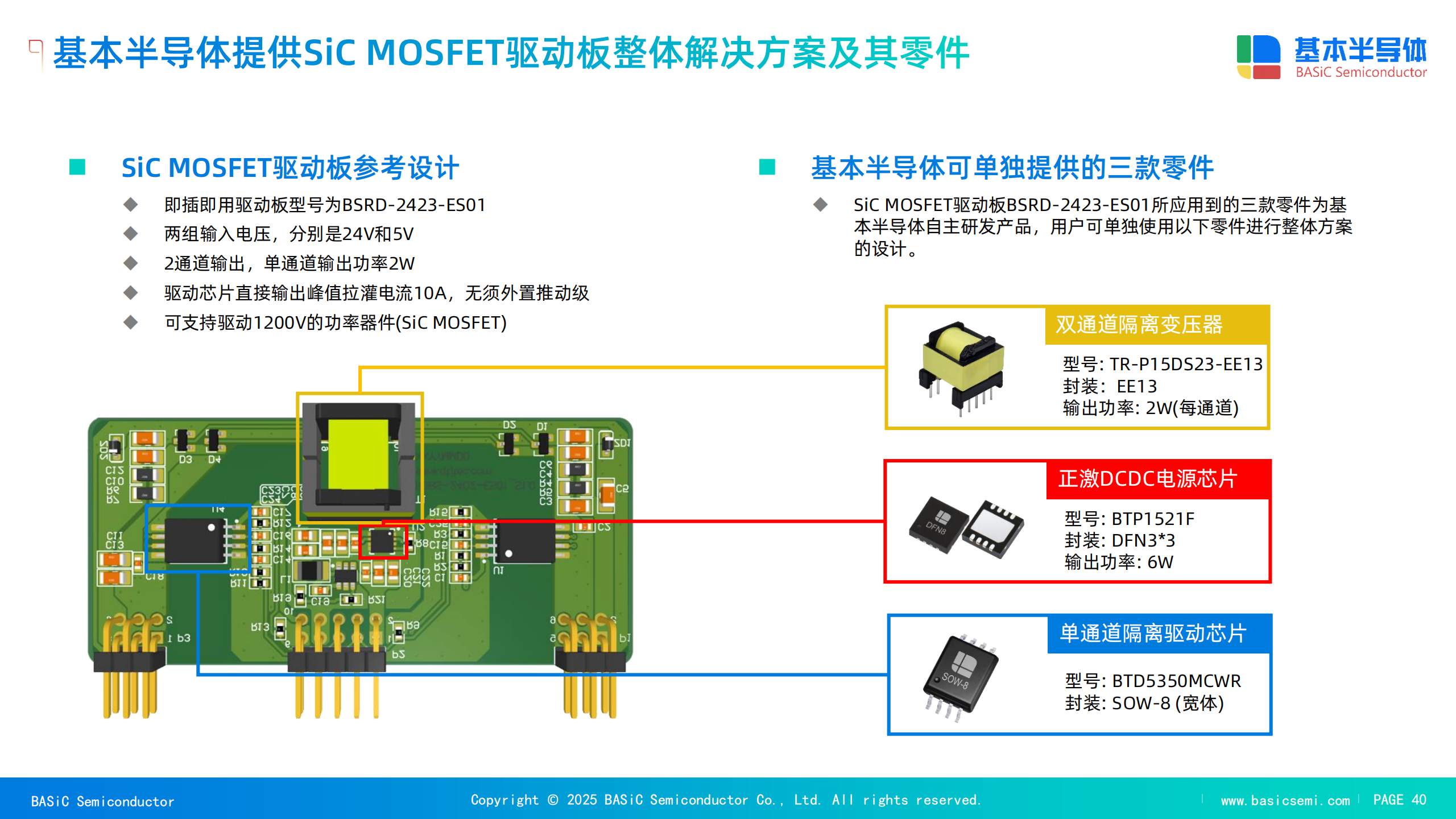










评论