根据韩国媒体 TheElce 的报导,三星正在开发一种新的晶片封装技术,以防止自研 Exynos 系列手机处理器 (AP) 过热的情况。
报导引用知情人士的说法指出,三星新的封装技术将在手机处理器的顶部附加了一块散热块(HPB),这样的技术被称之为晶圆级扇出型 HPB 封装 (FOWLP-HPB) 技术,由三星晶片部门旗下的先进封装 (AVP) 业务部门开发,预计未来用于的 Exynos 系列手机处理器上,目标是在 2024 年第四季完成开发,并开始大量生产。
另外,该公司还正在开发一种可以安装多个晶片的晶圆级扇出型 FOWLP 封装技术,该技术则是将于 2025 年第四季推出。预计,新的两种封装技术都将把 HPB 安装在 SoC 顶部,而记忆体则放置在 HPB 的旁边。
报导表示,事实上目前 HPB 已经在服务器和 PC 的处理器中使用。由于智能手机的外形尺寸较小,使得技术现在才被导入。而相较于当前的智能手机,大多使用均热片透过容纳冷媒来冷却处理器和其他核心营组件,HPB 则是仅作用在处理器的散热上。
现阶段,三星正在考虑采用 2.5D 或 3D 封装来将该技术进一步导入,这是因为人工智慧应用的日益普及,也增加了人们对晶片绕量增加的忧虑。对此,三星以往的经验感受甚深,因为两年前推出的 Galaxy S22 智能手机就因为处理器过热问题饱受使用者的批评。
而相较于现在希望藉由 HPB 来进行手机处理器的散热,当时三星则是试图透过其游戏的优化服务 (GOS) 应用程式来阻止这种情况。也就是该应用程式在不通知客户的情况下,强制降低手机处理器的效能,以防止过热的情况发生。不过,在三星提出 HPB 机制来降低手机处理器过热的情况之后,预计在后续的手机处理器设计上都将采用这样的做法。
审核编辑 黄宇
-
芯片封装
+关注
关注
14文章
623浏览量
32392 -
三星
+关注
关注
1文章
1781浏览量
34443
发布评论请先 登录
三星贴片电容 0805 封装的 CL31A105KQNFNNE 高频特性如何?
深度解析三星移动SoC先进封装技术

三星贴片电容封装尺寸对布局密度的影响

三星公布首批2纳米芯片性能数据
全球首款2nm芯片被曝准备量产 三星Exynos 2600
特斯拉Dojo重塑供应链,三星和英特尔分别赢得芯片和封装合同

三星最新消息:三星将在美国工厂为苹果生产芯片 三星和海力士不会被征收100%关税
曝三星S26拿到全球2nm芯片首发权 三星获特斯拉千亿芯片代工大单
突破堆叠瓶颈:三星电子拟于16层HBM导入混合键合技术




 三星开发新的芯片封装技术FOWLP-HPB,以防止AP过热
三星开发新的芯片封装技术FOWLP-HPB,以防止AP过热




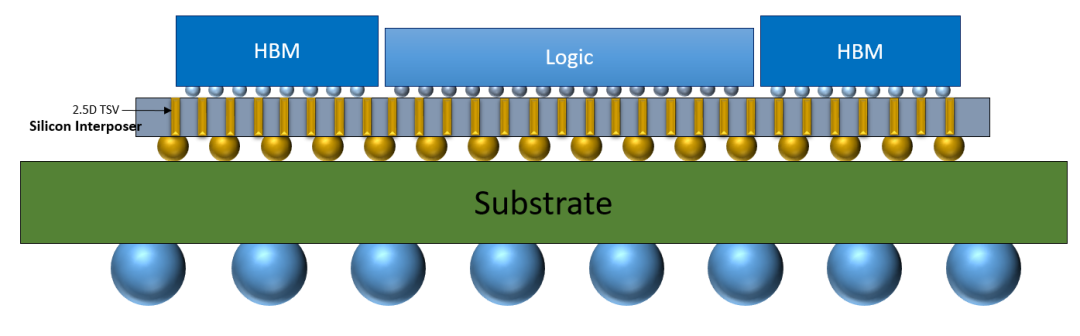



评论