根据韩国电子产业媒体TheElec的最新报道,三星电子已经赢得了英伟达的2.5D封装订单。据悉,该订单将由三星的自主研发的2.5D封装技术——高级封装(AVP)团队来完成,包括提供Interposer(中间层)和I-Cube产品。而对于高带宽内存(HBM)和GPU晶圆,三星将交由其他合作伙伴负责生产。
了解到,2.5D封装技术能够有效地将CPU、GPU、I/O接口、HBM芯片等多种芯片以横向方式置于中间层之上。如台积电所采取的CoWoS技术以及三星的I-Cube便是此类技术。目前,英伟达的A100和H100系列GPU与英特尔的Gaudi系列已采用此类技术进行封装。
自去年以来,三星正积极寻求2.5D封装业务的发展机会,他们对潜在客户承诺,将优先安排AVP团队为之服务,并为其提供自行设计的中间层晶圆方案。
消息人士透露,此次三星将为英伟达提供集成四枚HBM芯片的2.5D封装解决方案。据悉,三星的技术亦可支持八枚HBM芯片的封装,但需注意,在12寸晶圆上堆叠八枚HBM芯片总需16个中间层,恐怕会影响整体生产效率。为此,针对八枚及以上HBM芯片的封装,三星正致力于研发名为“面板级封装”的新型技术。
业界推测,英伟达之所以选择三星作为首批2.5D封装供应合作伙伴,或许与其AI芯片市场需求呈现迅速增长趋势、而台积电CoWoS产能有限有关。同时,赢得英伟达订单也预示着三星有望接收到更多来自英伟达的HBM订单。
-
封装技术
+关注
关注
12文章
607浏览量
69406 -
CoWoS
+关注
关注
0文章
171浏览量
11556 -
HBM
+关注
关注
2文章
438浏览量
15914 -
2.5D封装
+关注
关注
1文章
25浏览量
519
发布评论请先 登录

基于 HT 的 2.5D 组态可视化技术方案与场景实现

台积电如何为 HPC 与 AI 时代的 2.5D/3D 先进封装重塑热管理

是德科技与三星携手英伟达展示端到端AI-RAN验证工作流程
消息称英伟达HBM4订单两家七三分,独缺这一家
2D、2.5D与3D封装技术的区别与应用解析


浅谈2D封装,2.5D封装,3D封装各有什么区别?
英伟达力挺SOCAMM2,国产存储厂商紧密跟进
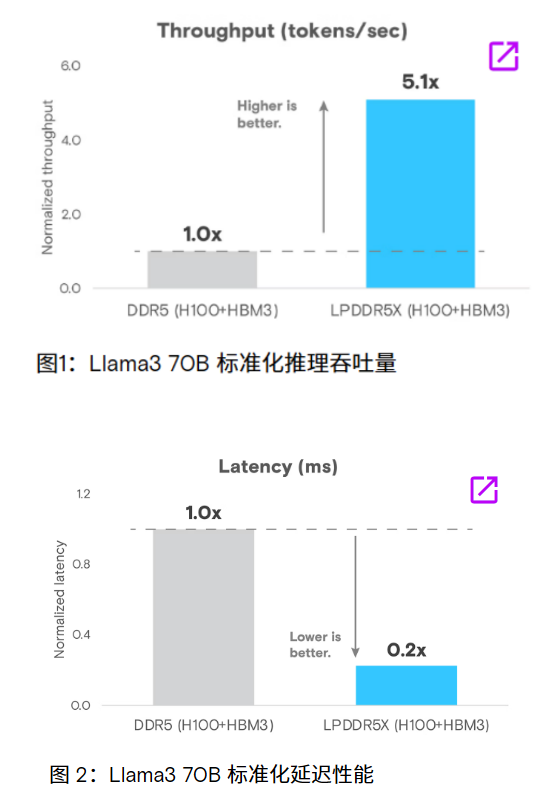
传三星 HBM4 通过英伟达认证,量产在即
英伟达被传暂停生产H20芯片 外交部回应
华大九天推出芯粒(Chiplet)与2.5D/3D先进封装版图设计解决方案Empyrean Storm

三星Q2净利润暴跌56%:代工遇冷,HBM业务受挫
看点:三星电子Q2利润预计重挫39% 星动纪元宣布完成近5亿元A轮融资
多芯粒2.5D/3D集成技术研究现状




 三星拿下英伟达2.5D封装订单
三星拿下英伟达2.5D封装订单




评论