反应离子刻蚀
反应离子刻蚀(RIE,Reactive Ion Etching)是制作半导体集成电路的一种重要蚀刻工艺。它是在平板电极间施加射频电压,通过产生的等离子体对样品进行化学和物理刻蚀。在除去不需要的集成电路板上的保护膜时,利用反应性气体的离子束切断保护膜物质的化学键,产生低分子物质,然后这些物质挥发或游离出板面。
结构
两个平行放置电极:一个电极作为地线,一个电极外加射频功率
气体从接地侧的电极以淋浴状喷出,晶圆放置在施加射频的电极侧(阴极耦合)
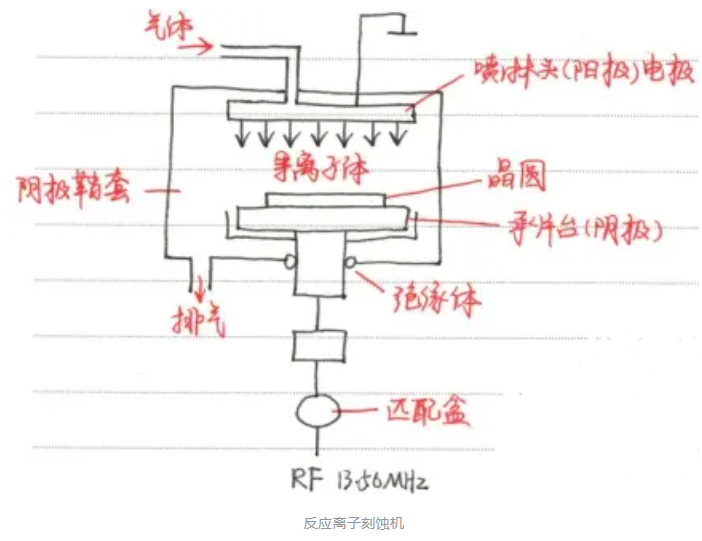
刻蚀气体在等离子体中分解电离,形成离子和自由基等刻蚀类物质,称为Enchant → Enchant到达晶圆表面的过程(压力低时能刻蚀出深度形状,但如果压力过低,放电就不顺利,会出现等离子体难以产生的问题) → 到达晶片表面的Enchant与被刻蚀物发生反应 → 反应副产物从晶圆脱离(反应副产物需迅速脱离并排气,否则反应副产物会附着在表面,刻蚀反应无法进行)

反应离子刻蚀的优缺点
反应离子刻蚀(RIE,Reactive Ion Etching)作为制作半导体集成电路的一种重要蚀刻工艺,具有一系列的优点和缺点。
优点:
良好的形貌控制能力:反应离子刻蚀可以实现各向异性刻蚀,这对于获得精细和复杂的图形结构非常有利。
较高的选择比:与某些其他蚀刻技术相比,反应离子刻蚀能够更有效地区分并去除特定的材料层,从而实现对不同材料的精确刻蚀。
刻蚀速率适中:虽然可能不是最快的刻蚀方法,但反应离子刻蚀的刻蚀速率可以满足大多数工艺需求。
促进化学反应:由于高能离子的轰击,反应离子刻蚀可以破坏被刻蚀材料的化学键,加速与活性刻蚀反应基团的反应速度,从而提高刻蚀效率。
缺点:
设备成本高昂:反应离子刻蚀设备通常比较复杂且昂贵,这增加了工艺的成本。
选择比并非最高:虽然具有一定的选择比,但与某些更先进的蚀刻技术相比,反应离子刻蚀的选择比可能不是最高的。
对表面损伤大:由于高能离子的轰击,反应离子刻蚀可能会对被刻蚀材料的表面造成较大的损伤。
可能产生污染:在刻蚀过程中,可能会产生一些有害气体或残留物,这需要对工作环境进行严格的控制和处理。
难以形成更精细的图形:对于需要极高精度的图形刻蚀,反应离子刻蚀可能难以满足要求。
反应离子刻蚀是一种各向异性很强、选择性高的干法腐蚀技术,利用离子能量使被刻蚀层的表面形成容易刻蚀的损伤层,促进化学反应,同时离子还可以清除表面生成物,露出清洁的刻蚀表面。然而,这种刻蚀技术不能获得较高的选择比,对表面的损伤大,有污染,难以形成更精细的图形。
反应离子刻蚀设备广泛应用于半导体器件、电力电子器件、光电子、太阳能电池、微机械等领域。此外,还有电感耦合反应离子刻蚀机(ICP-RIE)这种机型,它可以提供更高的等离子浓度,适合金属等其他材料的刻蚀。
审核编辑:黄飞
-
集成电路
+关注
关注
5446文章
12465浏览量
372683 -
晶圆
+关注
关注
53文章
5344浏览量
131687 -
刻蚀
+关注
关注
2文章
217浏览量
13681
发布评论请先 登录
Sic mesfet工艺技术研究与器件研究
反应离子蚀刻的实用方法报告
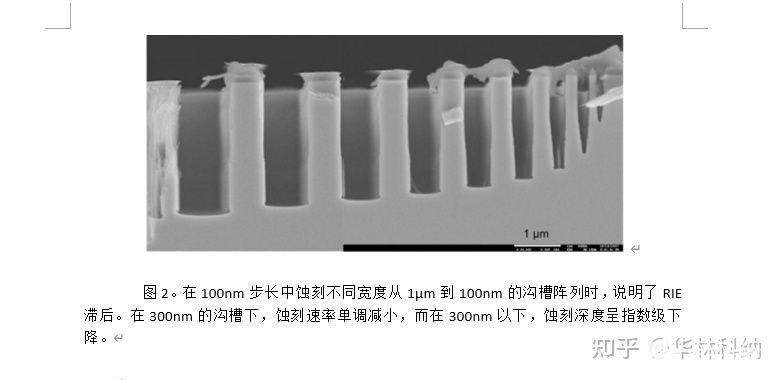
关于微技术中硅反应离子刻蚀的研究
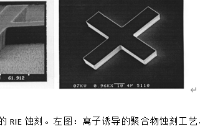
干法刻蚀解决RIE中无法得到高深宽比结构或陡直壁问题
干法刻蚀的概念、碳硅反应离子刻蚀以及ICP的应用






 浅析反应离子刻蚀工艺技术
浅析反应离子刻蚀工艺技术


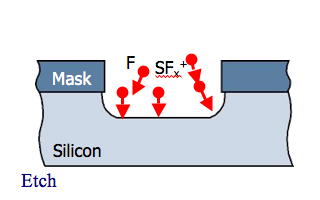
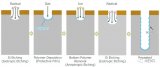














评论