影响深硅刻蚀的关键参数有:气体流量、上电极功率、下电极功率、腔体压力和冷却器。
硅刻蚀与氧化硅、氮化硅等材料的刻蚀方式存在差异,氧化硅和氮化硅倾向于物理轰击刻蚀,表现为各向异性。相反,硅的刻蚀倾向于通过氟自由基的化学反应为主,呈各向同性。因此,在硅刻蚀过程中,通常需要使用C4F8气体来保护刻蚀侧壁。
在常见的硅刻蚀设备中,涉及以下几个关键参数:
气体流量:SF6和C4F8,它们在刻蚀过程中发挥不同的作用。
上电极功率(ICP):用于激发刻蚀和钝化等离子体。
下电极功率(Bias):用于吸收离子和自由基,影响刻蚀速率。
腔体压力:用于调控等离子体密度,影响刻蚀过程的控制。
冷却器:用于控制晶圆刻蚀过程中产生的热量。
目前,用于硅刻蚀的设备主要有两种类型:常规ICP刻蚀和深硅刻蚀机。常规ICP刻蚀采用纯BOSCH工艺,以一步刻蚀一步钝化的方式工作。这类设备通常在低气压和高气体流量条件下操作,以提供更高的等离子体密度和更好的均匀性。然而,它只能通过调整刻蚀/钝化比例来控制刻蚀角度。而深硅刻蚀机采用优化后的BOSCH工艺,以一步小功率硅刻蚀,一步钝化,一步大功率刻蚀钝化层的循环方式工作,故具有更高的刻蚀速率,更好的侧壁形貌。
深硅刻蚀机可通过调节多个参数来实现优化,包括上电极中心功率、上电极边缘功率、钝化层沉积气压、刻蚀气压、中间气体流量、边缘气体流量和下电极功率。以下列举了刻蚀中一些重要参数的影响。
1. 上电极中心功率(固定其他参数)
如图1所示,随着上电极功率的增加,侧壁角度逐渐减小,而刻蚀速度逐渐增大。这一变化可以归因于上电极功率的提升,增加了等离子体的浓度,进一步扩大了鞘区,使得鞘区内离子轰击效应增强。这导致了侧壁角度的减小,同时刻蚀速率的增加。

图1
2. 下电极功率(固定其他参数)
下电极功率与上电极功率的匹配在深硅刻蚀中显得尤为关键。当功率较低时,刻蚀速率下降,刻蚀呈现各向同性倾向,导致侧壁角度减小。随着功率的增加,刻蚀速率增加,刻蚀逐渐呈各向异性。然而,一旦超出匹配范围,离子轰击过量会导致侧壁减小。
确保下电极功率与上电极功率的匹配是至关重要的。过低的功率可能导致刻蚀速率不足,结果是各向同性的刻蚀以及减小侧壁角度。相反,功率过高可能导致过量的离子轰击,使刻蚀过程变得不稳定,同样导致侧壁的不理想变化。
在优化深硅刻蚀过程时,保持适当的下电极功率与上电极功率匹配范围,以实现刻蚀的各向异性和稳定性,是取得理想刻蚀效果的关键。

图2
3. 边缘气体流量(固定其他参数)
控制中心和边缘刻蚀气体流量往往对刻蚀的均匀性产生显著影响。举例而言,对于相同的刻蚀面积,若边缘刻蚀气体流量为零,导致边缘刻蚀气体浓度不足,从而使得边缘刻蚀速率较慢。通过调节中心和边缘气体流量的匹配,可以优化刻蚀的均匀性。

图3
总体而言,即便使用相同的Recipe刻蚀参数,对于不同形状的刻蚀,其效果可能存在明显差异。因此,工艺人员通常需要依赖实验结果进行调控,以确保获得符合要求的刻蚀效果。这种实验性的调节方式允许工艺人员更灵活地应对不同形状、尺寸或结构的样品,以达到最佳的刻蚀结果。在优化刻蚀过程中,实验经验和观察结果的反馈将成为调整刻蚀参数的关键指导。
审核编辑:刘清
-
晶圆
+关注
关注
53文章
5477浏览量
132902 -
冷却器
+关注
关注
0文章
90浏览量
12346 -
刻蚀机
+关注
关注
0文章
60浏览量
4959
原文标题:如何调控BOSCH工艺深硅刻蚀?
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
【转帖】干法刻蚀的优点和过程
晶体硅太阳能电池刻蚀的作用及方法与刻蚀的工艺流程等介绍
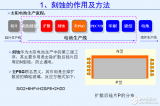
实现高精度深硅刻蚀的方法
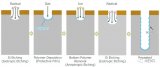
关于刻蚀的重要参数报告
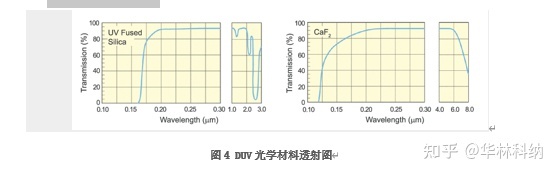



 如何调控BOSCH工艺深硅刻蚀?影响深硅刻蚀的关键参数有哪些?
如何调控BOSCH工艺深硅刻蚀?影响深硅刻蚀的关键参数有哪些?

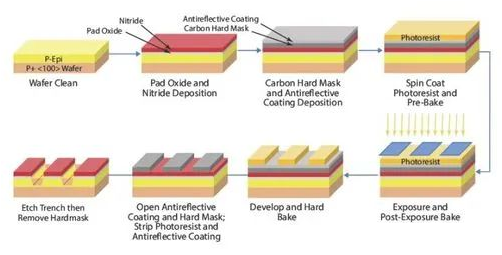
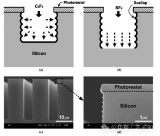
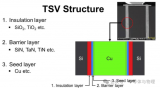


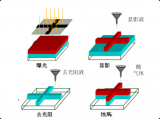



评论