随着半导体元件的制造工程接近物理界限,允许将多个元件聚集在一起封装成单一的电子元件,进而提高半导体性能的先进封装技术成为了竞争的关键。三星准备了自己的先进封装解决方案,正在与台积电的cowos包装技术展开竞争。
三星计划在2024年先进3D芯片封装技术SAINT(Samsung Advanced Interconnection Technology,三星高级互连技术),能以更小尺寸的封装,将AI芯片等高性能芯片的内存和处理器集成。三星SAINT将被用来制定各种不同的解决方案,可提供三种类型的封装技术,其中包括:
SAINT D - 用于垂直封装CPU、GPU和DRAM等核心IP
SAINT L - 用于堆叠应用处理器(AP)
三星虽然已经通过了验证测试,但是通过与顾客的追加测试,计划明年以提高数据中心的ai芯片和内置ai功能的手机应用处理器(处理器)的性能为目标,扩大服务。
如果一切都能按计划进行,三星SAINT有可能从竞争公司确保部分市场占有率。但nvidia和amd等公司是否满意他们提供的技术,还有待观察。
据报道,三星正在争夺大量hbm内存订单,这些订单将继续支持英伟达的下一代blackwell ai gpu。三星最近推出了synnevolt“hbm3e”存储器,并承揽了amd新一代Instinct加速器的订单,但与掌握人工智能市场约90%的英伟达相比,还是微不足道的水平。两家公司的hbm3预计将在2025年之前完成订单销售,ai gpu市场仍保持旺盛的需求。
随着该公司从单一芯片设计转换为以晶片(chiplet)为基础的架构,尖端包装将向前迈进一步。
台积电在扩张cowos设备的同时,对本公司的3d开关型技术soic的测试及升级进行了大量投资,满足了苹果和英伟达等顾客的要求。台湾积累电力公社表示,今年7月将投资900亿元台币(约29亿美元),新建先进的成套工厂。英特尔开始利用本公司的新一代3d芯片包装技术——fooveros制造尖端芯片。
世界第三大企业umc推出晶圆对晶圆(Wafer-to-Wafer,W2W)3D IC项目,利用硅堆栈技术的高效率综合存储器及处理器解决方案。
-
封装技术
+关注
关注
12文章
605浏览量
69367 -
3D芯片
+关注
关注
0文章
52浏览量
19090 -
AI芯片
+关注
关注
17文章
2164浏览量
36869
发布评论请先 登录
浅谈2D封装,2.5D封装,3D封装各有什么区别?
三星公布首批2纳米芯片性能数据
详解先进封装中的混合键合技术

iTOF技术,多样化的3D视觉应用
三星最新消息:三星将在美国工厂为苹果生产芯片 三星和海力士不会被征收100%关税
华大九天推出芯粒(Chiplet)与2.5D/3D先进封装版图设计解决方案Empyrean Storm




 三星2024年将推出先进3D芯片封装技术SAINT
三星2024年将推出先进3D芯片封装技术SAINT






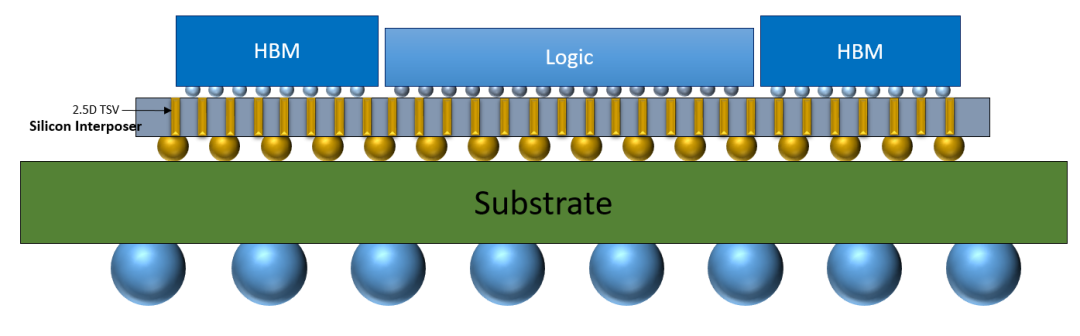



评论