众所周知,华为是全球备受瞩目的“专利大户”,从5G/6G到通信设备,再到手机芯片、操作系统、自动驾驶、EVS等均有涉及。而最近,华为又新增了多条专利信息,其中一项便是关于芯片封装和制备方法的,这将有利于提高芯片的性能。
根据企查查公开的信息显示,这项新专利的名称为“一种芯片封装以及芯片封装的制备方法”,申请日期为2020年12月16日,申请公布日为2023年8月4日,申请公开号为CN116547791A。

▲图片来源:企查查
据悉,这是一种用于简化芯片堆叠结构及其形成方法的制造技术。
根据专利摘要显示,该芯片封装包括基板、裸芯片、第一保护结构和阻隔结构;该裸芯片、该第一保护结构和该阻隔结构均被设置在该基板的第一表面上;该第一保护结构包裹该裸芯片的侧面,该阻隔结构包裹该第一保护结构背离该裸芯片的表面,且该裸芯片的第一表面、该第一保护结构的第一表面和该阻隔结构的第一表面齐平。
其中,该裸芯片的第一表面为该裸芯片背离该基板的表面,该第一保护结构的第一表面为该第一保护结构背离该基板的表面,该阻隔结构的第一表面为该阻隔结构背离该基板的表面。
通过这种芯片堆叠结构的设计,旨在简化芯片堆叠结构的制备工艺,并有利于提高生产效率。该专利对于芯片封装行业具有重要意义,可以加快芯片制造的速度、降低生产成本,并提高芯片的性能和可靠性。
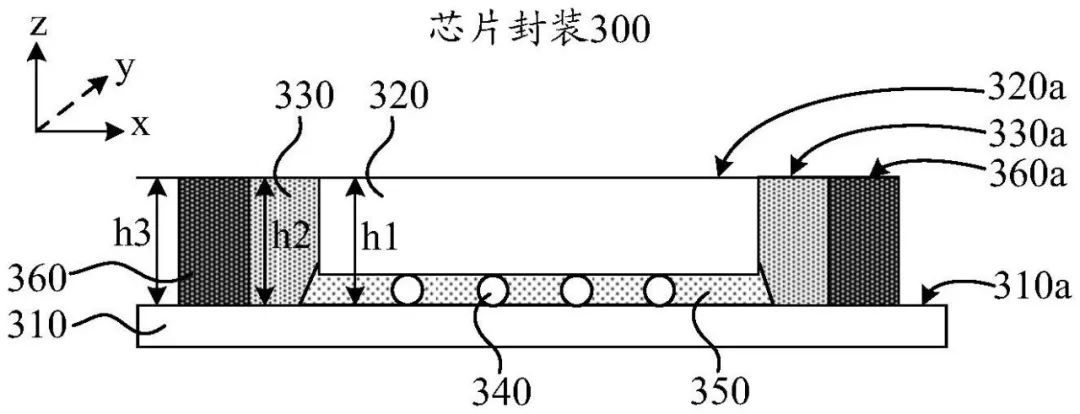
▲专利原理示意图
该专利一经曝光,立即引起了网友的广泛关注和讨论,例如“华为可以将两块14nm制程芯片堆叠在一起,实现与7nm制程芯片相似的性能和功耗”的说法也随之流传开来。
不过,华为官方已经多次证实这是谣传。因为“通过芯片叠加工艺让两块14nm芯片达到7nm水平”这样的说法本身就是错误的,芯片堆叠技术方案难题包含了热管理、电气互联、封装和测试、制造技术等多个方面,要想完成这些并非易事。
此外,两块14nm芯片堆叠在一起,还要功耗跟7nm相当,暂且说可以组合,但这样实现后也是通过降频。要知道,14nm芯片达到7nm的性能水平就必须功耗翻倍,同时还得进一步扩大芯片面积才能塞下更多的晶体管,这显然脱离了芯片发展规律。
虽然这项新专利实现不了7nm工艺,但却展现了华为在芯片领域的研发实力和创新能力,也为全球芯片行业的发展提供了更多新的可能。
据统计,截至2022年,华为持有超过12万项有效授权专利,是中国国家知识产权局和欧洲专利局2021/2022年度专利授权量排名第一的公司,也是2022年中国PCT国际专利申请量全球第一的公司。在研发方面,华为2022年研发支出超过1600亿元,近十年研发支持超过9700亿元。正是这些大手笔研发投入,让华为在各领域都能遥遥领先,为消费者带来不断迭代的新功能、新技术。
未来,随着研发投入的持续积淀,以及最新芯片堆叠封装专利技术的普及与应用,我们可以期待华为将在芯片领域取得更多的技术突破,为中国芯片的发展注入更多新的动力。
-
芯片
+关注
关注
462文章
53530浏览量
458837 -
华为
+关注
关注
217文章
35782浏览量
260657 -
堆叠
+关注
关注
0文章
37浏览量
17011
原文标题:突破!华为首次公开芯片堆叠专利,7nm有戏了?
文章出处:【微信号:robotqy,微信公众号:机械自动化前沿】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
国产芯片真的 “稳” 了?这家企业的 14nm 制程,已经悄悄渗透到这些行业…
看点:马斯克:将深度参与特斯拉芯片设计 华为首款透明天线路由器开售
“汽车智能化” 和 “家电高端化”
国产AI芯片真能扛住“算力内卷”?海思昇腾的这波操作藏了多少细节?
AMD 7nm Versal系列器件NoC的使用及注意事项

【「AI芯片:科技探索与AGI愿景」阅读体验】+半导体芯片产业的前沿技术

长城汽车荣登智能座舱领域专利公开量榜首
突破!华为先进封装技术揭开神秘面纱
广汽传祺联合华为首次实现出发层泊车代驾技术试点
最新专利曝光,华为要将“雷达之王”装到车上?

芯片晶圆堆叠过程中的边缘缺陷修整






 华为首次公开芯片堆叠专利,7nm有戏了?
华为首次公开芯片堆叠专利,7nm有戏了?













评论