BGA(Ball Grid Array,球栅阵列)封装是一种表面安装的封装方式,以其高密度、高性能的特点在电子行业中得到了广泛应用。然而,在BGA封装焊接过程中,可能会出现各种缺陷和异常。让我们一起来看看这些常见的问题及其产生的原因。
焊球断裂:焊球断裂是BGA焊接过程中常见的问题,主要原因是焊接温度的不适当控制或设备振动。如果焊接温度过高,焊球可能会过度膨胀,导致焊球断裂;如果设备振动过大,也可能导致焊球的机械应力增大,从而引发断裂。
焊接虚焊:虚焊是另一个常见的问题,主要表现为焊接点未能形成良好的金属连接。虚焊的主要原因包括焊锡的湿润性差,焊接温度低于锡膏的熔点,或焊锡在焊接过程中受到污染。
焊球偏移:在焊接过程中,由于热膨胀、表面张力不均等因素,焊球可能会发生偏移,导致连接质量下降。特别是在高密度BGA封装中,焊球的微小偏移都可能导致严重的性能问题。
桥联:如果焊锡过多或焊锡过度流动,可能会形成桥联,即两个或更多的焊接点之间形成了不应存在的电气连接。桥联的出现不仅影响电路的正常工作,还可能引发短路,对设备造成损坏。
焊接后裂纹:焊接后裂纹是指焊接过程中或焊接后出现的裂纹,这是由于焊接应力、热循环应力或机械振动引起的。这种裂纹可能会导致电路断路,影响设备的可靠性。
外观缺陷:在BGA焊接过程中,可能会出现焊锡表面的不均匀、焊锡颜色变暗等外观缺陷。这些缺陷一般是由于焊接工艺参数设置不当、环境温湿度控制不佳或焊锡质量问题引起的。虽然这些缺陷不一定会直接影响电路板的功能,但可能会影响电路板的寿命和可靠性。
内部缺陷:使用X光或其他无损检测技术,可能会发现BGA焊接的内部缺陷,如焊球内部的孔洞、裂纹等。这些内部缺陷可能由于焊接过程中气体产生和困困然后导致,或者是由于焊锡冷却过程中收缩不均匀引起的。这些内部缺陷可能会影响电路的电性能,并降低其抗疲劳和抗振动的性能。
焊接后不良的电气性能:有些缺陷可能无法直接通过视觉或X光检测发现,只有在电性能测试中才能发现。例如,如果焊接质量差,可能会导致电阻增大、电流扰动、信号延迟等问题。这些问题可能会严重影响电路板的性能,甚至导致电路板无法正常工作。
BGA封装焊接的常见缺陷和异常有很多,每一种缺陷和异常都可能影响到电路板的性能和可靠性。因此,对BGA焊接过程的控制非常重要,需要有严格的工艺参数设置,优质的焊接材料,精密的焊接设备,以及严格的质量检测和控制。通过深入理解BGA封装焊接的常见缺陷和异常,可以帮助我们更好地控制焊接过程,提高电路板的质量和可靠性。
-
封装
+关注
关注
128文章
9139浏览量
147893 -
贴片机
+关注
关注
10文章
666浏览量
24138
发布评论请先 登录
BGA芯片阵列封装植球技巧,助力电子完美连接

紫宸激光植球技术:为BGA/LGA封装注入精“芯”动力

PCBA焊接缺陷急救手册:快速定位与解决方案
拒绝焊接缺陷,创想智控焊接熔池相机提前预警
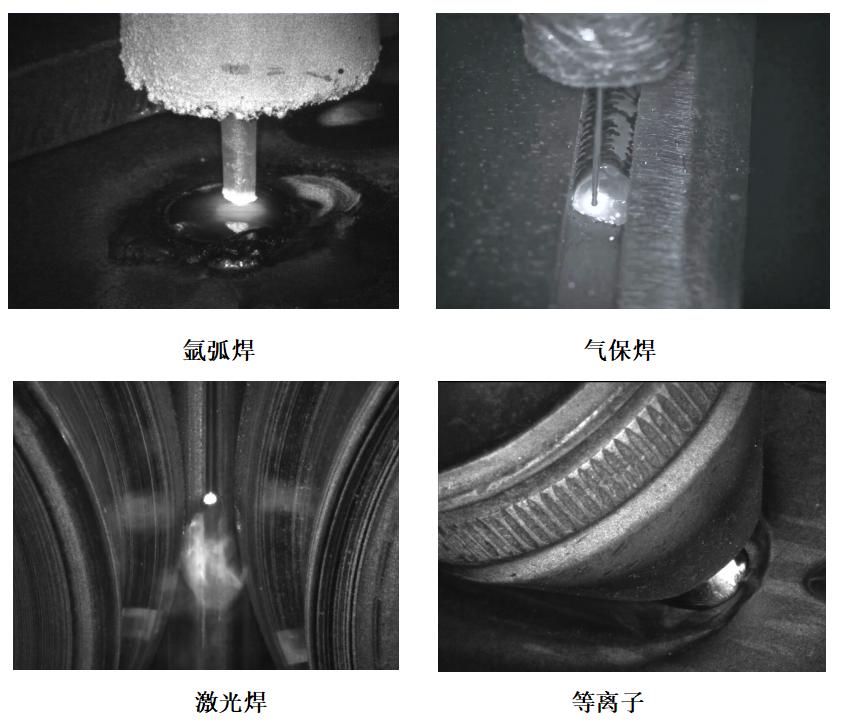
GT-BGA-2000高速BGA测试插座
半导体封装质量把关:红墨水试验技术要点与常见问题解答

PCBA 工程师必看!BGA 焊接质量如何决定整块电路板的 “生死”?
BGA封装焊球推力测试解析:评估焊点可靠性的原理与实操指南

从捷多邦案例看X-Ray检测在BGA焊接评估中的作用
激光焊接十大常见缺陷及解决方法
BGA焊盘设计与布线

BGA芯片焊接全攻略:从准备到实战的详尽指南






 探究BGA封装焊接:常见缺陷与异常解析
探究BGA封装焊接:常见缺陷与异常解析













评论