如何降低芯片封装纳米烧结银的烧结温度、减少烧结裂纹、降低烧结空洞率、提高烧结体的致密性和热导率成为目前纳米银研究的重要内容。
芯片封装纳米烧结银的烧结工艺流程就显得尤为重要了。善仁新材研究院根据客户的使用情况,总结出芯片封装纳米烧结银的工艺流程供大家参考:
善仁新材的芯片封装纳米烧结银包括AS9330系列和AS9375两个系列,其中AS9330为半烧结银膏,AS9375为全烧结银膏。
芯片烧结银的工艺流程如下:
1 清洁芯片和被粘结的界面
2 假设界面表面能太低,建议提高界面表面能
3 粘结尺寸过大时,建议一个界面开导气槽
4 一个界面涂布烧结银时,涂布的要均匀
5 芯片放到涂有烧结银的界面上时,建议加一点压力到上界面压一下
6 烧结时需逐步阶梯升温到一定的温度,比如3分钟升高5度等
7 烧结结束时,建议在烘箱中逐步降温到室温再把器件拿出
8 烧结银烧结时,要主要烧结温度,烧结时间,烧结压力”铁三角“的调整问题。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片
+关注
关注
462文章
53530浏览量
458869 -
封装
+关注
关注
128文章
9139浏览量
147868
发布评论请先 登录
相关推荐
热点推荐
无压烧结银膏在框架上容易发生树脂析出的原因和解决办法
树脂析出的根本原因
树脂析出的核心在于银膏中的有机载体系统与框架基板表面以及烧结工艺之间的不匹配。原因可以归结为以下几点:
基板表面能与浸润性问题
框架表面污染:框架(如铜框架、镀银、镀金框架)在生
发表于 10-08 09:23
为什么无压烧结银膏在铜基板容易有树脂析出?
/点胶性能和暂时的粘接力。
在烧结过程中,热量会使有机载体挥发或分解。理想情况下,这些有机物应该均匀地、缓慢地通过银膏层向上方(空气侧)逸出。然而,当银膏被夹在两个界面之间时(例如上方的芯片
发表于 10-05 13:29
氮化镓芯片无压烧结银膏的脱泡手段有哪些?
。
缺点 :效率极低,耗时长,且对于高粘度的烧结银膏效果非常有限,只能去除极少部分较大的气泡。通常不作为主要手段,仅作为辅助或不得已时的选择。
发表于 10-04 21:13
无压烧结银膏应该怎样脱泡,手段有哪些?
氮化镓(GaN)芯片,特别是在高功率、高频应用场景下,对封装互连材料的可靠性和散热性能要求极高。无压烧结银膏作为一种理想的键合材料,其烧结前
发表于 10-04 21:11
从SiC模块到AI芯片,低温烧结银胶卡位半导体黄金赛道
电子发烧友网综合报道 所谓低温烧结银胶是一种以银粉为主要成分、通过低温烧结工艺实现芯片与基板高强度连接的高性能
发表于 05-26 07:38
•1859次阅读
超声波指纹模组灵敏度飞升!低温纳米烧结银浆立大功
工艺中。
低温烧结,开启便捷高效大门
低温烧结是AS9120BL3纳米银浆的一大显著优势,也是其区别于传统银浆的关键特性。与传统
发表于 05-22 10:26
碳化硅SiC芯片封装:银烧结与铜烧结设备的技术探秘
随着碳化硅(SiC)功率器件在电力电子领域的广泛应用,其高效、耐高压、高温等特性得到了业界的广泛认可。然而,要充分发挥SiC芯片的性能优势,封装技术起着至关重要的作用。在SiC芯片封装

纳米铜烧结为何完胜纳米银烧结?
在半导体功率模块封装领域,互连技术一直是影响模块性能、可靠性和成本的关键因素。近年来,随着纳米技术的快速发展,纳米银烧结和纳米铜烧结技术作为两种新兴的互连技术,备受业界关注。然而,在众

150℃无压烧结银最简单三个步骤
的热点。在材料科学与电子工程领域,烧结技术作为连接与成型的关键工艺之一,始终占据着举足轻重的地位。接下来,我们将详细介绍150℃无压烧结银AS9378TB的最简单三个步骤,以便读者和客
发表于 02-23 16:31
烧结银在智能机器人的应用
烧结银作为一种经过特殊工艺处理的导电材料,近年来在智能机器人领域的应用逐渐凸显出其独特优势。本文将深入探讨烧结银在智能机器人中的应用现状、技





 芯片封装烧结银工艺
芯片封装烧结银工艺



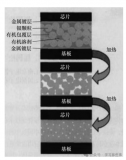
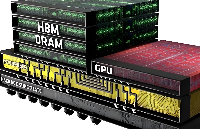











评论