关键词:半导体芯片,电子封装,胶粘剂(胶水,粘接剂),胶接工艺,胶粘技术
引言:胶接是通过具有黏附能力的物质,把同种或不同种材料牢固地连接在起的方法。具有黏附能力的物质称为胶粘剂或黏合剂,被胶接的物体称为被粘物,胶粘剂和被黏物构成的组件称为胶接接头。其主要优点是操作简单、生产率高;工艺灵活、快速、简便;接头可靠、牢固、美观产品结构和加工工艺简单;省材、省力、成本低、变形小。容易实现修旧利废接技术可以有效地应用于不同种类的金属或非金属之间的联接等。
胶水的固化方式,一般有以下几种:1、常温固化;2、加热固化;3、UV固化;4、复合型固化。
UNDERFILL 底部填充技术
一
底部填充技术の简介
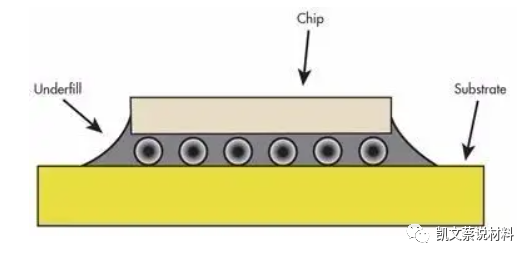

底部填充技术上世纪七十年代发源于IBM公司,已经成为电子制造产业重要的组成部分。起初该技术的应用范围只限于陶瓷基板,直到工业界从陶瓷基板过渡到有机(叠层)基板,底部填充技术才得到大规模应用,并且将有机底部填充材料的使用作为工业标准确定下来。
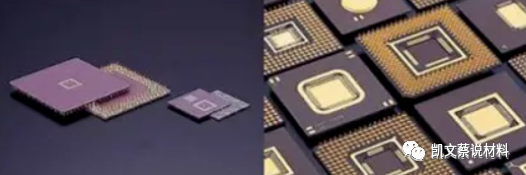
随着电子产品的发展趋向微型化、薄型化、高性能化,IC封装也趋于微型化、高度集成化方向发展。通过采用底部填充可以分散芯片表面承受的应力进而提高整个产品的可靠性,因而底部填充成为提高电子产品可靠性的必要工艺。底部填充工艺(underfill)是将环氧树脂胶水点涂在倒装晶片边缘,通过“毛细管效应”,胶水被吸往元器件的对侧,完成底部充填过程,然后通过加热使胶水固化。底部填充可以解决精密电子元件的诸多问题,比如对于CSP、BGA、POP等工艺,底部填充能极大提高其抗冲击能力;对FLIP CHIP而言,因其热膨胀系数(CTE)不一致产生热应力极易导致焊球失效,底部填充能有效提高抵抗热应力的能力。Under Fill点胶工艺广泛应用于消费类电子行业,如手机、穿戴、TWS、汽车电子等相关联PCB或FPC。
二
底部填充技术の主要工艺流程
原理:底部填充胶的应用原理是利用毛细作用使得胶水迅速流过BGA 芯片底部芯片底部,其毛细流动的最小空间是10um。这也符合了焊接工艺中焊盘和焊锡球之间的最低电气特性要求,因为胶水是不会流过低于4um的间隙,所以保障了焊接工艺的电气安全特性。
(1)毛细管底部填充从器件 边缘注入。
使用的底部填充系统可分为三类:毛细管底部填充、助焊(非流动)型底部填充和四角或角-点底部填充系统。每类底部填充系统都有其优势和局限,但使用最为广泛的是毛细管底部填充材料。毛细管底部填充的应用范围包括板上倒装芯片(FCOB)和封装内倒装芯片(FCiP)。通过采用底部填充可以分散芯片表面承受的应力进而提高了整个产品的可靠性。
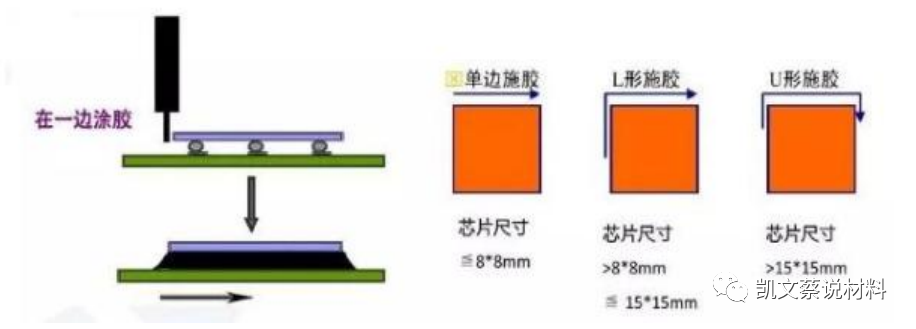
在传统倒装芯片和芯片尺寸封装(CSP)中使用毛细管底部填充的工艺类似。首先将芯片粘贴到基板上已沉积焊膏的位置,之后进行再流,这样就形成了合金互连。在芯片完成倒装之后,采用分散技术将底部填充材料注入到CSP的一条或两条边。材料在封装下面流动并填充CSP和组装电路板之间的空隙。尽管采用毛细管底部填充可以极大地提高可靠性,但完成这一工艺过程需要底部填充材料的注入设备、足够的厂房空间安装设备以及可以完成精确操作的工人。由于这些投资要求以及缩短生产时间的压力,后来开发出了助焊(非流动)型底部填充技术。
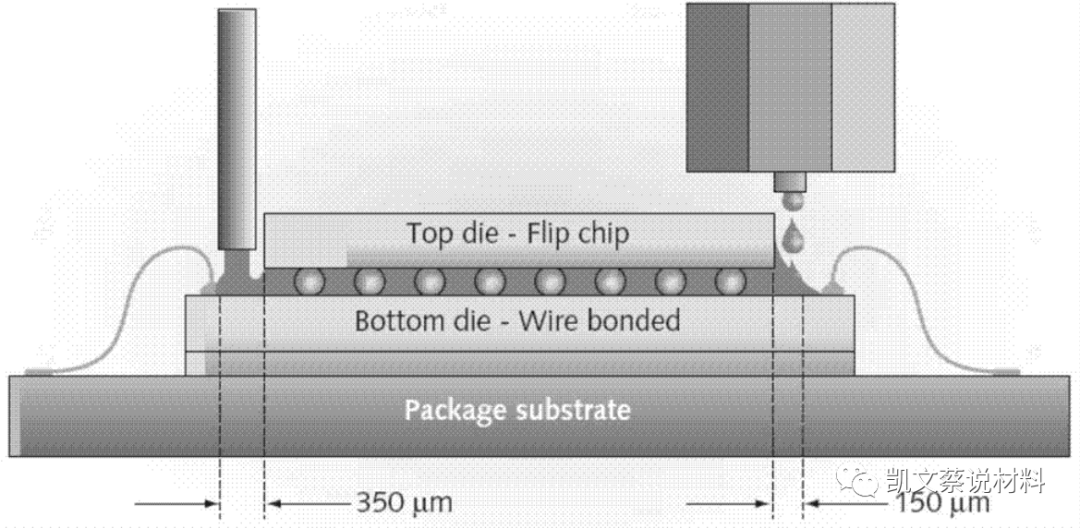
(2)非流动型底部填充工艺流程 及优点。
相对于其他底部填充系统来说,非流动型底部填充的最大优点在于对工艺的改进,在材料性能方面并没有明显差异。为了让底部填充的填充过程与传统的表面组装工艺更好的兼容,非流动型底部填充不能使用控温精确度很高的固化炉。通过将助焊性能集成到底部填充材料中,CSP的粘片和材料固化工艺合二为一。在组装过程中,在元件放置之前先将非流动型底部填充材料涂覆到粘片位置上。当线路板进行再流时,底部填充材料可以作为助焊剂,协助获得合金互连,并且本身在再流炉中同步完成固化。所以可以在传统的表面组装工艺线上完成底部填充。从设备和人员投入的角度来讲,非流动型底部填充系统节约了成本和时间,但自身也受到一些限制。与毛细管底部填充不同,非流动型底部填充材料中必须含有填充物。在底部填充材料中的填充材料可能正好位于焊料球和电路板焊盘之间。从设计上考虑,为了改善再流过程中焊料键合,要求该系统内不能含有微粒。如果没有微粒,底部填充材料的热膨胀系数(CTE)比较高,经过温度循环后其性能就不如毛细管底部填充稳定。另外,如果采用传统的再流工艺,而不进行精确温度控制也会降低再流工艺的成品率。此外电路板上吸附的湿气再流时也会被释放出来形成孔洞。但新的改进工艺已经克服了上述缺点。
(3)预成型底部填充应用的工 艺流程。
对于带 中间插入层或边角阵列的CSP来说,采用毛细管底部填充或非流动型底部填充系统都不如角-点底部填充方法更合适。这种方法首先将底部填充材料涂覆到CSP对应的焊盘位置。与非流动型底部填充不同,角-点技术与现有的组装设备和常规的焊料再流条件兼容。由于这类底部填充是可以返修的,制造商们也避免了因为一个器件缺陷就废弃整个电路板的风险。技术的转换需要提高可靠性 由于器件及其引脚节距变得更小、功能要求更多,并且需要产品工艺实现无铅化,因此在下一代电子产品中,底部填充技术的应用变得越来越重要。底部填充可以提高CSP中无铅焊料连接的可靠性,与传统的锡-铅焊料相比,无铅互连更容易产生CTE失配造成的失效。由于无铅工艺的再流温度较高,封装基板的翘曲变得更为强烈,而无铅焊料本身延展性又较低,因此该种互连的失效率较高。向无铅制造转换的趋势和无铅焊料本身的脆性等综合作用,使得在器件中使用底部填充技术已经成为成本最低,选择最为灵活的解决方案。
随着产业链向引脚节距0.3mm的CSP、节距小于180祄的倒装芯片封装以及更小尺寸发展,采用底部填充材料几乎是唯一可以保证全线成品率的方法。即将出现的可能 除了满足不断变化的机械要求,保证高可靠性之外,电子产品制造商还必须让产品的成本更具竞争力。面对这样的挑战,尚处于研发阶段的新底部填充技术,尽管仍处于一个产品的婴儿期,已经显示出很好的前景。非流动型底部填充的优势在于工艺效率较高,并且减少了设备和人员成本。但在使用底部填充材料时遇到的技术难题使这些优势都变得不重要了。不过市场上出现了含有50%填充成分的非流动型底部填充材料。采用了该比例填充料之后,在保持非流动型底部填充工艺流程的同时,改善了产品的温度循环性能。另一个备受关注的创新是预成型底部填充技术,该项技术有望在后道封装中完全消除底部填充工艺,而在CSP进行板级组装之前涂覆底部填充材料,或者在晶圆级工艺中涂覆底部填充材料。预成型底部填充在概念上很好,但要实施到当前的产品中,在工艺流程上还有一些挑战需要面对。在晶圆级底部填充材料的涂覆中,可以在凸点工艺之前或之后涂覆预成型底部填充材料,但两种方法都需要非常精确的控制。如果在凸点工艺之前涂覆,必须考虑工艺兼容问题。与之相反,如果在凸点工艺之后涂覆,则要求预成型底部填充材料不会覆盖或者损坏已完成的凸点。此外还需考虑到晶圆分割过程中底部填充材料的完整性以及一段时间之后产品的稳定性,这些在正式使用底部填充材料到产品之前都需要加以衡量。尽管某些材料供应商对预成型底部填充材料的研发非常超前,但将这一产品投入大规模应用还有更多的工作要完成。

(4)预成型底部填充应用 的工艺流程。

结论 如果没有底部填充材料的使用,当今的窄节距器件就无法克服可靠性问题。此外为了降低无铅焊料连接位置由CTE失配引起的失效率,无铅制造的工艺流程和温度要求都要求使用底部填充材料。新工艺流程的要求、器件功能的不断增多和封装尺寸的减小,这些要素都要求越来越多地使用牢固的底部填充系统。尽管已有很多种不同类别的底部填充技术,为了满足电子产品多功能、低成本的要求,还需要开发出下一代低成本、工艺流程简单的底部填充技术。
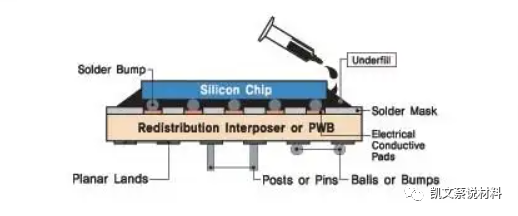

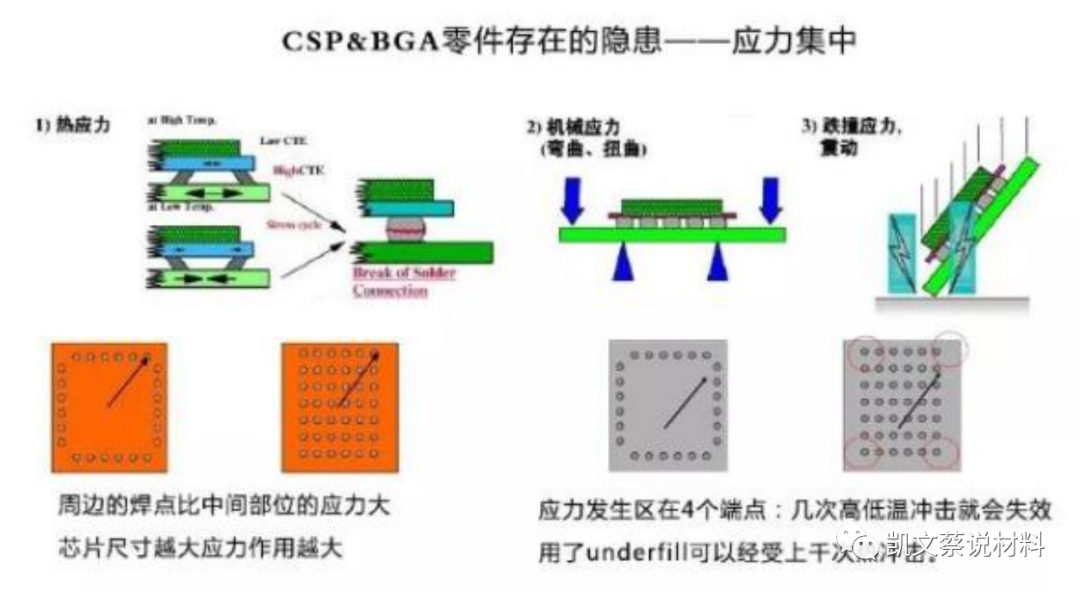
三
底部填充技术の作用
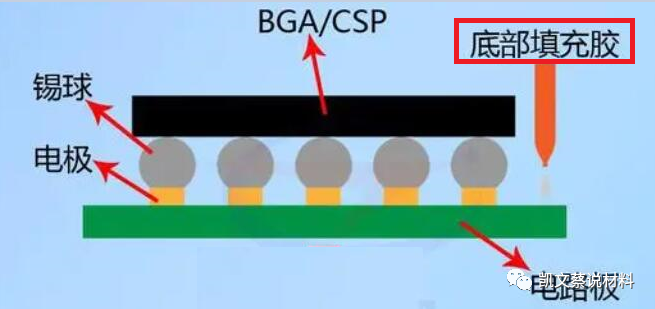
随着手机、电脑等便携式电子产品,日趋薄型化、小型化、高性能化,IC封装也日趋小型化、高聚集化,CSP/BGA得到快速普及和应用,CSP/BGA的封装工艺操作要求也越来越高。底部填充胶的作用也越来越被看重。BGA和CSP,是通过微细的锡球被固定在线路板上,如果受到冲击、弯折等外部作用力的影响,焊接部位容易发生断裂。而底部填充胶特点是:疾速活动,疾速固化,能够迅速浸透到BGA和CSP底部,具有优良的填充性能,固化之后可以起到缓和温度冲击及吸收内部应力,补强BGA与基板连接的作用,进而大大增强了连接的可信赖性。举个例子,我们日常使用的手机,从2米高地方落地,开机仍然可以正常运作,对手机性能基本没有影响,只是外壳刮花了点。很神奇对不对?这就是因为应用了BGA底部填充胶,将BGA/CSP进行填充,让其更牢固的粘接在PBC板上。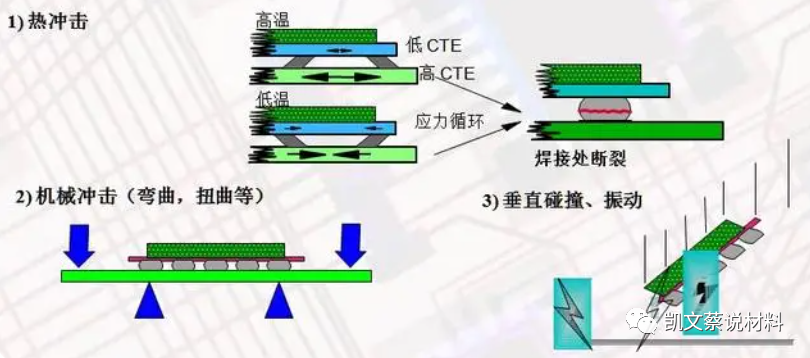
四
使用UNDERFILL底部填充胶水の注意事项
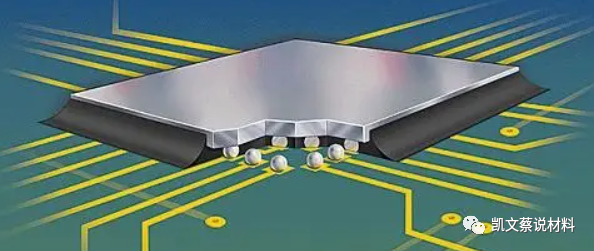
(1)流动性:流动性或者说填充速度往往是客户非常关注的一个指标,尤其是作为实际使用的SMT厂家,而实际对于可靠性要求非常高的一些行业,这个倒是其次的。就目前SMT行业的普遍要求,一般在1~30分钟理论上都是可接受的(当然手机行业一般是在2-10分钟以内,有些甚至要求以秒计,这个也需要结合芯片的大小)。测试方法:最简单的方法当然是直接在芯片上点胶进行测试,而且评估不同胶水的流动性时最好是同时进行平行测试(最好样板数要5-10个以上)。在研发段对流动性的测试就是用两块玻璃片间胶水的流动速度来判断研发方向的。影响流动性的因素有很多,在平行的测试条件下,下面有些可以检讨的因素:主要因素:1)粘度:毋庸置疑粘度肯定是影响流动速度最关键的因素之一,目前像粘度在几百cps的胶水基本上都是可以不需要预热点胶的,填充速度基本上都是一两分钟以内的;而像粘度稍大一些的达到几千cps的胶差别就比较大了(从几分钟到十几分钟不等);2)预热温度:这也是一个非常关键的影响因素,尤其是对一些粘度在一千以上的胶水,一般在预热(预热温度就需要结合各家的产品的特性,一般可以胶水的粘温曲线做参考,当并非一一直接对应的关系)的情况下,粘度为几千的胶水能降到几百,流动性会显著增大,但要注意预热温度过高过低都可能会导致流动性变差;3)基板的差别(芯片的尺寸及锡球的分布、锡球球径及数量、锡球间距、助焊剂残留、干燥程度等),这个对填充速度也是有一定影响的,在某些情况下影响也是非常明显的。当然这些差别对另一个底填胶的指标影响更大,后面会细说。当然如果是几种胶水平行测试,这个因素的影响是一致的。次要因素:1)施胶量(点胶方式);2)基板角度(有些厂家会将点胶后的基板倾斜一定角度加快流动性);3)环境温度(不预热的情况下)。说明:以上的一些因素的主次也都是相对而言的,如果客户能接受预热的方式的话,同时客户对流动性的要求不会精确到秒的话,那么上述因素的影响都会变小了。不预热的情况下要求快速填充的话,除了把胶的常温粘度做小外貌似没有更好的办法。另外同样是预热的条件下,流动速度就和胶水体系自身的设计思路有很大的关系了。同样一款2000cps左右粘度的胶水,预热的情况下流动速度也可以差几倍时间的。最后对于预热这个环节每家的说法都不一样,很多客户不愿意预热其实也是为了点胶操作的便利性,然而站在理论分析的角度,基板预热可以起到烘烤芯片的作用,而且也可以减少填充时产生空洞(气泡)的概率,当然加快填充速度也是必然的。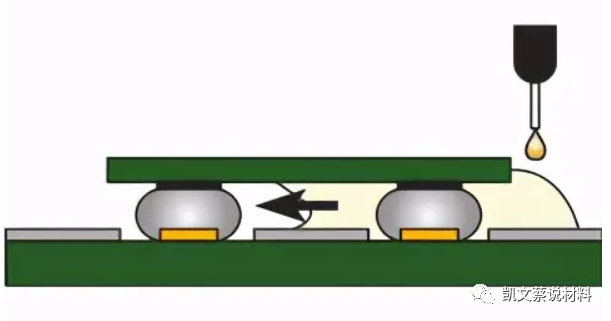
(2)、固化温度和时间(固化度):这个指标其实在研发端是比较容易判断的,用DSC曲线就很容易判断出来,当然由于DSC在测试时胶量是以mg来测试,所以一般建议给客户的固化温度是在DSC的理论时间上乘以4倍的(韩国元化学的建议)。然而在客户端如果判断,其实简单的方法就是按胶商TDS上建议的固化温度和时间还是比较保险的。另外有些客户经常会问如果不完全按TDS建议会如何,简单的推断的方法同等温度下时间加长或者同等时间下温度升高,理论上都是会完全固化的,但反向推断的话最好找供应商确认下。因为每种胶特性不一样,低于某个温度时间即使加几倍时间也未必能固化,同理也不是温度越高时间就会越短,就目前接触到的底填胶水的固化温度没有建议高过150度的(SONY曾经有款手机,使用SUNSTAR的胶水,在150度快速固化时后期测试时会有些缺陷,同样改用130度加长时间固化后就没有这个问题了)。太高温固化和太快速固化对胶水的后期一些性能还是有着蛮大的影响的(有些体系的胶水会影响更明显)。另外对于固化程度的判断,这个做为使用者的客户可能不大好判断,因为目测的完全固化时间和理论上的完全固化还是有差别的,客户一般容易从固化后的硬度,颜色等判断,但这个些指标可能在胶水只固化了80%以上时已经没法分辨出来了,如果能增加一些粘接力等测试辅助可能会更准确些,当然更精确的方法还是要用会DSC等一些热力学测试的设备和方法了。而在实际应用中,胶水达到90%或95%以上的固化已经算是完全固化了,具体要达到百分之九十几这个就要看后期可靠性的要求了。未完全固化的胶水是很难真正全面发挥应有作用的,尤其是后期测试要求很严格的时候。所以建议客户最好使用相对保险的固化条件,如果设置在临界值的话,固化温度或固化时间少有偏差就可能导致固化不完全。
胶水(胶粘剂)の紹介
一
胶粘剂的组成
现在使用的胶粘剂均是采用多种组分合成树脂胶粘剂,单一组分的胶粘剂已不能满足使用中的要求。合成胶粘剂由主剂和助剂组成,主剂又称为主料、基料或粘料;助剂有固化剂、稀释剂、增塑剂、填料、偶联剂、引发剂、增稠剂、防老剂、阻聚剂、稳定剂、络合剂、乳化剂等,根据要求与用途还可以包括阻燃剂、发泡剂、消泡剂、着色剂和防霉剂等成分。
1.主剂主剂是胶粘剂的主要成分,主导胶粘剂粘接性能,同时也是区别胶粘剂类别的重要标志。主剂一般由一种或两种,甚至三种高聚物构成,要求具有良好的粘附性和润湿性等。通常用的粘料有:
·天然高分子化合物如蛋白质、皮胶、鱼胶、松香、桃胶、骨胶等。2)合成高分子化合物①热固性树脂,如环氧树脂、酚醛树脂、聚氨酯树脂、脲醛树脂、有机硅树脂等。②热塑性树脂,如聚醋酸乙烯酯、聚乙烯醇及缩醛类树脂、聚苯乙烯等。③弹性材料,如丁腈胶、氯丁橡胶、聚硫橡胶等。④各种合成树脂、合成橡胶的混合体或接枝、镶嵌和共聚体等。
2.助剂为了满足特定的物理化学特性,加入的各种辅助组分称为助剂,例如:为了使主体粘料形成网型或体型结构,增加胶层内聚强度而加入固化剂(它们与主体粘料反应并产生交联作用);为了加速固化、降低反应温度而加入固化促进剂或催化剂;为了提高耐大气老化、热老化、电弧老化、臭氧老化等性能而加入防老剂;为了赋予胶粘剂某些特定性质、降低成本而加入填料;为降低胶层刚性、增加韧性而加入增韧剂;为了改善工艺性降低粘度、延长使用寿命加入稀释剂等。包括:
1)固化剂固化剂又称硬化剂,是促使黏结物质通过化学反应加快固化的组分,它是胶粘剂中最主要的配合材料。它的作用是直接或通过催化剂与主体聚合物进行反应,固化后把固化剂分子引进树脂中,使原来是热塑性的线型主体聚合物变成坚韧和坚硬的体形网状结构。
固化剂的种类很多,不同的树脂、不同要求采用不同的固化剂。胶接的工艺性和其使用性能是由加人的固化剂的性能和数量来决定的。
2)增韧剂
增韧剂的活性基团直接参与胶粘剂的固化反应,并进入到固化产物最终形成的一个大分子的链结构中。没有加入增韧剂的胶粘剂固化后,其性能较脆,易开裂,实用性差。加入增韧剂的胶接剂,均有较好的抗冲击强度和抗剥离性。不同的增韧剂还可不同程度地降低其内应力、固化收缩率,提高低温性能。
常用的增韧剂有聚酰胺树脂、合成橡胶、缩醛树脂、聚砜树脂等。
3)稀释剂稀释剂又称溶剂,主要作用是降低胶粘剂粘度,增加胶粘剂的浸润能力,改善工艺性能。有的能降低胶粘剂的活性,从而延长使用期。但加入量过多,会降低胶粘剂的胶接强度、耐热性、耐介质性能。常用的稀释剂有丙酮、漆料等多种与粘料相容的溶剂。
4)填料填料一般在胶黏剂中不发生化学反应,使用填料可以提高胶接接头的强度、抗冲击韧性、耐磨性、耐老化性、硬度、最高使用温度和耐热性,降低线膨胀系数、固化收缩率和成本等。常用的填料有氧化铜、氧化镁、银粉、瓷粉、云母粉、石棉粉、滑石粉等。5)改性剂改性剂是为了改善胶黏剂的某一方面性能,以满足特殊要求而加入的一些组分,如为增加胶接强度,可加入偶联剂,还可以加入防腐剂、防霉剂、阻燃剂和稳定剂等。
二
胶粘剂的分类
(一)、按成分来分:
胶粘剂种类很多,比较普遍的有:脲醛树脂胶粘剂、聚醋酸乙烯胶粘剂、聚丙烯酸树脂胶粘剂,聚丙烯酸树脂、聚氨酯胶粘剂、热熔胶粘剂、环氧树脂胶粘剂、合成胶粘剂等等。
1、有机硅胶粘剂
是一种密封胶粘剂,具有耐寒、耐热、耐老化、防水、防潮、伸缩疲劳强度高、永久变形小、无毒等特点。近年来,此类胶粘剂在国内发展迅速,但目前我国有机硅胶粘剂的原料部分依靠进口。
2、聚氨酯胶粘剂
能粘接多种材料,粘接后在低温或超低温时仍能保持材料理化性质,主要应用于制鞋、包装、汽车、磁性记录材料等领域。
3、聚丙烯酸树脂
主要用于生产压敏胶粘剂,也用于纺织和建筑领域。
建筑用胶粘剂:主要用于建筑工程装饰、密封或结构之间的粘接。
4、 热熔胶粘剂
根据原料不同,可分为EVA热熔胶、聚酰胺热熔胶、聚酯热熔胶、聚烯烃热熔胶等。目前国内主要生产和使用的是EVA热熔胶。聚烯烃系列胶粘剂主要原料是乙烯系列、SBS、SIS共聚体。
5、环氧树脂胶粘剂
可对金属与大多数非金属材料之间进行粘接,广泛用于建筑、汽车、电子、电器及日常家庭用品方面
6、脲醛树脂、酚醛、三聚氰胺-甲醛胶粘剂
主要用于木材加工行业,使用后的甲醛释放量高于国际标准。
木材加工用胶粘剂:用于中密度纤维板、石膏板、胶合板和刨花板等
7、合成胶粘剂
主要用于木材加工、建筑、装饰、汽车、制鞋、包装、纺织、电子、印刷装订等领域。目前,我国每年进口合成胶粘剂近20万吨,品种包括热熔胶粘剂、有机硅密封胶粘剂、聚丙烯酸胶粘剂、聚氨酯胶粘剂、汽车用聚氯乙烯可塑胶粘剂等。同时,每年出口合成胶粘剂约2万吨,主要是聚醋酸乙烯、聚乙烯酸缩甲醛及压敏胶粘剂。
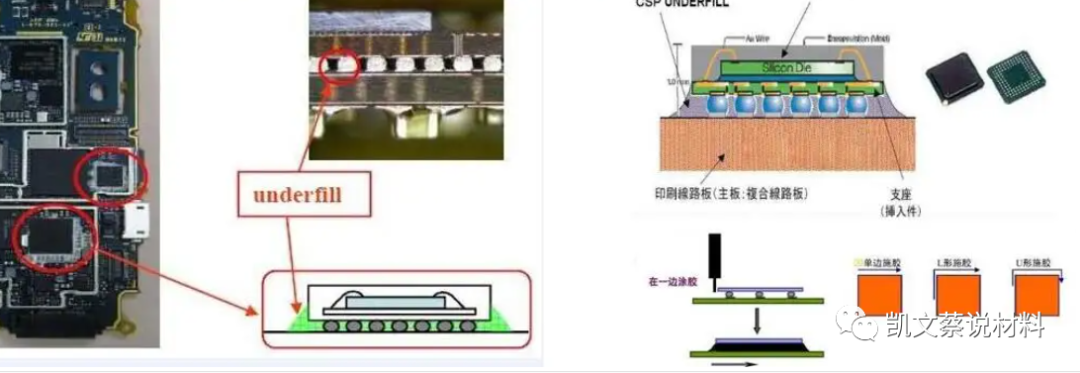
(二)、按用途来分:
1、密封胶粘剂
主要用于门、窗及装配式房屋预制件的连接处。高档密封胶粘剂为有机硅及聚氨酯胶粘剂,中档的为氯丁橡胶类胶粘剂、聚丙烯酸等。在我国,建筑用胶粘剂市场上,有机硅胶粘剂、聚氨酯密封胶粘剂应是今后发展的方向,目前其占据建筑密封胶粘剂的销售量为30%左右。
2、建筑结构用胶粘剂
主要用于结构单元之间的联接。如钢筋混凝土结构外部修补,金属补强固定以及建筑现场施工,一般考虑采用环氧树脂系列胶粘剂。
3、汽车用胶粘剂
分为4种,即车体用、车内装饰用、挡风玻璃用以及车体底盘用胶粘剂。
目前我国汽车用胶粘剂年消耗量约为4万吨,其中使用量最大的是聚氯乙烯可塑胶粘剂、氯丁橡胶胶粘剂及沥青系列胶粘剂。
4、包装用胶粘剂
主要是用于制作压敏胶带与压敏标签,对纸、塑料、金属等包装材料表面进行粘合。纸的包装材料用胶粘剂为聚醋酸乙烯乳液。塑料与金属包装材料用胶粘剂为聚丙烯酸乳液、VAE乳液、聚氨酯胶粘剂及氰基丙烯酸酯胶粘剂。
5、电子用胶粘剂
消耗量较少,目前每年不到1万吨,大部分用于集成电路及电子产品,现主要用环氧树脂、不饱和聚酯树脂、有机硅胶粘剂。用于5微米厚电子元件的封端胶粘剂我们可以自己供给,但3微米厚电子元件用胶粘剂需从国外进口。
6、制鞋用胶粘剂
年消费量约为12.5万吨,其中氯丁橡胶类胶粘剂需要11万吨,聚氨酯胶粘剂约1.5万吨。由于氯丁橡胶类胶粘剂需用苯类作溶剂,而苯类对人体有害,应限制发展,为满足制鞋业发展需求,采用聚氨酯系列胶粘剂将是方向。
(三)、按物理形态来分:
1、密封胶
1.1 按密封胶硫化方法分类
(1)湿空气硫化型密封胶
此类密封胶系列用空气中的水分进行硫化。它主要包括单组分的聚氨酯、硅橡胶和聚硫橡胶等。其聚合物基料中含有活性基团,能同空气中的水发生反应,形成交联键,使密封胶硫化成网状结构。
(2)化学硫化型密封胶
双组分的聚氨酯、硅橡胶、聚硫橡胶、氯丁橡胶和环氧树脂密封胶都属于这一类,一般在室温条件下完成硫化。某些单组分的氯磺化聚乙烯和氯丁橡胶密封胶以及聚氯乙烯溶胶糊状密封胶则须在加热条件下经化学反应完成硫化。
(3)热转变型密封胶
用增塑剂分散的聚氯乙烯树脂和含有沥青的橡胶并用的密封胶是两个不同类型的热转变体系。乙烯基树脂增塑体在室温下是液态悬浮体,通过加热转化为固体而硬化;而橡胶-沥青并用密封胶则为热熔性的。
(4)氧化硬化型密封胶
表面干燥的嵌逢或安装玻璃用密封胶主要以干性或半干性植物油或动物油为基料,这类油料可以是精制聚合的、吹制的或化学改性的。
(5)溶剂挥发凝固型密封胶
这是以溶剂挥发后无粘性高聚物为基料的密封胶。这一类密封胶主要有丁基橡胶、高分子量聚异丁烯、一定聚合程度的丙烯酸酯、氯磺化聚乙烯以及氯丁橡胶等密封胶。
1.2 按密封胶形态分类
(1)膏状密封胶
此类密封胶基本上用于静态接缝中,使用期一般为2年或2年以上。通常采用3种主体材料:油和树脂、聚丁烯、沥青。
(2)液态弹性体密封胶
此类密封胶包括经硫化可形成真正弹性状态的液体聚合物,它们具有承受重复的接缝变形能力。弹性体密封胶所使用的聚合物弹性体包括液体聚硫橡胶、巯端基聚丙烯醚、液体聚氨酯、室温硫化硅橡胶和低分子丁基橡胶等。该类密封胶通常配合成两个组分,使用时将两个组分混合。
(3)热熔密封胶
热熔密封胶又叫热施工型密封胶。指以弹性体同热塑性树脂掺合物为基料的密封胶。这类密封胶通常在加热(150~200℃)情况下经一定口型模型直接挤出到接缝中。热施工可改进密封胶对被粘基料的湿润能力,因此对大多数被粘基料具有良好的粘接力。一经放入适当位置,就冷却成型或成膜,成为收缩性很小的坚固的弹性体。热施工密封胶的主体材料主要是异丁烯类聚合物、三元乙丙橡胶和热塑性的苯乙烯嵌段共聚物。它们通常同热塑性树脂如EVA、EEA、聚乙烯、聚酰胺、聚酯等掺合。
(4)液体密封胶
该类密封胶主要用于机械接合面的密封,用以代替固体密封材料即固体垫圈以防止机械内部流体从接合面泄漏。该类密封胶通常以高分子材料例如橡胶、树脂等为主体材料,再配以填料及其它组分制成。液体密封胶通常分不干性粘着型、半干性粘弹性、干性附着型和干性可剥型等4类。根据具体使用部位及要求选择。
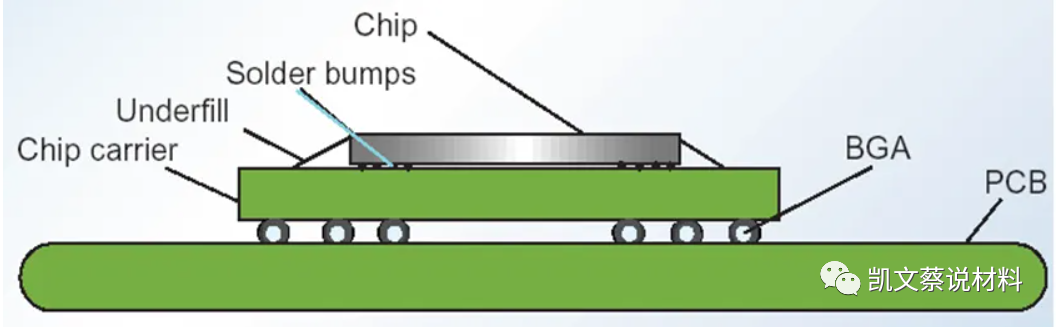
1.3 按密封胶施工后性能分类
(1)固化型密封胶
固化型密封胶可分成刚性密封胶和柔性密封胶两种类型:a)刚性密封胶硫化或凝固后形成坚硬的固体,很少具有弹性;此类密封胶有的品种既起密封作用又起胶接作用,其代表性密封胶是以环氧树脂、聚酯树脂、聚丙烯酸酯、聚酰胺和聚乙酸乙烯酯等树脂为基料的密封胶。b)柔性密封胶在硫化后保持柔软性。它们一般以橡胶弹性体为基料。柔性变化幅度大,硬度(邵尔A)在10~80范围内。这类密封胶中有些品种是纯橡胶,大多数具有良好胶粘剂的性能。
(2)非固化型密封胶
这类密封胶是软质凝固性的密封胶,施工之后仍保持不干性状态。通常为膏状,可用刮刀或刷子用到接缝中,可以配合出许多不同粘度和不同性能的密封胶。
2、按胶粘剂硬化方法分类
低温硬化代号为a;常温硬化代号为b;加温硬化代号为c;适合多种温度区域硬化代号为d;与水反应固化代号为e;厌氧固化代号为f;辐射(光、电子束、放射线)固化代号为g;热熔冷硬化代号为h;压敏粘接代号为i;混凝或凝聚代号为j,其他代号为k。
3、按胶粘剂被粘物分类
多类材料代号为A;木材代号为B;纸代号为C;天然纤维代号为D;合成纤维代号为E;聚烯烃纤维(不含E类)代号为F;金属及合金代号为G;难粘金属(金、银、铜等)代号为H;金属纤维代号为I,无机纤维代号为J;透明无机材料(玻璃、宝石等)代号为K;不透明无机材料代号为L;天然橡胶代号为M;合成橡胶代号为N;难粘橡胶(硅橡胶、氟橡胶、丁基橡胶)代号为O,硬质塑料代号为P,塑料薄膜代号为Q;皮革、合成革代号为R,泡沫塑料代号为S; 难粘塑料及薄膜(氟塑料、聚乙烯、聚丙烯等)代号为T;生物体组织骨骼及齿质材料代号为U;其他代号为V。
4、胶水状态
无溶剂液体代号为1;2有机溶剂液体代号为2;3水基液体代号为3,4膏状、糊状代号为4,5粉状、粒状、块状代号为5;6片状、膜状、网状、带状代号为6;7丝状、条状、棒状代号为7。
5、其它胶粘剂: (不常用到)
金属结构胶、聚合物结构胶、光敏密封结构胶、其它复合型结构胶
热固性高分子胶:环氧树脂胶、聚氨酯(PU)胶、氨基树脂胶、酚醛树脂胶、丙烯酸树脂胶、呋喃树脂胶、间笨二酚-甲醛树脂胶、二甲笨-甲醛树脂胶、不饱和聚酯胶、复合型树脂胶、聚酰亚胺胶、脲醛树脂胶、其它高分子胶
密封胶粘剂:室温硫化硅橡胶、环氧树脂密封胶、聚氨酯密封胶、不饱和聚酯类、丙烯酸酯类、密封腻子、氯丁橡胶类密封胶、弹性体密封胶、液体密封垫料、聚硫橡胶密封胶、其它密封胶
热熔胶:热熔胶条、胶粒、胶粉、EVA热熔胶、橡胶热熔胶、聚丙烯、聚酯、聚酰胺、聚胺酯热熔胶、苯乙烯类热熔胶、新型热熔胶、聚乙烯及乙烯共聚物热熔胶、其他热熔胶
水基胶粘剂:丙烯酸乳液、醋酸乙烯基乳液、聚乙烯醇缩醛胶、乳液胶、其它水基胶
压敏胶(不干胶):胶水、胶粘带、无溶剂压敏胶、溶剂压敏胶、固化压敏胶、橡胶压敏胶、丙烯酸酯压敏胶、其它压敏胶
溶剂型胶:树脂溶液胶、橡胶溶液胶、其它溶剂胶
无机胶粘剂:热熔无机胶、自然干无机胶、化学反应无机胶、水硬无机胶、其它无机胶
热塑性高分子胶粘剂:固体高分子胶、溶液高分子胶、乳液高分子胶、单体高分子胶、其它热塑性高分子胶
天然胶粘剂:蛋白质胶、碳水化合物胶粘剂、其他天然胶
橡胶粘合剂:硅橡胶粘合剂、氯丁橡胶粘合剂、丁腈橡胶粘合剂、改性天然橡胶粘合剂、氯磺化聚乙烯粘合剂、聚硫橡胶粘合剂羧基橡胶粘合剂、聚异丁烯、丁基橡胶粘合剂、其它橡胶粘合剂
耐高温胶:有机硅胶、无机胶、高温模具树脂胶、金属高温粘合剂、其它耐高温胶
聚合物胶粘剂:丁腈聚合物胶、聚硫橡胶粘合剂、聚氯乙烯胶粘剂、聚丁二烯胶、过氯乙烯胶粘剂、其它聚合物胶
修补剂:金属修补剂、高温修补剂、紧急修补剂、耐磨修补剂、耐腐蚀修补剂、塑胶修补剂、其它修补剂
医用胶、纸品用胶、导磁胶、防磁胶、防火胶、防淬火胶、防淬裂胶、动物胶、植物胶、矿物胶、食品级胶粘剂、其它胶水。
胶水(胶粘剂)技术原理の简介

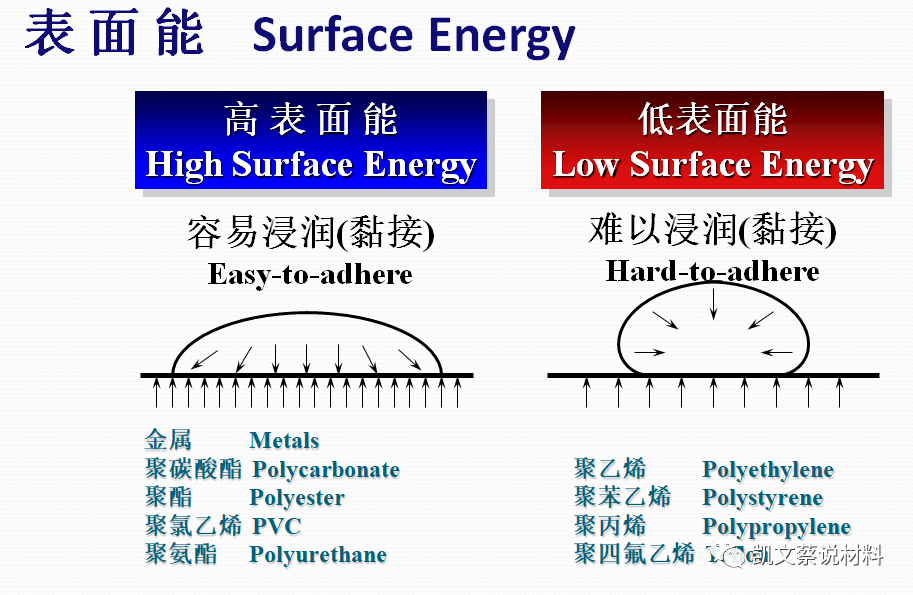


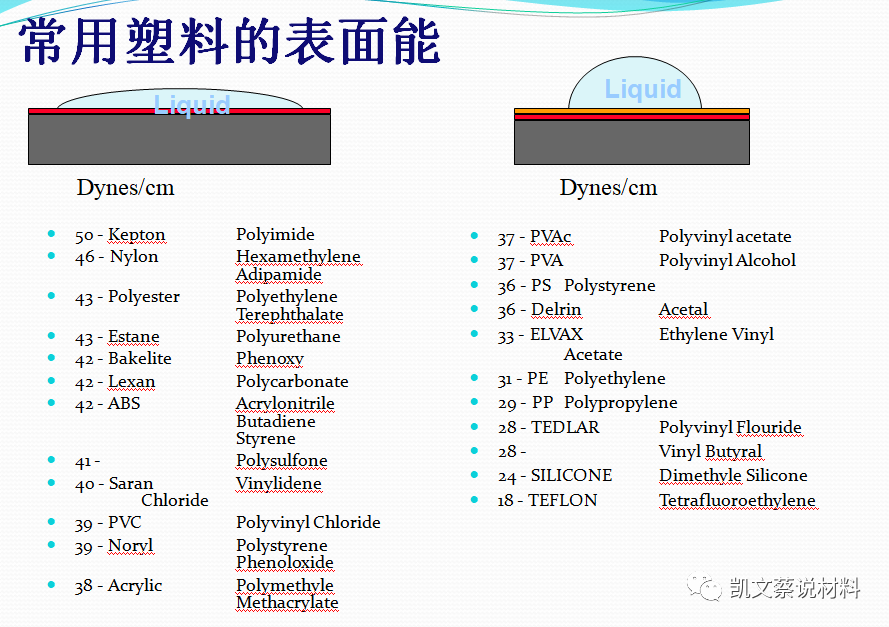
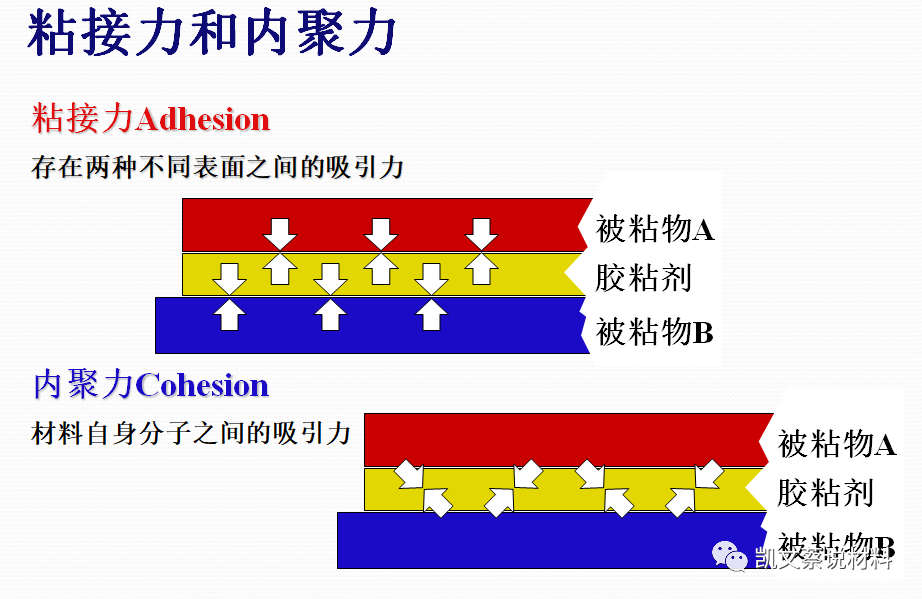
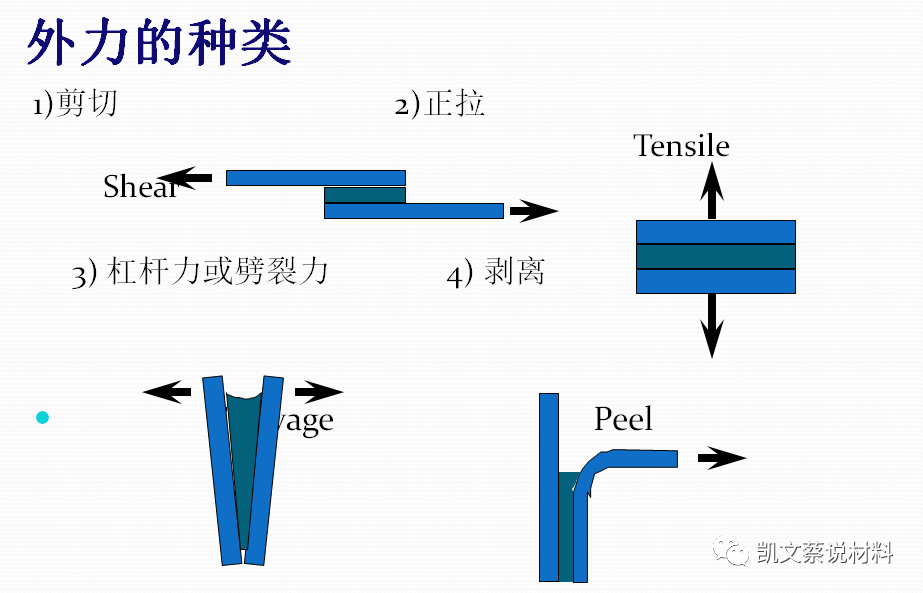
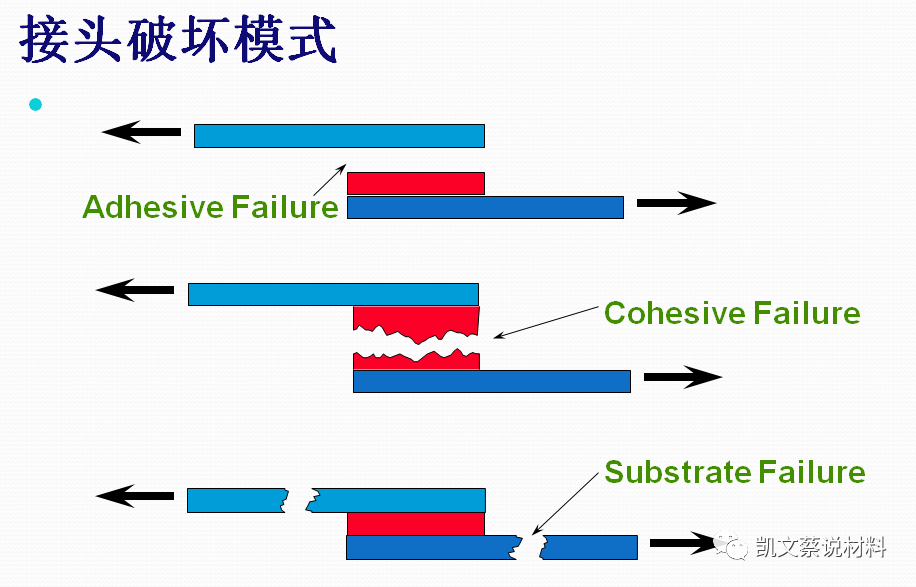
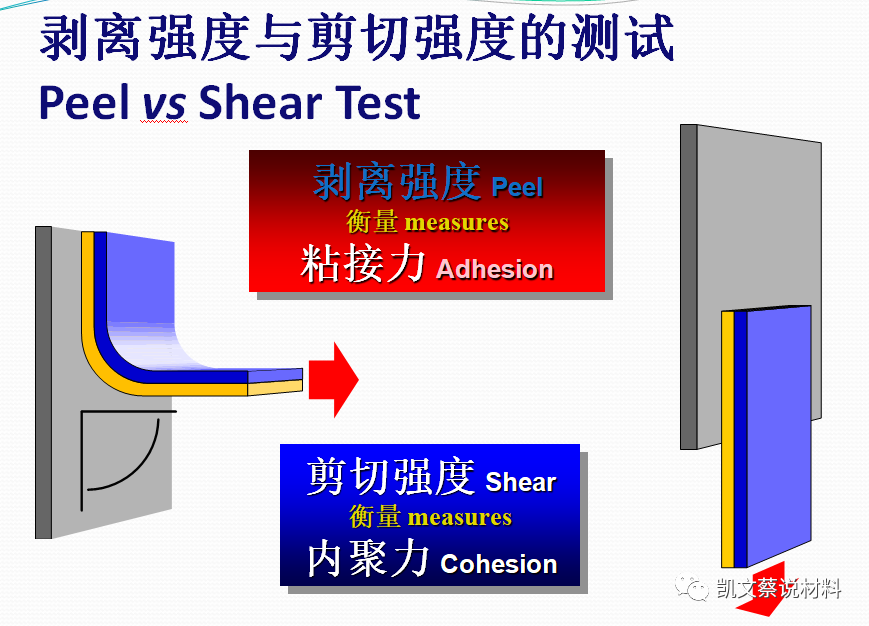













二步固化胶水、双固化胶水、双重固化胶水の紹介
一
二步固化
分两步固化:预固化,本固化。

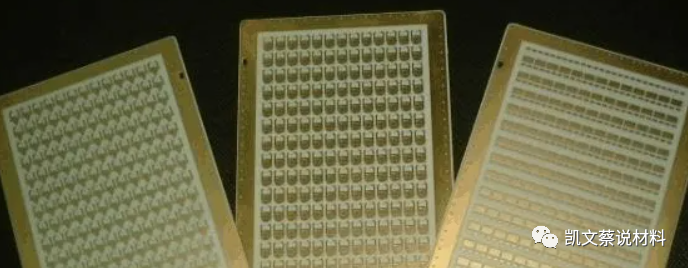
二
双固化
有两种固化方式,比如:可以加热或UV或常温等。
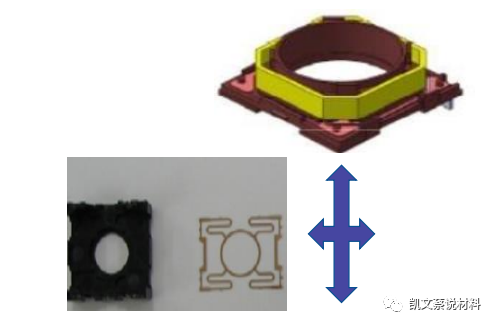
三
双重固化
需要两种固化方式才能完全固化,比如:先UV后常温,或先UV后加热。
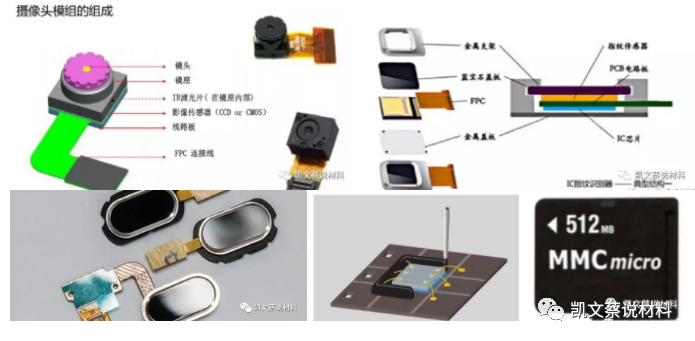
半导体芯片BGA/CSP用の底填胶水
一
概述
3808是一种单组份环氧的可维修的底部填充环氧树脂,适用CSP(FBGA)以及 BGA,加热可快速固化,抗机械力出色。低粘度树脂可充分填充CSP和BGA的底部,同时具备高速固化点胶可返工特性。
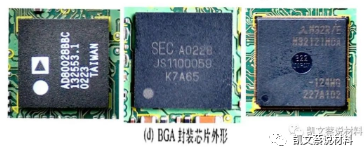
二
特性
固化速度快;
点胶可返工。

三
产品参数、固化条件

-
芯片
+关注
关注
462文章
53539浏览量
459160
发布评论请先 登录
芯源半导体安全芯片技术原理


功率半导体器件——理论及应用

最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测






 国货当自强:半导体芯片底填胶水
国货当自强:半导体芯片底填胶水


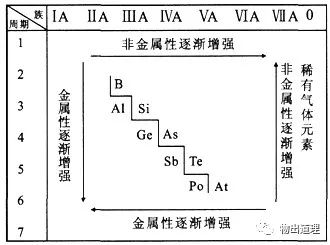











评论