砷化镓晶圆的材料特性
砷化镓(GaAs)是国际公认的继“硅”之后最成熟的化合物半导体材料,具有高频率、高电子迁移率、高输出功率、低噪音以及线性度良好等优越特性,作为第二代半导体材料中价格昂贵的一种,被冠以“半导体贵族”之称,是光电子和微电子工业最重要的支撑材料之一。
砷化镓晶圆的脆性高,与硅材料晶圆相比,在切割过程中更容易产生芯片崩裂现象,使芯片的晶体内部产生应力损伤,导致产品失效和使用性能降低。
砷化镓晶圆的应用
用砷化镓制成的半导体器件具有高频、高温、低温性能好、噪声小、抗辐射能力强等优点,可用于生产二极管、场效应晶体管(FET)和集成电路(IC)等,主要应用于高端军事电子、光纤通信系统、宽带卫星无线通信系统、测试仪器、汽车电子、激光、照明等领域。
目前,基于砷化镓衬底的led发光芯片在市场上有大量需求。
选刀要点
切割砷化镓晶圆,通常采用轮毂型电镀划片刀,选刀不当极易造成晶片碎裂,导致成品率偏低。用极细粒度金刚石(4800#,5000#)规格的刀片,能有效减少晶片碎裂,但切割之前需要进行修刀。
案例实录
►
测试目的
1、对比测试
2、验证切割品质

►
材料情况
切割产品 | 砷化镓外延片 |
产品尺寸 | 4寸 |
产品厚度 | 100μm |
胶膜类型 | 蓝膜 |
►
修刀参数
修刀板型号 | 5000# |
尺寸规格 | 75x75x1mm |
修刀速度 | 8/10/15 mm/s |
修刀刀数 | 3种速度各5刀 |
►
工艺参数
切割工艺 | 单刀切透 |
设备型号 | DAD322 |
主轴转速 | 38K rpm |
进刀速度 | CH2:25mm/s CH1:35mm/s |
刀片高度 | CH2:0.08mm CH1:0.07mm |
►
样刀准备
SSTYE 5000-R-90-AAA
►
样刀规格

刀片型号 | 5000-R-90 AAA |
金刚石粒度 | 5000# |
结合剂硬度 | R(硬) |
集中度 | 90 |
切痕宽度 | 0.015-0.020 |
►
测试结果
1、刀痕良好,<18μm,在控制范围内。
2、正面崩边<3μm。
3、背面崩边<15μm,在控制范围内。
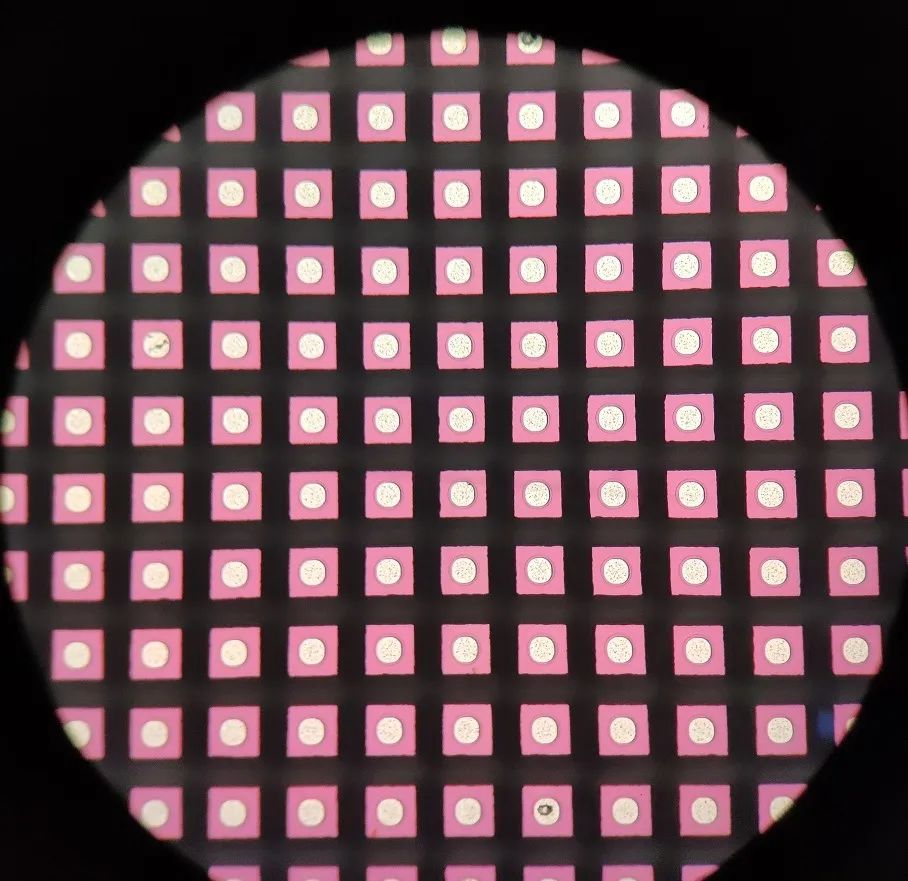


切割效果(滑动查看更多图片)
西斯特科技
深圳西斯特科技有限公司 (简称西斯特SST) ,以“让一切磨削加工变得容易”为主旨,倡导磨削系统方法论,2015年金秋创立于深圳,根植于技术创新的精神,屹立于创造价值、追求梦想的企业文化。
基于对应用现场的深度解读、创新性的磨具设计和磨削系统方法论的实际应用,西斯特秉承先进的磨削理念,践行于半导体、消费电子、汽车零部件等行业,提供高端磨具产品以及“切、磨、钻、抛”系统解决方案,在晶圆与封装基板划切、微晶玻璃和功能陶瓷磨削、汽车零部件精密磨削等领域应用广泛。
西斯特科技始终以先进的技术、创新的产品、优质服务的理念,引领产业革命,创造无限可能。
-
晶圆
+关注
关注
53文章
5345浏览量
131700
发布评论请先 登录
半导体行业案例:晶圆切割工艺后的质量监控

基于纳米流体强化的切割液性能提升与晶圆 TTV 均匀性控制

EMC设计实战秘籍 I 第十期正式开启!






 案例分享第十期:砷化镓(GaAs)晶圆切割实例
案例分享第十期:砷化镓(GaAs)晶圆切割实例

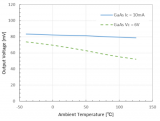












评论