摘要:随着半导体器件向着微型化、髙度集成化及高功率密度方向发展,其发热量急剧增大,热失效已经成为阻碍微电子封装器件性能和寿命的首要问题。高性能的热管理材料能有效提高微电子封装内部元器件散热能力,其中封装结构散热路径上的热界面材料(Thermal Interface Material,TIM)便是热管理中至关重要的环节。通过热界面材料填充器件热源和散热单元之间的空隙,可以大幅度降低接触热阻,增加热量的传递效率。对微电子封装而言,高性能的热界面材料不仅需要高的导热系数以降低封装热阻,还需具备一定的压缩性以弥补封装的装配偏差,然而通常很难兼顾上述两种特性。本文重点关注微电子封装中热界面材料,系统地梳理了目前热界面材料的常见类型、应用存在问题、关注研究热点和国内外发展现状。
01引言
随着微电子封装技术不断发展,高密度的三维集成技术应用愈加广泛,由此带来的高热流密度环境对微电子封装的热管理带来极大考验,选择优异性能的热管理材料来增强电子器件散热能力成为研究重点。而对于微电子封装的热管理而言,在散热路径上各结构之间填充热界面材料可有效排出空隙间的空气,通过增加接触面积加快热点热量传导。因此,热界面材料是微电子封装散热管理的关键之一。
在电子器件的散热过程中,热传导需要在两个固体表面传输,但是界面处不是理想的平面,而是存在少量小尺度凹凸界面,在实际应用中界面位置也仅依靠凸起结构接触,大部分空隙由空气填充。由于空气导热系数很低,仅有 0.026 W/(m·K),与上百的金属材料导热系数相比低了近 4 个数量级,因此可忽略通过空气传导的热量,进而大幅降低了传导散热效率,界面位置也成为了微电子封装的传导散热瓶颈。
因此选择使用合适的热界面材料来填充界面之间的空气间隙,可有效降低不同结构之间的接触热阻,实现芯片热量的快速传递。实际的热界面状态及热流方向上通过固体-界面材料-固体结构的热阻示意如图 1 所示。
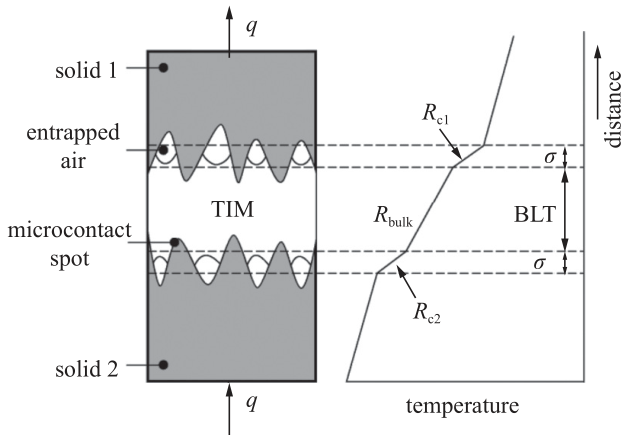
图 1 实际热界面状态及热流方向上热阻示意图
由图 1 可知,热界面材料位于上下两个固体之间,实际并不是完全的接触,热量由下往上分别经固体 1、热界面材料和固体 2,进而产生温差。假设上述散热路径为均匀的一维传导,由傅里叶导热定律,可知热量经过热界面材料的体热阻 Rbulk为
 (1)
(1)
热界面材料总热阻可表示为:
 (2)
(2)
式中,Rtot为热界面材料总热阻;BLT 为热界面材料的粘合层厚度;kTIM为热界面材料的导热系数;Rc1和 Rc2为热界面材料与上下两个固体表面的界面接触热阻。通过公式可得出影响到界面材料总热阻 Rtot的参数包括以下三个方面。
(1)接触热阻:在固体与热界面材料之间存在接触热阻,这种接触热阻大小主要取决于材料的表面浸润性、材料表面粗糙度、粘度和界面之间压力等。
(2)粘合层厚度:热界面材料的粘合层厚度是衡量两个表面分离的程度,由于热界面材料的导热系数通常较低,所以粘合层厚度越小其热阻越小。热界面材料在理论上只填充界面空隙,而实际粘合层过薄也会导致间隙,这是由于热界面材料涂抹不均匀和热循环过程热膨胀系数不匹配导致的可靠性问题。
对于液态热界面材料,粘合层厚度不仅受材料用量影响,还受到材料的粘度和加持压力影响。对于填充固体颗粒热界面材料,填充剂尺寸可能会限制到粘合层厚度。对于衬垫型热界面材料,粘合层厚度受到装配操作和机械要求限制。
(3)导热系数:热界面材料导热系数是衡量材料内部导热性能的指标。当粘合层厚度较小时,接触热阻在总热阻中起主导作用,但对于较厚粘合层的热界面材料,导热系数成为关键参数。
随着微电子封装产品对散热要求的不断提高,热界面材料成为热管理研究的热点。本文综述了微电子封装中热界面材料的研究现状,梳理介绍了目前行业内常用的热界面材料以及新型热界面材料类型、功能特点、应用现状和存在问题,并展望了未来的研究方向,为从事微电子封装热管理的研究人员了解热界面材料应用注意事项和应用方案选取提供参考。
02微电子封装热界面材料特性
图 2 为典型微电子封装器件的散热路径示意图,高功耗芯片一般采取倒扣焊工艺通过向上散热通道将热量及时传至外部散热器,因此“芯片-TIM-封装-TIM-散热器”是封装内芯片工作时的主要散热路径。微电子封装理想的热界面材料应是由一种兼顾低粘合层厚度、高柔韧性、高导热系数和低接触热阻的材料组成。
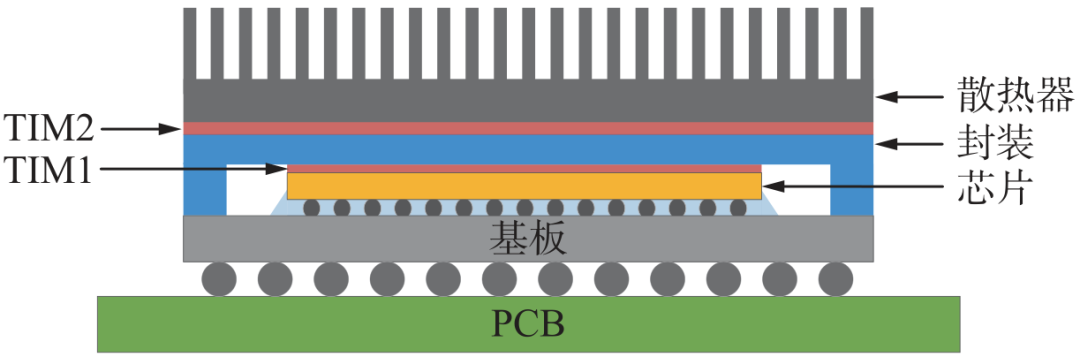
图 2 典型微电子封装器件散热路径
在热界面材料的应用选型和设计中,除界面接触热阻外,还有其他参数需要考虑,比如电气绝缘性和机械强度,这将影响到热界面材料在微电子封装中的装配操作和封装可靠性。
热界面材料可以是液态(通常为粘度非常高的粘稠体)或固态形式,在应用时也不必保持相同形态。使用液态热界面材料可能会导致某些混乱状态和不确定的粘合层厚度,因此还需扩大其适用性,使其既能填充小间隙,又可填充大缝隙,通常只要热界面材料粘度足够低,都能较好渗入空隙。衬垫热界面材料的应用工艺更为简单,但可能与基板的匹配性一般,这主要取决于基板的粗糙度和平整度。
在实际操作过程中,液态热界面材料可能也会对封装的可靠性产生负面影响,在温度循环过程中,封装体将发生机械变形,导致热界面材料向外扩散,最终从界面之间溢出,这种泵出效应是使用液态热界面材料面临的重要问题。
在微电子封装的微组装工艺过程中,热界面材料不仅要充当消除接触热阻的功能,还需考虑微组装过程中不同结构的偏差匹配问题。如图 2 所示的微电子封装结构,各层结构高度都存在一定偏差范围,尤其是焊球经过回流焊之后会有塌陷,在最终的微组装后不同结构之间会产生较大高度累积偏差。这种结构偏差需要具备一定压缩性的材料来弥补以提高微电子封装的装配适应性和可靠性,而具有一定柔韧性的热界面材料是封装内具备上述特征的理想材料。因此热界面材料的高柔韧性也是微电子封装应用时需要重点考虑的问题之一。
另一个需要考虑的是热界面材料能否充当粘合剂或者使用时是否需要外部压力。液态热界面材料在使用过程中需要施加一定压力与基体良好接触,这取决于热界面材料粘度。而固态热界面材料在操作使用过程中通常需要很大压力使热界面材料与基体贴合。
而有些热界面材料同时也作为粘合剂使用,可无需任何外部压力便可将两个基材粘合,但它也可能产生分层,这会带来新的可靠性问题。如果两个基体是不同 CTE(热膨胀系数)材料,那么热界面材料必须能够吸收由于 CTE 不匹配而产生的应变,否则可能导致界面开裂和破坏,对液态热界面材料通常不会有该问题,而对固态热界面材料来说,这可能是一个关键问题,特别是在粘合层很薄的时候更应重点关注。
03常见热界面材料
市场上常见热界面材料主要分为高分子基复合材料、金属基热界面材料及处于前沿探索阶段的新型热界面材料。常见 TIM 类型和典型特性见表 1。本章节重点对下列常用热界面材料加以介绍:高分子基复合材料包括导热硅脂、导热凝胶、导热胶、导热垫及导热相变材料等;金属基热界面材料以低熔点焊料、液态金属材料等为代表;新型的热界面材料则以导热高分子、石墨烯和碳纳米管阵列等为代表。
表 1 常见 TIM 类型和典型特性

3.1 高分子基热界面材料
(1)导热硅脂
导热硅脂是一种膏状热界面材料,一般用作高功率电子器件散热,由于它可直接减少接触面之间的空气间隙而具备优异导热特性而得到广泛应用。导热硅脂通常是将较高导热系数的无机填料与硅油基体进行混合脱泡加工而成。基体中填充的无机填料决定了导热硅脂的导热性能。
无机填料主要是在聚合物基体中添加 Al、Ag 等金属或Al2O3、AlN、BN、SiC、ZnO 等陶瓷导热颗粒。导热硅脂的优点是流变稳定性良好,其粘合层厚度非常小,高等级的导热油脂其热界面热阻可低至 10 Kmm2/W;缺点是泵出效应明显,使用时易发生溢出及相分离现象,长期使用过程中导热硅脂也会由于溶剂的挥发而变干,大大降低了导热硅脂的可靠性。
此外硅油的导热系数偏低,其导热系数通常不高于 10W/(m·K),所以很难制备出高导热性能的导热硅脂。因此,由于导热硅脂不具备压缩性、操作使用难度大、长期使用易失效以及其泵出效应带来的可靠性问题,使其在微电子封装领域应用受限。
(2)导热凝胶
导热凝胶是一种粒子填充型聚合物,其基体材料硅树脂一般进行弱交联固化处理,以此来增强材料的内聚力。
导热凝胶可兼具液体与固体特性,像液体一样分散,其特点是高导热性、低表面能和良好的一致性,从而降低了接触热阻,在固化后可形成一个更坚实的结构,在保证了低热阻的同时消除了泵出效应问题,另外低模量特性也可吸收应力。
优异的导热性能、良好的可压缩性和力学可靠性,使得导热凝胶在微电子封装应用前景较好,但相比而言,导热凝胶的导热系数不高,未来研究重点在于材料导热性能的提高。
(3)导热胶
导热胶是将液态高分子物质材料涂抹在微电子封装内部的散热元件上,在常温或加热的固化条件下产生的热固高分子材料,其导热性能良好,可实现热量在界面之间的快速传导。
导热胶在固化过程中并不需外部压力作用便可自然产生强烈键合作用。导热胶是在环氧树脂聚合物基体中添加导热填料制备而成,与导热凝胶类似,导热胶同时具备液态和固态两种物态,由于其在固态时更坚硬,其粘合力也更强。
此外,也有直接作为双面胶使用的固态导热胶。虽然导热胶的导热系数不高,但由于其厚度可根据结构进行适应性调节,因此可以弥补微电子封装中导热通道的散热结构偏差,降低对结构组装的公差要求,而较薄 BLT 也可保证较低的热阻,因此导热胶在微电子封装应用广泛,后续重点在提高材料导热系数方面开展研究。
(4)导热垫
导热垫同样是通过在基体添加填料的方式制备,其基体材料为有机硅树脂或聚氨酯,填料通常为Al2O3、BN 等陶瓷或金属、石墨填料。为提高其强度,也可将玻璃纤维布作为载体。然而,虽然导热垫中聚合物基体的高度交联容易获得操作便利的固体弹性垫,但这也导致其 BLT 较厚(约 200~1000 µm),同时由于流变特性一般,为保证良好接触,使用时需要在施加较大压力。
导热垫的柔韧性是非常重要的特点,高的导热颗粒填充体积分数可提高导热性能,但由此增加了其刚度,因此导热垫性能受限于高柔韧性和高导热颗粒填充率之间的矛盾。但由于导热垫具备减震性、无污染和便利性等优点,使其在一些热阻要求不是特别高的领域得到了非常广泛的应用。
在微电子封装领域中由于导热垫的导热性能一般且BLT 较厚的原因,并未得到广泛应用,后续可在降低BLT 厚度和提高导热性能等方面开展研究。
(5)导热相变材料
导热相变材料同时具备导热硅脂和导热垫的优点,其基体材料的熔化温度基本位于室温和工作温度之间,使用时如导热膜一样便利,但在操作过程中会熔化并且能够贴合基板形成薄 BLT 厚度的导热油脂。也可使用熔化温度高于工作温度的相变材料,在这种情况下,热界面材料在加工过程中进行回流并在工作过程中保持固态。
导热相变材料由于具有低热阻和良好便利性的优点受到了散热行业极大关注。为大幅提高导热性能,生产商一般会采取在相变材料中加入高导热填料方式。导热相变材料一般以石蜡、聚烯烃、低分子量聚酯等组成,再加上高导热的填料比如 BN、Al2O3、AlN 等来提高传热性能。
但是,由于导热相变材料存在相变过程中熔融泄漏和导热系数降低的现象,严重制约了其在微电子封装领域的广泛应用,所以对导热相变材料未来的研发着重在封装定形和传热强化上。
3.2 金属基热界面材料
传统热界面材料如高分子基热界面材料的热量传导性能通常一般,在射频和 IGBT 组件等高功率功能元件中,基于镓、汞、铟、锡、铋等的金属/合金热界面材料更被普遍采用。金属热界面材料主要有低熔点焊料、液态金属材料和金属纳米颗粒等。金属材料一般具有较高的导热系数,所以在热界面材料领域具有较高关注度。
(1)低熔点焊料
具有高强度、低热阻和可靠稳定特点的金硅、锗金、金锡等共晶焊料在可靠性要求高的领域获得广泛应用。当今在工业中应用最常见的热界面焊料为铟,因为它是一种相对较软的金属材料,能够贴合于基体上并吸收内部应力,同时熔化温度(157℃)相对较低。
AMD 和英特尔都开发并使用铟作为高端处理器的热界面材料。但采用纯铟也具有成本较高和耐腐蚀性较差等局限性。另外一种应用广泛的低熔点焊料为共晶 80Au/20Sn 的金锡焊料(熔点280℃)。
金锡共晶合金焊料因其低熔点和高强度的优点以保证焊接的高可靠性,同时具有良好的抗热疲劳特性,且在严酷环境条件下仍具有优异的抗氧化、优异流变性以及高导热等特性,因此在光电封装器件领域,金锡合金已逐步成为最优的钎焊材料。
其次,金锡焊料的优异润湿能力和极高连接强度(约275 MPa)优点也广泛应用于可靠性要求较高的航天、航空和医疗等微电子封装领域。但是,该材料也具有高成本、高焊接温度和高模量的缺点。
(2)液态金属
低熔点合金类的热界面材料在操作过程中发生相变可从固体状态变为熔化状态,具有非常高的润湿度,而且界面热阻非常低。室温下,液态金属热界面材料直接将热界面材料的导热系数提高了一个数量级,可达 10~40 W/(m∙K) 水平。
但是,液态金属的表面张力较大、流动性不太好、润湿能力不佳,难以黏附众多结构材料,这限制了液态金属作为热界面材料的使用。
虽然与高分子基的热界面材料相比,金属热界面材料能够更好的满足器件传热需求,但金属材料的高熔点不利于微电子封装的工艺实现,所以需要降低金属材料的熔点。
可通过以下两个方式降低金属熔点:一是将金属颗粒的尺寸缩小至纳米级别,二是形成共晶组织、固溶体或金属间的化合物。此外,低熔点焊料还存在孔洞缺陷、回流焊接温度高、与器件的CTE 差异较大等缺点。
综上所述,金属基热界面材料在微电子封装领域应用的关键问题在于材料熔点的降低和应力可靠性的提高。
3.3 新型热界面材料
(1)导热高分子
导热高分子复合材料的种类较多,通常按生产工艺方法可分为本体型和填充型。本体型导热高分子材料的主要基体为高分子复合物材料,其特殊的物理结构可在生产加工过程中通过改变其分子链节结构获得。
但目前人们对这种高分子复合材料主要的关注点并不在导热性能方面,而更多关注导电性能。虽然这种类型材料的导热性能比较优异,但因为其繁琐的生产过程难以达到批产标准。另一类填充型的导热高分子复合材料,其导热性能也可以通过将导热填料加入至高分子化合物材料加以改善。
现阶段常用的导热高分子材料导热填料主要有碳纳米管、石墨烯 、氮化铝(AlN)、氮化硼(BN)、碳化硅(SiC),并采用机械共混的方法提高其导热性能由于该类产品低费用、易生产、成型方式灵活等优点可以实现工业化应用,成为目前国内外高分子导热材料的主要制备技术和研究重点。
导热高分子材料在微电子封装应用方面,后续应更多关注界面热阻的降低,而不是仅关注导热系数的提高,这是因为过多的导热填料会不可避免破坏聚合物相容性,导致界面热阻较高;另外,还需对聚合物集体流变性能、聚合物与散热器分子间相互作用影响、TIM 绝缘性和稳定性等方面开展重点研究攻关。
(2)石墨烯
石墨烯是碳原子以 sp2键紧密排列成的二维蜂窝状晶格结构,其导热性能高于碳纳米管。石墨烯有极高的导热系数,单层石墨烯的导热系数最大可达到 5300W/(m·K),而且热稳定性良好。另外除了具备极高导热系数优点外,石墨烯成本也不高,且与基体材料的相互作用力强,是理想的界面材料填料。
不少研究发现,跟传统界面导热材料相比,石墨烯基界面导热材料的导热系数有明显提高。石墨烯基界面导热材料有助于电子技术往高密度、高集成方向发展。石墨烯基界面导热材料的导热填料大多是单纯石墨烯或者石墨烯与碳纳米管、金属掺杂于一体的混合填料。
石墨烯当作树脂基体填料时需互相搭接以建立高效的导热网络,所以要求石墨烯在树脂基体中具有高分散性。未来还需深入研究制约石墨烯基界面导热材料特性的因素,重点攻克石墨烯的分散性及强耦合性能等难题。
(3)碳纳米管阵列
碳纳米管一般由六边形布置的碳原子构成数层到数十层的同轴圆管,因此拥有相当高的导热系数,单壁碳纳米管在室温下的导热系数高于 6000 W/(m·K),碳纳米管在室温下的导热系数也高于3000 W/(m·K)。垂直方向上碳纳米管阵列密度低,并且带有方向性,不仅高导热系数是单一取向,热膨胀系数在径向面内也更低,且不容易老化。垂直排列的碳纳米管阵列横跨衬底之间的缝隙,能够消除所有界面,加之单个碳纳米管优异的传热性能和柔韧性,被当作一种理想的热界面材料。
碳纳米管的直径、分布密度、缺陷等因素决定了碳纳米管阵列的导热性能,这些因素可通过调整催化剂和生长条件来控制。碳纳米管用作热界面材料具有各向异性和接触界面热阻过大的显著缺点。
硅基底是碳纳米管阵列生长最常见基体,因硅导热系数不及常规金属,为增加整体材料的导热性能,不少学者采用金刚石、Cu、Al、SiC 等高导热材料作为阵列生长基体。但同时带来了碳纳米管与基底由于热输运机理差异导致界面接触热阻过大的问题。因此,碳纳米管阵列材料的研究主要集中在碳纳米管的功能化方面以降低碳纳米管与基底的界面热阻。
04国内外热界面材料研究进展
上世纪九十年代以来,西方国家对于热界面材料制备以及传热性能的提升进行了广泛研究,主要以美国的大学和科研机构为代表,包括麻省理工、佐治亚理工学院、IBM、英特尔等,此外美国军方也在热界面材料方面发布指南展开研究,比如 DARPA 项目。
经过这几十年研究造就了一大批美国和日本的企业,比如Laird、Chomerics、 Bergquist、Fujipoly、SEKISUI、DowCorning、ShinEtsu 和 Honeywell 等,这些公司占据了全球绝大部分热界面材料的高端市场。
国外在热界面材料方面最新研究进展主要如下。加利福尼亚大学河滨分校 Fariborz Kargar 和Alexander A. Balandin 研究团队发现了不同粒径填料的“协同”填料效应对复合材料导热性能的增强作用,并制备了石墨烯-铜纳米颗粒环氧基二元复合材料,在石墨烯浓度 fg=40 wt% 和铜颗粒浓度 fCu=35 wt% 时,其复合材料的导热系数为 13.5±1.6 W/(m·K)。
在导热硅脂的商业应用方面,德国汉高公司(Henkel)公布其最新的热界面材料 BERGQUISTLIQUI FORM TLF 10000 凝胶实现商业化,在 0.5 mm界面厚度下,热阻抗低至 0.45 K·cm2/W,导热系数高达 10.0 W/(m·K)。
新加坡南洋理工大学Manuela Loeblein 等人通过压缩三维泡沫状石墨烯和氮化硼制备出高性能的纳米热界面材料,具有较高纵向导热系数(62~86 W/m·K)和优异的表面一致性。
意大利技术研究院 Muhammad Zahid 等人利用可持续资源再生纤维素和石墨烯纳米片制造出热界面材料,其平面导热系数约为 800 W/m·K,在损坏的情况下还可以通过溶剂分散回收。
伊利诺伊大学厄巴纳-香槟校区和德克萨斯大学达拉斯校区有关研究人员通过改良的化学气相沉积工艺技术,顺利开发出超高导热系数的立方砷化硼,其导热系约为 1000±90 W/m·K,并可生产出立方砷化硼薄膜以实现大功率元器件在电子散热管理领域的广泛应用。
由于我国对热界面材料的研发起步相对较晚,目前应用在高端微电子技术领域的热界面材料基本依赖进口,但围绕热界面材料的研究也取得了不少成果,近年来国内针对热界面材料的代表性研究进展如下。
中科院深圳先进技术研究院团队开发设计了一种由氮化硼纳米管与纤维素纳米纤维构成的纳米复合材料,在 25.0% 氮化硼纳米管下表现出高达 21.39W/(m·K) 的导热系数。
上海交通大学研究团队为平衡高导热和电绝缘性能,将填料氮化硼纳米管和 α-Al2O3进行活性硅烷处理,并将两者按照一定的比例制备成环氧复合材料,有效提高了介电聚合物复合材料的导热性能。
四川大学王跃川团队利用二元填料氧化石墨烯和六方氮化硼制备了高导热和高电绝缘的高导热聚酰亚胺复合膜,其最大导热系数为 11.203 W/(m·K)。
中科院固体物理研究所研究团队采用微氧化反应法制备合成了镓合金热界面材料,制成的镓基二元合金热润滑脂或三元合金热润滑脂不仅提高了工作温度范围,室温下的最高导热系数更是达到19.2 W/(m·K)。
中科院宁波材料技术与工程研究所提出了一种多尺度结构调控的双组装方法,来构成各向异性的石墨烯框架,这些石墨烯框架不仅在垂直方向上高度定向排列,而且与内部相邻石墨烯片之间接触紧密,结点热阻较低,制成的石墨烯框架/环氧树脂复合材料在纵向的导热系数约为 62.4 W/(m·K)。
05热界面材料热特性测试
由于热界面材料的性能既取决于其固有热特性,又取决于界面匹配效果,因此不能简单用材料的整体导热系数来表征,其主要可分为三个部分热阻:两个与热界面材料上下表面相关的接触热阻和一个与自身材料特性相关的热阻。
有些测试方法旨在将接触热阻从热界面材料自身传导过程中分离出来,而另一些测试方法则关注界面的总传导热阻,热界面材料的总传导热阻随界面的表面特性(粗糙度和平整度)、施加压力、工作温度、材料机械性能和热性能而变化。
行业内热界面材料评价测试方法应用较广泛的主要有稳态法和瞬态法。两种方法各有优缺点,其中稳态法由于在 ASTM D-5470 标准中已有定义,已经被大多数制造商所采用,其测试条件与应用条件相似,计算方法比瞬态法简单,但测试速度非常慢。而瞬态法比稳态法速度快,但其测试原理更复杂,而且测试环境与实际应用存在较大差异。本节主要介绍上述两种方法的测试原理。
5.1 稳态法
稳态法是计算界面热阻与材料导热系数最普遍的方法,其具有成本较低、准确率较高、测试原理以及测试过程简单方便的特点。根据稳态导热原理,美国材料与试验协会(ASTM)提出了高导热材料的测试标准−ASTM D-5470,不少研究者依据该标准搭建了热界面材料导热系数和接触热阻的测试系统。
公式(2)中界面接触热阻 Rc与外力、基板表面粗糙度、热界面材料导热系数和润湿特性相关,与 BLT 无关,且假设 kTIM与 BLT 无关。那么通过式(2)得出:Rtot与 BLT 呈线性变化关系。通过分析几组不同 BLT 相对应的Rtot,从而拟合出直线方程,就可以得到kTIM和Rc。图 3 中给出了两种不同材料的Rtot随 BLT 线性变化曲线,其中斜率为 1/kTIM,与 y 轴的截距即为 2Rc。
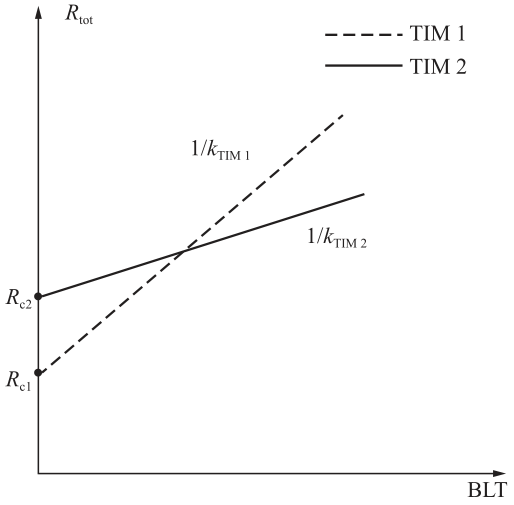
图 3 Rtot 随 BLT 线性变化曲线
图 4 为标准稳态热流测试系统原理图。测试系统主要包括热流仪、待测样品、加热装置、制冷装置、保温材料、压力加载系统和温度传感器等部分。热流仪用来检测通过待测样品的热流量,上下热流仪分别与加热和制冷装置紧密贴合,通过调节加热装置的热量输入和制冷装置的冷却温度实现待测样品的加热和冷却。
采用闭环控制的高精度压力加载系统为接触面提供特定均匀的压力。四周覆盖保温材料可以减少热量损失。热量沿着一维方向由上往下传递,温度在每个试样内呈现线性分布,但会在界面处由于热界面热阻存在而出现跳跃。再结合测试数据和公式(2)即可得出kTIM和Rc。
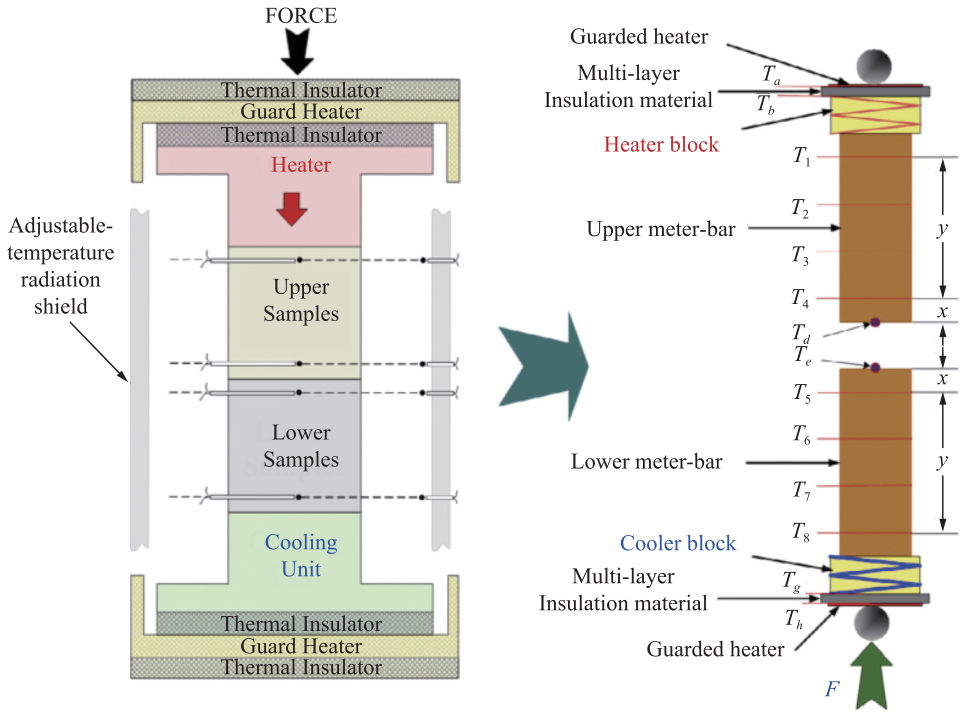
图 4 稳态法测试系统框架图
5.2 瞬态法
瞬态平面热源法(HotDisk 方法)在测量过程中将一个加热平面探头安装在样品中,在施加探头电流后利用探头检测温度和电阻随时间的改变得到待测样品的导热系数。该技术可在一次试验中同时获得导热系数、热扩散率和体积热容。
瞬态平面热源法作为一种绝对导热系数的测量手段,在理论上可获得较高测量精度,并且只要满足样件尺寸和标准规定测试条件,理论上对导热系数的测量范围也无限制。所以针对均质材料,使用瞬态平面热源法是一个操作简便、测量精度高的有效的测量方法,并可与其它测试方法形成良好的补充与比对。
图 5 为瞬态平面热源法测试结构示意图。其中图 5(a)为测试结构,黄色为 HotDisk 探头,灰色为被测试样件,等温线由暗红色(热端)到蓝色(冷端)虚线组成。图 5(b)为 HotDisk 探头,是一种两片绝缘薄膜夹持双螺旋金属薄带的薄片结构,绝缘薄膜既起到强度支撑作用又具有电绝缘功能,整个HOTDISK 探头既作为通电发热源又作为温度探测器使用。
在测试过程中,HotDisk 探头被夹持在两个测试样件中间,在试样和探头温度达到恒定后,在探头上加载一个短时固定电流,探头通电后产生热量,热量向四周的测试样件进行散热,使得探头和样件的温度升高。探头和样件的温度上升范围一般为 0.5~5℃,通过测量探头的电阻变化可以获得探头温度整个变化过程,然后根据加载电流的大小和时间以及其它参数,可以计算出被测试样件的导热系数。
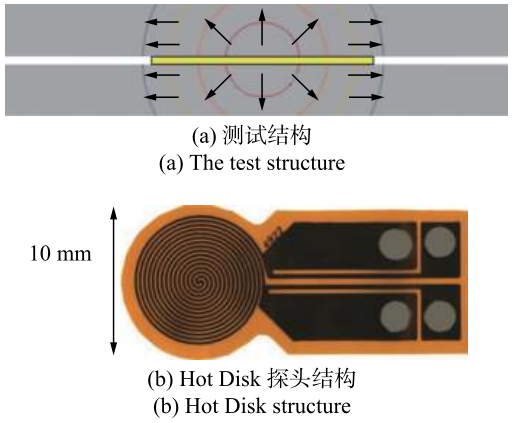
图 5 瞬态平面热源法测试结构
06结束语
热界面材料在微电子封装的散热管理中起到了关键作用。本文系统综述了热界面材料的研究进展,总结了各种类型热界面材料在微电子封装应用时存在的问题和关注的方向,主要概况以下四个方面:
(1)热界面材料在散热性能方面的研究不只关注导热系数的提升,还应关注界面之间接触热阻的降低。微电子封装中通常热界面材料的 BLT 厚度很小,此时接触热阻在热界面材料的总热阻中起主导作用。
(2)微电子封装中热界面材料的选型设计除了考虑散热性能,还应考虑对封装可靠性影响,重点关注封装内不同材料的 CTE 匹配问题、液态界面材料泵出效应和封装微组装过程中高度公差匹配问题等。
(3)在高导热界面材料的研制方面,主要通过研究各种材料制备手段将新型高导热材料(如碳纳米管、石墨烯等)作为导热填料与基体结合,获得同时满足散热和可靠性要求的复合热界面材料。
(4)在热界面材料的测试方面,针对不同的热界面材料类型和适用要求选择对应的热界面材料测试方法,稳态法更适用于不同温度和压力下的热界面材料热阻测试,瞬态法更适用于无压力的导热硅脂和导热胶等材料在不同温度下的导热系数测试。
审核编辑:刘清
-
散热器
+关注
关注
2文章
1145浏览量
39856 -
Tim
+关注
关注
0文章
85浏览量
19153 -
半导体器件
+关注
关注
12文章
813浏览量
34364 -
CTE
+关注
关注
0文章
14浏览量
8090
原文标题:微电子封装热界面材料研究综述
文章出处:【微信号:DT-Semiconductor,微信公众号:DT半导体】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
BERGQUIST热界面材料选型指南:满足多样化电子散热需求
汇诚仪器与中科微电子苏州研究院合作,热重分析仪助力科研创新

激光焊接技术在焊接微电子模块工艺中的应用

芯片热界面材料在聚光下的热传导测量

灵动微电子最新最火热的一款芯片推荐
电子产品散热设计指南:如何精准选择导热界面材料
导热界面材料的测试方法
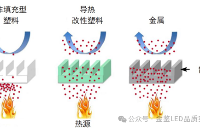
技术资讯 I 导热材料对热阻的影响

从理论到实践:推拉力测试机在微电子封装失效分析中的关键作用




 微电子封装中热界面材料综述
微电子封装中热界面材料综述










评论