案例背景
PCBA元器件发生脱落现象,据此进行试验分析,查找失效原因。
#1样品BGA脱落;#2样品BGA有微裂纹(未偏位);#3样品FPC空板(未贴装器件)。
分析过程
#1样品
#1样品外观图
剥离面分析
SEM剥离面形貌分析
#1-1:
#1-2:
说明:从表面残留焊锡及断面状态分析,存在有河流花样及解理台阶,判断其为解理断裂,即脆性断裂。
EDS成分分析
说明: 对#1-1焊盘进行EDS分析,主要检出Sn、Ni、P、Cu元素,其中P含量高达15%左右。
PCB镀层的分析
PCB镀层(Pd钯)的分析:选取邦定芯片的一个pin位置,采用化学褪金后观察Pd表面的晶格状态。
说明:#1样品褪金后Pb层的晶格状态分析:晶格致密、平整,晶粒间无空洞或缝隙,无异常。
#2样品
#2样品外观图
1.外观分析
#整体图示
2-1号焊点
2-4号焊点
3-1号焊点
说明:#2样品上侧(靠近玻璃芯片处)的焊球(①、③)与基板起翘分离。②、④焊球未见明显异常。
2.断面分析
金相分析
说明: #2样品的①、②焊点切片断面金相分析,焊点① 焊球与焊盘开裂,呈分离状态,开裂缝隙由外向内(芯片端→PCB边缘端)变小。
SEM分析
#焊点①断裂两侧状态分析
说明:焊盘为SMD类型,从焊点两侧断裂状态可见,存在焊锡受阻焊膜压迫形成台阶现象,以及焊锡与阻焊膜之间存在应力残留的结构特征。两边缘开裂位置基本都在富磷层。
小课堂:BGA焊盘两种定义方式
1.阻膜定义(SMD):
焊盘的尺寸要比非阻焊掩膜大,再流焊接后,熔化的焊料球接触阻焊掩膜。
主要问题是由SMD焊点产生的应力集中,这是造成焊点失效及可靠性变弱的起因。
2.非阻焊定义(NSMD):
掩膜的开口要比铜箔焊盘大,所以在再流之后,焊料球不会接触阻焊掩膜。
#焊点②焊接状态分析:
说明:#2样品的焊点②状态良好,IMC层连续、均匀,平均厚度为1.58μm,富磷层0.17um。
EDS成分分析
说明: 对焊点①进行EDS分析,主要检出Sn、Ni、P、Cu元素,其中富磷层P含量在10.5%左右,Ni层P含量在8.5%左右。
#3样品
Ni/Pd/Au镀层厚度分析
#Ni/Pd/Au厚度:
注:厚度单位为μm。
说明:从上记检测结果可见:Au平均厚度:0.0925um;Pd平均厚度:0.0875um;Ni平均厚度:6.275um。
镍钯金工艺镀层Au、Pd厚度一般要求在0.08μm左右,上记结果符合要求。
分析结果
综合以上检测信息,针对BGA焊点裂纹失效解析如下:
1. 通过对#1样品BGA剥离后的断口分析,有明显的脆性断裂特征(平整、河流花样、解理台阶),说明该断裂是由应力导致的瞬时冲击形成(原始状态)。
2.通过对剥离面的EDS分析,P含量高达15%左右(#1样),切片断面的分析,富磷层的P含量在10.5%左右(#2样),说明断裂位置部分处于富磷层。
3.通过切片断面的分析,断裂界面出现在IMC层及富磷层,断裂裂纹为上下契合状,进一步说明了焊点是受到应力导致断裂。同时,FPC采用SMD焊盘结构,焊盘上覆盖的阻焊膜使BGA焊点与阻焊膜接触的位置形成了应力集中点(同时也可能有焊接时的应力残留未释放),在受到外部应力作用时,该位置易被突破。
分析结论:根据以上综合分析,造成焊点断裂的原因判断为,FPC受到应力作用,同时BGA焊点位置由于SMD焊盘设计结构有应力集中的缺陷,从而造成BGA在受到一定程度的应力后出现裂纹失效。
改善方案
结合样品的工艺流程分析,初步推断超声清洗工程可能存在应力作用。BGA类产品,对应力作用比较敏感。
FPC清洗时,BGA所处的不同深度、不同位置受到的应力作用可能不同。建议从超声清洗工艺进行验证排查,找到合适的清洗条件(频率、温度)。
新阳检测中心有话说:
本篇文章介绍了PCBA失效分析案例。如需转载本篇文章,后台私信获取授权即可。若未经授权转载,我们将依法维护法定权利。原创不易,感谢支持!
新阳检测中心将继续分享关于PCB/PCBA、汽车电子及相关电子元器件失效分析、可靠性评价、真伪鉴别等方面的专业知识,点击关注获取更多知识分享与资讯信息。
审核编辑:汤梓红
-
元器件
+关注
关注
113文章
4945浏览量
98185 -
失效分析
+关注
关注
18文章
244浏览量
67561 -
PCBA
+关注
关注
25文章
1874浏览量
55766
发布评论请先 登录
芯片失效步骤及其失效难题分析!

电子元器件失效分析与典型案例(全彩版)
PCB及PCBA失效分析的流程与方法






 PCBA失效分析
PCBA失效分析

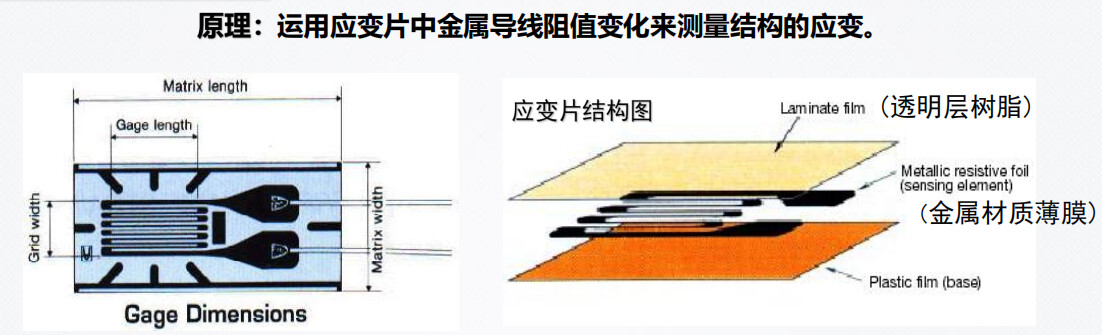

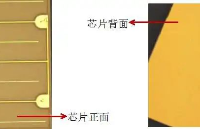
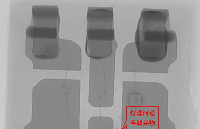



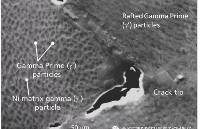










评论