目前国内绝大多数IGBT模块厂家采用传统硅胶灌封方式;
随着国内客户在新能源车用电网电力风电方面(1200V以上领域)对IGBT模块要求越来越高;硅胶灌封有不足之处;连续在高温200度环境下工作;性能变差;底部会产生VOLD;铝线形变;器件容易击穿烧毁
代表世界最新技术的日本超级IGBT模块大厂(M社/F社)已逐步采用高耐热;低热膨胀低收缩性液态环氧来代替硅胶灌封,国内已有电力方面IGBT模组大公司在进行环氧灌封技术试验(1200V以上领域)

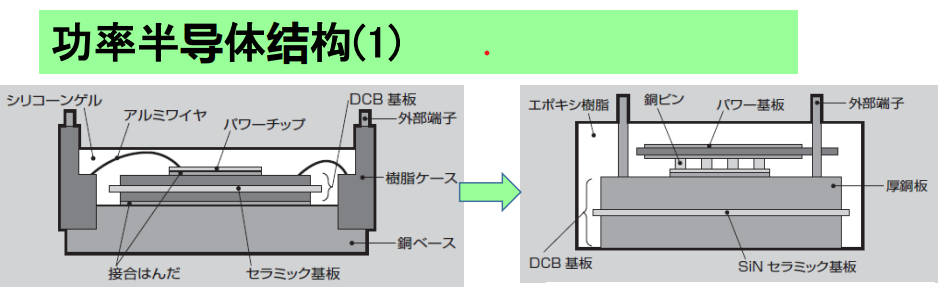
审核编辑:符乾江
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
半导体
+关注
关注
339文章
31263浏览量
266624 -
IGBT
+关注
关注
1291文章
4452浏览量
264432
发布评论请先 登录
相关推荐
热点推荐
Wolfspeed 300mm碳化硅技术为下一代AI与HPC系统提供可靠基础
的制约。本文探讨了 Wolfspeed 的 300 mm 碳化硅 (SiC) 技术平台如何为下一代人工智能 (AI) 和高性能计算 (HPC) 异构封装架构提供可规模化的材料基础,从而在热管理、机械完整性和电气集成方面实现新的突
DirectScan 技术解析:下一代半导体电子束检测的创新路径与应用
量产应用。DirectScan检测通过核心技术创新破解了这一行业痛点,为下一代半导体制造提供了高效、精准的检测解决方案。本文将从技术原理、核心优势、应用场景及落地实

今日看点:士兰微发布新一代灌封功率模块;荣耀首款人形机器人亮相
士兰微 发布 新一代灌封功率模块 近日,士兰微宣布全新推出自主研发、具备自有知识产权的灌封系列模块
士兰微推出新一代灌封功率模块MiniPack系列和SPD系列
士兰微新一代自主研发、具备自有知识产权的灌封解决方案,依托结构优化、材料升级与芯片迭代深度耦合设计,打造高功率密度、低杂感、高可靠车规级功率模块,全面适配纯电、混动等多平台电驱需求。以

冬季灌封胶不干?环氧聚氨酯低温固化五大避坑指南 |铬锐特实业
铬锐特实业|冬季灌封胶不干怎么办?本文针对环氧及聚氨酯灌封胶低温固化难题,总结五大实用避坑指南:预热、保温、控湿、精确配比、强制后固化,帮你快速解决不干、发软、返工问题。

意法半导体推进下一代芯片制造技术 在法国图尔工厂新建一条PLP封装试点生产线
意法半导体(简称ST)公布了其位于法国图尔的试点生产线开发下一代面板级包装(PLP)技术的最新进展。该生产线预计将于2026年第三季度投入运营。
用于下一代 GGE 和 HSPA 手机的多模式/多频段功率放大器模块 skyworksinc
、接线图、封装手册、中文资料、英文资料,用于下一代 GGE 和 HSPA 手机的多模式/多频段功率放大器模块真值表,用于下一代 GGE 和 HSPA 手机的多模式/多频段功率放大器
发表于 09-08 18:33

适用于下一代 GGE 和 HSPA 手机的多模/多频段 PAM skyworksinc
电子发烧友网为你提供()适用于下一代 GGE 和 HSPA 手机的多模/多频段 PAM相关产品参数、数据手册,更有适用于下一代 GGE 和 HSPA 手机的多模/多频段 PAM的引脚图、接线图、封装
发表于 09-05 18:34

下一代高速芯片晶体管解制造问题解决了!
的过渡步骤。
不过2017 年提出的叉片设计初始版本似乎过于复杂,无法以可接受的成本和良率进行制造。现在,Imec 推出了其叉片晶体管设计的改进版本,该设计有望更易于制造,同时仍能为下一代工艺技术提供功率
发表于 06-20 10:40
LG Display宣布重大投资计划,推动下一代OLED技术发展
近日,韩国媒体报道,LGDisplay(LG显示)董事会批准了一项高达1.26万亿韩元(约合9.169亿美元)的投资计划,旨在开发下一代OLED(有机发光二极管)技术。此举旨在进一步巩

下一代PX5 RTOS具有哪些优势
许多古老的RTOS设计至今仍在使用,包括Zephyr(1980年代)、Nucleus(1990年代)和FreeRTOS(2003年)。所有这些旧设计都有专有的API,通常更大、更慢,并且缺乏下一代RTOS的必要安全认证和功能。
光庭信息推出下一代整车操作系统A²OS
,正式推出面向中央计算架构、支持人机协同开发的下一代整车操作系统A²OS(AI × Automotive OS),赋能下一代域控软件解决方案的快速研发,显著提升整车智能化水平。 A²OS 核心架构 A²OS采用"软硬解耦、软软解
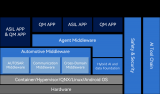



 下一代主流IGBT模块封装技术研发趋势--环氧灌封技术
下一代主流IGBT模块封装技术研发趋势--环氧灌封技术







评论