摘要
准备好无缺陷掩模供应是将极端紫外线光刻(EUVL)应用于32纳米半间距(HP)及更大的大批量半导体制造的关键挑战之一。根据ITRS在2008年更新的数据,对于32纳米的惠普,需要去除的缺陷尺寸为25纳米。另一方面,在2008年发表的报告中,对于32纳米高压线和空间图案,EUV掩模上吸收体缺陷的临界缺陷尺寸被描述为大约24纳米,这意味着必须去除具有相同尺寸的颗粒。在如此严格的缺陷要求下,清洁工艺必须发挥关键作用,以去除这些微小的颗粒缺陷。然而,由于缺乏薄膜保护,EUV掩模清洗面临着与反射掩模结构、诸如钌(Ru)覆盖层的新材料以及更频繁的清洗相关的独特挑战。因此,它必须足够温和,不会损坏EUV掩模上的脆弱图案和表面,特别是非常薄的钌覆盖层。竞争的需求使得EUV口罩清洁更具挑战性。
本文报告了使用灵敏度为80纳米的空白检测工具M1350对清洁相关问题的综合评估。在本文中,我们使用灵敏度为50纳米的新型空白检测工具M7360,将我们的努力扩展到更小的缺陷。
介绍
湿法清洗过程中残留在表面的小颗粒(所谓的添加剂)是扩展当前基于SPM(硫酸和过氧化氢混合物)的清洗过程以满足EUV要求的主要问题。为了应对这一挑战,我们评估了各种清洁工艺和化学物质的效果,并成功地在EUV掩模坯体上实现了零清洁添加和100%的颗粒去除效率。这些数据是使用80纳米灵敏度的Lasertec M1350获得的。今年,我们开始使用第二代检测工具 M7360对清洁性能进行评估,该工具在EUV掩模坯件上的检测灵敏度为50纳米二氧化硅等效粒径缺陷。这种高灵敏度的检测工具使我们能够改进清洁过程,并认识到在清洁更小颗粒方面的进一步挑战,这些颗粒以前在M1350上是看不到的.在本文中,我们介绍了我们使用M7360和其他计量工具对较小颗粒的清洁性能和加法器分析的最新结果。
实验
本研究采用的清洗工艺基于标准的SPM和SC1化学。我们选择了处理过程中带有颗粒和污染物的测试样品,以代表实际使用过程中更真实的口罩污染情况。为了量化清洁性能,使用清洁前后M1350和M7360的缺陷图计算清洁过程中的颗粒去除效率(PRE)和加法器。在我们的指标中,PRE定义为PRE= (n1 - n2) /n1×100.这里,n1是处理过程中添加的粒子数,n2是n1中未移动的粒子数.另一方面,通过比较清洁前后的缺陷位置来计算清洁加法器。
用M7360标记一些缺陷,以表征缺陷尺寸和成分。用原子力显微镜(AFM)测量高度,用扫描电子显微镜(SEM)测量横向尺寸,用俄歇电子能谱(AES)测量成分,对缺陷进行表征。由于我们针对AES分析的缺陷尺寸非常小,因此我们通过仔细比较作为缺陷附近参考的光谱来确定缺陷成分。
结果和讨论
本节使用M1350和M7360评估了处理颗粒和清洁加法器的性能,以量化整体清洁性能。图1(a)中M1350测量的缺陷图分别显示了添加的处理颗粒和当前记录(POR)清洗过程后的剩余颗粒。从这些评估中,我们得出结论,我们目前的POR清洁工艺能够清洁50纳米的颗粒,并且没有大于80纳米的添加剂。然而,对于更小的缺陷,我们认为工艺加法器是当前POR清洗工艺中需要解决的关键问题。
本节研究描述的下一步是我们在清洗后发现的添加物。表征的目的是确定加法器的来源,并开发减少它们的方法。图3显示了根据原子力显微镜图像确定的加法器尺寸(面积和高度)的散点图。
在分段测试中,整个清洗过程分为三个独特的步骤,并针对该步骤中使用的相应化学品对加法器进行评估。这三个步骤是SPM化学,热去离子水冲洗和SC1化学过程。M7360测量的加法器图如图6所示.观察到最多的加法器是SPM化学过程,其次是热水过程和SC1化学过程。这些结果表明,SPM化学导致大多数加法器。
如前所述,我们确定加法器为No。1。 EUV口罩清洁过程中的挑战。如上所述,我们将加法器源隔离为SPM化学步骤。下一步是消除加法器。理想情况下,在运送到使用地点之前,人们希望过滤掉化学物质中的所有颗粒。我们解决加法器问题的方法是双重的;一种是通过过滤从SPM化学品中去除颗粒,另一种是防止颗粒粘附在表面。事实上,我们通过改进过滤系统,在M1350检测的基础上,实现了大于80 nm缺陷的零加法器最终清洗。然而,基于M7360检查,相同的清洗过程产生了约60个尺寸小于80纳米的加法器。对于液体化学过滤来说,保持无颗粒是极其困难的,尤其是对于小颗粒。
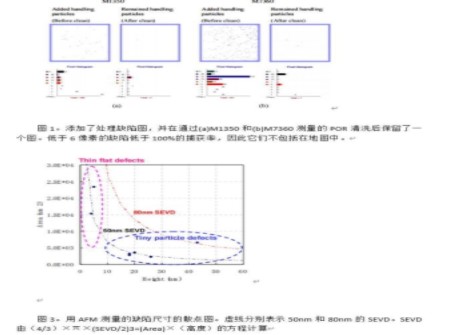

结论
我们使用50纳米灵敏度的Lasertec M7360检测系统研究了基于SPM的清洁性能。发现当前的清洁工艺对于50纳米处理颗粒具有足够高的颗粒去除效率。然而,我们观察到许多小于80纳米的加法器。加法器的来源被确定为来自SPM化学品的颗粒。我们认为过程加法器是第一个为EUV口罩清洗。
本文已经采取了两种并行的方法来消除加法器:液体粒子过滤和过程优化来减轻加法器。我们已经证明了基于M7360检查可以实现一位数的加法器。
审核编辑:汤梓红
-
纳米
+关注
关注
2文章
723浏览量
41520 -
微米
+关注
关注
0文章
15浏览量
11077 -
EUV
+关注
关注
8文章
614浏览量
88525
发布评论请先 登录
半导体湿法腐蚀工艺中,如何选择合适的掩模图形来控制腐蚀区域?
国内材料巨头入主掩模版,空白掩模有望国产化(附投资逻辑)

湿法刻蚀sc2工艺应用是什么

超声波除油清洗设备是否可以有效去除难以清洁的油渍?
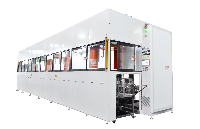
湿法刻蚀:晶圆上的微观雕刻
JCMSuite应用:衰减相移掩模
半导体湿法清洗有机溶剂有哪些
碳纳米管在EUV光刻效率中的作用

纳米压印光刻技术旨在与极紫外光刻(EUV)竞争
半导体湿法刻蚀残留物的原理
芯片湿法蚀刻工艺
优化湿法腐蚀后碳化硅衬底TTV管控






 使用标准湿法清洁从EUV掩模空白中去除纳米颗粒
使用标准湿法清洁从EUV掩模空白中去除纳米颗粒

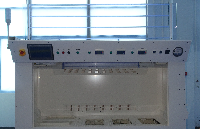










评论