超越摩尔,三星的异构集成之路
在近期举办的2021年SamsungFoundry论坛上,三星透露了2/3nm制程工艺的新进展,并公开发布了全新的17nm工艺。三星市场战略副总裁MoonSoo Kang也面向产业合作伙伴,公布了三星在异构集成上的计划,如何为摩尔定律再度添加一个“维度”。

旗舰GPU与移动芯片的面积变化对比 / 三星
几十年间,半导体产业一直在不懈地推动摩尔定律,以更先进的制程做到更多的晶体管数目,这就是我们常说的“延续摩尔”方案,也是当前计算与电路领域持续创新最大的推动力。
尽管摩尔定律的延续,芯片面积仍在扩大,比如一直在追求算力的GPU,已经快要逼近光罩尺寸的限度了。再加上晶体管数目的增加,使得芯片设计成本和生产成本无休止地增加。在不少人看来,单靠“延续摩尔”不再是一个技术与成本上可持续的方案。
与此同时,更多的功能与特性集成在单个芯片上,却又没有单个制程可以满足所有不同功能的需求,比如模拟、射频、高压等,即便可以满足也无法达到优秀的性能与成本平衡。“延续摩尔”的方案在这类挑战面前束手无策,因此才出现了异构集成这种“扩展摩尔”的方案。通过两种方案的互补,共同做到“超越摩尔”。
Chiplet:降低成本提高良率的救星
随着单个芯片加入更多特性,即便摩尔定律延续下去,其芯片面积仍在增加,为所有不同功能的设计区块使用同一个制程节点成了抵消的选择,好在如今有了Chiplet这一救星的出现。将一大块裸片分成较小的chiplet,并为每个chiplet使用最优的制程,可以显著提高整个芯片的良率,同时减少生产成本。例如某些特定的接口IP并不会因为采用先进制程而获得面积或性能上的优化,对这些IP使用成熟制程和专用定制制程,可以做到更低的成本以及更优的性能。
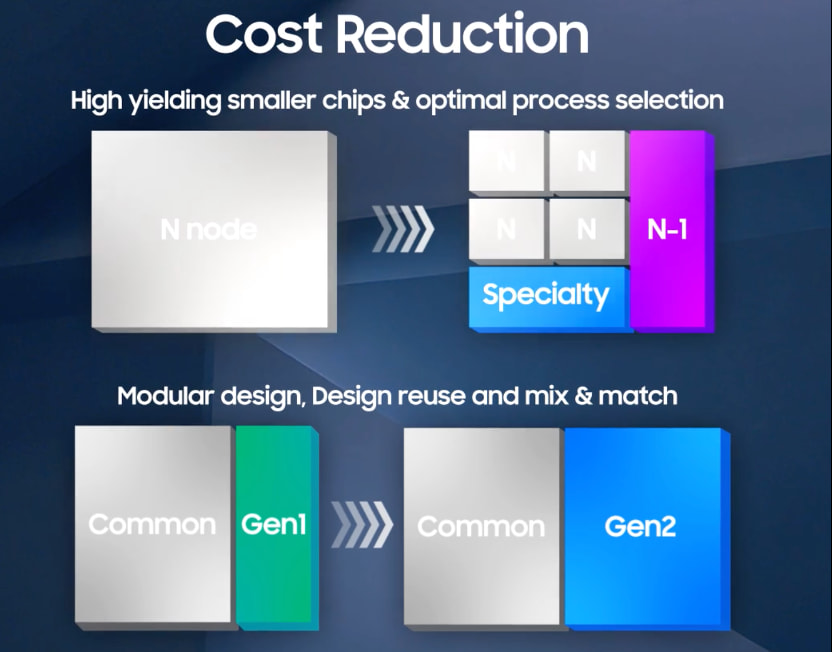
Chiplet方案 / 三星
另一个可行方案就是模组化的设计与制造,也就是重复使用相同的组件chiplet。不少IP模组都可以作为chiplet重复使用,只有芯片的其他部分需要重新设计和生产,此举显著减少了设计、开发与生产的成本,芯片厂商可以借此更快实现产品迭代。
X-Cube:垂直3D集成
异构集成不只是为了成本和良率考虑,也能进一步提升芯片性能。传统的2D设计中,信号路径有几毫米长。而在3D集成下,芯片的堆叠可以将信号路径减少至几微米,大大改进了芯片延迟。除此之外,3D集成中更出色的内联间距可以实现更高的带宽,进一步提高芯片性能。
早在2014年,三星就首次实现了将宽IO内存与移动应用处理器的3D堆叠,也就是三星的Widcon技术。随后,3D芯片堆叠技术继续发展,诞生了一系列HBM内存产品。HBM就是由DRAM与逻辑堆叠,并由微凸块和TSV相连而成的。也正是因为3D堆叠技术,三星得以开发出了3层的CMOS图像传感器,由图像传感器、逻辑与DRAM三种不同的裸片堆叠在一起而成。
2020年,三星推出了X-Cube技术,这项技术使得两个逻辑单元裸片可以垂直堆叠在一起,形成一个单独的3D芯片,由微凸块与TSV连接。X-Cube分为两种形式,两个裸片由微凸块连接或是直接铜键合。
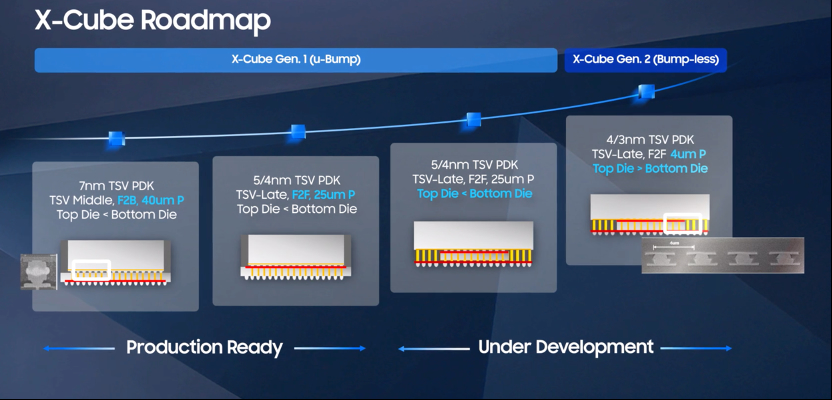
X-Cube路线图 / 三星
第一代X-Cube技术(u-Bump)主要依靠微凸块连接,三星已经发布了针对7nm逻辑制程的TSV PDK,采用F2B结构,凸块间距为40um。面向4/5nm的TSV PDK也已经发布,改用F2F的结构,凸块间距降低至25um。尚在开发中的第二代X-Cube技术(Bump-less)则采用了直接铜键合技术,间距降低至4um。
值得一提的是,英特尔的Foveros3D堆叠技术路线与三星X-Cube大致相同。第一代Foveros的凸块间距在36um至50um之间,而下一代FoverosOmni技术同样可以做到25um的凸块间距。尚在开发的Foveros Direct也采用了直接铜键合的方式,宣称凸块间距降低至10um以下。
过去的X-Cube架构中,底部裸片的面积要大于顶部裸片,然而为了更好了满足客户对芯片分区和散热等不同要求,三星也将在后续提供顶部裸片大于底部裸片的结构。目前三星已经完成了3D堆叠SRAM的验证,在7nm的制程下,可以做到48.6GB/s的带宽,以及7.2ns的读取延迟与2.6ns的写入延迟。
除此之外,三星还提供了一项差异化技术,ISC(集成堆叠电容)。这一电容应用了已经在三星DRAM产品中获得验证的硅电容结构、材料和工艺,具有1100nF/mm2的电容密度,可以有效提高电源完整性。三星的ISC还提供了多种不同的配置,比如分立型、硅中介层型和多晶圆堆叠型,以满足客户不同的结构需求,ISC预计将在2022年进入量产阶段。
I-Cube:横向2.5D组合
另一方面,为了从横向组合芯片,三星开发了所谓的2.5D技术I-Cube,将逻辑单元与多个HBM集成在同一硅中介层上。目前三星已经成功实现了一个逻辑裸片+两个HBM的I-Cube2量产,成品之一就是百度的昆仑AI芯片。百度的昆仑AI芯片不仅使用了三星的14nm制程,也运用了三星的I-CUBE 2技术。
I-Cube使用了预筛选的技术,在封装的中间阶段进行运算测试,从而提高良率。该技术还采用了无封胶的结构,做到更好的散热性能,据三星强调,与传统的2.5D方案相比,I-Cube的散热效率高上4.5%。此外,与其他代工厂商相比,三星的I-Cube技术还有一些优势,比如与三星内存合作,率先用上最新的内存方案

I-Cube4示意图 / 三星
目前三星已经在计划集成4HBM3模组的I-Cube4量产工作,而6 HBM的I-Cube6也已经做好量产准备,前者预计2022年进入大批量产阶段。三星更是准备了两个逻辑裸片+8个HBM的I-Cube8方案,目前尚处于开发阶段,预计2022年末将正式上线。
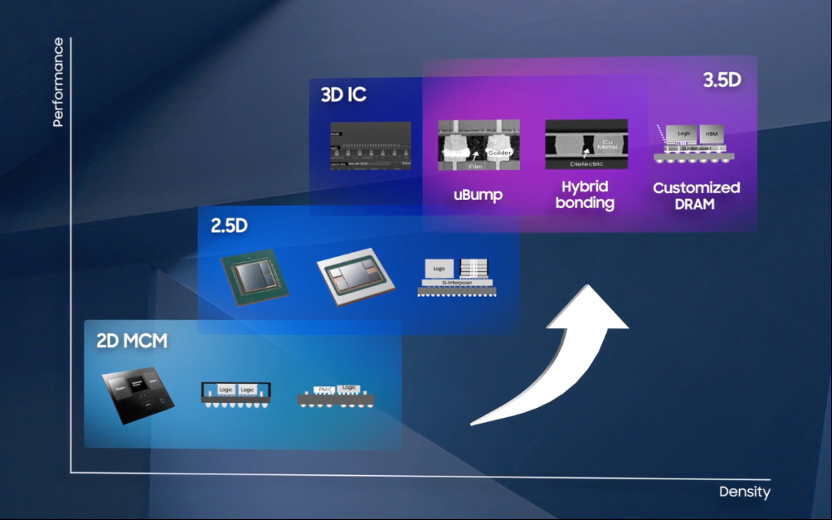
2D至3.5D的封装方案 / 三星
除了2D、2.5D与3D的IC技术之外,三星还在开发全新的3.5D封装技术,这种系统级封装内还将加入堆叠的定制DRAM或SRAM裸片,实现更高的性能与密度。
小结
在开发2.5D/3D集成的多芯片或多Chiplet系统级芯片时,设计者往往还会遇到在传统单芯片设计上罕见的技术障碍,比如多出来的接口IP或潜在的功耗增加。这时候,三星、台积电和刚进入IDM 2.0的英特尔等代工厂商还会提供异构设计的方法和工具,帮助设计者克服这些挑战。在异构集成的大势之下,代工厂也将提供更多的服务模式,增加封装、测试以及一站式的设计服务。
在近期举办的2021年SamsungFoundry论坛上,三星透露了2/3nm制程工艺的新进展,并公开发布了全新的17nm工艺。三星市场战略副总裁MoonSoo Kang也面向产业合作伙伴,公布了三星在异构集成上的计划,如何为摩尔定律再度添加一个“维度”。

旗舰GPU与移动芯片的面积变化对比 / 三星
几十年间,半导体产业一直在不懈地推动摩尔定律,以更先进的制程做到更多的晶体管数目,这就是我们常说的“延续摩尔”方案,也是当前计算与电路领域持续创新最大的推动力。
尽管摩尔定律的延续,芯片面积仍在扩大,比如一直在追求算力的GPU,已经快要逼近光罩尺寸的限度了。再加上晶体管数目的增加,使得芯片设计成本和生产成本无休止地增加。在不少人看来,单靠“延续摩尔”不再是一个技术与成本上可持续的方案。
与此同时,更多的功能与特性集成在单个芯片上,却又没有单个制程可以满足所有不同功能的需求,比如模拟、射频、高压等,即便可以满足也无法达到优秀的性能与成本平衡。“延续摩尔”的方案在这类挑战面前束手无策,因此才出现了异构集成这种“扩展摩尔”的方案。通过两种方案的互补,共同做到“超越摩尔”。
Chiplet:降低成本提高良率的救星
随着单个芯片加入更多特性,即便摩尔定律延续下去,其芯片面积仍在增加,为所有不同功能的设计区块使用同一个制程节点成了抵消的选择,好在如今有了Chiplet这一救星的出现。将一大块裸片分成较小的chiplet,并为每个chiplet使用最优的制程,可以显著提高整个芯片的良率,同时减少生产成本。例如某些特定的接口IP并不会因为采用先进制程而获得面积或性能上的优化,对这些IP使用成熟制程和专用定制制程,可以做到更低的成本以及更优的性能。
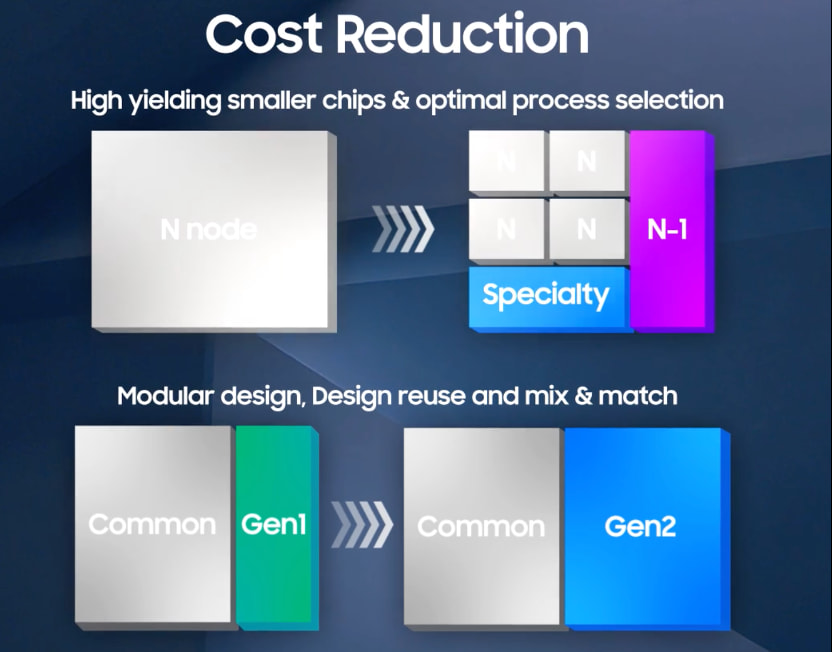
Chiplet方案 / 三星
另一个可行方案就是模组化的设计与制造,也就是重复使用相同的组件chiplet。不少IP模组都可以作为chiplet重复使用,只有芯片的其他部分需要重新设计和生产,此举显著减少了设计、开发与生产的成本,芯片厂商可以借此更快实现产品迭代。
X-Cube:垂直3D集成
异构集成不只是为了成本和良率考虑,也能进一步提升芯片性能。传统的2D设计中,信号路径有几毫米长。而在3D集成下,芯片的堆叠可以将信号路径减少至几微米,大大改进了芯片延迟。除此之外,3D集成中更出色的内联间距可以实现更高的带宽,进一步提高芯片性能。
早在2014年,三星就首次实现了将宽IO内存与移动应用处理器的3D堆叠,也就是三星的Widcon技术。随后,3D芯片堆叠技术继续发展,诞生了一系列HBM内存产品。HBM就是由DRAM与逻辑堆叠,并由微凸块和TSV相连而成的。也正是因为3D堆叠技术,三星得以开发出了3层的CMOS图像传感器,由图像传感器、逻辑与DRAM三种不同的裸片堆叠在一起而成。
2020年,三星推出了X-Cube技术,这项技术使得两个逻辑单元裸片可以垂直堆叠在一起,形成一个单独的3D芯片,由微凸块与TSV连接。X-Cube分为两种形式,两个裸片由微凸块连接或是直接铜键合。
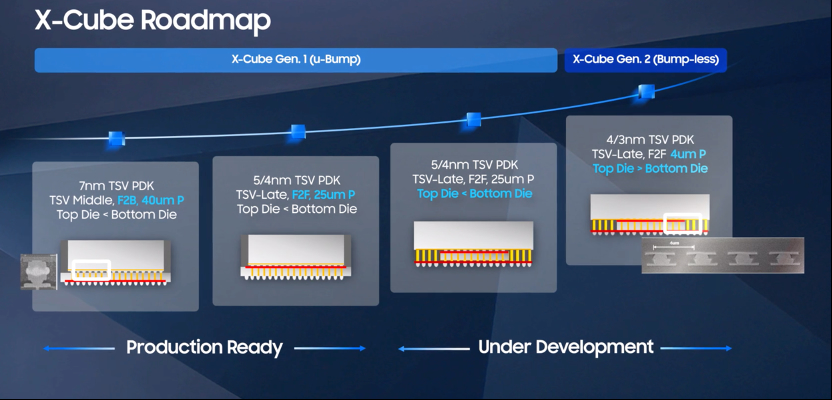
X-Cube路线图 / 三星
第一代X-Cube技术(u-Bump)主要依靠微凸块连接,三星已经发布了针对7nm逻辑制程的TSV PDK,采用F2B结构,凸块间距为40um。面向4/5nm的TSV PDK也已经发布,改用F2F的结构,凸块间距降低至25um。尚在开发中的第二代X-Cube技术(Bump-less)则采用了直接铜键合技术,间距降低至4um。
值得一提的是,英特尔的Foveros3D堆叠技术路线与三星X-Cube大致相同。第一代Foveros的凸块间距在36um至50um之间,而下一代FoverosOmni技术同样可以做到25um的凸块间距。尚在开发的Foveros Direct也采用了直接铜键合的方式,宣称凸块间距降低至10um以下。
过去的X-Cube架构中,底部裸片的面积要大于顶部裸片,然而为了更好了满足客户对芯片分区和散热等不同要求,三星也将在后续提供顶部裸片大于底部裸片的结构。目前三星已经完成了3D堆叠SRAM的验证,在7nm的制程下,可以做到48.6GB/s的带宽,以及7.2ns的读取延迟与2.6ns的写入延迟。
除此之外,三星还提供了一项差异化技术,ISC(集成堆叠电容)。这一电容应用了已经在三星DRAM产品中获得验证的硅电容结构、材料和工艺,具有1100nF/mm2的电容密度,可以有效提高电源完整性。三星的ISC还提供了多种不同的配置,比如分立型、硅中介层型和多晶圆堆叠型,以满足客户不同的结构需求,ISC预计将在2022年进入量产阶段。
I-Cube:横向2.5D组合
另一方面,为了从横向组合芯片,三星开发了所谓的2.5D技术I-Cube,将逻辑单元与多个HBM集成在同一硅中介层上。目前三星已经成功实现了一个逻辑裸片+两个HBM的I-Cube2量产,成品之一就是百度的昆仑AI芯片。百度的昆仑AI芯片不仅使用了三星的14nm制程,也运用了三星的I-CUBE 2技术。
I-Cube使用了预筛选的技术,在封装的中间阶段进行运算测试,从而提高良率。该技术还采用了无封胶的结构,做到更好的散热性能,据三星强调,与传统的2.5D方案相比,I-Cube的散热效率高上4.5%。此外,与其他代工厂商相比,三星的I-Cube技术还有一些优势,比如与三星内存合作,率先用上最新的内存方案

I-Cube4示意图 / 三星
目前三星已经在计划集成4HBM3模组的I-Cube4量产工作,而6 HBM的I-Cube6也已经做好量产准备,前者预计2022年进入大批量产阶段。三星更是准备了两个逻辑裸片+8个HBM的I-Cube8方案,目前尚处于开发阶段,预计2022年末将正式上线。
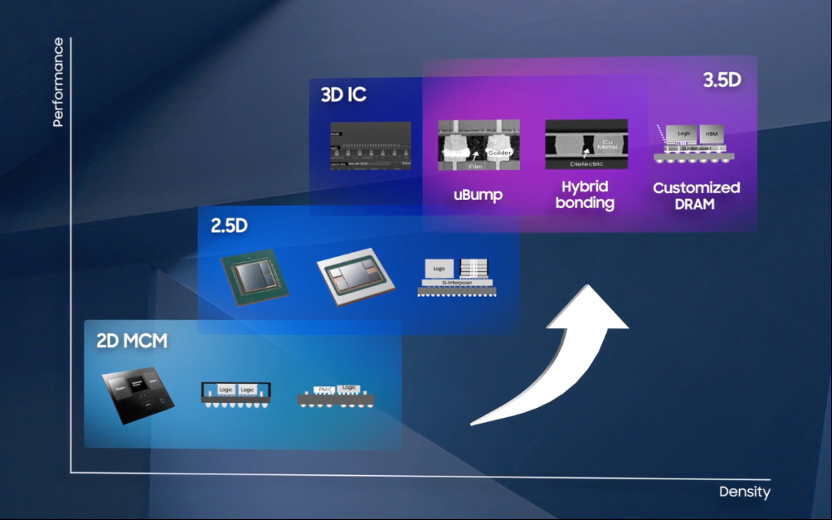
2D至3.5D的封装方案 / 三星
除了2D、2.5D与3D的IC技术之外,三星还在开发全新的3.5D封装技术,这种系统级封装内还将加入堆叠的定制DRAM或SRAM裸片,实现更高的性能与密度。
小结
在开发2.5D/3D集成的多芯片或多Chiplet系统级芯片时,设计者往往还会遇到在传统单芯片设计上罕见的技术障碍,比如多出来的接口IP或潜在的功耗增加。这时候,三星、台积电和刚进入IDM 2.0的英特尔等代工厂商还会提供异构设计的方法和工具,帮助设计者克服这些挑战。在异构集成的大势之下,代工厂也将提供更多的服务模式,增加封装、测试以及一站式的设计服务。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
三星电子
+关注
关注
34文章
15900浏览量
183274 -
异构
+关注
关注
0文章
47浏览量
13573 -
异构集成
+关注
关注
0文章
42浏览量
2374
发布评论请先 登录
相关推荐
热点推荐

三星电容的温度系数如何选择?
在电子元件选型中,温度系数是决定电容性能稳定性的核心参数之一。三星电容凭借X5R、X7R等主流温度特性材料,为不同场景提供了精准匹配方案。今天从温度系数的物理意义出发,结合典型应用场景,解析选型逻辑

华大九天Argus 3D重塑3D IC全链路PV验证新格局
随着摩尔定律逐步逼近物理极限,半导体行业正转向三维垂直拓展的技术路径,以延续迭代节奏、实现“超越摩尔”目标。Chiplet为核心的先进封装技术,通过将不同工艺、功能的裸片(Die)

爆!三星退出SATA SSD业务!
电子发烧友网报道(文/黄晶晶)2025年12月14日,知名硬件爆料人Tom(YouTube频道Moore's Law Is Dead)爆料称,三星计划在2026年初预计CES展会后,宣布逐步退出

三星电子正式发布Galaxy Z TriFold
2025年12月2日,三星电子正式发布Galaxy Z TriFold,进一步巩固了三星在移动AI时代中针对形态创新的行业优势。
0201三星贴片电容的优势与应用
三星0201贴片电容凭借0.50mm×0.25mm的极致尺寸(部分批次为0.6mm×0.3mm),在有限空间内实现高性能集成,成为推动电子设备小型化与功能升级的关键元件。 0201三星贴片电容的优势

三星COG材质电容的耐压值是多少?
三星COG材质电容的耐压值通常覆盖6.3V至500V,常见规格包括50V、100V、250V及500V,具体取决于封装尺寸与产品系列。以下为详细分析: 一、耐压值范围与典型规格 基础耐压值 COG
【2025九峰山论坛】破局摩尔定律:异质异构集成如何撬动新赛道?
在半导体产业不断演进的历程中,异质异构集成技术正逐渐成为推动行业突破现有瓶颈、迈向全新发展阶段的关键力量。在这样的产业变革背景下,九峰山论坛暨化合物半导体产业博览会于武汉光谷盛大召开,吸引了来自美国

当摩尔定律 “踩刹车” ,三星 、AP、普迪飞共话半导体制造新变革新机遇
在过去的GSA高管论坛上,三星半导体执行副总裁MarcoChisari、SAP全球高科技副总裁JeffHowell及普迪飞CEOJohnKibarian等行业领军者围绕半导体产业核心挑战展开深度对话

三星最新消息:三星将在美国工厂为苹果生产芯片 三星和海力士不会被征收100%关税
给大家带来三星的最新消息: 三星将在美国工厂为苹果生产芯片 据外媒报道,三星电子公司将在美国德克萨斯州奥斯汀的芯片代工厂生产苹果公司的下一代芯片。而苹果公司在新闻稿中也印证了这个一消息,在新闻稿中
曝三星S26拿到全球2nm芯片首发权 三星获特斯拉千亿芯片代工大单
我们来看看三星的最新消息: 曝三星S26拿到全球2nm芯片首发权 数码博主“刹那数码”爆料称,三星Exynos 2600芯片已进入质量测试阶段,计划在今年10月完成基于HPB(High
看点:三星电子Q2利润预计重挫39% 星动纪元宣布完成近5亿元A轮融资
给大家带来一些业界资讯: 三星电子Q2利润预计重挫39% 由于三星向英伟达供应先进存储芯片延迟,三星预计将公布4-6月营业利润为6.3万亿韩元(约46.2亿美元;三星电子打算在周二公布
购买三星车规电容(MLCC),为什么选择代理商贞光科技?
作为三星MLCC授权代理商,我们贞光科技深耕汽车电子领域多年,见证了新能源汽车市场的爆发式增长。车规级MLCC需求激增,选择专业可靠的代理商变得至关重要。三星车规MLCC——贞光科技核心代理产品技术

外媒称三星与英飞凌/恩智浦达成合作,共同研发下一代汽车芯片
与处理器的协同设计”,并致力于“增强芯片的安全性能与实时处理能力”。三星据称正在为该领域开发高集成度的 SoC 方案,以实现更优的能效比。 三星和英飞凌、恩智浦这两家公司之间已有深厚联系,几年前市场曾一度传言



 超越摩尔,三星的异构集成之路
超越摩尔,三星的异构集成之路





评论